2.5D硅中介層(Interposer)晶圓制造成本有望降低。半導體業界已研發出標準化的制程、設備及新型黏著劑,可確保硅中介層晶圓在薄化過程中不會發生厚度不一致或斷裂現象,并能順利從載具上剝離,有助提高整體生產良率,減少成本浪費。
2013-04-11 09:50:26 2167
2167 目前在全球半導體產業領域,有業界人士認為2.5D先進封裝技術的芯片產品成本,未來可望隨著相關產品量產而愈來愈低,但這樣的假設可能忽略技術本身及制造商營運管理面的諸多問題與困境,可能并非如此容易預測新興封裝技術產品的未來價格走勢。
2016-03-24 08:23:56 3661
3661 Info封裝與CoWoS封裝是目前2.5D封裝的典型代表,同屬于TSMC開發的2.5D封裝,那么如何區分 Info封裝與CoWoS封裝呢?主要從以下方面進行闡述。
2023-06-20 11:50:20 1215
1215 
電子封裝集成度的不斷提高,集成電路的功率容量和發熱量也越來越高,封裝體內就 �產生了越來越多的溫度分布以及熱應力問題 文章建立了基板一粘結層一硅芯片熱應力分析有限元模。利用有限元法分析了芯片/基板
2012-02-01 17:19:01
翹曲產生的焊接缺陷是什么?
2021-04-23 06:23:37
空焊短路不打緊,更嚴重的是翹曲后的焊點,將會呈現拉伸與擠壓的形狀,完美的焊點應該是接近「球型」(圖八),而翹曲將導致焊點呈現「瘦高」(圖九)或「矮胖」形狀(圖十),這些「非球型」的焊點,容易產生應力集中而斷裂,使得后續在可靠性驗證中,出現早夭現象的機率提高。宜特
2019-08-08 17:05:02
就是在2.5 / 3D EM求解器中開始優化會話,讓我的電腦在周末出汗。這似乎不可行。我已經看到一些使用Momentum描述優化的Web內容,但那是幾個版本之前。據我所知(現在),我無法以參數化方式將過
2018-09-26 15:17:48
翹曲 在回流焊期間,較大的塑料封裝可能會產生翹曲。一些情況下,會看到覆層(over-moldingcompound)和基板產生了翹曲,這會導致外部連接點與焊盤的接觸減至最小。一些工程師指出,小片
2018-09-05 16:37:49
本帖最后由 pcbsun 于 2013-2-19 15:02 編輯
PCB和元器件在焊接過程中產生翹曲,由于應力變形而產生虛焊、短路等缺陷。翹曲往往是由于PCB的上下部分溫度不平衡造成
2013-02-19 15:01:17
;一般板固化片卷方向為經向;覆銅板長方向為經向;除了以上翹曲注意PCB優客板下單平臺還提示以下:1、層壓厚消除應力 壓板後冷壓,修剪毛邊;2、鉆孔前烘板:150度4小時;3、薄板最好不經過機械磨刷,采用
2017-08-18 09:19:09
5-10年前,翹曲幅度控制在6-8mil以內,都還不至于影響后續SMT等工藝;然而經過這幾年來,各項先進工藝的材料種類復雜且反復堆棧,受到溫度影響后的變形量已比5-10年前的樣品來的嚴重。宜特板階
2019-08-08 16:53:58
影響可焊性從而產生缺陷,這些缺陷包括錫珠、錫球、開路、光澤度不好等。 2、翹曲產生的焊接缺陷 電路板和元器件在焊接過程中產生翹曲,由于應力變形而產生虛焊、短路等缺陷。翹曲往往是由于電路板的上下
2019-05-08 01:06:52
首先說的是覆銅的時候是網格好還是全銅好,大的板子,網格銅好,因為全銅在受到外力的時候會保持翹曲情況,網格的就不會保持~會恢復到原來的平整情況,一般工藝邊也留銅目的就是要保障板子的翹曲度
2018-09-14 16:31:28
PCB板的翹曲度介紹首先說的是覆銅的時候是網格好還是全銅好,大的板子,網格銅好,因為全銅在受到外力的時候會保持翹曲情況,網格的就不會保持~會恢復到原來的平整情況,一般工藝邊也留銅目的就是要保障板子
2013-10-15 11:02:46
不能將所有的問題放在零件身上,PCB也會有翹曲的狀況,原先以為PCB厚度只要超過1.6mm,PCB本身發生翹曲(warpage)的機率會較小,但實則不然。宜特板階可靠性實驗室曾經有個經典案例,IC上
2019-08-08 16:37:49
方法1 引言為了獲得BGA與PCB之間良好的連接,找到一個不產生翹曲的解決辦法是必要的。為了適應當代更小、密度更高的IC技術的發展趨勢,作為新的IC封裝技術形式的球柵陣列封裝BGA是人們關注的焦點。然而
2018-08-23 17:26:53
階段或者器件使用階段。封裝工藝導致的不良粘接界面是引起分層的主要因素。界面空洞、封裝時的表面污染和固化不完全都會導致粘接不良。其他影響因素還包括固化和冷卻時收縮應力與翹曲。在冷卻過程中,塑封料和相鄰材料
2021-11-19 06:30:00
注塑制品一個普遍存在的缺點是有內應力。內應力的存在不僅是制件在儲存和使用中出現翹曲變形和開裂的重要原因,也是影響制件光學性能、電學性能、物理力學性能和表觀質量的重要因素。
2015-07-28 10:19:53
翹曲度是實測平面在空間中的彎曲程度,以翹曲量來表示,比如絕對平面的翹曲度為0。計算翹曲平面在高度方向最遠的兩點距離為最大翹曲變形量。翹曲度計算公式:晶圓翹曲度影響著晶圓直接鍵合質量,翹曲度越小,表面
2022-11-18 17:45:23
原因。耐熱性的FR-5也發生若干起泡。由于四種條件中沒有顯著差別。所以認為發生起泡的主要原因在于構造本身。根據截面解析的結果芯片本身顯著翹曲,由于嵌入以后內在的殘留應力在再流焊時被釋放而發生變形,或者
2018-09-12 15:36:46
如何預防印制電路板在加工過程中產生翹曲?怎樣去處理翹曲的PCB板?
2021-04-25 09:38:32
如何防止PCB通過回流爐時彎曲和翹曲?
2019-08-20 16:36:55
首家P|CB樣板打板 三.制造過程中防板翹曲 1.工程設計:印制板設計時應注意事項: A.層間半固化片的排列應當對稱,例如六層板,1~2和5~6層間的厚度和半固化片的張數應當一致,否則層壓后容易
2013-09-24 15:45:03
IPC-TM-650.2.4.22B。把印制板放到經檢定的平臺上,把測試針插到翹曲度最大的地方,以測試針的直徑,除以印制板曲邊的長度,就可以計算出該印制板的翹曲度了。三.制造過程中防板翹曲1.工程設計:印制板
2013-03-19 21:41:29
線路板翹曲會造成元器件定位不準;板彎在SMT,THT時,元器件插腳不整,將給組裝和安裝工作帶來不少困難。 IPC-6012,SMB--SMT的線路板最大翹曲度或扭曲度0.75%,其它板子翹曲度
2018-11-28 11:11:42
預防印制電路板在加工過程中產生翹曲印制電路板翹曲整平方法
2021-02-25 08:21:39
*240+76.3*76.3)=251.8mm 弓曲板翹曲度為=(R1-R2)/W*100%=3/76.3*100%= 3.93% 扭曲板翹曲度為=(R1-R2)/D*100% =5/251.8*100
2023-04-20 16:39:58
對于密間距元件裝配的回流焊接工藝控制的重點,在于控制基板在回流焊接過程中的翹曲變形,防止細小的焊點在此過程中的氧化,減少焊點中的空洞。基板在回流過程中的細微變形可能會在焊點中產生應力,導致焊點
2018-09-06 16:32:22
曲度了。 那么在PCB制板過程中,造成板彎和板翹的原因有哪些?下面我們來探討一下。 每個板彎與板翹所形成的原因或許都不太一樣,但應該都可以歸咎于施加于板子上的應力大過了板子材料所能承受的應力,當板子
2017-12-07 11:17:46
等工藝過程。在這些過程中,由于板受冷、熱和溶液、溶劑的沖洗、浸泡等外界因素的影響,產生伸縮率不同,應力各異的內部結構變化,造成板的各類翹曲。將印制板加工后進入整機生產過程,先是裝插元器件,然后投入自動
2013-09-12 10:31:14
在PCB布局的過程中,元件的3D封裝是起什么作用的?是不是一定要呢?
2019-06-25 22:07:19
本帖最后由 一只耳朵怪 于 2018-5-24 16:52 編輯
如何預防PCB板翹曲線路板翹曲會造成元器件定位不準;板彎在SMT,THT時,元器件插腳不整,將給組裝和安裝工作帶來不少困難
2018-05-24 13:25:09
找可能導致MLCC失效的原因,比如PCB安裝時的翹曲,外力擠壓,手工焊接導致的熱應力,超聲波焊接,高頻振動等等 后面分析1、大容量的貼片陶瓷電容比較容易發生漏電2、跟分板的應力有關系3、對電容進行分析,存在裂紋
2019-04-13 18:55:29
隨之增加。對所有表面處理方式的封裝基板,過大的應變都會導致焊點的損壞。這些失效包括在PCBA制造和測試過程中的焊球開裂、線路損壞、焊盤起翹和基板開裂。 作用在PCBA水溶性焊錫絲焊點上的應力,無非機械
2016-06-16 14:01:59
`針對PCB板翹曲如何解決? 線路板翹曲會造成元器件定位不準;板彎在SMT,THT時,元器件插腳不整,將給組裝和安裝工作帶來不少困難。 IPC-6012,SMB--SMT的線路板最大翹曲度或扭曲
2017-11-10 11:43:39
針對PCB板翹曲如何解決? 線路板翹曲會造成元器件定位不準;板彎在SMT,THT時,元器件插腳不整,將給組裝和安裝工作帶來不少困難。 IPC-6012,SMB--SMT的線路板最大翹曲度或扭曲
2017-11-10 15:54:28
IPC-TM-650.2.4.22B。把印制板放到經檢定的平臺上,把測試針插到翹曲度最大的地方,以測試針的直徑,除以印制板曲邊的長度,就可以計算出該印制板的翹曲度了。 三、制造過程中防板翹曲 1、工程設計
2019-08-05 14:20:43
IPC-TM-650.2.4.22B。把印制板放到經檢定的平臺上,把測試針插到翹曲度最大的地方,以測試針的直徑,除以印制板曲邊的長度,就可以計算出該印制板的翹曲度了。 三.制造過程中防板翹曲 1.
2018-09-17 17:11:13
及杜絕豎放、避免重壓就可以了。對于線路圖形存在大面積的銅皮的PCB板,最好將銅箔網格化以減少應力。 3、消除基板應力,減少加工過程PCB板翹曲 由于在PCB加工過程中,基板要多次受到熱的作用及要受到
2013-01-17 11:29:04
轉帖線路板翹曲會造成元器件定位不準;板彎在SMT,THT時,元器件插腳不整,將給組裝和安裝工作帶來不少困難。IPC-6012,SMB--SMT的線路板最大翹曲度或扭曲度0.75%,其它板子翹曲度一般
2017-12-28 08:57:45
豎放、避免重壓就可以了。對于線路圖形存在大面積的銅皮的PCB板,最好將銅箔網格化以減少應力。 3、消除基板應力,減少加工過程PCB板翹曲 由于在PCB加工過程中,基板要多次受到熱的作用及要受到多種
2013-03-11 10:48:04
對于測量精度高的零件,中圖儀器2.5d自動影像測量儀相當于一臺小的三座標測量儀,即為復合式影像測量儀,全行程采用立柱式、龍門橋式的穩定結構,單軸的超高測量精度可達(1.8+L/200)um,在需要
2022-08-02 15:43:00
中圖儀器CH系列2.5d影像儀品牌6.5X電動變倍高分辨率鏡頭和大視野鏡頭組合測量,表面光、透射光、同軸光分段編程控制,鑄就強大的毛邊、弱邊抓取功能,清晰呈現工件真實邊緣,實現準確測量。儀器測量手段
2022-11-04 11:43:57
利用硅壓阻力學芯片傳感器作為原位監測的載體,研究了直接粘貼芯片的封裝方式中,芯片在基板上的不同位置對于封裝后殘余應力的影響以及在熱處理過程中殘余應力的變化,發
2009-07-14 12:04:03 19
19 Novator系列2.5d全自動影像儀將傳統影像測量與激光測量掃描技術相結合,充分發揮了光學電動變倍鏡頭的高精度優勢,多種測量新特性、新功能的創新支持,可實現2.5D和3D復合測量。還支持頻閃照明
2023-03-06 09:29:01
Novator系列2.5D影像測量儀是一種全自動影像測量儀。它將傳統影像測量與激光測量掃描技術相結合,充分發揮了光學電動變倍鏡頭的高精度優勢,支持點激光輪廓掃描測量、線激光3D掃描成像,可進行高度
2023-06-07 11:19:54
電子發燒友網訊:【編譯/Triquinne 】為打破通訊系統內存帶寬限制,華為和Altera將合力研發以2.5D封裝形式集成FPGA和內存單元。華為一位資深科學家表示,這項技術雖然棘手,但是在網絡
2012-11-15 16:40:03 1256
1256 一位華為的資深科學家表示,華為和Altera將推出集成了FPGA和有眾多I/O接口的內存的2.5D硅基封裝芯片,旨在突破通信設備中的內存帶寬的極限。這項技術雖然面臨巨大的挑戰,但該技術
2012-11-16 11:03:22 1845
1845 目前大部分中高端機型都采用了2.5D屏幕玻璃,“溫潤晶瑩”且“柔美舒適”,廠商愛這么描述2.5D玻璃,那你對它又了解多少呢?
2017-01-23 09:47:25 6340
6340 MacRumors網站從早前日經英文站點Nikkei Asian News有關iPhone 8曲面屏幕的傳聞推斷,iPhone 8采用的2.5D曲面屏幕,弧度遠比Galaxy S7 edge那些3D
2017-03-17 09:42:54 560
560 榮耀8目前在京東的最低價格是1499元,看來榮耀9發布之后,榮耀8真的不值錢了,不過,這樣一來,榮耀8的性價比就變得更高,而且比榮耀8青春版更值得去購買。最主要的看點其實還是榮耀8采用的雙2.5D
2017-06-27 17:23:12 2757
2757 加利福尼亞,圣克拉拉(2017年8月9日)——格芯今日宣布推出2.5D封裝解決方案,展示了其針對高性能14納米FinFET FX-14?ASIC集成電路設計系統的功能。
2017-08-14 17:46:54 794
794 對于數據密集型應用,大量能量和延時消耗在計算和存儲單元之間的數據傳輸上,造成馮諾依曼瓶頸。在采用2.5D封裝集成的系統中,這一問題依然存在。為此,提出一種新型的硬件加速方案。引入存儲型計算到2.5D
2018-02-26 11:47:46 1
1 對于目前的高端市場,市場上最流行的2.5D和3D集成技術為3D堆疊存儲TSV,以及異構堆疊TSV中介層。Chip-on-Wafer-on-Substrate(CoWos)技術已經廣泛用于高性能計算
2019-02-15 10:42:19 6212
6212 
焊接應力,是焊接構件由于焊接而產生的應力。焊接過程中焊件中產生的內應力和焊接熱過程引起的焊件的形狀和尺寸變化。
2020-02-04 15:01:13 2562
2562 協作機器人夾爪制造商OnRobot推出最新2.5D視覺系統Eyes,適用于各家先進機器手臂,提供外加的深度感知和零件辨識功能。
2020-05-31 10:14:43 983
983 半導體業界,幾家公司正在競相開發基于各種下一代互連技術的新型2.5D和3D封裝。
2020-06-16 14:25:05 7462
7462 代工廠、設備供應商、研發機構等都在研發一種稱之為銅混合鍵合(Hybrid bonding)工藝,這項技術正在推動下一代2.5D和3D封裝技術。
2020-10-10 15:24:32 6208
6208 
異構集成基礎:基于工業的2.5D/3D尋徑和協同設計方法
2021-07-05 10:13:36 12
12 今天,三星推出了全新2.5D封裝解決方案H-Cube(Hybrid Substrate Cube,混合基板封裝),專用于需要高性能和大面積封裝技術的高性能計算(HPC)、人工智能(AI)、數據中心和網絡產品等領域。
2021-11-12 15:52:17 2351
2351 農歷新年后開工第一天,上海微電子裝備集團(以下簡稱“上海微電子”)正式舉行“中國首臺2.5D/3D先進封裝光刻機發運儀式”,由上海微電子生產的中國首臺2.5D/3D先進封裝光刻機正式交付客戶。不過,具體客戶未知。
2022-02-08 12:47:41 16628
16628 開始呈現疲軟的狀態,先進
制成工藝也無法帶來成本上的縮減。如何超越摩爾定律(More than Moore’s
law),讓行業繼續高速發展,成為業界苦苦尋思的問題。而目前來看,2.5D/3D
先進封裝技術將會是行業一個重要的突破口,是超越摩爾定律的必經之路
2022-04-29 17:20:01 8
8 (Signal Integrity, SI)、電源完整性 (Power
Integrity, PI) 及可靠性優化。總結了目前 2.5D/3D 芯片仿真進展與挑戰,介紹了基于芯片模型的
Ansys 芯片-封裝-系統 (CPS) 多物理場協同仿真方法,闡述了如何模擬芯片在真實工況下達到優化
芯片信
2022-05-06 15:20:42 8
8 在閱讀文章之前,大家可以思考下 2.5D 設計屬于哪種界定?
2022-06-06 10:17:22 1135
1135 為了更有效辨別 2D 與 2.5D 之間的區別,圖撲軟件選用 2D 空調裝配生產線與 2.5D 化工廠安全流程作比較。通過自主研發的 HT 產品,采用 B/S 架構快速搭建零代碼拖拽式 Web 組態可視化場景,以真實的場景化、圖形化、動態化的效果,反映二者運行狀態、工藝流程、動態效果之間的不同。
2022-06-07 10:10:45 779
779 3D晶圓級封裝,包括CIS發射器、MEMS封裝、標準器件封裝。是指在不改變封裝體尺寸的前提下,在同一個封裝體內于垂直方向疊放兩個以上芯片的封裝技術,它起源于快閃存儲器(NOR/NAND)及SDRAM的疊層封裝。
2022-07-25 15:35:41 1660
1660 異質整合需要通過先進封裝提升系統性能,以2.5D/3D IC封裝為例,可提供用于存儲器與小芯片集成的高密度互連,例如提供Sub-micron的線寬與線距,或五層的互連,是良好的Interposer(中介層)。
2022-08-24 09:35:53 3319
3319 2.5D封裝是傳統2D IC封裝技術的進展,可實現更精細的線路與空間利用。在2.5D封裝中,裸晶堆棧或并排放置在具有硅通孔(TSV)的中介層(interposer)頂部。其底座,即中介層,可提供芯片之間的連接性。
2022-10-26 09:34:04 641
641 2.5D封裝是傳統2D IC封裝技術的進展,可實現更精細的線路與空間利用。在2.5D封裝中,裸晶堆棧或并排放置在具有硅通孔(TSV)的中介層(interposer)頂部。其底座,即中介層,可提供芯片之間的連接性。
2022-11-14 10:14:53 970
970 2.5D封裝是傳統2D IC封裝技術的進展,可實現更精細的線路與空間利用。在2.5D封裝中,裸晶堆棧或并排放置在具有硅通孔(TSV)的中介層(interposer)頂部。其底座,即中介層,可提供芯片之間的連接性。
2022-11-15 09:35:36 1635
1635 先進的2.5D異質整合結構芯片封裝技術來扮演這個角色。但是為什么需要采用2.5D封裝技術,以目前來說,2.5D封裝是一種高階的IC芯片封裝技術,可實現各種IC芯片的高速整合。
2022-12-05 16:25:39 612
612 
應力測試原理:電路板在生產組裝過程中,容易造成形變,過大的形變會導致電路板元器件開裂、焊球開裂、線路起翹等。如何控制和監測電路板形變量,是電路板生產組裝過程不可或缺的一環。137+柒陸壹伍
2023-03-11 14:49:58 482
482 SiP是一個非常寬泛的概念,廣義上看,它囊括了幾乎所有多芯片封裝技術,但就最先進SiP封裝技術而言,主要包括 2.5D/3D Fan-out(扇出)、Embedded、2.5D/3D Integration,以及異構Chiplet封裝技術。
2023-03-20 09:51:54 1064
1064 
創建真正的 3D 設計被證明比 2.5D 復雜和困難得多,需要在技術和工具方面進行重大創新。
2023-04-03 10:32:41 2492
2492 裸芯通過微凸點組裝到Interposer上,如上圖所示。其Interposer上堆疊了三顆裸芯。Interposer包括兩種類型的互聯:①由微凸點和Interposer頂部的RDL組成的水平互連,它連接各種裸芯②由微凸點、TSV簇和C4凸點組成的垂直互聯,它將裸芯連接至封裝。
2023-04-10 11:28:50 6680
6680 就收入而言,倒裝芯片BGA、倒裝芯片CSP和2.5D/3D是主要的封裝平臺,其中2.5D/3D技術的增長率最高。2.5D/3D 市場預計將從 2022 年的 92 億美元增長到 2028 年的 258 億美元,實現 19% 的復合年增長率。
2023-04-24 10:09:52 788
788 
電子發燒友網站提供《用焊接在一起的PCB重建2.5D凸輪.zip》資料免費下載
2023-06-08 11:05:24 0
0 據2022年2月7日消息,上海微電子裝備(集團)股份有限公司(SMEE)舉行首臺2.5D/3D先進封裝光刻機發運儀式,向客戶正式交付先進封裝光刻機。需要指出的是,上海微電子此次交付的是用于IC
2022-02-11 09:37:04 10565
10565 
Info封裝與CoWoS封裝是目前2.5D封裝的典型代表,同屬于TSMC開發的2.5D封裝,那么如何區分 Info封裝與CoWoS封裝呢?主要從以下方面進行闡述。
2023-06-20 11:51:35 3474
3474 
nvidia的a100、h100和其他ai gpu目前使用控制臺來制造晶片和2.5包的前端工程。nvidia ai gpu使用的hbm芯片由sk海力士獨家提供。但是tsmc沒有能力處理2.5d包裝所需的所有工作。
2023-07-20 10:45:23 549
549 熱點新聞 1、三星計劃為英偉達AI GPU提供HBM3和2.5D封裝服務 據報道,英偉達正在努力實現數據中心AI GPU中使用的HBM3和2.5D封裝的采購多元化。消息人士稱,這家美國芯片巨頭正在
2023-07-20 17:00:02 420
420 
日本的半導體公司rafidus成立于2022年8月,目前正集中開發利用2.5d和3d包裝將多個不同芯片組合起來的異構體集成技術。Rapidus當天通過網站表示:“計劃與西方企業合作,開發新一代3d lsi(大規模集成電路),并利用領先技術,批量生產2納米及以下工程的芯片。”
2023-07-21 10:32:31 647
647 2.5D封裝和3D IC封裝都是新興的半導體封裝技術,它們都可以實現芯片間的高速、高密度互連,從而提高系統的性能和集成度。
2023-08-01 10:07:36 2736
2736 
先進封裝技術以SiP、WLP、2.5D/3D為三大發展重點。先進封裝核心技術包括Bumping凸點、RDL重布線、硅中介層和TSV通孔等,依托這些技術的組合各廠商發展出了滿足多樣化需求的封裝解決方案,SiP系統級封裝、WLP晶圓級封裝、2.5D/3D封裝為三大發展重點。
2023-09-28 15:29:37 1765
1765 
打破IC發展限制,向高密度封裝時代邁進。集成電路封裝是指將制備合格芯片、元件等裝配到載體上,采用適當連接技術形成電氣連接,安裝外殼,構成有效組件的整個過程,封裝主要起著安放、固定、密封、保護芯片,以及確保電路性能和熱性能等作用。
2023-10-08 11:43:25 308
308 
來源:《半導體芯科技》雜志 ASIC設計服務暨IP研發銷售廠商智原科技(Faraday Technology Corporation)宣布推出其2.5D/3D先進封裝服務。通過獨家的芯片
2023-11-20 18:35:42 219
219 據悉,三星很有可能將這些裝置作為2.5d包使用在nvidia ai gpu和hbm3芯片上。根據Shinkawa的訂單結構分析,如果英偉達的訂單增加,三星的設備訂單也會增加。
2023-12-07 15:37:16 303
303 半導體芯片封裝的重要性、傳統和先進技術以及該領域的未來趨勢。
2024-01-02 11:09:17 427
427 
2.5D 和 3D 半導體封裝技術對于電子設備性能至關重要。這兩種解決方案都不同程度地增強了性能、減小了尺寸并提高了能效。2.5D 封裝有利于組合各種組件并減少占地面積。它適合高性能計算和人工智能加速器中的應用。3D 封裝提供無與倫比的集成度、高效散熱并縮短互連長度,使其成為高性能應用的理想選擇。
2024-01-07 09:42:10 532
532 
隨著集成電路技術的飛速發展,封裝技術作為連接芯片與外部世界的重要橋梁,也在不斷地創新與演進。2.5D封裝和3D封裝作為近年來的熱門技術,為電子系統的小型化、高性能化和低功耗化提供了有力支持。本文將詳細介紹2.5D封裝和3D封裝技術,并對它們進行對比分析。
2024-02-01 10:16:55 628
628 
自去年以來,隨著英偉達AI芯片需求的迅猛增長,作為其制造及封裝合作伙伴的臺積電(TSMC)在先進封裝技術方面面臨了前所未有的產能壓力。為了應對這一挑戰,臺積電正積極擴大其2.5D封裝產能,以確保能夠滿足持續增長的產能需求。
2024-02-06 16:47:14 3111
3111 了解到,2.5D封裝技術能夠有效地將CPU、GPU、I/O接口、HBM芯片等多種芯片以橫向方式置于中間層之上。如臺積電所采取的CoWoS技術以及三星的I-Cube便是此類技術。
2024-04-08 11:03:17 188
188
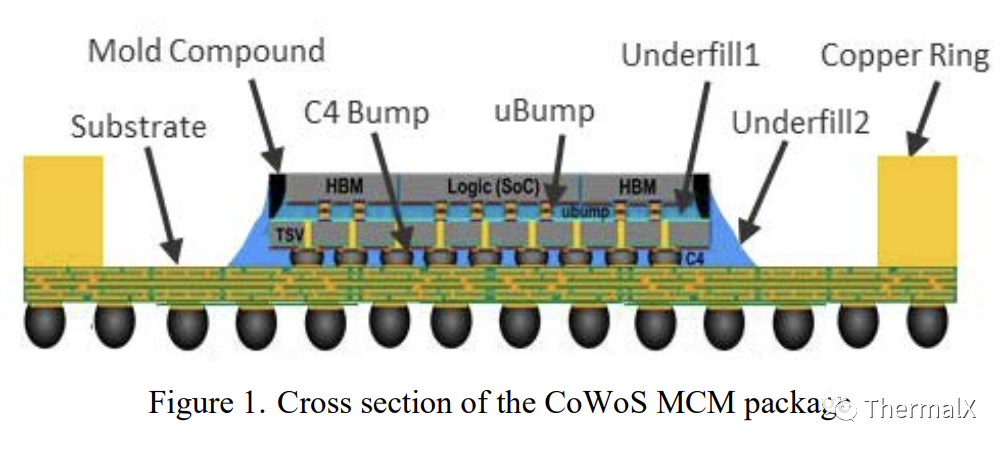


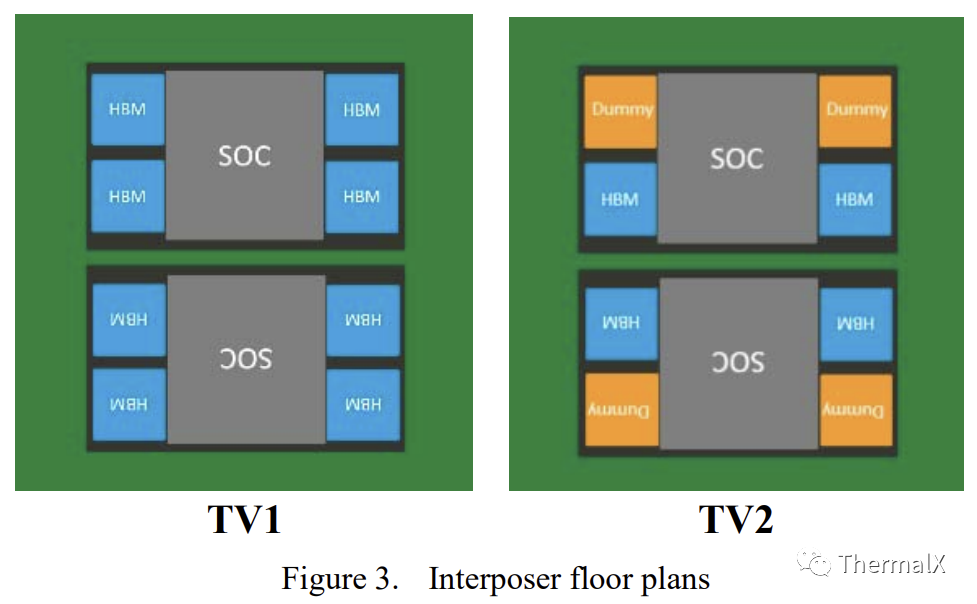
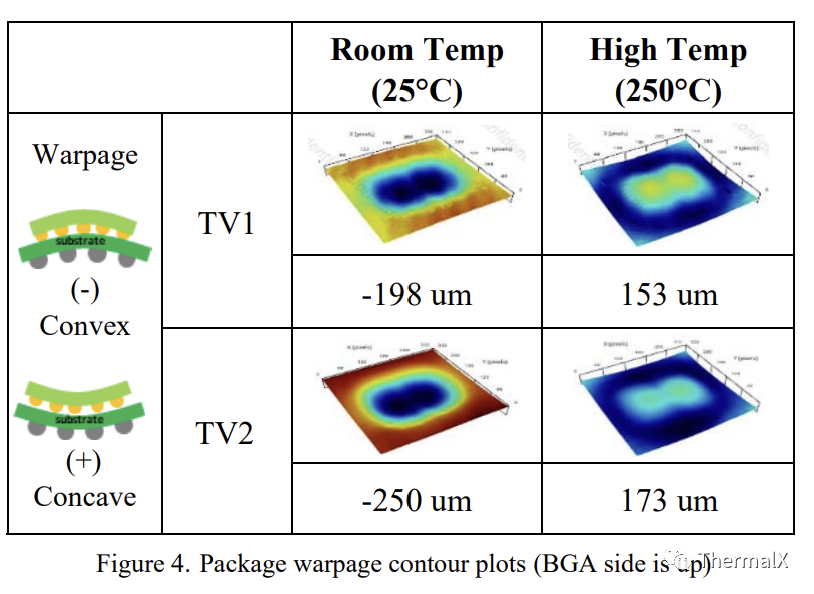


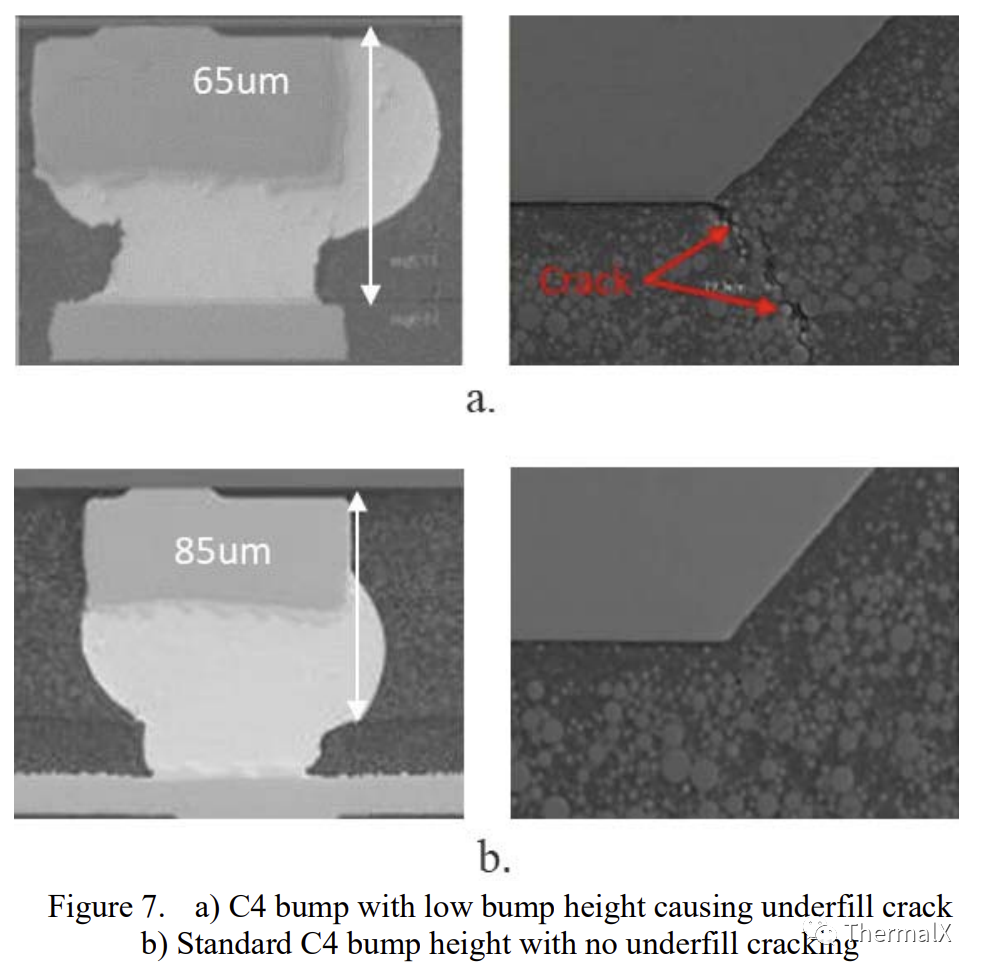



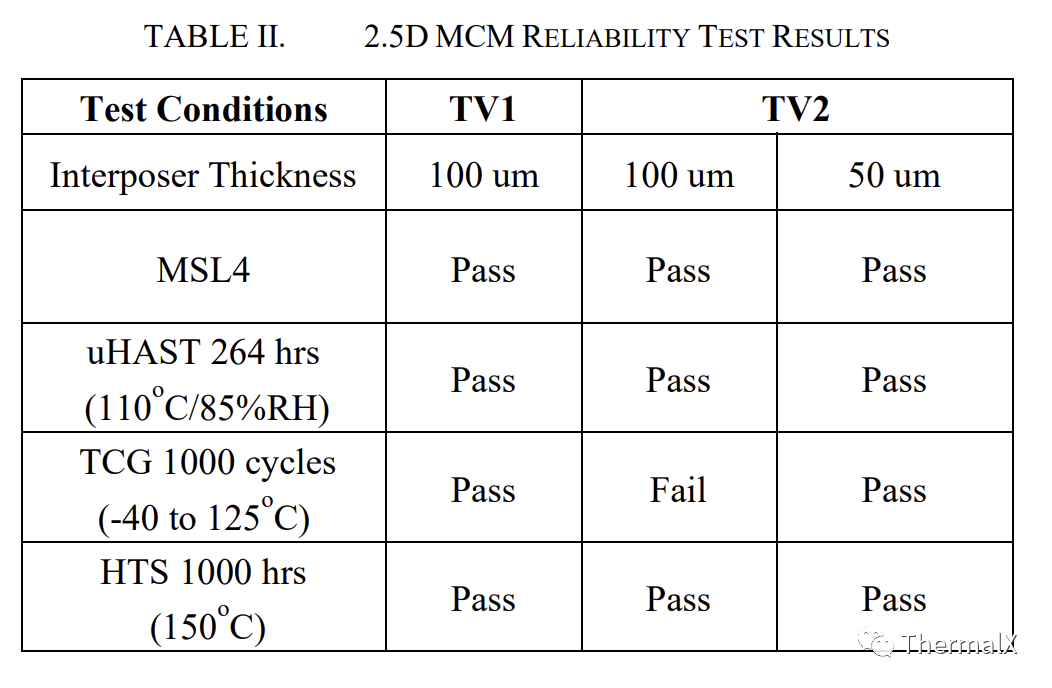
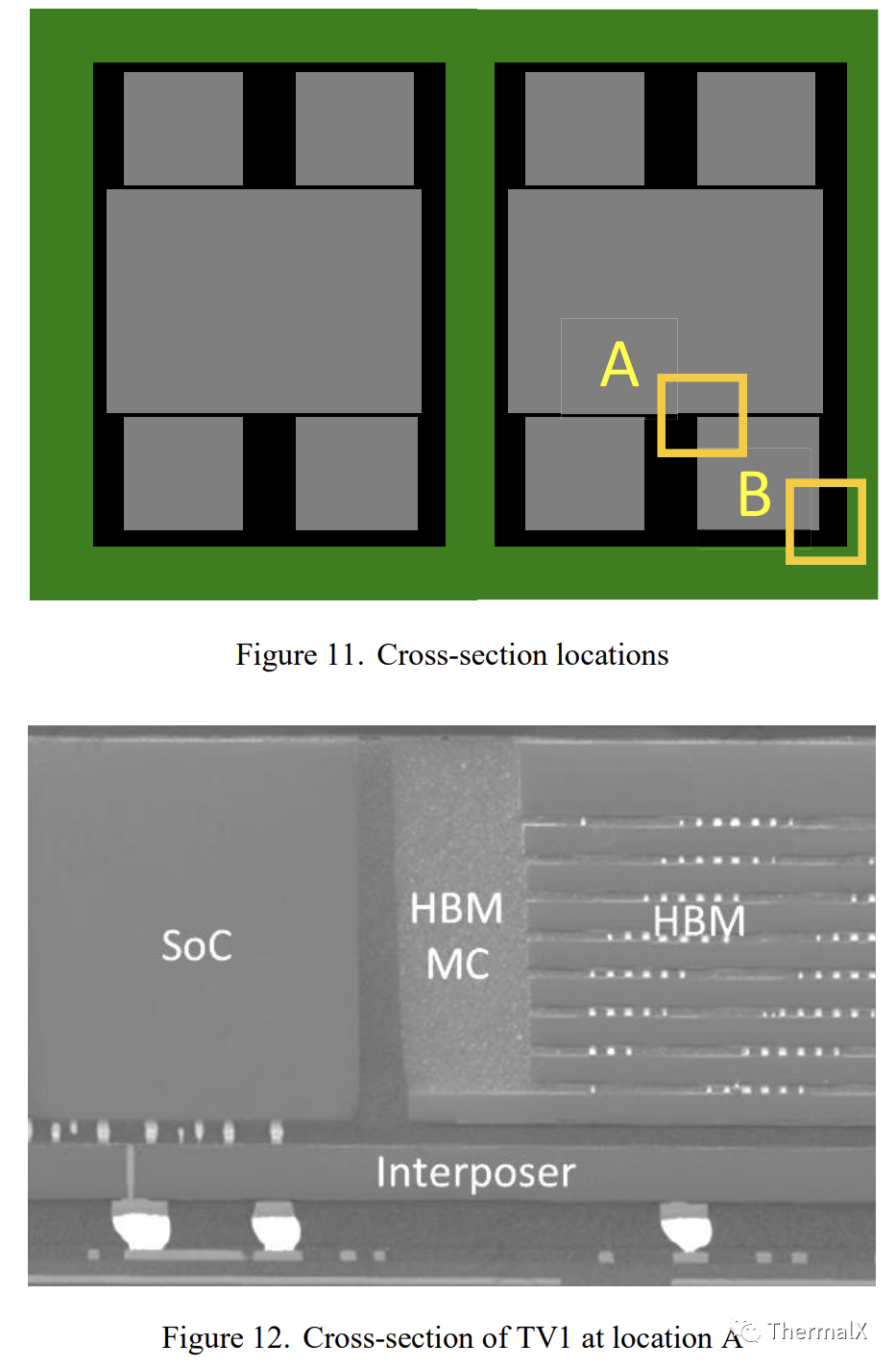
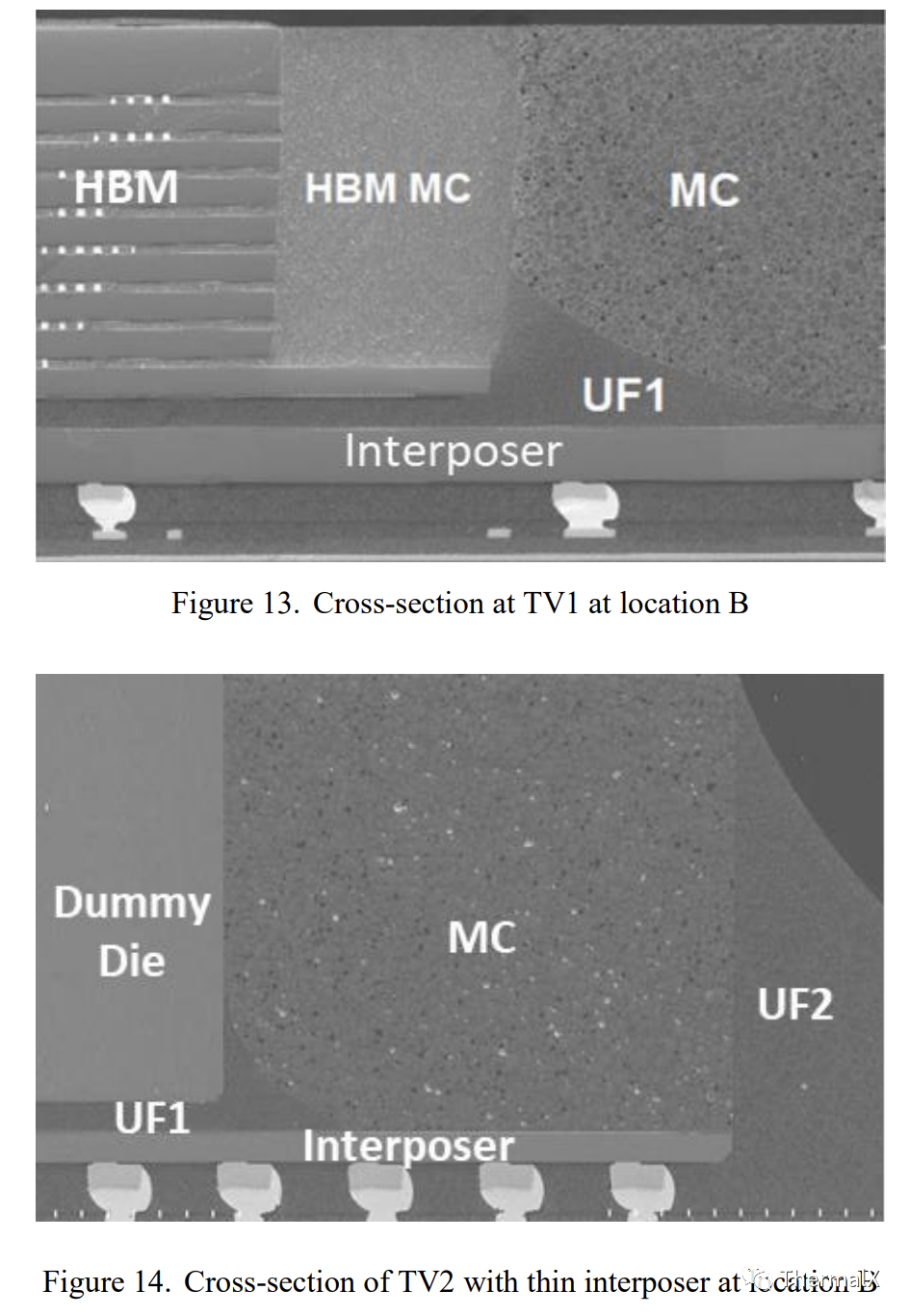
 電子發燒友App
電子發燒友App





































評論