半導體制造領域很少有技術能像引線鍵合那樣經受住時間的考驗。這一過程涉及將半導體器件與其封裝進行電連接,自電子工業誕生以來一直是電子工業的基石。
與半導體市場中的其他技術一樣,引線鍵合技術隨著時間的推移而發生變化,以跟上不斷縮小的架構、芯片復雜性和不斷增加的互連密度的步伐。隨著晶體管尺寸的縮小和芯片變得更加復雜,對更細間距的焊線、更可靠的連接以及能夠承受惡劣環境的材料的需求推動了創新。由于成本和性能優勢,銅、銅合金和銀等新材料已開始取代傳統金線。
Promex Industries首席執行官迪克·奧特 (Dick Otte) 表示:“近幾十年來,引線鍵合技術的主要進步在于支持手機和高密度電子產品。” “主要的進步包括采用銅線,它的導電性更強一些,但比黃金的成本節省了很多。這是近年來我在引線鍵合領域看到的最重要的變化。”
什么是引線鍵合?
引線鍵合是在硅芯片上的 IC 與其封裝之間創建互連的常用方法,其中將細線從器件上的鍵合焊盤連接到封裝上的相應焊盤(即引線)。此連接建立了從芯片內部電路到連接到印刷電路板 (PCB) 的外部引腳的電氣路徑。
該過程首先將一根電線放置在細長焊接工具末端的下方。施加精確的力,將導線推向電極表面,導致接觸點產生初始變形。該能量來自產生 60 kHz 左右機械振蕩的超聲波裝置。這些振蕩通過焊接工具傳導至熔化區域,持續時間約為 100 毫秒。
超聲波振動產生的摩擦會在界面處產生局部加熱,當與鍵合工具施加的壓力相結合時,會促進原子在界面上的擴散。當線材和基材材料的原子由于機械變形和摩擦效應而緊密接近時,它們開始形成金屬間化合物。這些化合物通常比母體材料更穩定,并確保導線和基材之間的牢固結合。
引線鍵合有兩種主要類型:球形鍵合和楔形鍵合。球形鍵合是最普遍的,約占所有鍵合的 90%,通常使用金和銅布線的熱超聲鍵合技術形成。楔形接合通常使用超聲波或熱壓縮技術創建,更常見于鋁合金和金線,并且經常用于特定應用。

圖 1:三種引線鍵合技術的比較。
然而,引線鍵合在先進節點和復雜芯片中已經失去了動力。隨著焊盤數量和密度的增加,確保電線不會接觸或造成干擾的空間有限。這就是熱壓 (TCP) 鍵合和倒裝芯片封裝技術等先進封裝技術發揮作用的地方。這些方法利用焊料或銅凸塊在芯片和基板之間建立直接連接,從而無需長導線互連。因此,它們為現代半導體器件,特別是高頻或高性能應用中的半導體器件提供了更緊湊、高效和高性能的解決方案。
“真正推動從引線鍵合到倒裝芯片的轉變的是對電子產品日益增長的高速要求,”Promex Industries 的高級工藝工程師 Jeff Schaefer 說。“電線會產生電感,而電感會導致高速世界的電氣參數問題。”
其他人也同意。“當你走向數百個,甚至數千個互連時,那么你將開始認真考慮采用引線鍵合與轉向倒裝芯片是否仍然正確,”布魯克的應用程序和產品管理Frank Chen 說。“但一般來說,大多數公司仍然會在倒裝芯片上使用引線鍵合,除非他們有大量的 I/O 將它們推入陣列格式。”
引線鍵合的演變
盡管長期以來人們一直預測引線鍵合將被先進封裝所取代,但當今 80% 以上的半導體封裝仍然使用引線鍵合進行組裝。其經過驗證的可靠性、成本效益以及成熟的芯片制造工藝(不需要超高互連密度)意味著它也可能在未來幾十年內繼續存在。
根據Technavio的最新報告,焊線機設備市場預計在2022年至2027年期間將以3.3%的復合年增長率繼續增長,市場規模預計在此期間增加2.1924億美元。這一增長是由汽車應用中電子內容的增加和 OSAT 行業的快速增長(特別是在亞太國家)推動的。
金 (Au) 鍵合線幾十年來一直是行業標準,這是有充分理由的。其無與倫比的化學穩定性、耐腐蝕性和可靠性使其成為半導體封裝的合理材料。隨著黃金價格在 2001 年至 2011 年的十年間上漲 478%,這種情況開始發生變化。制造商開始尋找可行的替代品,這些替代品可以提供更低的成本,但具有相似或更好的導電性。
銅是顯而易見的選擇,因為它具有成本效益和優異的導電性和導熱性。盡管銅價同期上漲近 700%,但與每盎司 2,100 美元的黃金相比,其最高價格為每磅 4.58 美元。此外,銅能夠使用直徑較小的導線傳導與金相同的電流,且不會過熱,這使其極具吸引力。此外,其與鋁的反應速率較慢,提高了其可靠性,特別是在長期高溫儲存條件下。
“您需要實現高質量且非常可靠的引線鍵合,影響這一目標的因素有很多,”西門子 EDA 的 IC 封裝和 RF 產品線總監 Per Viklund 說道。“需要根據電氣和鍵合性能選擇正確的導線材料,并且需要使用正確的金屬鍵合工藝。當然,你所追求的是一種永遠不會自行松動的紐帶。”
汽車電子產品的增長是采用銅進行引線鍵合的關鍵驅動力。如今的新車可以配備超過一千個 IC,雖然在一些汽車應用中仍然使用金,但隨著時間的推移,銅因其卓越的導熱性和彈性而被證明在惡劣環境和高溫下更加可靠。
“當您使用汽車電源模塊時,您對引線鍵合或非常高的電流/非常低的電感有特殊要求,”Viklund 補充道。“您可以對這些類型的設計采取一些特殊的技巧,但存在一些物理限制,無法添加無限數量的焊線。這只是不切實際。”
汽車行業越來越依賴從發動機控制單元到駕駛員輔助系統等各種先進電子設備,因此要求材料能夠在充滿挑戰的條件下始終如一地發揮作用,缺陷率低于十億分之一,即每十億公里中有一個缺陷。銅的固有特性,例如高熔點和優異的導電性,使其特別適合這些要求。
“傳統上,金線是首選的線材,” Amkor Wirebond BGA 產品副總裁 Prasad Dhond 說道。“它更容易使用,它是一種更柔軟的材料,但它在汽車可靠性測試過程中出現了一些問題。當然,成本也是一個大問題。”
金在長時間高溫下的可靠性問題包括在芯片上的導線和鋁焊盤之間的接合處形成柯肯德爾空洞。這些空隙不會出現在銅鋁鍵合中。
然而,銅也面臨著挑戰。雖然銅確實在成本和導熱性方面具有優勢,但其在引線鍵合中的使用帶來的復雜性需要先進的設備和專業技術。一些替代品,例如鍍鈀銅線,盡管硬度和成本比純銅更高,但仍然低于金,但表現出顯著的耐腐蝕性。銅還必須在無氧合成氣體環境(95% 氮氣和 5% 氫氣)中加工。
“您希望在材料之間建立真正良好、牢固的結合,”Nordson 半導體產品產品線經理 Chris Davis 說道。“但是銅因腐蝕而聞名,因此不能在其周圍使用其他金屬,否則會發生電偶腐蝕。用金和鋁,你會得到紫色的牌匾。銅最便宜,金最貴,鋁介于兩者之間,但鋁只能通過特定工藝粘合,并且由于表面有氧化層,粘合起來相當棘手。總有一些權衡。”
汽車驅動變革
直到 2010 年左右,半導體行業主要在基于引線鍵合的封裝中使用金布線,但當金價飆升時,該行業從金布線轉向銅布線,從而使芯片制造商能夠降低封裝成本。汽車制造商最初不愿意改用銅,因為其局限性,以及缺乏對惡劣環境下關鍵應用的銅引線鍵合的長期測試。隨著銅被證明在高溫和高振動應用中具有更高的可靠性,這種情況已經發生了變化。
“在汽車領域,銅線現在最受歡迎,”Dhond 說。“從可靠性的角度來看,客戶更喜歡它。在過去的 10 年里,出現了向銅的巨大轉變,幾乎我們推出的所有汽車新產品都使用銅線。”
銅的一個挑戰是實現鍵合所需的熱量使其不適合具有脆弱鍵合焊盤或對高溫敏感的芯片。它的剛度也會給形成一致且可靠的環路帶來挑戰,特別是在細間距應用中。此外,銅的氧化會導致電氣性能下降和潛在的長期可靠性問題。
對于這些應用,銀合金可以提供與金相似的性能,而成本與鍍鈀銅相似。與銅相比,銀具有卓越的導熱性和更低的電阻率,使其成為電力電子器件的理想選擇。其彈性和硬度在金和銅之間取得平衡,簡化了鍵合工藝,其較低的熔點有助于保護脆弱的鍵合焊盤。與銅相比,銀線鍵合也不易受到腐蝕。
純銀 (Ag) 本質上很軟,因此不適合直接用于引線接合應用。為了解決這一限制,通常根據規格將銀與鈀 (Pd) 和金按不同比例制成合金。銀的高反射率也使其成為 LED 封裝的首選,而最大化光輸出是 LED 封裝的首要考慮因素。
最后,鋁是一種行業標準的引線鍵合材料,其使用時間幾乎與金一樣長,并且具有獨特的特性,使其成為各種應用的理想選擇。它與芯片上的鋁焊盤兼容,允許在室溫下以低能量水平進行鍵合,這有助于防止損壞敏感設備。
與純銀一樣,純鋁雖然可拉伸,但相對較軟。為了增強其特定應用的機械性能,它通常與硅等元素形成合金,通常含量約為 1%,有時還與鎂合金。這些鋁合金可生產出尺寸更細、強度更高的線材。
鋁的高導電性和導熱性使其成為功率器件和信號傳輸的首選。雖然它通常用于無線電和音頻設備、電源和恒溫器等低頻應用,但其多功能性可擴展到廣泛的應用。鋁采用楔形接合技術進行接合,這限制了其在極細間距應用中的使用。此外,鋁的易氧化性使其不適合高純度和耐腐蝕性至關重要的環境。
“不同的材料面臨著不同的挑戰,特別是當您將一種材料熔合到另一種材料時,”Viklund 補充道。“ 線材能夠可靠地粘合到芯片頂面上的任何材料。問題一直是我們如何將電線熔接到芯片上,并確保它留在那里。它幾乎是鋁、金、銅和各種合金。這取決于電氣性能和粘合性能,最后取決于成本。你必須在這些之間取得適當的平衡,否則它不會被你的客戶采用。”

圖 2:金線、鋁線、銅線和銀線的一些特性
存儲器
存儲器應用是引線鍵合技術變革的另一個重要驅動力。隨著 NAND 閃存中多層架構的引入,引線鍵合技術的復雜性和相關的測試挑戰都在不斷升級。現代存儲芯片,尤其是 3D NAND 配置中的存儲芯片,可以包含數百層,并逐層堆疊。
“對于某些類型的設計,例如 NAND 內存,需要進行大量芯片堆疊和引線鍵合,”Viklund 說。“當然,挑戰在于以保護電線的方式進行引線鍵合,因為下一個芯片會與它重疊。”
這才是問題真正開始的地方。“多層是一個殺手,”謝弗補充道。“就電線數量而言,最大的挑戰是層數的增加。我們對一層進行引線鍵合,然后檢查、返工,對第二層進行引線鍵合,然后重復,等等。一旦頂層有了層,就幾乎不可能對各層進行返工。”
層數越多,難度越大。“今天的內存中可能有十幾層甚至更多層的引線鍵合,因此它可能會變得非常復雜,”陳說。“問題是,引線鍵合能否繼續擴大規模?跟上不斷增加的密度是否可行?如果電線彼此距離太近,最終會發生所有機械和熱循環,電線可能會開始移動并最終短路。問題是我們如何在所有電線之間獲得足夠的余量,以便我們能夠處理這樣的公差?”
結論
面對不斷變化的技術需求,引線鍵合繼續證明其適應性和相關性。隨著半導體器件的小型化和復雜性的增加,引線鍵合已經進行了創新,結合了新材料和精煉技術來應對現代電子產品的挑戰。雖然為了滿足特定需求而出現了倒裝芯片技術等替代互連方法,但引線鍵合仍然是連接芯片與封裝的主要方式。
在經濟和性能因素的推動下,該行業從金轉向銅,體現了引線鍵合的適應性。此外,采用多層架構的存儲器應用的復雜性日益增加,強調了對能夠適應復雜設計而不影響可靠性的引線鍵合解決方案的需求。隨著半導體格局的不斷發展,引線鍵合的彈性和創新傳統表明,它將仍然是行業未來不可或缺的一部分,在變化中適應并蓬勃發展。
編輯:黃飛
?
 電子發燒友App
電子發燒友App










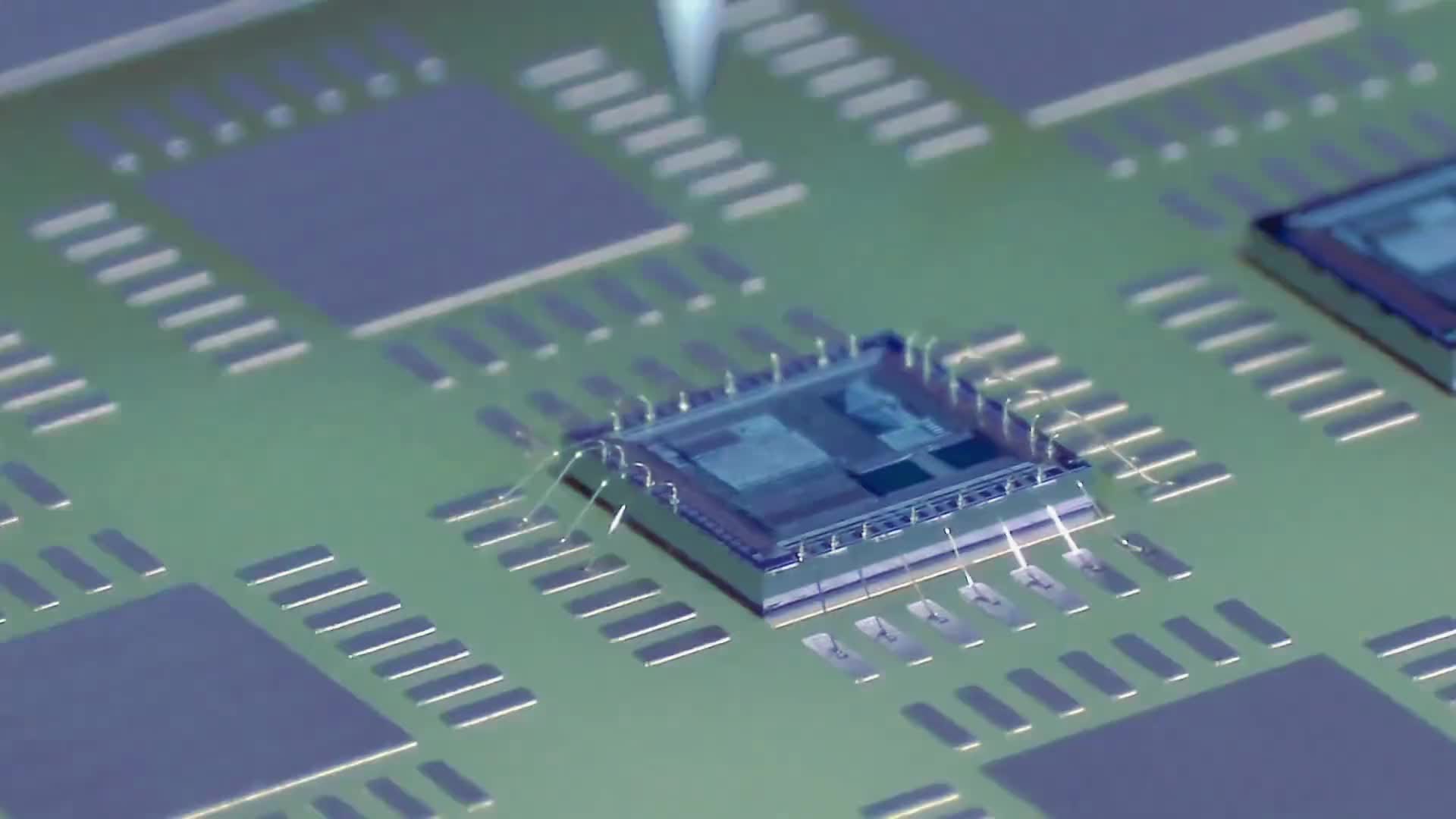









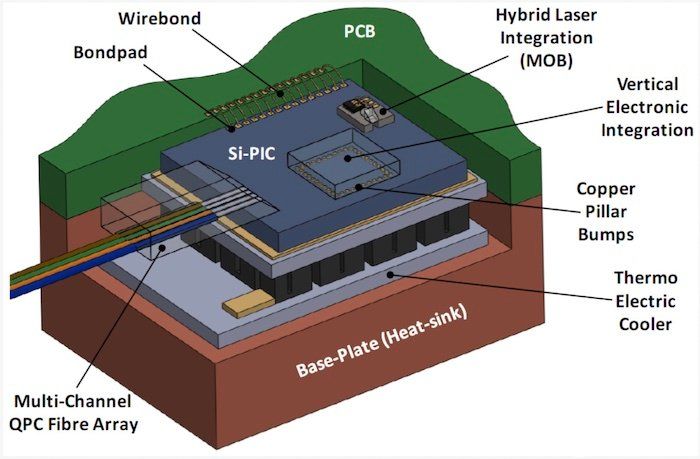

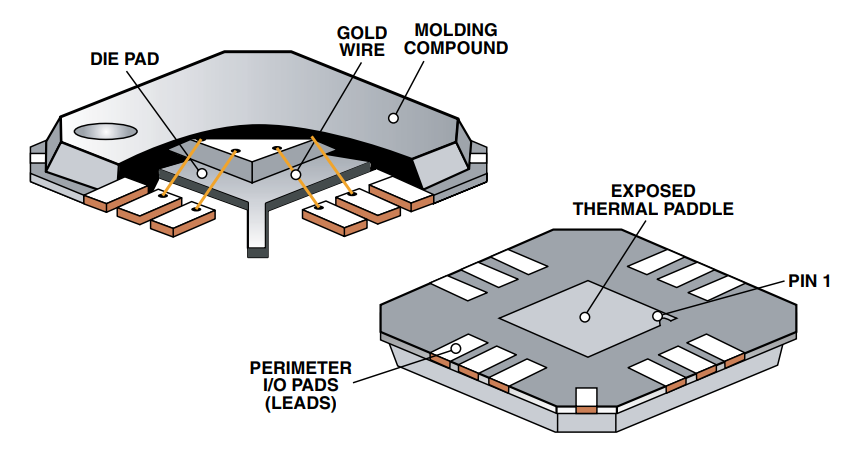
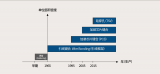





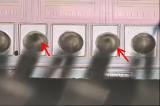
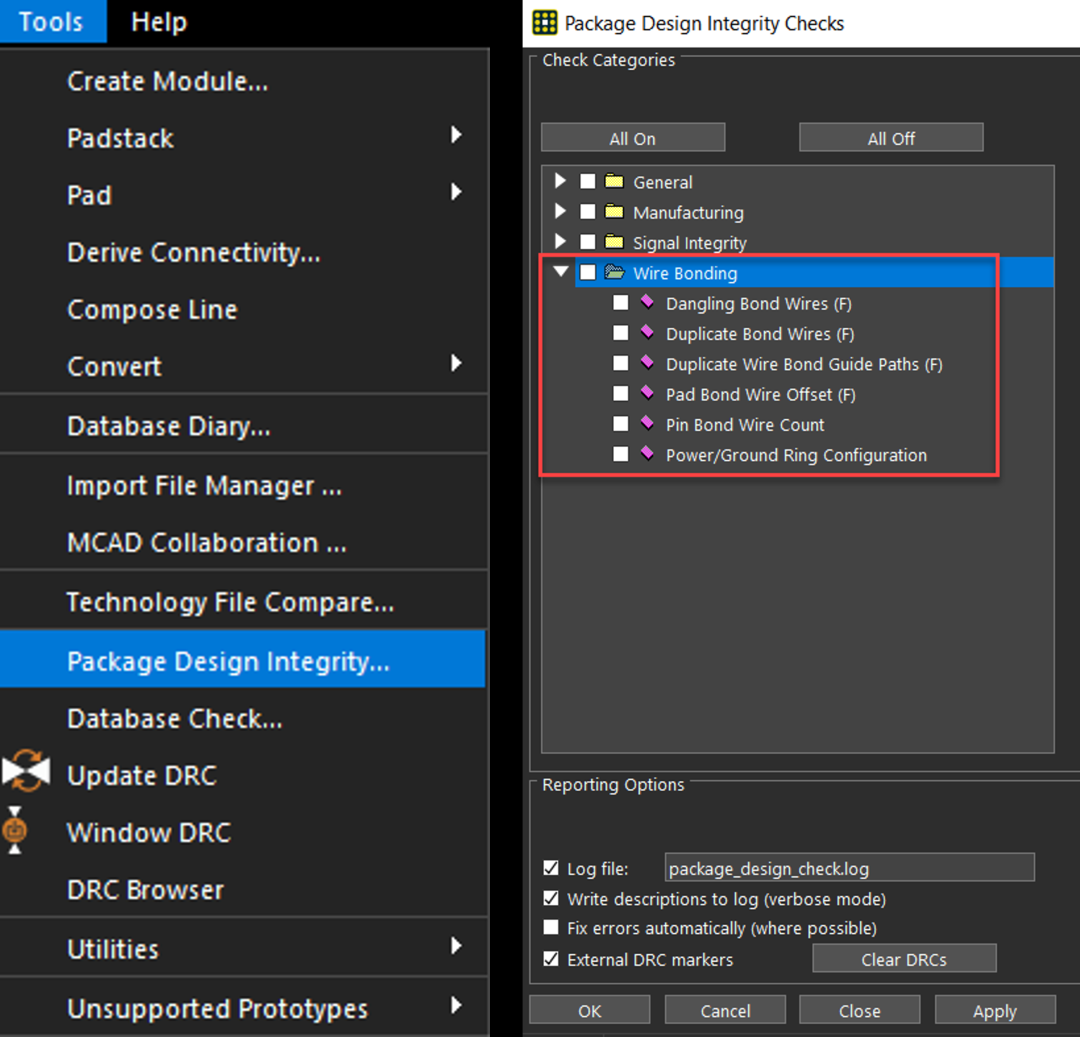

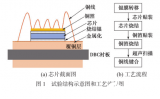
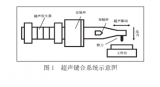











評論