什么是光刻
光刻機本身就跟一個單反差不多,由光源、光路系統和工作臺組成:
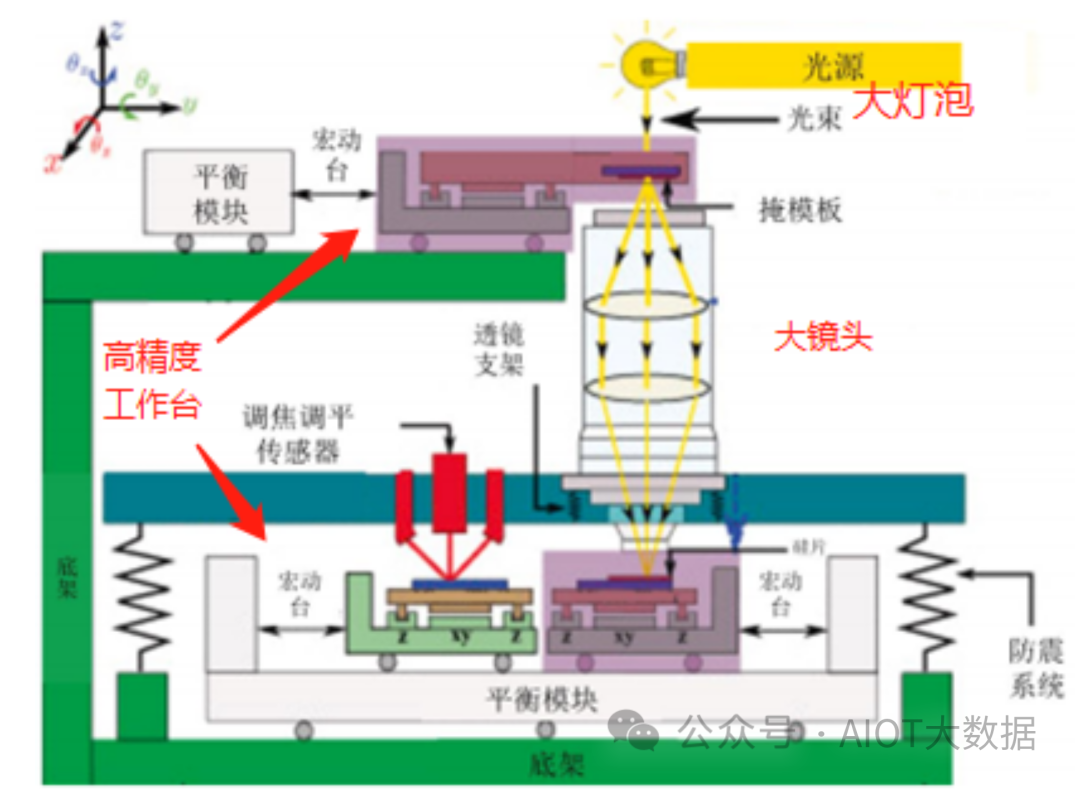
? ?
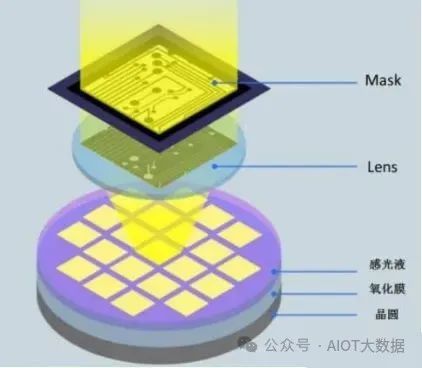
掩模上承載有設計圖形,光線透過它,把設計圖形透射在光刻膠上。掩模的性能直接決定了光刻工藝的質量。在投影式光刻機中,掩模作為一個光學元件位于會聚透鏡(condenserlens)與投影透鏡(projectionlens)之間,它并不和晶圓有直接接觸。掩模上的圖形縮小4~10倍(現代光刻機一般都是縮小4倍)后透射在晶圓表面。為了區別接觸式曝光中使用的掩模,投影式曝光中使用的掩模又被稱為倍縮式掩模(reticle)。
掩膜版:光刻過程的核心耗材
掩膜版基本介紹:
微電子制造過程中的圖形轉移母版掩膜版(Photomask)又稱光罩、光掩膜、光刻掩膜版等,是微電子制造過程中的圖形轉移工具或母版,是圖形設計和工藝技術等知識產權信息的載體。在光刻過程中,掩膜版是設計圖形的載體。通過光刻,將掩膜版上的設計圖形轉移到光刻膠上,再經過刻蝕,將圖形刻到襯底上,從而實現圖形到硅片的轉移,功能類似于傳統照相機的“底片”,承載了電子電路的核心技術參數。 ? ?
以薄膜晶體管液晶顯示器(TFT-LCD)制造為例,利用掩膜版的曝光掩蔽作用,將設計好的薄膜晶體管(TFT)陣列和彩色濾光片圖形按照薄膜晶體管的膜層結構順序,依次曝光轉移至玻璃基板,最終形成多個膜層所疊加的顯示器件;以晶圓制造為例,其制造過程需要經過多次曝光工藝,利用掩膜版的曝光掩蔽作用,在半導體晶圓表面形成柵極、源漏極、摻雜窗口、電極接觸孔等。
相比較而言,半導體掩膜版在最小線寬、CD精度、位置精度等重要參數方面,均顯著高于平板顯示、PCB等領域掩膜版產品。掩膜版是光刻過程中的重要部件,其性能的好壞對光刻有著重要影響。根據基板材質的不同,掩膜版主要可分為石英掩膜版、蘇打掩膜版和其他(包含凸版、菲林等)。
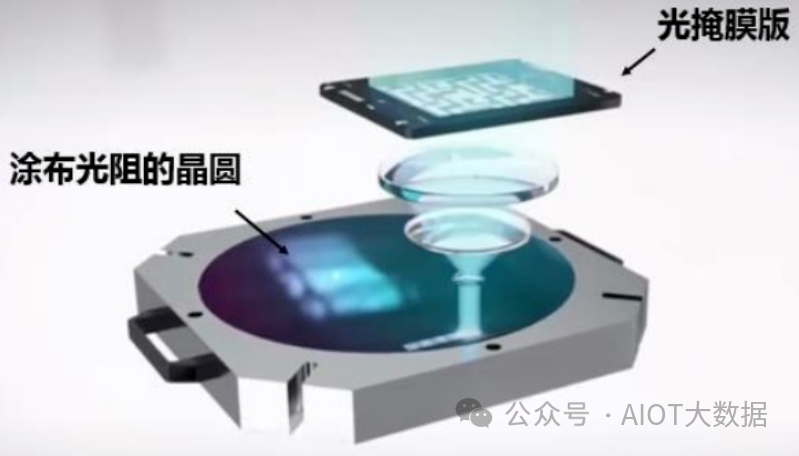
掩膜版結構:掩膜基板+遮光膜
掩膜版通常由基板和遮光膜組成,其中最重要的原材料是掩膜基板。基板襯底在透光性及穩定性等方面性能要求較高,須做到表面平整,無夾砂、氣泡等微小缺陷。由于石英玻璃的化學性能穩定、光學透過率高、熱膨脹系數低,近年來已成為制備掩膜版的主流原材料,被廣泛應用于超大規模集成電路掩膜版制作。 ? ?
目前,石英掩膜版和蘇打掩膜版是最常見的兩種主流產品,均屬于玻璃基板。遮光膜分為硬質遮光膜和乳膠遮光膜,其中乳膠遮光膜主要用于PCB、觸控等場景;硬質遮光膜材料主要包括鉻、硅、硅化鉬、氧化鐵等,在各類硬質遮光膜中,由于鉻材料機械強度高、可形成細微圖形,因此鉻膜成為硬質遮光膜的主流。掩膜版成本構成以直接材料和制造費用為主,分別占比67%和29%。其中直接材料主要包括掩膜版基板、遮光膜及其他輔助材料等,掩膜版基板占直接材料的比重超過90%。
光刻技術是掩膜版制造的重要環節
掩膜版制造工藝復雜,加工工藝流程主要包括CAM圖檔處理、光阻涂布、激光光刻、顯影、蝕刻、脫膜、清洗、宏觀檢查、自動光學檢查、精度測量、缺陷處理、貼光學膜等環節,其中光刻技術是掩膜版制造的重要環節。光刻需要先對掩膜基板涂膠(通常是正性光刻膠),后通過光刻機對表面進行曝光,通常以130nm為分界,130nm以上的光刻設備采用激光直寫設備,但隨著掩膜版的線寬線距越來越小,曝光過程中就會出現嚴重的衍射現象,導致曝光圖形邊緣分辨率較低,圖形失真,因此130nm及以下通常需采用電子束光刻完成。關鍵參數量測及檢測環節對掩膜版的質量及良率至關重要,其中需對掩膜版關鍵尺寸(CD,CriticalDimension)、套刻精度(Overlay)等關鍵參數進行測量,同時需使用自動光學檢測設備(AOI,AutomaticOpticalInspection)檢測掩膜版制造過程產生的缺陷,如產品表面缺陷(Defect)、線條斷線(Open)、線條短接(Short)、白凸(Intrusion)、圖形缺失等以及通過激光等對掩膜版生產過程中的缺陷及微粒進行修復。
掩膜版是微電子加工技術常用的光刻工藝所使用的圖形母版,功能類似于傳統照相機的“底片”,是承載圖形設計和工藝技術等知識產權信息的載體,廣泛應用于半導體、平板顯示、電路板、觸控屏等領域。 ? ?
以TFT-LCD制造為例,利用掩膜版的曝光掩蔽作用,將設計好的TFT陣列和彩色濾光片圖形按照薄膜晶體管的膜層結構順序,依次曝光轉移至玻璃基板,最終形成多個膜層所疊加的顯示器件;以晶圓制造為例,其制造過程需要經過多次曝光工藝,利用掩膜版的曝光掩蔽作用,在半導體晶圓表面形成柵極、源漏極、摻雜窗口、電極接觸孔等。
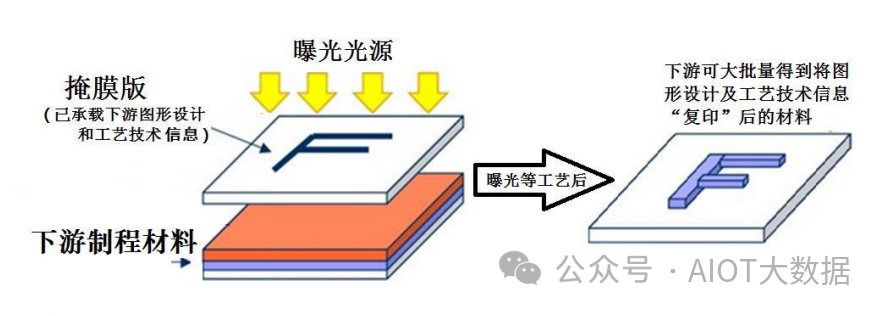
根據客戶的設計要求,用光刻機在原材料上光刻出相應的圖形,將不需要的金屬層和膠層洗去,得到掩膜版產成品。根據基板材質的不同,產品主要可分為石英掩膜版、蘇打掩膜版和其他(包含凸版和菲林)。

? ?
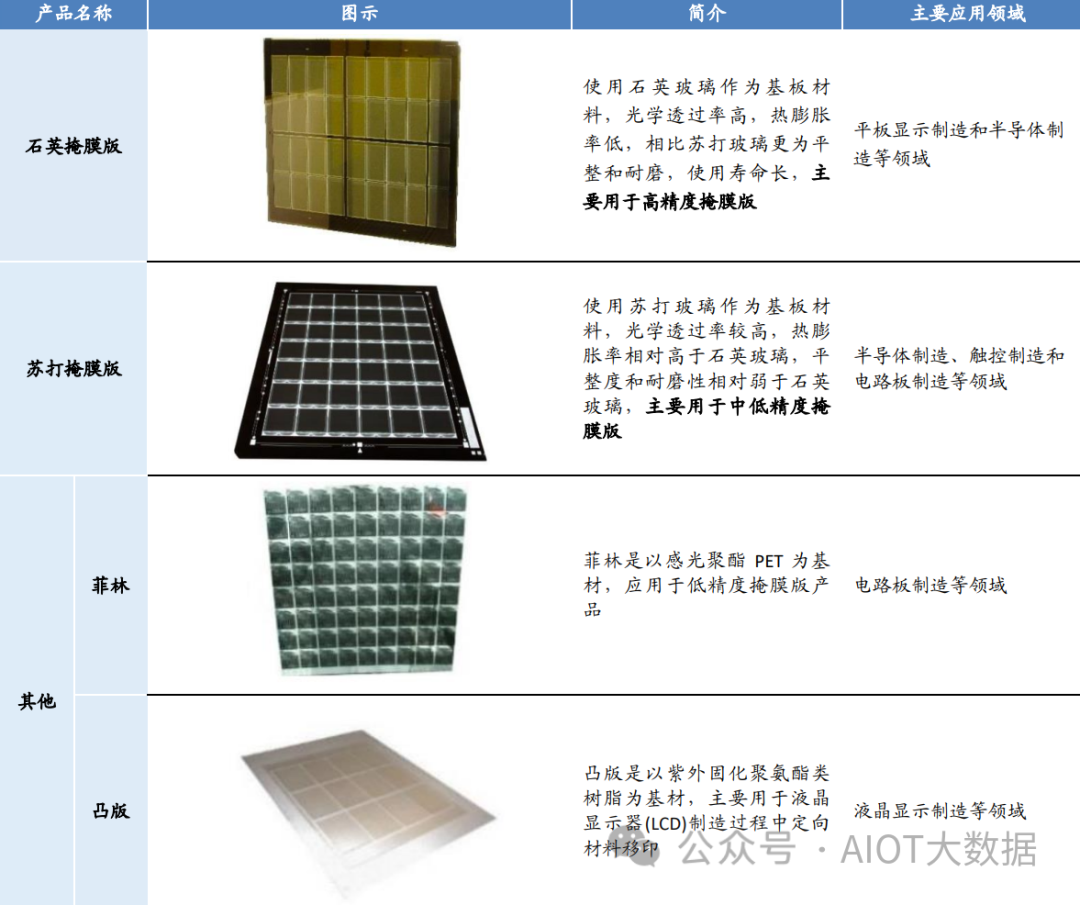
國產掩膜版分類與應用

掩膜版關鍵參數 ? ?

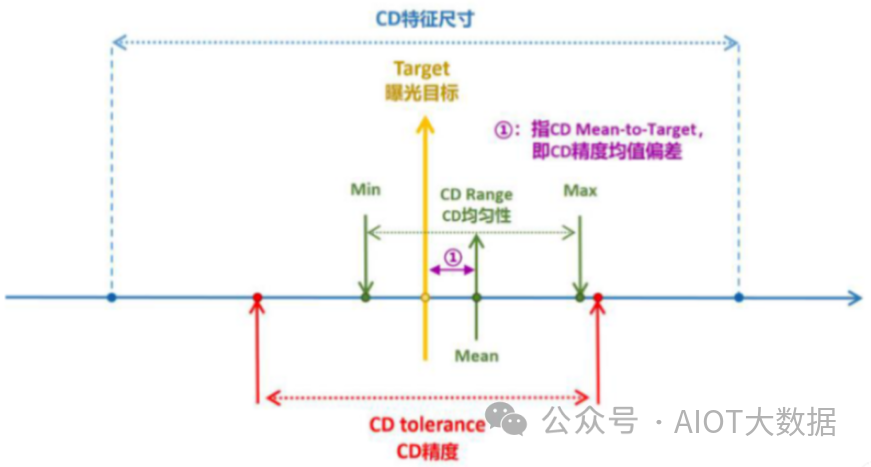
掩膜版主要由基板、遮光層和保護膜組成,其中基板(主要采用玻璃基材,包括石英和蘇打兩種材質)占直接原材料成本比重達90%。
1)掩膜版基板是制作微細光掩膜圖形的感光空白板。石英掩膜版使用石英玻璃作為基板材料,石英玻璃具有光學透過率高、熱膨脹率低、平整度和耐磨度高、使用壽命長的優點,主要用于高精度掩膜版。蘇打玻璃作為基板材料,光學性能略遜于石英玻璃,主要用于中低精度掩膜版; ? ?
2)遮光層主要分為硬質遮光層和乳膠遮光層,乳膠遮光層主要應用于PCB和觸控等場景,而硬質遮光層則由于其鉻版的高機械強度和耐用性,以及能形成細微圖形的能力,常常通過在基板上鍍鉻來形成;
3)保護膜Pellicle是指具有耐光性和高透光率的掩膜版防護膜。
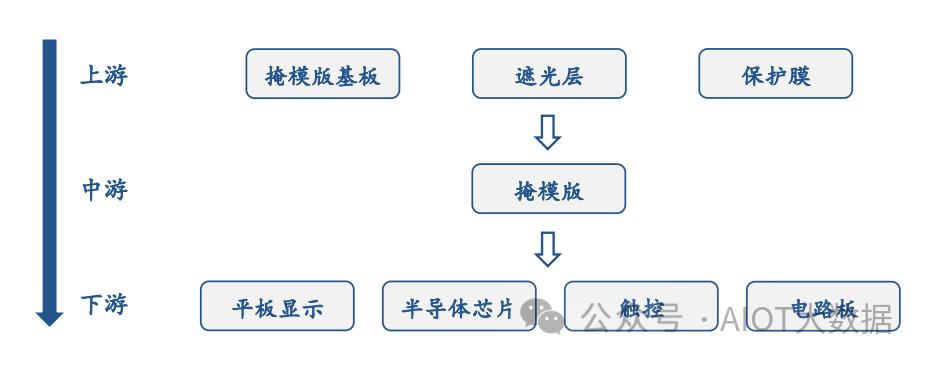

石英玻璃在透光率以及化學性能上優于其余掩膜基材。通常溫度和濕度的改變將引起材料一定程度上的形變,從而造成掩膜板上圖像的細小位移及線寬的改變。石英玻璃由于其在熱膨脹和硬度等物理屬性上的優勢,使得它對自然環境的影響如溫度,濕度,壓力有比較大的容忍性。這意味著石英掩膜板能保持化學性質穩定和在特定波長光源照射下的高穿透度。
遮光膜材料主要包括:金屬鉻、硅、氧化鐵、硅化鉬等,遮光膜材料的選擇主要取決于產品的圖形精度、透過率、耐化學品性能等因素。其中,鉻是最常用的遮光膜材料,根據不同的層數,可以應用于投影曝光機用光掩膜、LSI用光掩膜、FPD用光掩膜和Stepper用Reticle等領域。但是鉻也有一些缺點,如反射率高和膜形成工藝復雜等。硅是一種SeeThrough型的遮光膜材料,適合手動對位操作,但其微加工性能不如鉻,因此只用于低端硬質光掩膜。氧化鐵和硅化鉬是兩種特殊的遮光膜材料,前者沒有明顯的優缺點,后者具有HalfTone特性優異的優點,但耐化學品性能差,主要用于LSI用HalfToneMask。 ? ?

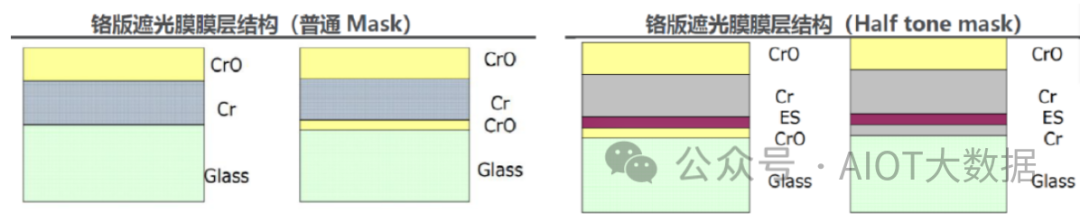
硬掩膜保護膜通常由耐腐蝕和硬度較高的材料構成,如Si3N4,SiO2,多晶硅等。
軟掩膜保護膜
這類保護膜通常由聚合物材料構成。硝化纖維樹脂長期以來在G-線和I-線掩模版的保護中占據重要地位。當光刻技術進階至DUV波段,硝化纖維樹脂由于在這一波段的較高吸收系數,而影響到掩模版的光學性能,因此含氟樹脂,如聚四氟乙烯和其他含F的聚合物,由于在DUV波段上的優異透明度,成為了DUV掩模版保護膜的熱門候選材料。
硝化纖維樹脂硝化纖維樹脂是一種由纖維素通過硝化反應得到的樹脂。通常為白色的固體,可溶于醇、醚、酮類等有機溶劑中。在掩膜版的保護膜制作中,硝化纖維樹脂通常會被溶解在一個特定的溶劑中,然后再旋涂到玻璃上,形成一層均勻、透明的薄膜。最后揭下薄膜,切割為合適尺寸的保護膜即可。
掩膜保護膜落上灰塵影響曝光質量嗎?不會。光刻掩膜版上雖然有灰塵,但在投影光刻中,由于聚焦深度相對較小,那些遠離曝光平面的灰塵通常不會在曝光圖案上產生清晰的影像。也就是說,掩膜保護膜上的顆粒由于離圖案生成的晶圓太遠,其影響通常是可以忽略不計的。 ? ?
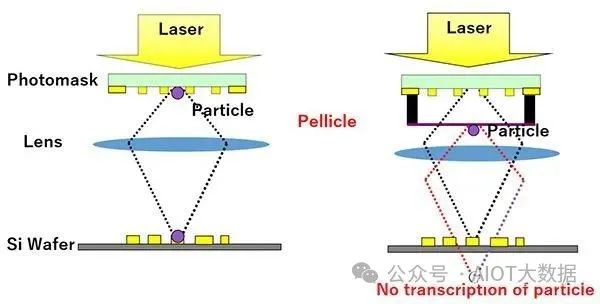
掩膜保護膜的使用量芯片制程大量掩膜版,當然也需要大量的掩膜保護膜。每個光刻層至少需要一個掩膜及其保護膜。180nm節點器件大約需要25個掩膜及其保護膜,32nm節點器件大約需要50個掩膜及其保護膜,16nm節點器件大約需要75個掩膜及其保護膜。
EUV掩膜保護膜的制作難點當EUV光照射到保護薄膜上時,薄膜會散發熱量,溫度可能升至600至1,000攝氏度之間。在高溫下,薄膜材料可能會經歷物理和化學上的變化,與薄膜緊密相連的其他部分可能也會受到熱量的影響而造成損壞。
上游核心原材料方面,掩膜版基板行業集中程度較高,供應商數量較少,但供應相對充足。境外供應商集中在日本、韓國和中國臺灣。石英基板供應商均為境外專業的基板供應商如韓國KTG、中國臺灣InabataSangyo、韓國SAMSUNGC&T和日本高化學株式會社;蘇打基板已經國產化,主要的蘇打基板供應商如湖南普照信息材料有限公司;保護膜Pellicle供應商如韓國FINESEMITECH。
平板顯示領域基本不存在面板廠自行配套掩模版的情況,因此平板顯示掩膜版廠商主要為第三方掩模版廠商。
TFT-LCD掩膜版和AMOLED掩膜版有明確的代數分類,包含G1-G11,通常生產線代數越高,顯示面板玻璃基板的尺寸越大。 ? ?
半導體芯片掩膜版制造企業可分為晶圓廠自行配套(inhouse)和獨立第三方掩膜版生產商兩大類。目前晶圓廠自行配套占比52.7%,但獨立第三方的市場份額正在逐步擴大。
為了降低成本,晶圓廠更傾向于將28nm以上等較為成熟的制程向獨立第三方掩模版制造企業進行采購;28nm以下的先進制程技術難度大且涉及機密,因此先進制程掩模版大部分由晶圓廠自己的專業工廠內部生產,如英特爾、三星、臺積電等公司的掩模版均主要由自制掩膜版部門提供。
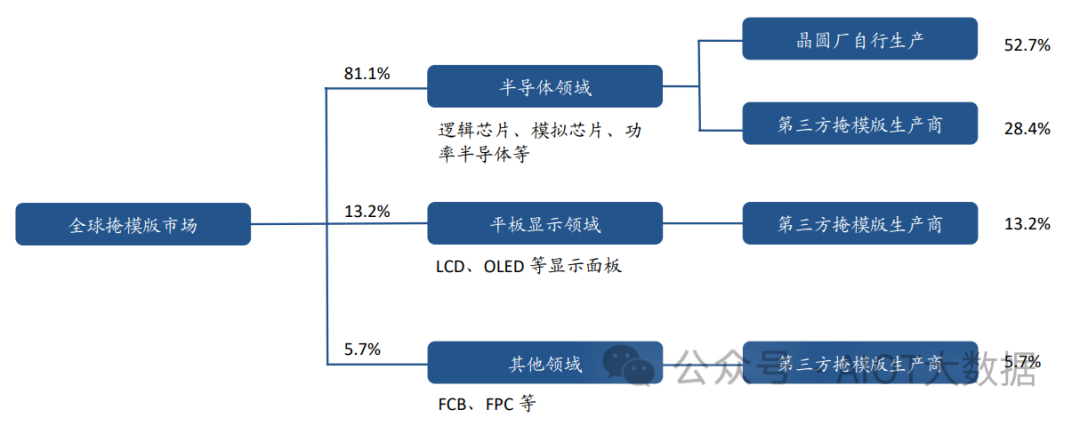
掩膜版加工工藝包括圖形轉換、圖形光刻、顯影、蝕刻、脫膜、清洗、尺寸測量、缺陷檢查、缺陷修補、清洗、貼膜、檢查、出貨等步驟。對應的設備包括光刻機、顯影機、蝕刻機、清洗機、測量儀、LCVD修補設備、CD測量機、壁障修補機、面板修補設備、TFT檢查設備、貼膜機等。
其中,光刻為加工的核心工藝。平板顯示、半導體、觸控等行業基本都采用掩膜版作為基準圖案進行曝光復制量產,無掩膜光刻技術精度低,主要用于電路板行業。
掩膜版光刻制作技術通常分為激光直寫法和電子束直寫法。激光直寫法具有光刻速度更快、能制作大尺寸掩膜版的優點,但掩膜版精度不如電子束直寫法。
1)激光直寫法使用波長為193nm、248nm、365nm、413nm等的連續或脈沖激光光源,整形精縮成為200-500nm的激光點在掩膜光刻膠上畫出電路圖案后,通過顯影蝕刻獲得電路圖案;
2)電子束直寫法使用小至納米級的電子束斑為筆,在掩膜光刻膠上畫出電路圖案,掩膜版上的電子束膠在曝光顯影后,通過濕法或干法蝕刻獲得電路圖形。130nm及更先進制程的半導體掩模版需要使用電子束。 ? ?
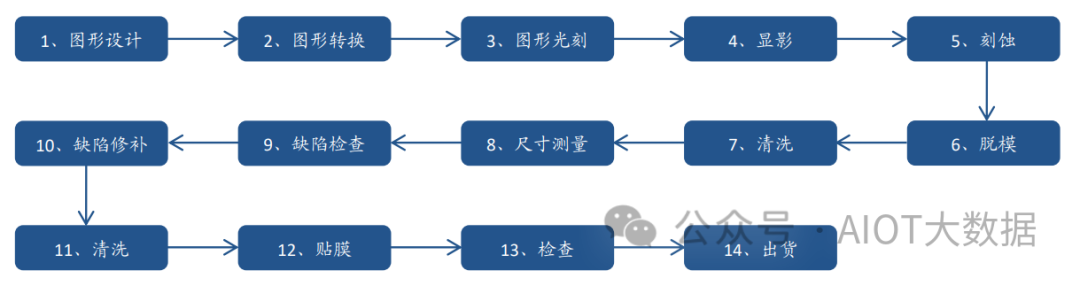
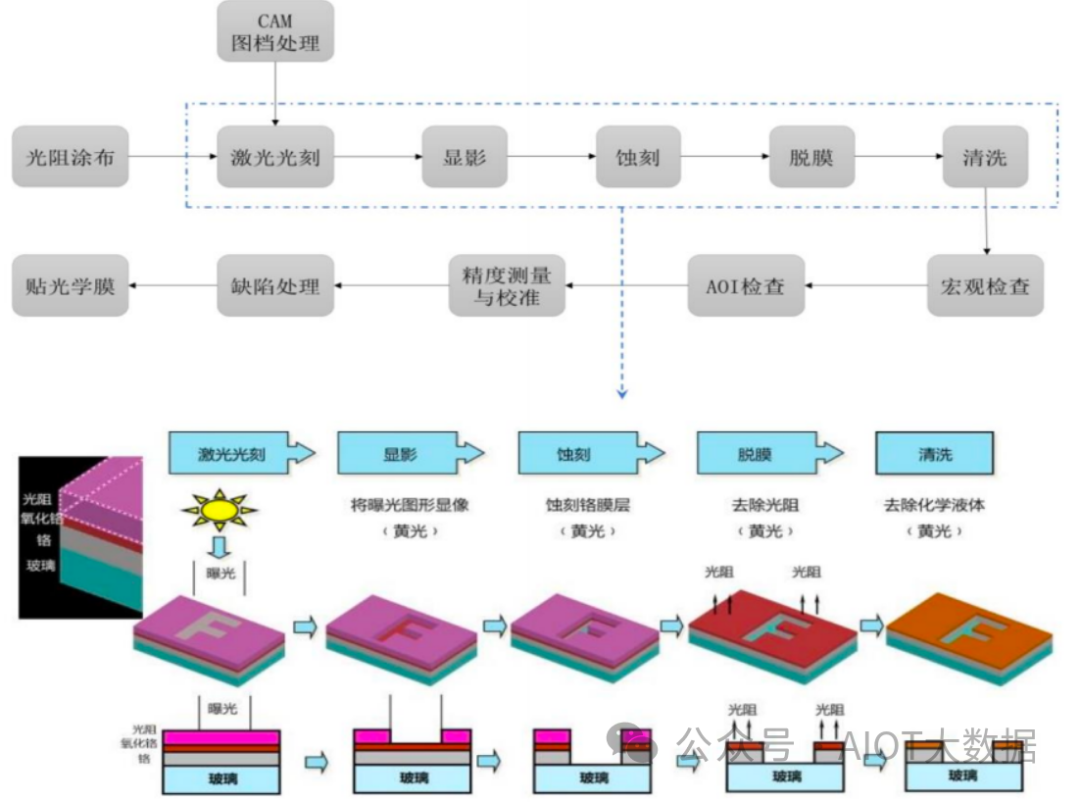
? ?

半導體掩模版的制作設備、制作工藝、圖形處理技術和檢測技術都與顯示面板行業的大尺寸掩模版差別顯著。半導體掩模版是光刻過程的“藍圖”,技術難度顯著高于平板顯示掩模版。
1)半導體器件與集成電路設計相比平板顯示更加復雜。半導體掩模版圖形為芯片電路圖形,相較于平板顯示掩模版圖形為標準像素點,圖形更為復雜、線縫寬度更小、套刻層數更多,同時隨著下游半導體產品的快速更新而不斷迭代。更多的光刻層數要求掩模版產品具有更高的套刻精度、CD精度一致性、均勻性等。
2)半導體掩模版與顯示面板掩模版制造的關鍵設備存在差異。半導體掩模版尺寸較小,通常為6寸;而平板顯示掩模版尺寸較大,可達75、85寸。兩者尺寸大小、參數特性、應用領域等差異帶來了設備上的較大差異。
隨著半導體芯片的制造工藝的精細化工藝發展,這對與之配套的半導體芯片及封裝掩膜版提出了更高要求,對線縫精度的要求越來越高,掩膜版廠商采取例如光學鄰近校正(OPC)和相移掩膜(PSM)等技術來應對。半導體生產工藝通常采用投影式光刻方法,激光透過掩模版后,經過投影物鏡成像到晶圓的光刻膠表面,通過掩模版對光線的遮擋或透過功能,實現掩模圖案向晶圓線路圖的圖形轉移。這一過程中,光的干涉與衍射現象會造成CD精度降低。
1)光學鄰近效應修正技術(OpticalProximityCorrection,OPC)是一種光刻分辨率增強技術。由于光的衍射現象,激光通過掩模版的透光區和投影物鏡后會出現顯著的夫瑯禾費衍射現象,導致曝光圖形邊緣的分辨率降低,圖案邊緣失真嚴重,CD精度大幅下降。OPC通過修正光刻圖形和設計圖形之間由于曝光產生的變形和偏差,使得投影到光刻膠上的圖形更符合設計要求。 ? ?
隨著掩模版的線寬和線縫越來越小,當尺寸逐漸接近光刻機的波長時,曝光過程中就會出現嚴重的衍射現象。光的衍射現象是指光在傳播過程中,遇到尺寸與波長大小相近的障礙物時,光會傳到障礙物的陰影區并形成明暗變化的光強分布情況。這種情況在投影式光刻中尤為明顯,激光通過掩模版的透光區和投影物鏡后會出現顯著的夫瑯禾費衍射現象,導致曝光圖形邊緣的分辨率降低,圖案邊緣失真嚴重,CD精度大幅下降。因此,為了提高光刻環節曝光圖形的CD精度,必須要對掩模圖案進行光學鄰近效應修正(OPC)。由于光的衍射造成的圖像失真及OPC效果對比情況如下圖所示。 ? ?
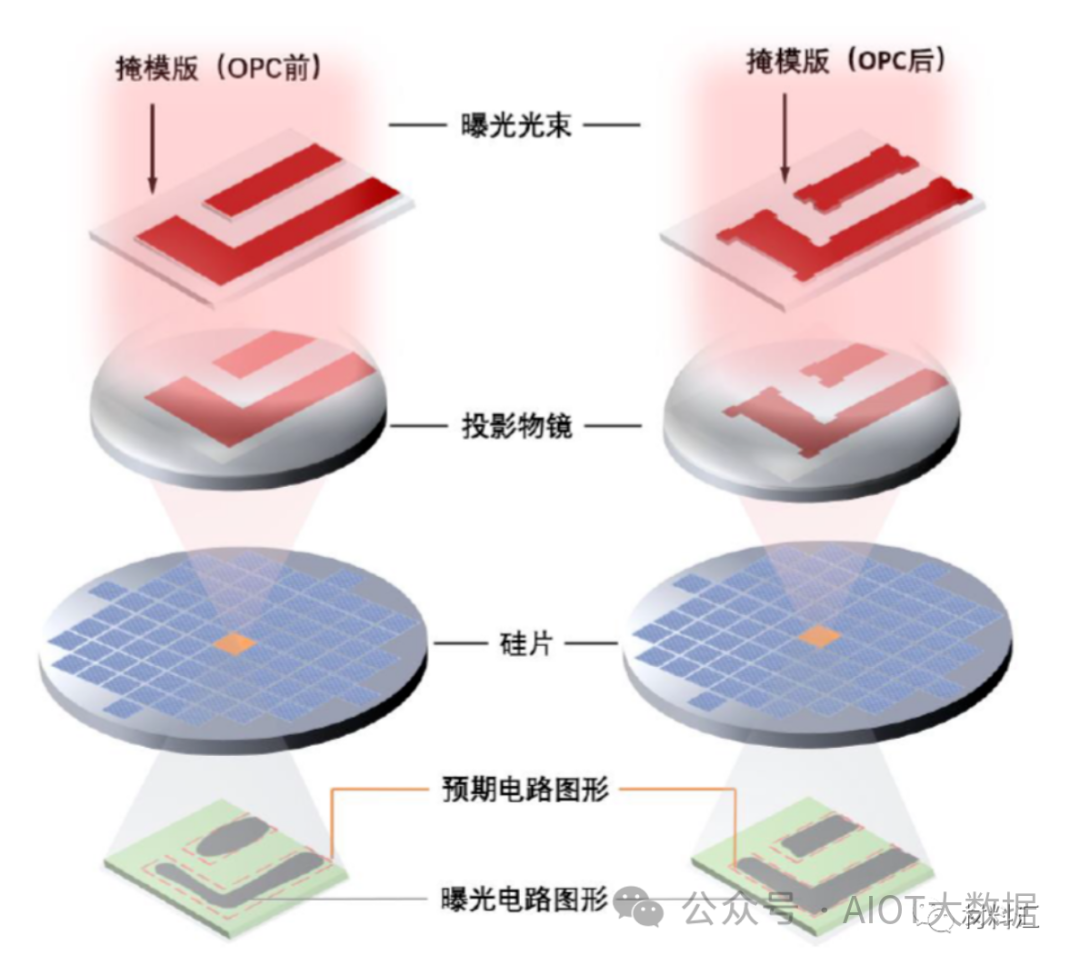
2)相移掩模版(PhaseShiftMask,PSM)是利用相移(PhaseShift)原理實現光的相位反轉,改善圖形對比度,增強圖形曝光分辨率的一種技術。當半導體的最小線寬小于130nm后,傳統的二元掩模版(BinaryMask)會出現光的干涉現象,會造成晶圓感光時遮光區域仍有曝光、透光區域光強不足的情況,導致整體的對比度降低,CD精度大幅下降。需要采用PSM來消除曝光光束中的干涉現象,提升CD精度水平。
隨著掩模版圖形越來越復雜、線路密度越來越大,掩模版的透光區間距離便越來越短,此時曝光過程中就會出現顯著的干涉現象。光的干涉是指兩束相干光相遇而引起光的強度重新分布的現象。當掩模版的透光區間位置趨于接近時,從相鄰兩個透光區射出的光線頻率相同、振動方向相近、相位差恒定,形成了相干光。兩列或多列相干光在空間相遇時相互疊加,光強在某些區域始終加強,在另一些區域則始終削弱,出現了穩定的強弱分布現象。上述現象會造成晶圓感光時遮光區域仍有曝光、透光區域光強不足的情況,導致整體的對比度降低,CD精度大幅下降,從而嚴重影響了晶圓的電路圖形質量。當半導體的最小線寬小于130nm后,傳統的二元掩模版(BinaryMask)會由于光的干涉現象而無法對晶圓進行有效曝光,需要采用相移掩模版(PhaseShiftMask,PSM)來消除曝光光束中的干涉現象,提升CD精度水平。二元掩模版和PSM掩模版的原理如下圖所示: ? ?

掩膜版按光刻工藝劃分
根據光刻工藝所用到的不同光源,常見的掩膜版大致分為:二元掩膜版、相移掩膜版、EUV掩膜版。二元掩膜版是指由透光與不透光兩種部分組成的光掩模版,是最早出現、也是使用最多的一類掩模版,被廣泛用于365nm(I線)至193nm的浸沒式光刻。
相移掩膜版是指在相鄰的透光縫隙處設置厚度與1/2光波長成正比的相移層的掩膜產品。這種產品的誕生主要由于集成電路設計的高速發展,設計圖形的尺寸日益縮小所導致的光學鄰近效應越來越明顯以及由于曝光波長的短化在改善清晰度的同時會減少焦點深度,進而降低工藝過程的穩定性。因此,為了保證光刻圖形的精確性以及保持焦點深度,相移掩模技術被越來越多的采用。相移掩膜技術使透過相移層的曝光光線與其他透射光產生180度的光相位差,使在相鄰透光縫隙中間點上的光強互相抵消或減弱,進而控制光的相位及透過率,改善對晶圓曝光時的分辨率及焦點深度,最終提高了復刻特性的光掩模。 ? ?
EUV掩膜版是指在EUV光刻期間使用的新穎掩膜版。由于EUV的波長很短,容易被所有材料吸收,因此不能使用像透鏡這樣的折射元件而是根據布拉格定律通過多層(ML)結構來反射光束。EUV掩膜版常用于7nm、5nm等先進制程,所以EUV掩膜版的工藝問題會非常難以發現并且十分致命。
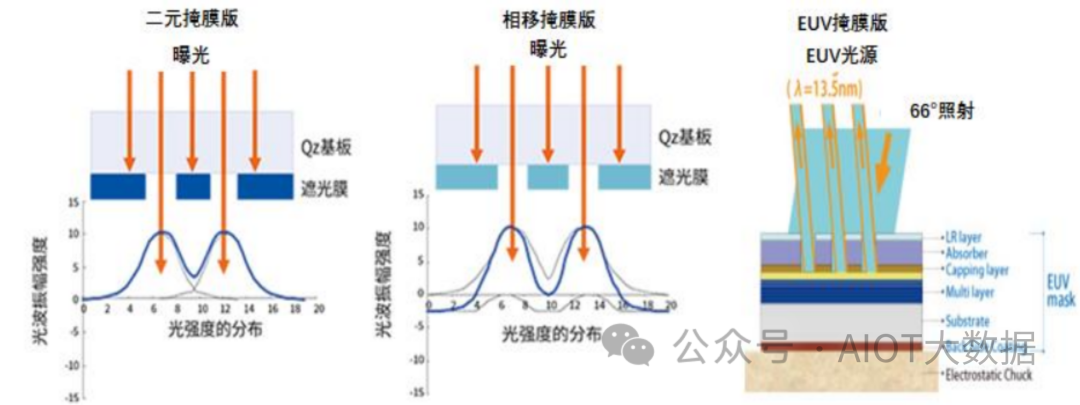
光掩膜版的性能也會因遮光膜的結構產生差異。對于普通掩膜版,為了滿足i線(365nm波長)和g線(436nm波長)光刻要求,它的膜層厚度要達到100nm左右。然而,傳統掩膜版存在固有缺點會導致在曝光之后得到的線條出現邊緣嚴不齊整的現象,目前普遍采用的方法是在鉻表面沉積一層幾十納米的三氧化二鉻,不過這樣會增加膜層的厚度且工藝相對復雜。
半色調掩膜版(halftonemask)是將半透明的遮光膜貼在光掩模上使得光在透過物質時傳播速度降低,相位隨之變化,進而局部改變圖案部分的相位,通過半透明的遮光膜發生相位變化的光、與未通過半透明的遮光膜相位未發生變化的光之間的干涉現象提高分辨率。
中國大陸2024年19條8.5/8.6代高精度TFT產線情況 ? ?

2024年24條中精度及高精度AMOLED/LTPS/a-Si ? ?

平板顯示用掩膜版技術路線 ? ?

隨著LTPO屏幕技術普及,掩膜版層數也隨之增加。為進一步降低AMOLED屏幕的功耗,業內在LTPS背板的基礎上開發出了LTPO背板顯示技術。傳統LTPS背板一般需要9-13層掩膜版,結合IGZO技術后,LTPO背板工藝所需掩膜版增加至13-17層。
掩膜版尺寸與面板尺寸發展簡圖

半導體掩模版是芯片制造的關鍵工具,用于半導體制造的光刻環節,對晶圓光刻的質量有重要影響。作為光刻復制圖形的基準和藍本,掩膜版是連接芯片設計和芯片制造的關鍵,掩膜版的精度和質量水平會直接影響最終下游制品的良品率。以晶圓制造為例,其制造過程需要經過多次曝光工藝,利用掩膜版的曝光掩蔽作用,在半導體晶圓表面形成柵極、源漏極、摻雜窗口、電極接觸孔等。 ? ?
半導體掩膜版制造工藝及流程
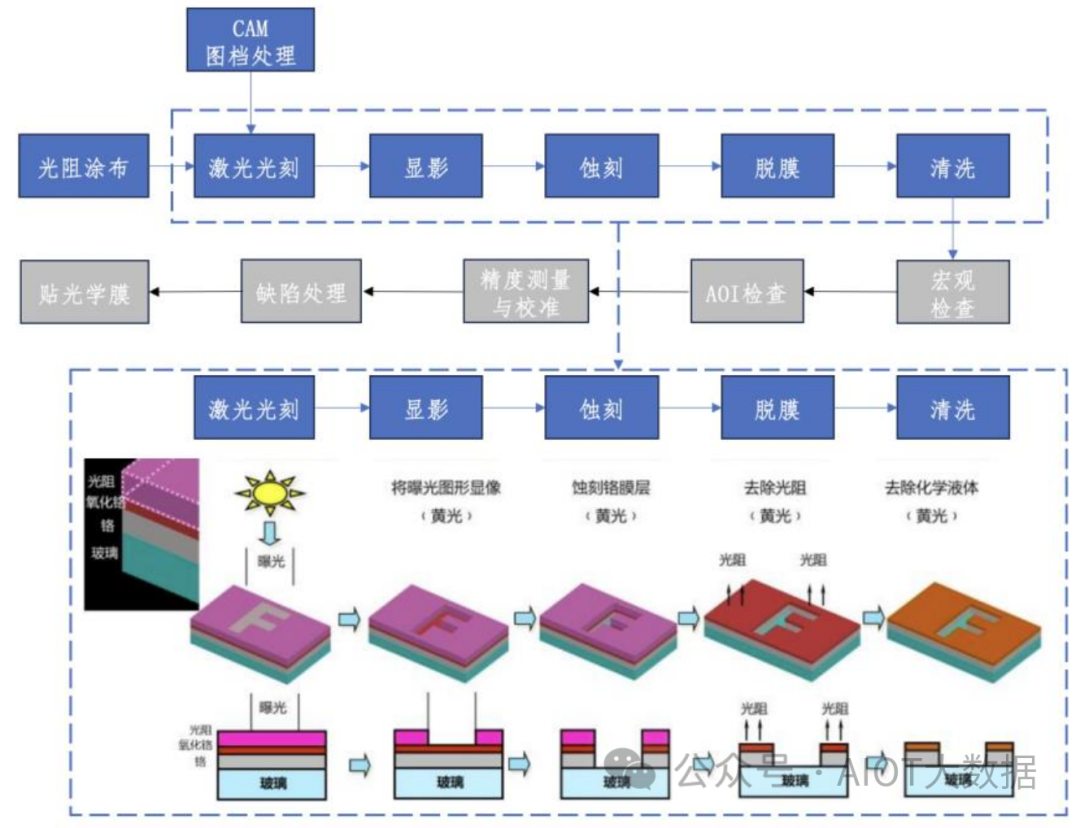
掩膜版制造工藝復雜,可以分為前道工藝和后道工藝。掩模版產品的工藝流程主要包括CAM圖檔處理、光阻涂布、激光光刻、顯影、蝕刻、脫膜、清洗、宏觀檢查、自動光學檢查、精度測量、缺陷處理、貼光學膜等環節。掩膜版的具體生產流程如下所示:
1、CAM(圖檔處理):通過電腦軟件處理,將產品圖檔轉化成為光刻機能夠正常識別的格式;同時對產品原始圖形/圖檔進行一定程度的設計、排布、特殊補正(如DCM、OPC)等,對產品圖形及后續工序起到一定程度的補償、優化等作用。
2、光阻涂布:在已經沉積了鉻膜的基板上,涂布一定厚度和均勻性的光阻,通過烘烤的方式使光阻固化,使得基板能夠在特定波長的光束下發生光化學反應,后續通過顯影、蝕刻等化學制程得到與設計圖形一致的鉻膜圖形。
3、激光光刻:將設計圖形的數據轉換成激光直寫系統控制數據,由計算機控制高精度激光束掃描,利用一定波長的激光,對涂有光阻的掩膜基板按照設計的圖檔進行激光直寫,從而把設計圖形直接轉移到掩膜上。 ? ?
4、顯影:利用化學藥液(顯影液)與光阻的相互作用,將曝光部分的光阻去除,未曝光部分與顯影液不反應而得以保留,從而得到與設計圖形一致的光阻圖形。
5、蝕刻:經過顯影工序后,利用化學藥液(蝕刻液)與鉻膜的化學反應將未被光阻保護的鉻膜去除,有光阻保護的鉻膜不與蝕刻液反應而得以保留。
6、脫膜:經過蝕刻工序后,利用化學藥液與光阻的化學反應,將掩膜版上殘留的部分光阻全部去除,最終得到與設計圖形一致的鉻膜圖形。
7、清洗:利用化學藥液與純水對掩膜版進行清洗,得到表面具有一定清潔度規格的掩膜版產品。
8、宏觀檢查:利用不同光源、光強的燈源,對掩膜版表面進行宏觀(目視)檢查,以確定掩膜版表面是否存在缺陷(Defect)、條紋(Mura)、顆粒(Particle)等不良。
9、自動光學檢查(AOI檢查):利用一定波長、光強的光源獲取被測產品的圖形,通過傳感器(攝像機)獲得檢測圖形的照明圖像并數字化,然后通過相應的邏輯及軟件算法進行比較、分析和判斷,以檢查產品表面缺陷(Defect),如線條斷線(Open)、線條短接(Short)、白凸(Intrusion)、圖形缺失等。
10、精度測量與校準:利用高精度測量設備,對掩膜版圖形的線/間(CD)精度及均勻性、總長(TP)精度、位置(Registration)精度等進行測量,以確認產品精度指標是否在要求規格內;同時利用測量設備的測量結果和相關算法,對掩膜版、設備平臺進行校正和補償,滿足產品要求。
11、缺陷處理:針對斷線、白凸及圖形缺失等缺陷,采用激光誘導化學氣相沉積(LCVD),在掩膜基板上沉積形成薄膜進行修復;針對鉻殘、短路等缺陷,采用一定能量激光進行切除。 ? ?
12、貼光學膜:采用聚酯材料制成的光學膜(Pellicle),將其貼附在掩膜版的表面,起到保護掩膜版表面不受灰塵、臟污、顆粒等污染的作用。
掩膜版的再生修復工藝
掩膜版本體缺陷再生
掩膜版的本體缺陷主要來源于掩膜版生產環節或者光刻工藝中不恰當的使用環節。
(1)透光缺陷。主要是指掩膜版表面鉻層的缺失。掩膜版生產過程中,基材鉻層存在缺陷,或者光刻膠中含有雜質,均可能在成品掩膜版上形成透光缺陷。在晶圓廠使用過程中,特別是采用接觸式曝光方式時,一旦晶圓表面存在硬顆粒時,掩膜版表面鉻層在硬物作用下容易產生磨損,形成透光缺陷。
(2)不透光缺陷。主要是掩膜版表面鉻層的多余。當掩膜版曝光過程中,若基材上存在顆粒,會造成此處光刻膠曝光能量不足,無法被顯影液溶解,后續刻蝕工藝環節中此處鉻無法被刻蝕掉形成鉻殘留。
(3)玻璃缺陷。掩膜版玻璃基材中可能存在氣泡、顆粒、小坑、裂紋等缺陷,會直接影響掩膜版的透光率。常見玻璃基材有蘇打玻璃、硼硅玻璃和石英玻璃,石英玻璃在缺陷控制方面比其他玻璃優越,但價格昂貴。
掩膜版的表面異物缺陷通常是在工藝中引進的:(1)顆粒來源于工藝設備、環境、氣體、化學試劑和去離子水,主要是一些聚合物、光刻膠殘留等,顆粒吸附于掩膜版表面主要靠范德瓦爾斯吸引力,所以對顆粒的去除方法主要以物理或化學的方法對顆粒進行底切,減少顆粒與表面的接觸面積,從而去除顆粒。(2)有機物沾污通常來源于環境中的有機蒸汽、存儲容器、光刻膠的殘留和生產操作中引入的手印。有機雜質會生成疏水層,使掩膜版表面無法得到徹底的清洗。(3)無機物沾污來源于化學試劑和刻蝕等工藝中,主要是金屬離子污染。
掩膜版再生 ? ?
激光修復技術
早期掩膜版修復再生主要采用激光修復的方式,但是受到激光束斑尺寸的限制,修復精度僅能達到微米級,而且修復的邊緣不整齊。但是激光修復簡單,效率高,修復成本低,因此在微米級的掩膜版制造中仍然有著廣泛的應用。
聚焦離子束(FIB)技術
亞微米級掩膜版最常用的修復再生方法是聚焦離子束(FIB)。聚焦離子束(FIB)采用離子源發射的離子束,在電場和磁場的作用下,離子束經過加速聚焦后作為入射束,通過偏轉系統控制離子束,使得高能量的離子在特定區域表面進行數字光柵掃描,從而實現亞微米甚至納米量級的微細加工。
FIB技術在掩膜版修復再方面主要有以下應用:
(1)通過高能離子束濺射來去除不需要的遮光材料掩膜版遮光層一般為鉻層,厚度為100nm左右,用離子束濺射去除鉻層時需要嚴格控制剝離的深度。當離子束剝離了鉻層后繼續對玻璃進行濺射時,會造成玻璃損傷,形成新的缺陷,因此需配合“終點檢測”技術,控制剝離的深度。另一個問題就是鎵離子污染,會降低石英玻璃的透光率。在離子濺射后,采用RIE(反應離子刻蝕)將注入有鎵離子的表層玻璃刻蝕去除,使石英玻璃的透光率恢復到90%以上。
(2)結合氣體注入系統(GasInjectionSystem,GIS),進行定位誘導化學氣相沉積,生長金屬材料,修補透光缺陷通過氣體注入系統(GIS)將氣相反應前驅物噴射到需要修補的透光缺陷區域,同時聚焦離子束對設定的圖形區域進行掃描,氣相前驅物受到離子束的輻照而發生分解,從而在透光缺陷區域沉積一層金屬。
掩膜版清洗再生
掩膜版清洗再生技術可以最大程度的保證掩膜版的潔凈程度,降低掩膜版霧狀缺陷的生長速率。目前國際上主流的清洗技術分為傳統的RCA清洗以及UV+O3這兩種清洗方式。 ? ?
RCA清洗技術
RCA掩膜清洗技術是在半導體晶圓清洗技術基礎上發展的洗凈技術。掩膜版清洗選用RCA清洗中的SPM溶液和SC-1清洗液。
SPM溶液:主要成分為H2SO4+H2O2,溫度為100~130℃,主要用于去除表面的有機污染物。有機污染物的存在,會在表面形成一層疏水膜,降低后續清洗液的效率,因此清洗第一步需要將有機污染物去除。高溫SPM溶液具有很高的氧化能力,能將有機物氧化生成CO2和H2O。經過SPM溶液后,掩膜版表面會殘留有硫酸根離子。硫酸根離子的存在,結合空氣中的水分子與銨鹽易形成硫酸銨結晶,即掩膜版常見的霧狀缺陷,這種缺陷在早期的掩膜版中經常發現。
DIW沖洗:熱去離子水(DIW)是去除硫酸的有效方法,通過熱去離子水將掩膜版表面硫酸沖洗干凈。
SC-1溶液+兆聲清洗:兆聲波結合SC-1溶液可以去除有機和無機顆粒。在稀氨水的堿性條件下,由于光掩膜表面和顆粒表面同時帶有負電荷,電勢相互排斥,結合兆聲波能量更容易將黏附在光掩膜上的顆粒振動而使之脫離光掩膜表面。兆聲波結合SC-1溶液的另一個重要的作用是去除殘留的硫酸根離子,在兆聲能量的作用下,銨根離子與硫酸根離子結合,形成易溶于水的硫酸銨,達到清除硫酸根離子的目的。
DIW+兆聲清洗:通過兆聲加DIW,去除表面的硫酸銨與殘留顆粒。
干燥:干燥方式分為兩種,一種為高速旋轉甩干,一種利用高溫IPA氣體干燥。高速旋轉配合熱N2,在離心力的作用下,掩膜版表面的水被甩出,余下很薄的水膜在熱N2的作用下徹底烘干;IPA與H2O能以任意比例混溶,而IPA在掩膜表面并不具有浸潤的特性。上升的純IPA氣體碰到掩膜表面的H2O互相混溶而凝結成液體落下,由于IPA與掩膜表面并不浸潤,所以不會在掩膜表面留下痕跡,達到干燥掩膜的目的。 ? ?
UV+O3清洗技術
紫外光表面清洗技術在國際上是隨著光電子信息產業的發展而提出來的,相對于傳統的RCA掩膜版清洗技術,最大的優點是無硫化工藝,可以防止在掩膜版上形成硫酸銨霧狀缺陷。
氧等離子灰化(O2plasmaash):由于O3+H2O可以清除有機薄層,但反應速率太慢,不適宜大塊光刻膠的剝離。特別是干法刻蝕硬化后的光刻膠,溶解效率更低。首先采用氧等離子灰化技術消除大部分光刻膠,留下一個薄的光刻膠層。
O3+H2O+UV:短波紫外光(172nm)照射到掩膜版表面后,光子的能量可以打開和切斷有機物分子中的共價鍵,使有機物分子活化,分解成離子、游離態原子、受激分子等。臭氧水(10~100pmm臭氧)在短波紫外光的作用下,會不斷分解成O2和活性氧(O),活性氧有強烈的氧化作用,與活化了的有機物分子發生氧化反應,生成揮發性氣體(如CO2、CO、NO等)逸出物體表面,從而徹底清除了黏附在物體表面上的有機污染物。
DIW:去除殘余臭氧水。
SC-1+兆聲清洗:原理同傳統掩膜版RCA清洗技術,主要用于去除殘余顆粒。
DIW+兆聲清洗:去除SC-1溶液和殘余顆粒。
干燥:原理同傳統掩膜版RCA清洗技術,達到干燥掩膜的目的。
半導體晶圓制造材料成本結構 ? ?

2022年全球半導體掩膜版市場(左)和獨立第三方半導體掩膜版市場(右)競爭格局

2021-2023年中國大陸半導體廠商新建/擴產情況(部分) ? ?

掩膜版的技術迭代
掩膜版產品誕生至今約70多年,是電子制造行業中使用的生產制具。由于掩膜版技術演變較慢,下游運用廣泛且不同行業對掩膜版的性能、成本等要求不同,不同代別的產品存續交疊期長,如第二代菲林掩膜版誕生于二十世紀60年代初,至今仍在PCB、FPC、TN/STN等行業使用。 ? ?

1)手繪菲林
掩模板發明于20世紀50年代,早期的掩模板是純手工繪制,將人們用最普通的坐標圖紙,蓋上一層紅色的膜。至于為啥是紅色,最主要的原因是紅膜遮光性比較強。 ? ?
?
做好了一層紅膜后,其實這也是過渡方案,在進行芯片生產前,還需要微縮相機把整個掩模板的尺寸進行縮小,有時還需進行多次微縮。
2)計算機輔助
20世紀70年代,工程師們開始在計算機上作圖,通過在計算機上實現二維坐標軸的建立,但是因為當時的屏幕不大,鼠標也不像現在這么成熟,當時仍有部分工程師還在使用坐標紙畫圖。

3)電子設計自動化
20世紀90年代,針對越來越多的晶體管數量,一條一條線去勾勒芯片架構的時代已經過去,取而代之的是EDA軟件,EDA軟件是指用計算機輔助設計來實現集成電路芯片的功能設計、綜合、驗證、物理設計(包括布局、布線、版圖、設計規則檢查等)等流程的設計方式。至此,人們終于不需要再用紙和筆來設計芯片了。現在的芯片設計過程,從芯片的功能設計,到電路結構設計,再到芯片版圖的物理實現,全部借助于EDA軟件來完成,其中還包括復雜而精確的設計檢查、模擬仿真等,可以保證容納了上百億只晶體管的芯片設計萬無一失。 ? ?
掩膜版產品優勢主要是其在轉移電路圖形過程中的精確性和可靠性,第五代掩膜版產品擁有較高的光學透過率、較低的熱膨脹系數、良好的平整性和耐磨性以及能夠實現較高的精度被廣泛運用于各個行業。
未來潛在的風險是無掩膜技術的大規模使用,無掩膜技術因僅能滿足精度要求相對較低的行業(如PCB板)中圖形轉移的需求,且其生產效率低下,而無法滿足對圖形轉移精度要求高以及對生產效率有要求的行業運用,因此不存在被快速迭代的風險。

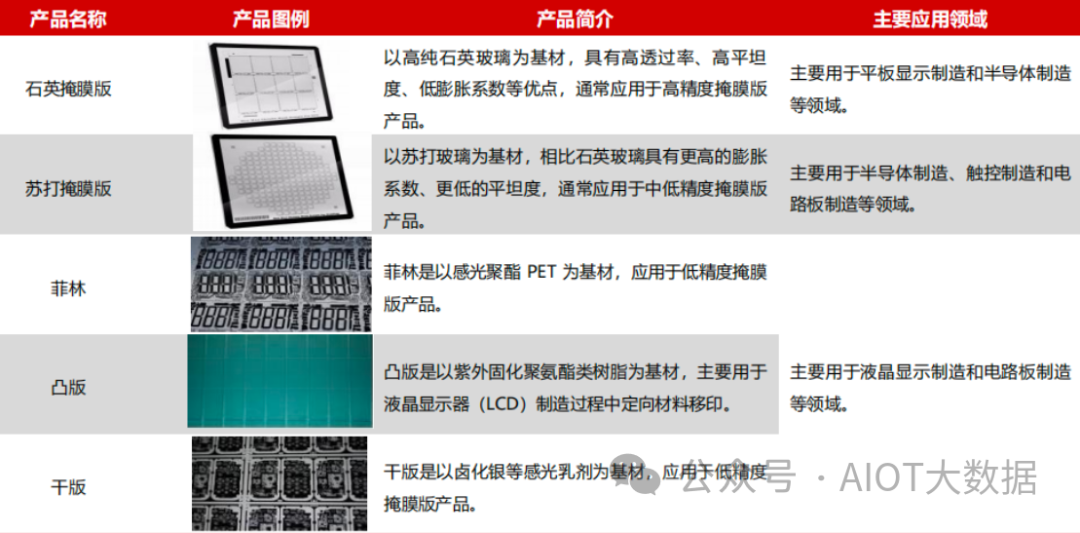
頭部的第三方掩膜版廠具備精密制程的量產能力,如Photronics、DNP的技術節點已達5nm,Toppan的技術節點達14nm;而包括臺灣在內的國內廠商主要產能還在65nm以上。 ? ?
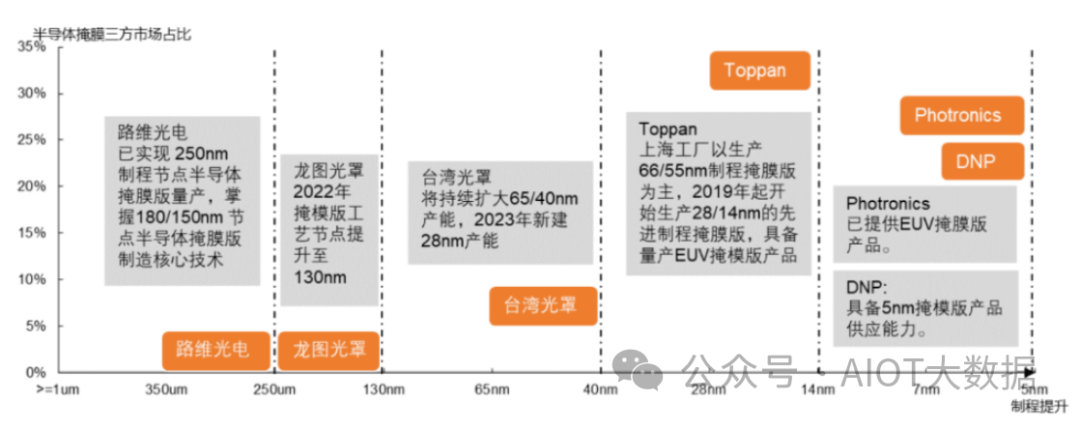
技術難點
光掩模版的技術難點主要在于光刻環節中,對制程的要求、對位置精度的控制、對曝光的控制、與光刻機設備的匹配等問題。

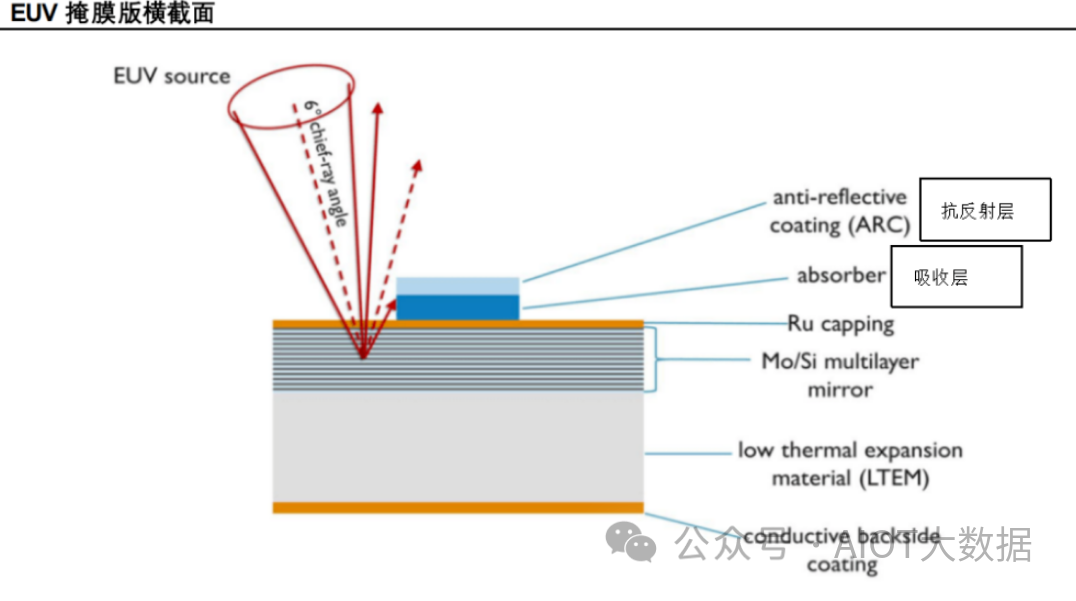
? ?

掩膜設備
掩膜設備通常為采用激光為輻射源的直寫光刻機,是制約產能瓶頸的重要因素。掩膜設備的主要供應商有瑞典Mycronic、德國Heidelberg等企業,其中瑞典Mycronic處于全球領先地位。目前高端的平板顯示用光刻機由瑞典Mycronic生產,全球主要平板顯示用掩膜版制造商對其生產的設備都存在較高程度依賴。
國內企業中,芯碁微裝、江蘇影速、天津芯碩等企業能夠實現此類設備的產業化,芯碁微裝在激光掩膜版制版領域的技術水平已經能夠與德國Heidelberg進行競爭。通常用于判斷掩膜設備技術水平的關鍵指標為:最小線寬、套刻精度、產能效率和CD均勻度等。 ? ?
從掩模版制造的核心原材料和設備來看,高精度半導體掩模版核心原材料石英基板仍被日韓企業壟斷,設備仍主要依賴進口。

行業競爭
在眾多應用領域中,半導體掩膜版技術要求最高且工藝難度大,長期被國外龍頭企業所壟斷。目前領先的掩膜版廠商有福尼克斯、SKE、HOYA、Toppan、臺灣光罩等。其中,LG-IT和SKE的掩膜版產品主要布局在平板顯示掩膜版領域,均擁有G11掩膜版生產線;Toppan和臺灣光罩的掩膜版產品主要布局在半導體掩膜版領域;福尼克斯、DNP、HOYA的掩膜版產品同時布局在平板顯示掩膜版領域和半導體掩膜版領域;清溢光電和路維光電的掩膜版產品種類多樣,應用領域廣泛,包括平板顯示掩膜版、半導體掩膜版、觸控掩膜版和電路板掩膜版等,路維光電擁有G11掩膜版生產線。 ? ?

? ?
審核編輯:黃飛
?
 電子發燒友App
電子發燒友App
















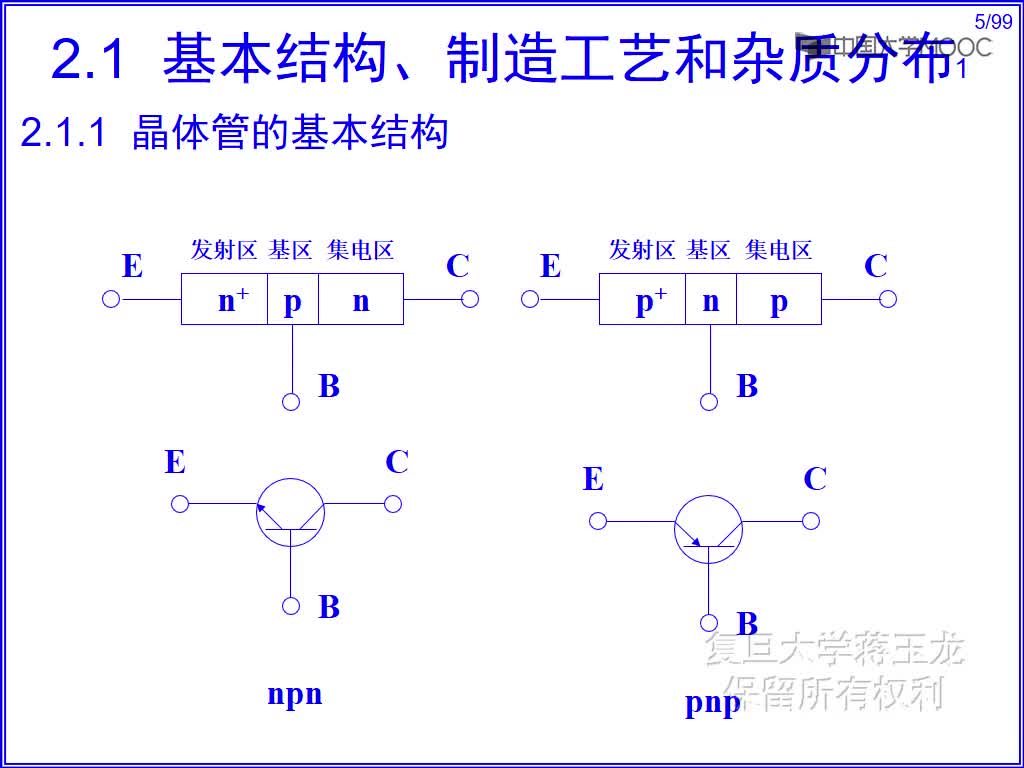
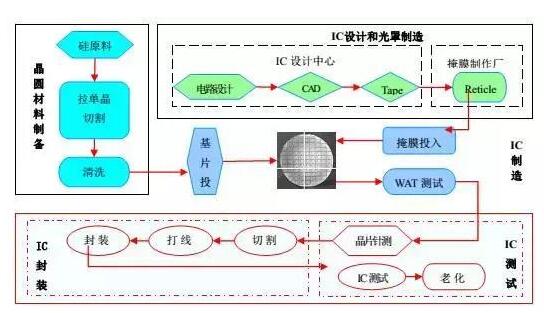


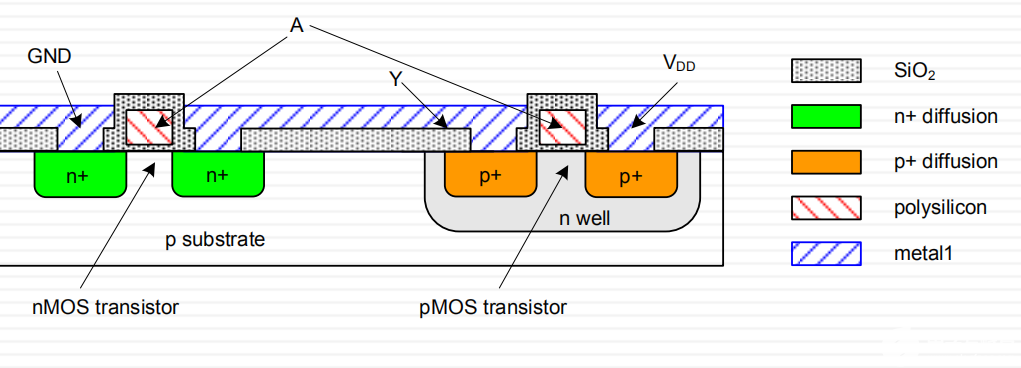
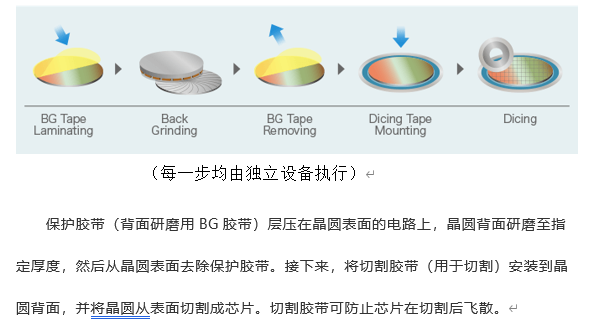
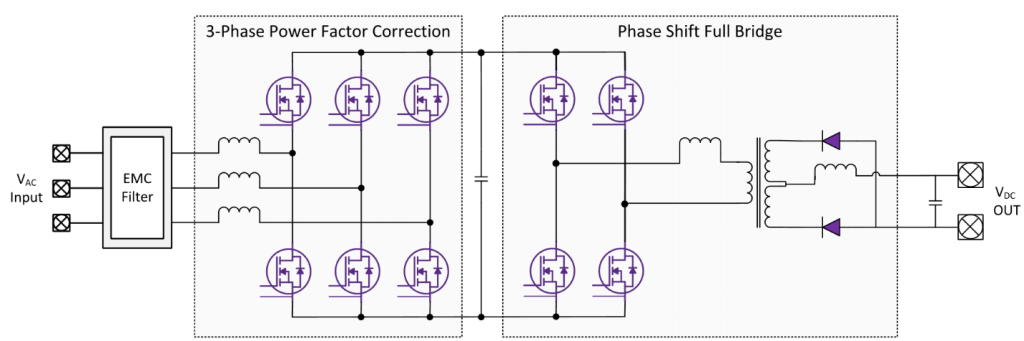
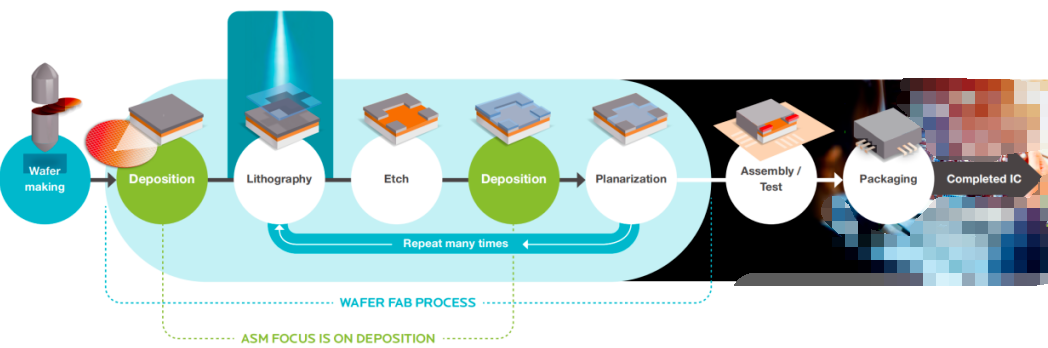

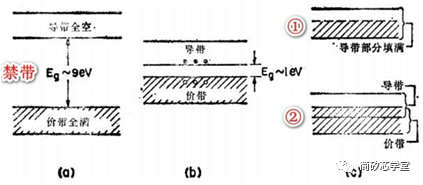











評論