在本文中,我們詳細(xì)研究了AlGaN的濕法刻蝕特性。特別地,我們研究了m面刻面形成和AlN摩爾分?jǐn)?shù)對蝕刻速率的依賴關(guān)系。我們還研究了氮化鋁摩爾分?jǐn)?shù)差異較大的紫外發(fā)光二極管結(jié)構(gòu)的濕法刻蝕特性。
2021-12-13 14:58:12 1270
1270 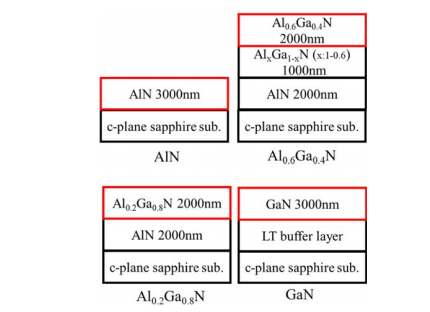
摘要 我們華林科納研究了正磷酸、聚磷酸、和鐵(III)氯化物蝕刻劑對工藝條件變化的敏感性,以確定該蝕刻劑系統(tǒng)在純鋁電路光刻制造中的潛在生產(chǎn)應(yīng)用。溫度變化、正磷酸濃度、多磷酸濃度的影響。檢測了酸濃度
2022-01-07 15:40:12 1194
1194 
摘要 我們華林科納對h2so4-h202-h20體系中(100)砷化鎵的蝕刻情況進(jìn)行了詳細(xì)的研究。研究了特定蝕刻劑成分的濃度對蝕刻速率和晶體表面形狀的影響。從這些結(jié)果中,蝕刻浴組成的吉布斯三角形
2022-01-25 10:32:24 2215
2215 
硅的各向異性蝕刻是指定向依賴的蝕刻,通常通過堿性蝕刻劑如水溶液氫氧化鉀,TMAH和其他羥化物如氫氧化鈉。由于蝕刻速率對晶體取向、蝕刻劑濃度和溫度的強(qiáng)烈依賴性,可以以高度可控和可重復(fù)的方式制備多種
2022-03-08 14:07:25 1769
1769 
硅片在大口徑化的同時,要求規(guī)格的嚴(yán)格化迅速發(fā)展。特別是由于平坦度要求變得極其嚴(yán)格,因此超精密磨削技術(shù)得以開發(fā),實(shí)現(xiàn)了無蝕刻化,無拋光化。雖然在單晶SiC晶片上晶片磨削技術(shù)的開發(fā)也在進(jìn)行,但在包括成本
2022-04-15 14:54:49 1392
1392 
本文提出了一種利用原子力顯微鏡(AFM)測量硅蝕刻速率的簡單方法,應(yīng)用硅表面的天然氧化物層作為掩膜,通過無損摩擦化學(xué)去除部分天然氧化物,暴露底下新鮮硅。因此,可以實(shí)現(xiàn)在氫氧化鉀溶液中對硅的選擇性蝕刻,通過原子精密的AFM可以檢測到硅的蝕刻深度,從而獲得了氫氧化鉀溶液中精確的硅蝕刻速率。
2022-04-22 14:06:01 1266
1266 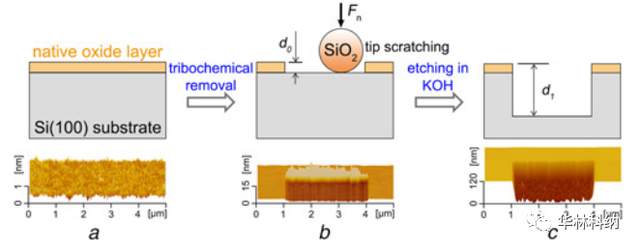
的電子和光電子器件的制造中對高選擇性濕法化學(xué)蝕刻劑的額外需求,還進(jìn)行了廣泛的研究以檢驗(yàn)多種蝕刻溶液。列出了這些蝕刻劑的蝕刻速率、選擇性和表面粗糙度,以驗(yàn)證它們對預(yù)期應(yīng)用的適用性。盡管頻繁使用GaSb
2022-05-11 14:00:42 1025
1025 
引言 正在開發(fā)化學(xué)下游蝕刻(CDE)工具,作為用于半導(dǎo)體晶片處理的含水酸浴蝕刻的替代物。對CDE的要求包括在接近電中性的環(huán)境中獲得高蝕刻速率的能力。高蝕刻率是由含NF”和0的混合物的等離子體放電分解
2022-06-29 17:21:42 3346
3346 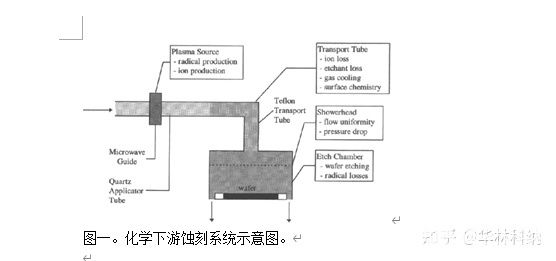
本文描述了我們華林科納用于III族氮化物半導(dǎo)體的選擇性側(cè)壁外延的具有平面?zhèn)缺诳堂娴墓栉⒚缀图{米鰭的形成。通過濕法蝕刻取向的硅晶片生產(chǎn)鰭片。使用等離子體增強(qiáng)化學(xué)氣相沉積來沉積二氧化硅,以產(chǎn)生硬掩模
2022-07-08 15:46:16 1095
1095 
本文主要闡述我們華林科納在補(bǔ)救InGaP/GaAs NPN HBT的噴霧濕法化學(xué)腐蝕過程中光刻膠粘附失效的幾個實(shí)驗(yàn)的結(jié)果。確定了可能影響粘附力的幾個因素,并使用實(shí)驗(yàn)設(shè)計(DOE)方法來研究所選因素
2022-07-12 14:01:13 1365
1365 
包括GaN和SiC在內(nèi)的寬帶隙半導(dǎo)體已被證明適用于高功率微波電子器件。AlGaN/GaN基本的研究結(jié)果令人印象深刻。雙極性器件由于其固有的更高功率密度和潛在的更高速度,對高功率電子器件也很有吸引力
2022-07-12 17:04:38 1103
1103 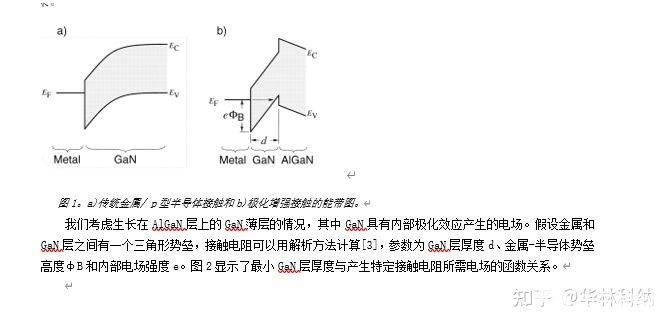
引言 氫氧化鉀(KOH)是一種用于各向異性濕法蝕刻技術(shù)的堿金屬氫氧化物,是用于硅晶片微加工的最常用的硅蝕刻化學(xué)物質(zhì)之一。各向異性蝕刻優(yōu)先侵蝕襯底。也就是說,它們在某些方向上的蝕刻速度比在其
2022-07-14 16:06:06 2775
2775 
濕法蝕刻工藝的原理是利用化學(xué)溶液將固體材料轉(zhuǎn)化為liquid化合物。由于采用了高選擇性化學(xué)物質(zhì)可以非常精確地適用于每一部電影。對于大多數(shù)解決方案選擇性大于100:1。
2022-07-27 15:50:25 2109
2109 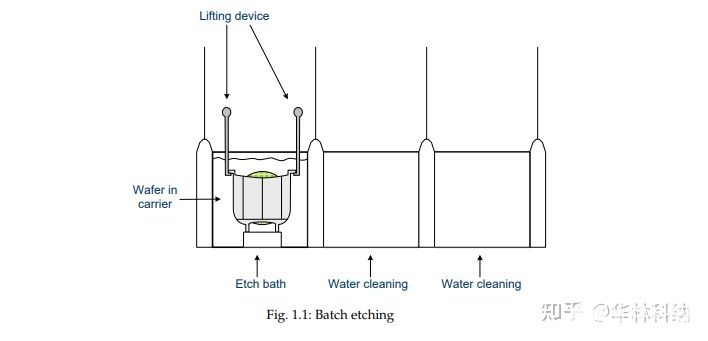
濕法蝕刻工藝的原理是使用化學(xué)溶液將固體材料轉(zhuǎn)化為液體化合物。選擇性非常高,因?yàn)樗没瘜W(xué)藥品可以非常精確地適應(yīng)各個薄膜。對于大多數(shù)解決方案,選擇性大于100:1。
2021-01-08 10:12:57
我司是做濕法蝕刻藥水的,所以在濕法這塊有很多年的研究。所以有遇到濕法蝕刻問題歡迎提問,很愿意為大家解答。謝謝!QQ:278116740
2017-05-08 09:58:09
`華林科納濕法設(shè)備分類全自動設(shè)備:全自動RCA清洗機(jī)全自動硅片刻蝕機(jī)全自動片盒清洗機(jī)全自動石英管清洗機(jī)半自動設(shè)備:半自動RCA清洗機(jī)半自動硅片刻蝕機(jī)半自動石英管清洗機(jī)半自動有機(jī)清洗機(jī)`
2021-02-07 10:14:51
為了在基板上形成功能性的MEMS結(jié)構(gòu),必須蝕刻先前沉積的薄膜和/或基板本身。通常,蝕刻過程分為兩類:浸入化學(xué)溶液后材料溶解的濕法蝕刻干蝕刻,其中使用反應(yīng)性離子或氣相蝕刻劑濺射或溶解材料在下文中,我們將簡要討論最流行的濕法和干法蝕刻技術(shù)。
2021-01-09 10:17:20
、CMP、ICP 干蝕刻、亞表面損傷、等離子體誘導(dǎo)損傷 直接比較了 GaN 襯底的表面處理方法,即使用膠體二氧化硅漿料的化學(xué)機(jī)械拋光 (CMP) 和使用 SiCl4 氣體的電感耦合等離子體 (ICP) 干
2021-07-07 10:26:01
方面存在局限性,因此需要探索自上而下、依賴蝕刻的 GaN NW 制造工藝。這項(xiàng)工作的重點(diǎn)是改進(jìn)自上而下的 GaN 納米線的制造方法,并為 SPE 的制造奠定了潛在的工藝。使用干法和濕法蝕刻的組合,現(xiàn)有
2021-07-08 13:11:24
和碳化硅,在室溫下電化學(xué)刻蝕在某些情況下是成功的。此外,光輔助濕法蝕刻產(chǎn)生類似的速率,與晶體極性無關(guān)。 介紹 寬帶隙半導(dǎo)體氮化鎵、碳化硅和氧化鋅對許多新興應(yīng)用具有吸引力。例如,AlGaN/GaN高電子
2021-10-14 11:48:31
書籍:《炬豐科技-半導(dǎo)體工藝》文章:GaN晶體蝕刻的幾何方面和光子應(yīng)用編號:JFSJ-21-044作者:炬豐科技網(wǎng)址:http://www.wetsemi.com/index.html摘要:濕法
2021-07-08 13:09:52
已經(jīng)報道了具有低至 4±6 nm 的 rms 粗糙度的表面。濕法蝕刻也已被證明用于蝕刻氮化鎵,蝕刻具有設(shè)備成本相對較低、表面損傷小等優(yōu)點(diǎn),但目前還沒有找到生產(chǎn)光滑垂直側(cè)壁的方法。還報道了 GaN 的解理
2021-07-07 10:24:07
黃金。以上只是基于實(shí)驗(yàn)的基礎(chǔ),實(shí)驗(yàn)設(shè)備也比較簡陋,如果再結(jié)合濕法清洗設(shè)備進(jìn)行蝕刻工藝,效果會有明顯的提高,南通華林科納半導(dǎo)體設(shè)備有限公司生產(chǎn)的濕法清洗設(shè)備能在各方面滿足要求,使清洗達(dá)到事半功倍的效果。 如有侵權(quán),請聯(lián)系作者刪除
2021-07-09 10:23:37
的陰極極化下,酸性介質(zhì)中的Fe31、Ce41、HIO3和堿性介質(zhì)中的Fe(CN)632以擴(kuò)散有限的速率電化學(xué)還原。在1M氫氧化鉀中,觀察到o2/h2o還原的高反應(yīng)性,這解釋了為什么n-GaN可以在該溶液
2021-10-13 14:43:35
測試,并且在錯誤的情況下可能導(dǎo)致工藝失敗,因此,基于研究的重要性,不管從藥液還是設(shè)備都需選擇穩(wěn)定可靠的,而華林科納半導(dǎo)體設(shè)備有限公司在濕法刻蝕領(lǐng)域已有十幾年的經(jīng)驗(yàn),其生產(chǎn)的設(shè)備功能完善,并能針對客戶的需求給出一系列的解決辦法跟方案。 如有侵權(quán),請聯(lián)系作者刪除
2021-07-06 09:39:22
:MacEtch 是一種濕法蝕刻工藝,可提供對取向、長度、形態(tài)等結(jié)構(gòu)參數(shù)的可控性,此外,它是一種制造極高縱橫比半導(dǎo)體納米結(jié)構(gòu)的簡單且低成本的方法。 3 該工藝?yán)昧嗽谘趸瘎ɡ邕^氧化氫 (H2O2))和酸(例如
2021-07-06 09:33:58
我是南通華林科納半導(dǎo)體的,主要做半導(dǎo)體,太陽能,液晶LED,電子器件濕法工藝,各種清洗,濕制程設(shè)備。我們3月14日—16日去上海新國際博覽中心參加2017慕尼黑上海半導(dǎo)體展,有其他去的公司嗎,應(yīng)該
2017-03-04 11:50:42
典型GaN晶體管的核心是一個導(dǎo)電通道,它由AlGaN阻擋層和GaN緩沖層間界面上產(chǎn)生的二維電子氣形成(見圖1)。這種器件傾向在一個異質(zhì)基板上生產(chǎn),典型的是硅或碳化硅,并具備三個電極:源極、漏極、柵極。為
2020-11-27 16:30:52
蘇州華林科納半導(dǎo)體設(shè)備技術(shù)有限公司成立于2008年3月,投資4500萬元。主要從事半導(dǎo)體、太陽能、FPD領(lǐng)域濕制程設(shè)備的設(shè)計、研發(fā)、生產(chǎn)及銷售;同時代理半導(dǎo)體、太陽能、FPD領(lǐng)域其它國外設(shè)備,負(fù)責(zé)
2015-04-02 17:21:04
射流的理論獲得了底部的各個部位的蝕刻液離子的擴(kuò)散速率,并搞清楚了側(cè)壁上出現(xiàn)的主要原因。針對酸性氯化銅溶液,擴(kuò)散速度與蝕刻反應(yīng)速度是成比例關(guān)系的。所以,凹槽內(nèi)底部各個部位蝕刻的速度相對中央最大速率區(qū)也是
2018-09-10 15:56:56
招聘蘇州華林科納半導(dǎo)體設(shè)備技術(shù)有限公司職位月薪:面議工作地點(diǎn):蘇州工作性質(zhì):全職工作經(jīng)驗(yàn):1年以上最低學(xué)歷:大專招聘人數(shù):5人 職位類別:銷售經(jīng)理職位描述要求:工作經(jīng)驗(yàn):1年以上崗位職責(zé):1、負(fù)責(zé)
2015-07-28 11:38:16
晶片全面曝光的方法,使單一晶片上可以獲得更多的芯片(chip)。如此一來,雖然產(chǎn)率得以提高,但同時也制造一些工藝處理問題。特別在對硅晶片蝕刻深凹槽(deeptrench)工藝方面。 由于采用全面曝光
2018-03-16 11:53:10
濕蝕刻是光刻之后的微細(xì)加工過程,該過程中使用化學(xué)物質(zhì)去除晶圓層。晶圓,也稱為基板,通常是平面表面,其中添加了薄薄的材料層,以用作電子和微流體設(shè)備的基礎(chǔ);最常見的晶圓是由硅或玻璃制成的。濕法刻蝕
2021-01-08 10:15:01
蘇州華林科納半導(dǎo)體設(shè)備技術(shù)有限公司成立于2008年3月,投資4500萬元。主要從事半導(dǎo)體、太陽能、FPD領(lǐng)域濕制程設(shè)備的設(shè)計、研發(fā)、生產(chǎn)及銷售;同時代理半導(dǎo)體、太陽能、FPD領(lǐng)域其它國外設(shè)備,負(fù)責(zé)
2015-04-02 17:23:36
蘇州華林科納半導(dǎo)體設(shè)備技術(shù)有限公司成立于2008年3月,投資4500萬元。主要從事半導(dǎo)體、太陽能、FPD領(lǐng)域濕制程設(shè)備的設(shè)計、研發(fā)、生產(chǎn)及銷售;同時代理半導(dǎo)體、太陽能、FPD領(lǐng)域其它國外設(shè)備,負(fù)責(zé)
2015-04-02 17:26:21
公司名稱:蘇州華林科納半導(dǎo)體設(shè)備技術(shù)有限公司公司地址:蘇州工業(yè)園區(qū)啟月街288號公司電話:0512-62872541蘇州華林科納半導(dǎo)體設(shè)備技術(shù)有限公司主要從事半導(dǎo)體、太陽能、FPD領(lǐng)域濕制程設(shè)備
2016-10-26 17:05:04
蘇州華林科納半導(dǎo)體設(shè)備技術(shù)有限公司成立于2008年3月,投資4500萬元。主要從事半導(dǎo)體、太陽能、FPD領(lǐng)域濕制程設(shè)備的設(shè)計、研發(fā)、生產(chǎn)及銷售;同時代理半導(dǎo)體、太陽能、FPD領(lǐng)域其它國外設(shè)備,負(fù)責(zé)
2015-04-02 17:22:46
功率AlGaN_GaN肖特基二極管結(jié)構(gòu)優(yōu)化設(shè)計_徐儒
2017-01-08 10:30:29 1
1 本文報道了algan/gan高電子遷移率晶體管(hemt)在反向柵偏壓作用下閾值電壓的負(fù)漂移。該器件在強(qiáng)pinch-off和低漏源電壓條件下偏置一定時間(反向柵極偏置應(yīng)力),然后測量傳輸特性。施加
2019-10-09 08:00:00 10
10 在噴淋蝕刻過程中,蝕刻液是通過蝕刻機(jī)上的噴頭,在一定壓力下均勻地噴淋到印制電路板上的。蝕刻液到達(dá)印制板之后進(jìn)入干鏌之間的凹槽內(nèi)并與凹槽內(nèi)露出的銅發(fā)生化學(xué)反應(yīng)。
2020-04-08 14:53:25 3295
3295 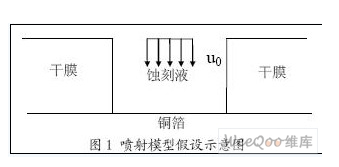
基于溫度步進(jìn)應(yīng)力實(shí)驗(yàn),研究了 AlGaN /GaN HEMT 器件在不同溫度應(yīng)力下的退化規(guī)律及退化機(jī)理。實(shí)驗(yàn)發(fā)現(xiàn): 在結(jié)溫為 139 ~ 200 ℃ 時,AlGaN /GaN HEMT 器件
2020-06-23 08:00:00 2
2 書籍:《炬豐科技-半導(dǎo)體工藝》 文章:單晶的濕法蝕刻和紅外吸收 編號:JFKJ-21-206 作者:炬豐科技 摘要 采用濕法腐蝕、x射線衍射和紅外吸收等方法研究了物理氣相色譜法生長AlN單晶的缺陷
2023-04-23 11:15:00 118
118 低損耗硅波導(dǎo)和有效的光柵耦合器來將光耦合到其中。通過使用各向異性濕法蝕刻技術(shù),我們將側(cè)壁粗糙度降低到1.2納米。波導(dǎo)沿[112]方向在絕緣體上硅襯底上形成圖案。
2021-12-22 10:17:21 712
712 電感耦合等離子體反應(yīng)離子蝕刻獲得的高蝕刻速率和高度各向異性的輪廓。光增強(qiáng)濕法蝕刻提供了一種獲得高蝕刻速率而沒有離子誘導(dǎo)損傷的替代途徑。該方法適用于器件制造以及n-氮化鎵中位錯密度的估算。這有可能發(fā)展成為一種快
2021-12-30 10:36:17 989
989 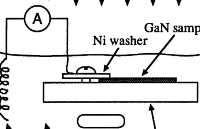
我們華林科納開發(fā)了一種可控、平滑的氫氧化鉀基濕法刻蝕技術(shù),AlN和AlxGa1xN之間的高選擇性被發(fā)現(xiàn)對于基于AlGaN的深紫外發(fā)光二極管實(shí)現(xiàn)有效的襯底減薄或去除至關(guān)重要,從而提高光提取效率
2022-01-05 16:10:51 564
564 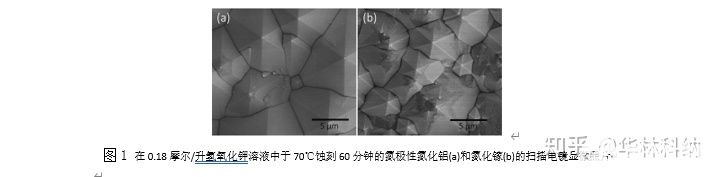
摘要 本文對本克斯使用的鋁蝕刻劑進(jìn)行調(diào)查,以長期提高蝕刻部件的質(zhì)量。非常薄的鋁箔圖案在磷酸、氯化鐵和水銹溶液中精確蝕刻的鋁箔圖案符合尺寸和一致性標(biāo)準(zhǔn)。蝕刻劑的主要問題是,由蒸發(fā)和耗盡引起的成分變化
2022-01-07 16:47:46 840
840 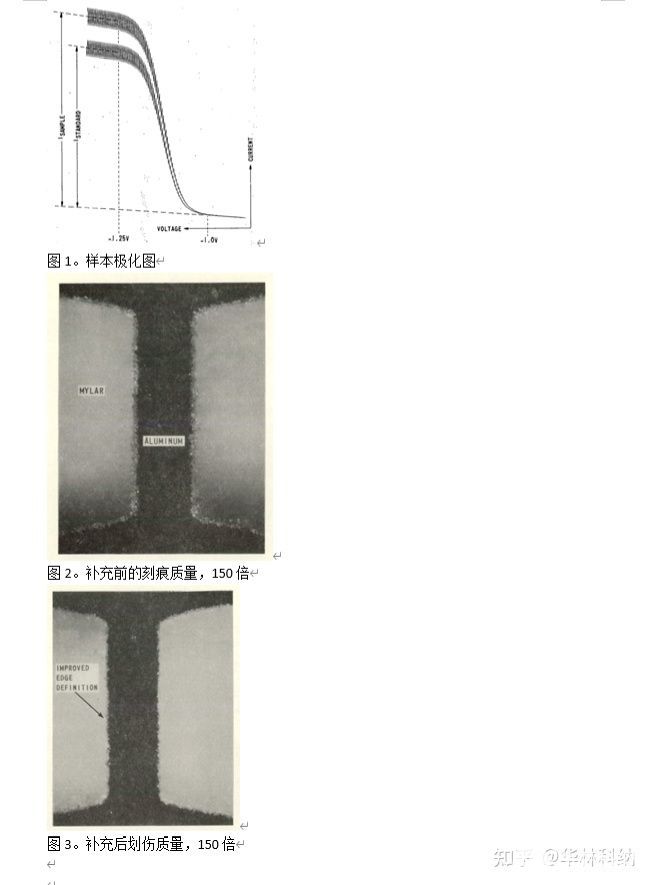
氫氧化鉀(KOH)是一種用于各向異性濕法蝕刻技術(shù)的堿金屬氫氧化物,是用于微加工硅片的最常用的硅蝕刻化學(xué)物質(zhì)之一。各向異性蝕刻優(yōu)先侵蝕基底。也就是說,它們在某些方向上的蝕刻速率比在其他方向上的蝕刻速率
2022-01-11 11:50:33 2152
2152 
(HFETs) 和AlGaN/GaN異質(zhì)結(jié)雙極晶體管(HBT)。 在本研究中,我們描述了對高質(zhì)量氮化鋁和氮化鎵單晶襯底之間的蝕刻選擇性以及兩種塊體材料的兩種極性之間的選擇性的研究。確定了每次蝕刻過程后的蝕刻
2022-01-14 11:16:26 2494
2494 
引言 我們華林科納研究了KOH基溶液中AIN的濕式化學(xué)蝕刻與蝕刻溫度和材料質(zhì)量的關(guān)系。這兩種材料的蝕刻速率都隨著蝕刻溫度的增加而增加,從20~80°C不等。通過在1100°C下快速熱退火,提高了反應(yīng)
2022-01-17 16:21:48 324
324 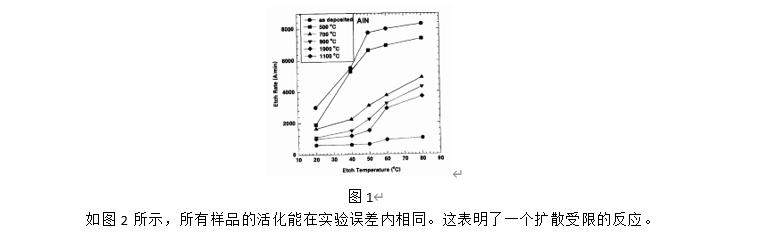
蝕刻的濕法蝕刻技術(shù)的方法。本文分析了玻璃濕法刻蝕工藝的基本要素,如:玻璃成分的影響、刻蝕速率、掩膜層殘余應(yīng)力的影響、主要掩膜材料的表征、濕法刻蝕工藝產(chǎn)生的表面質(zhì)量。通過分析的結(jié)果,提出了一種改進(jìn)的玻璃深度濕
2022-01-19 16:13:40 1873
1873 
濕法蝕刻工藝已經(jīng)廣泛用于生產(chǎn)各種應(yīng)用的微元件。這些過程簡單易操作。選擇合適的化學(xué)溶液(即蝕刻劑)是濕法蝕刻工藝中最重要的因素。它影響蝕刻速率和表面光潔度。銅及其合金是各種工業(yè),特別是電子工業(yè)的重要
2022-01-20 16:02:24 1863
1863 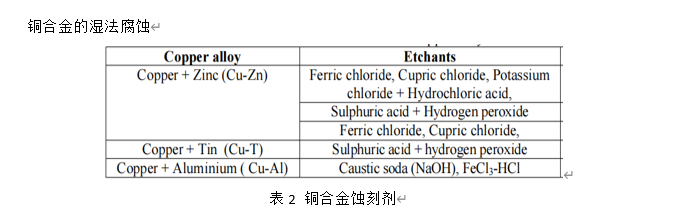
本文探討了紫外輻照對生長在藍(lán)寶石襯底上的非有意摻雜n型氮化鎵(GaN)層的濕法化學(xué)刻蝕的影響。實(shí)驗(yàn)過程中,我們發(fā)現(xiàn)氮化鎵的蝕刻發(fā)生在pH值分別為2-1和11-15的磷酸水溶液和氫氧化鉀溶液中。在稀釋
2022-01-24 16:30:31 948
948 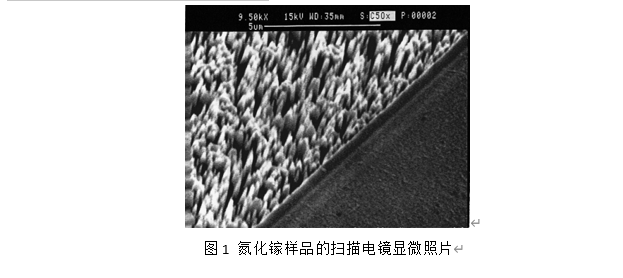
摘要 FeCl3·6h2o用于單晶氧化鋅薄膜的濕法蝕刻。該方法對抑制用酸蝕刻氧化鋅薄膜時通常觀察到的“W”形蝕刻輪廓有很大的影響。通過觸控筆輪廓儀和掃描電子顯微鏡證實(shí),在廣泛的蝕刻速率下獲得了
2022-01-26 14:46:48 307
307 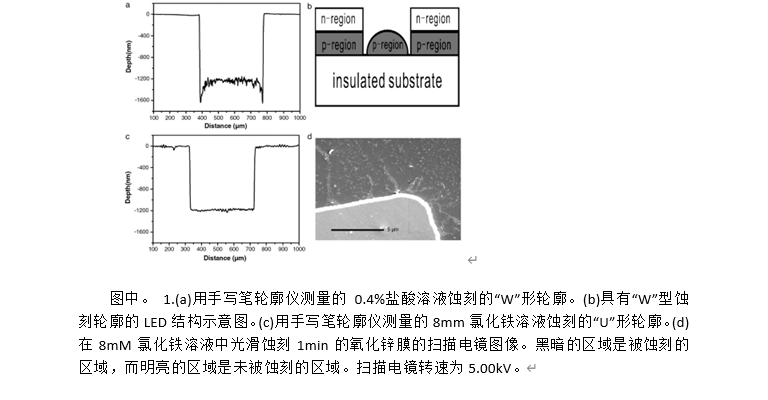
索引術(shù)語:氮化鎵,蝕刻 摘要 本文介紹了我們華林科納的一種利用氫氧化鉀溶液和大面積汞燈照明對氮化鎵進(jìn)行光增強(qiáng)濕法化學(xué)刻蝕的工藝。討論了n+氮化鎵、非有意摻雜氮化鎵和p-氮化鎵樣品的結(jié)果。 介紹 光電
2022-02-07 14:35:42 1479
1479 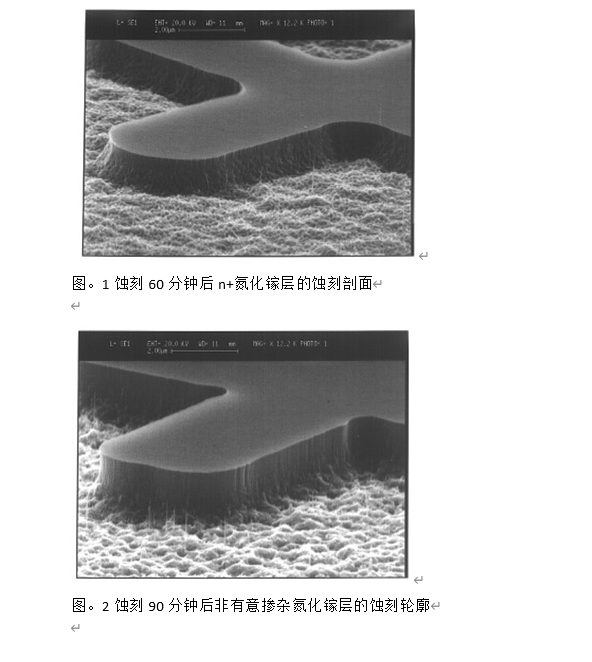
我們華林科納使用K2S2O8作為氧化劑來表征基于KOH的紫外(UV)光輔助濕法蝕刻技術(shù)。該解決方案提供了良好控制的蝕刻速率,并產(chǎn)生了光滑的高質(zhì)量蝕刻表面,同時通過原子力顯微鏡測量的表面粗糙度降低最小
2022-02-14 16:14:55 716
716 
電感耦合等離子體反應(yīng)離子蝕刻獲得的高蝕刻速率和高度各向異性的輪廓。光增強(qiáng)濕法蝕刻提供了一種獲得高蝕刻速率而沒有離子誘導(dǎo)損傷的替代途徑。該方法適用于器件制造以及n-氮化鎵中位錯密度的估算。這有可能發(fā)展成為一種快速評估材料的方法。
2022-02-23 16:20:24 2208
2208 
性,單片濕法刻蝕法是一種有用的技術(shù)。其進(jìn)一步推進(jìn)應(yīng)得到理論計算的支持。 因此,在我們之前的研究中開發(fā)了使用單晶片濕法蝕刻機(jī)進(jìn)行二氧化硅膜蝕刻的數(shù)值計算模型。首先,通過水流可視化獲得旋轉(zhuǎn)晶片上的整個水運(yùn)動,并進(jìn)行評估
2022-03-02 13:58:36 751
751 
在 KOH 水溶液中進(jìn)行濕法化學(xué)蝕刻期間,硅 (1 1 1) 的絕對蝕刻速率已通過光學(xué)干涉測量法使用掩膜樣品進(jìn)行了研究。蝕刻速率恒定為0.62 ± 0.07 μm/h 且與 60
2022-03-04 15:07:09 845
845 
HF對基片進(jìn)行了研究,主要分為隨機(jī)蝕刻和周期性蝕刻。 我們討論了蝕刻的問題機(jī)理、蝕刻速率、硬掩膜材料、周期性光俘獲結(jié)構(gòu)。
2022-03-08 11:52:41 1214
1214 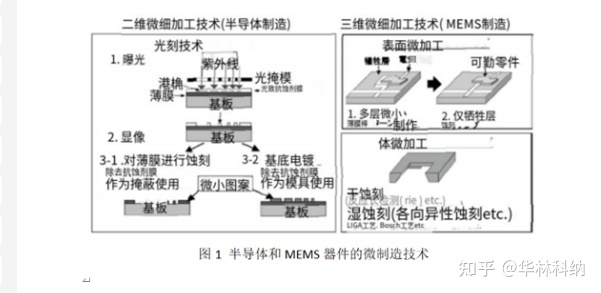
我們開發(fā)了一種改進(jìn)的各向異性濕法蝕刻工藝,通過在晶片上使用單個蝕刻掩模來制造各種硅微結(jié)構(gòu),這些微結(jié)構(gòu)具有圓形凹角和尖銳凸角、用于芯片隔離的凹槽、蜿蜒的微流體通道、具有彎曲V形凹槽的臺面結(jié)構(gòu)以及具有
2022-03-14 10:51:42 581
581 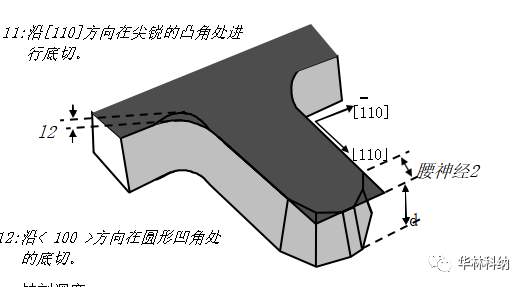
材料,其用于許多蝕刻步驟中以抵抗蝕刻。該掩模材料可以是光致抗蝕劑,并且使用光刻法將其圖案化。蝕刻也可以稱為制作空腔,這些空腔應(yīng)該根據(jù)用途具有特定的深度。產(chǎn)生的這種空腔的深度可以通過蝕刻時間和蝕刻速率
2022-03-16 16:31:58 1136
1136 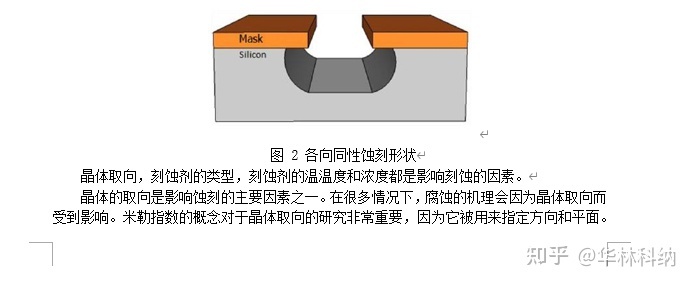
本文我們華林科納半導(dǎo)體有限公司研究了類似的現(xiàn)象是否發(fā)生在氫氧化鉀溶液中添加的其他醇,詳細(xì)研究了丁基醇濃度對(100)和(110)Si平面表面形貌和蝕刻速率的影響,并給出了異丙醇對氫氧化鉀溶液的蝕刻結(jié)果,為了研究醇分子在蝕刻溶液中的行為機(jī)理,我們還對溶液的表面張力進(jìn)行了測量。
2022-03-18 13:53:01 288
288 
本文提出了一種利用原子力顯微鏡(AFM)測量硅蝕刻速率的簡單方法,應(yīng)用硅表面的天然氧化物層作為掩膜,通過無損摩擦化學(xué)去除去除部分天然氧化物,暴露地下新鮮硅。因此,可以實(shí)現(xiàn)在氫氧化鉀溶液中對硅的選擇性蝕刻,通過原子精密的AFM可以檢測到硅的蝕刻深度,從而獲得了氫氧化鉀溶液中精確的硅的蝕刻速率。
2022-03-18 15:39:18 401
401 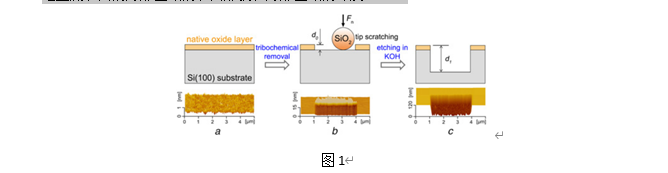
本文介紹了我們華林科納采用氮化硅膜作為掩膜,采用濕蝕刻技術(shù)制備黑硅,樣品在250~1000nm波長下的吸收率接近90%。實(shí)驗(yàn)結(jié)果表明,氮化硅膜作為掩模濕蝕刻技術(shù)制備黑硅是可行的,比飛秒激光、RIE
2022-03-29 16:02:59 819
819 
本文研究了通過光敏抗蝕劑的濕蝕刻劑滲透。后者能夠非常快速地響應(yīng)選擇濕蝕刻劑/聚合物的兼容性,以保護(hù)下面的膜不被降解。如今,大多數(shù)材料圖案化是用等離子蝕刻而不是濕法蝕刻來進(jìn)行的。事實(shí)上,與通常
2022-04-06 13:29:19 666
666 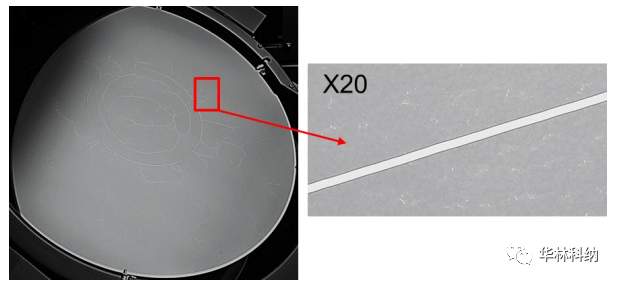
,并添加化學(xué)物質(zhì)來調(diào)整粘度和單晶圓旋轉(zhuǎn)加工的表面潤濕性。 當(dāng)硅被蝕刻并并入蝕刻溶液時,蝕刻速率將隨時間而降低。 這種變化已經(jīng)建模。 這些模型可以延長時間,補(bǔ)充化學(xué)物質(zhì),或者兩者兼而有之。
2022-04-07 14:46:33 751
751 
本研究的目的是開發(fā)和應(yīng)用一個數(shù)值模型來幫助設(shè)計和操作CDE工具,為此,我們編制了第一個已知的NF3/02氣體的等離子體動力學(xué)模型,通過與實(shí)驗(yàn)蝕刻速率數(shù)據(jù)的比較,實(shí)現(xiàn)了模型驗(yàn)證。此外,該模型通過改變
2022-04-08 16:44:54 894
894 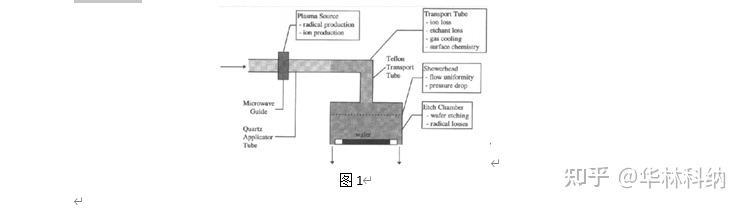
本文研究了通過光敏抗蝕劑的濕蝕刻劑滲透。后者能夠非常快速地響應(yīng)選擇濕蝕刻劑/聚合物的兼容性,以保護(hù)下面的膜不被降解。如今,大多數(shù)材料圖案化是用等離子蝕刻而不是濕法蝕刻來進(jìn)行的。事實(shí)上,與通常
2022-04-22 14:04:19 591
591 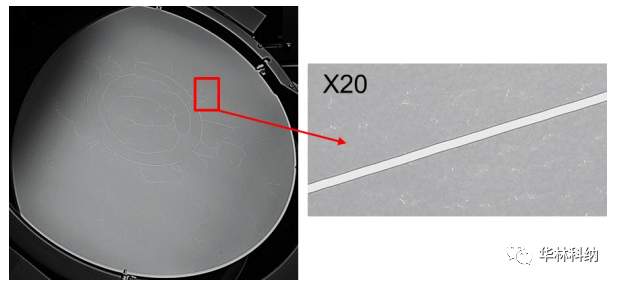
本文提出了一種將垂直氮化鎵鰭式場效應(yīng)晶體管中的鰭式溝道設(shè)計成直而光滑的溝道側(cè)壁的新技術(shù)。因此,詳細(xì)描述了在TMAH溶液中的氮化鎵濕法蝕刻;我們發(fā)現(xiàn)m-GaN平面比包括a-GaN平面在內(nèi)的其他取向
2022-05-05 16:38:03 1394
1394 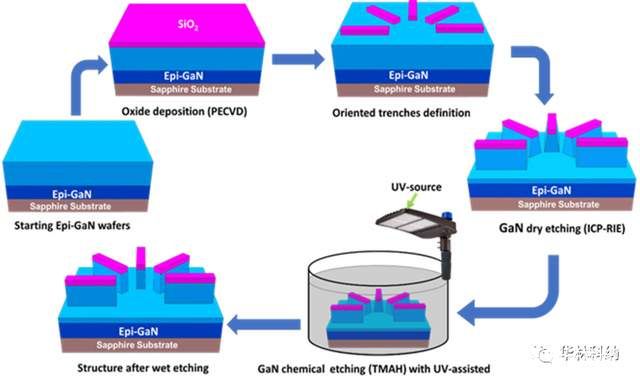
在使用低溫卡盤的低壓高密度等離子體反應(yīng)器中研究了硅結(jié)構(gòu)的深且窄的各向異性蝕刻。我們華林科納以前已經(jīng)證明了這種技術(shù)在這種結(jié)構(gòu)上的可行性。已經(jīng)研究了蝕刻速率和輪廓的改進(jìn),并且新的結(jié)果顯示
2022-05-11 15:46:19 730
730 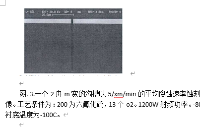
我們華林科納研究探索了一種新的濕法腐蝕方法和減薄厚度在100 μm以下玻璃的解決方案,為了用低氫氟酸制備蝕刻溶液,使用NH4F或nh4hf 2作為主要成分并加入硫酸或硝酸是有效的,研究了混合酸溶液
2022-05-20 16:20:24 3162
3162 本文講述了我們華林科納研究了M111N蝕刻速率最小值的高度,以及決定它的蝕刻機(jī)制,在涉及掩模的情況下,M111N最小值的高度可以受到硅/掩模結(jié)處的成核的影響,以這種方式影響蝕刻或生長速率的結(jié)可以
2022-05-20 17:12:59 853
853 
通常在蝕刻過程之后通過將總厚度變化除以蝕刻時間或者通過對不同的蝕刻時間進(jìn)行幾次厚度測量并使用斜率的“最佳擬合”來測量,當(dāng)懷疑蝕刻速率可能不隨時間呈線性或蝕刻開始可能有延遲時,這樣做有時可以實(shí)時測量蝕刻速率。
2022-05-27 15:12:13 3473
3473 本文介紹了我們華林科納采用混合酸溶液(H3PO4 : H2SO4 = 1 : 3)和熔融KOH作為濕法腐蝕介質(zhì),鹽酸作為陽極腐蝕介質(zhì),用掃描電鏡和透射電鏡分別觀察了蝕坑和T-Ds。
2022-05-27 16:56:03 537
537 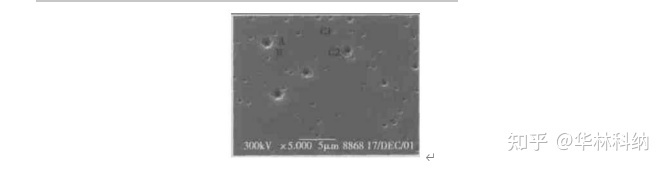
已全部加載完成

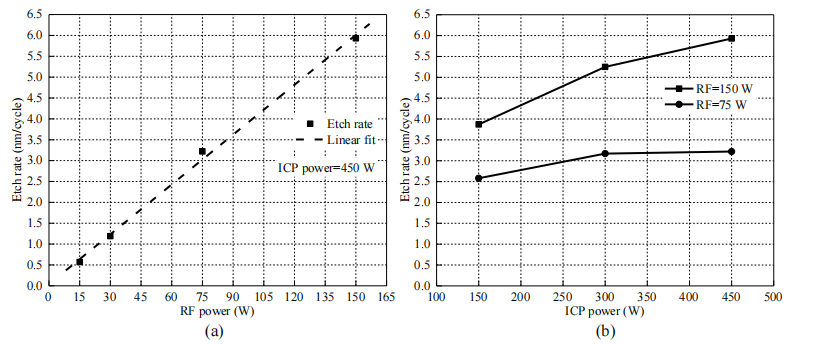
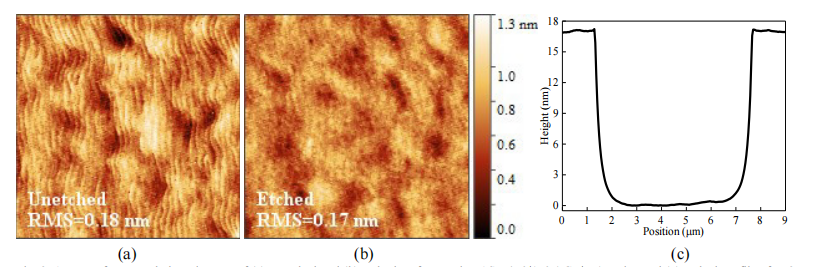
 電子發(fā)燒友App
電子發(fā)燒友App









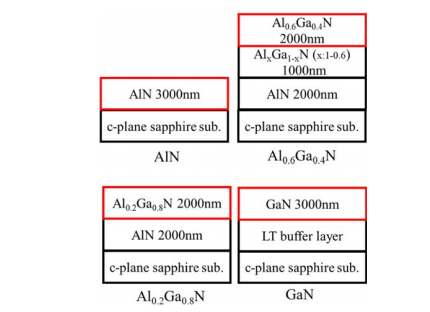




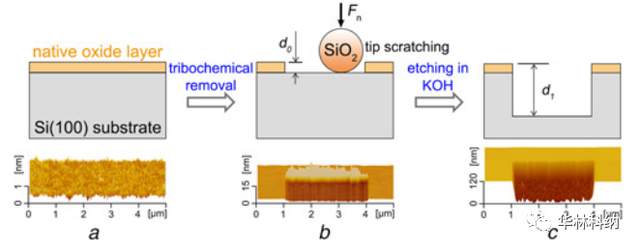

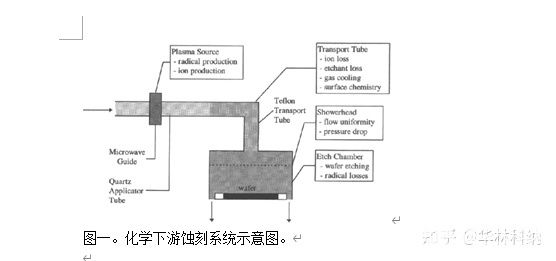


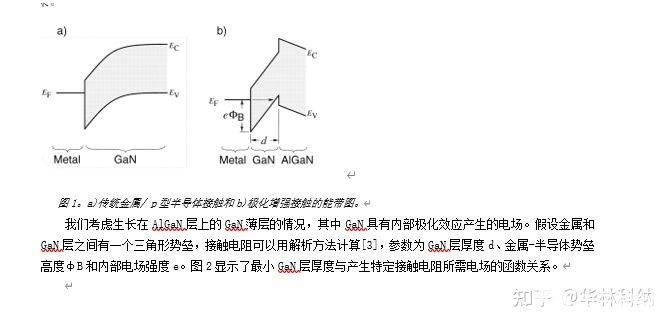

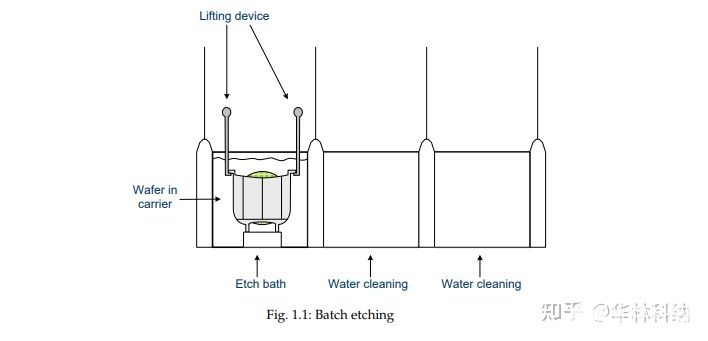

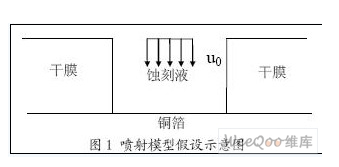
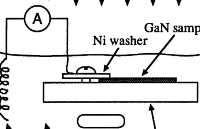
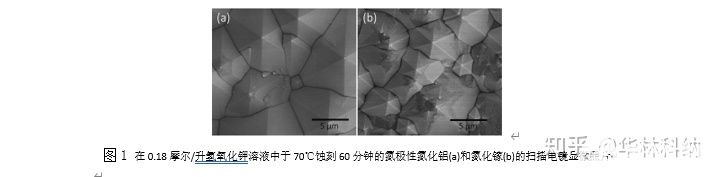
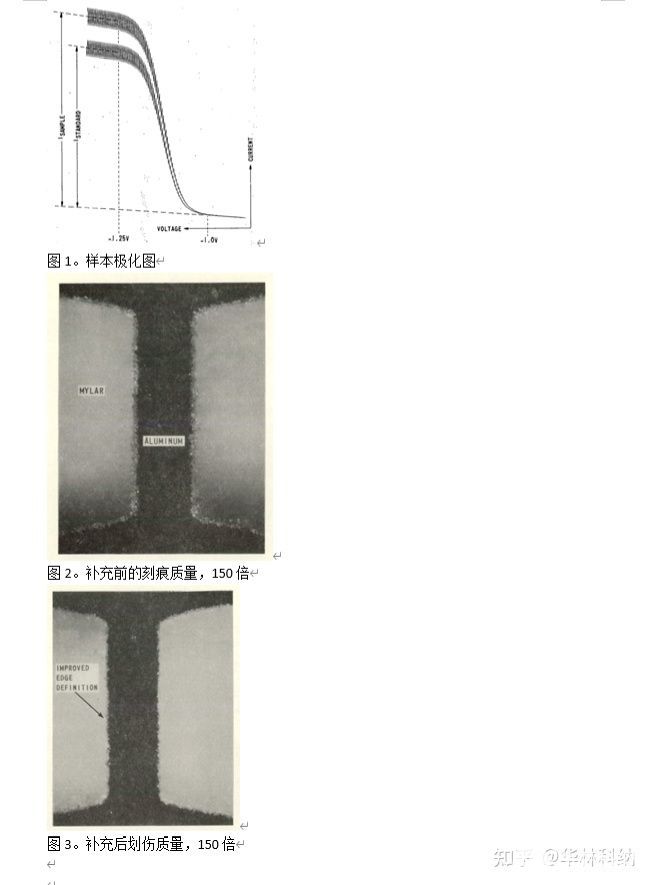


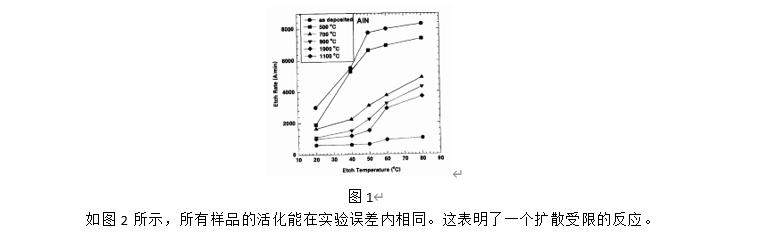

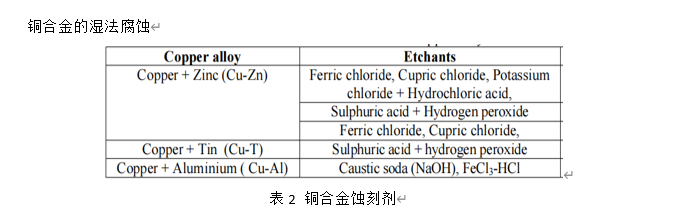
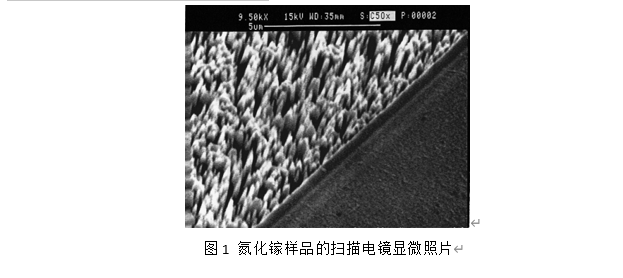
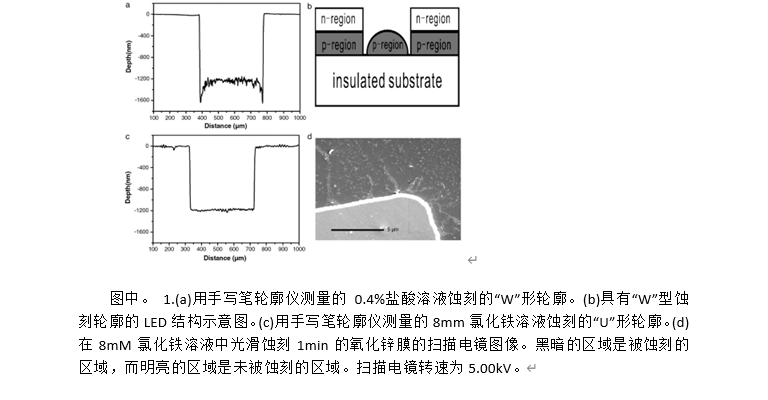
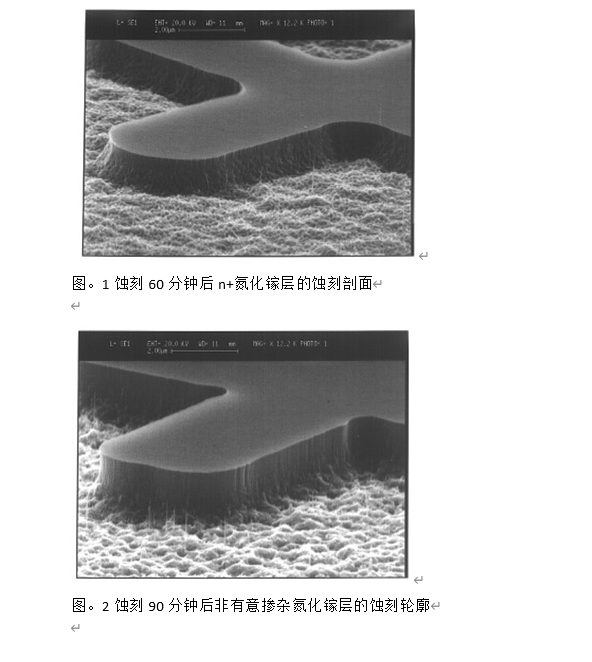




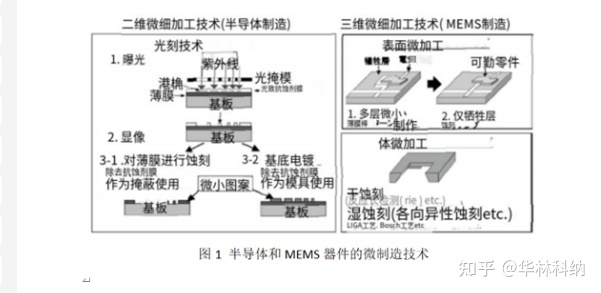
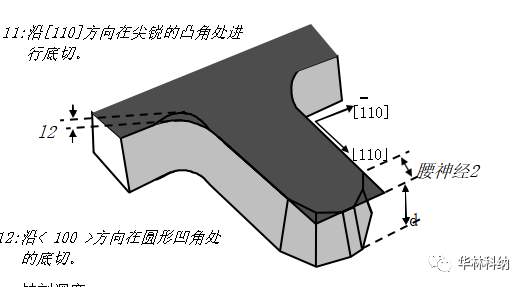
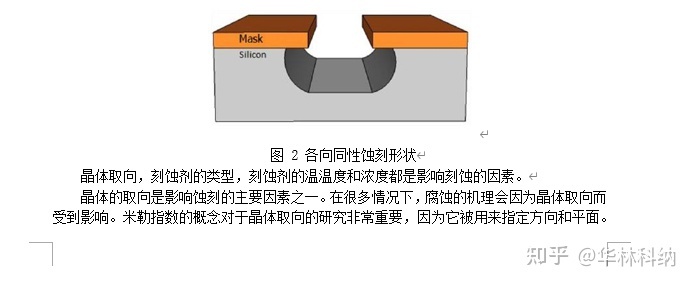

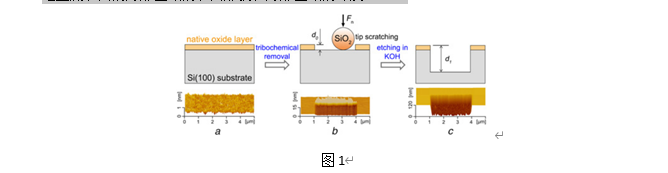

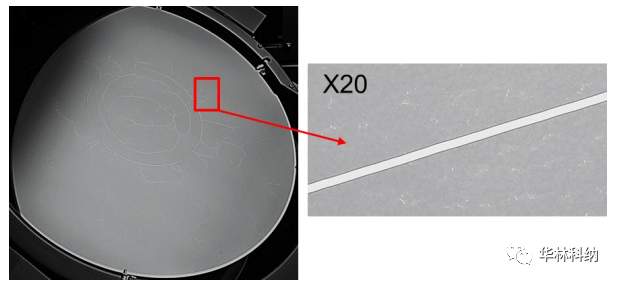

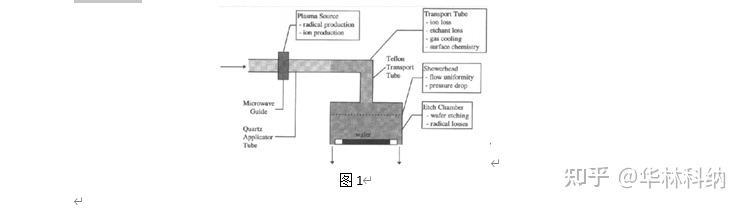
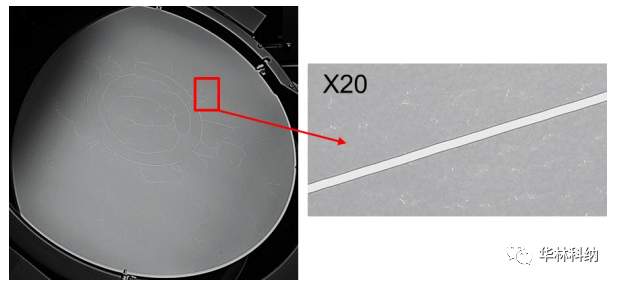
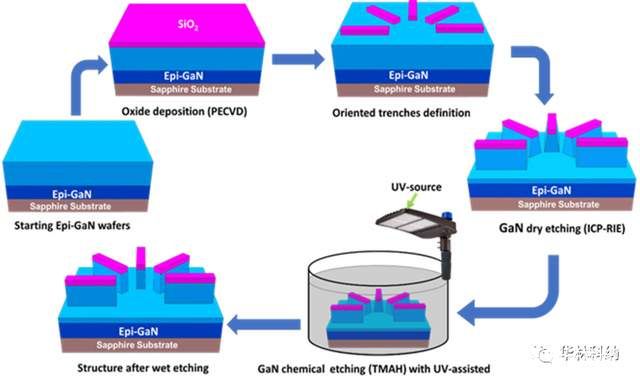
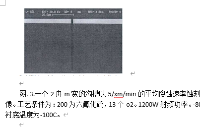

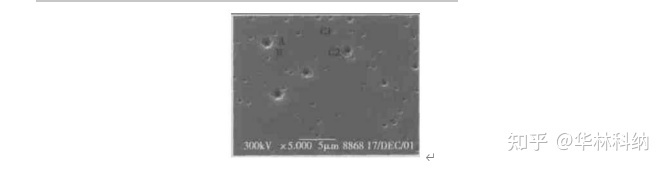
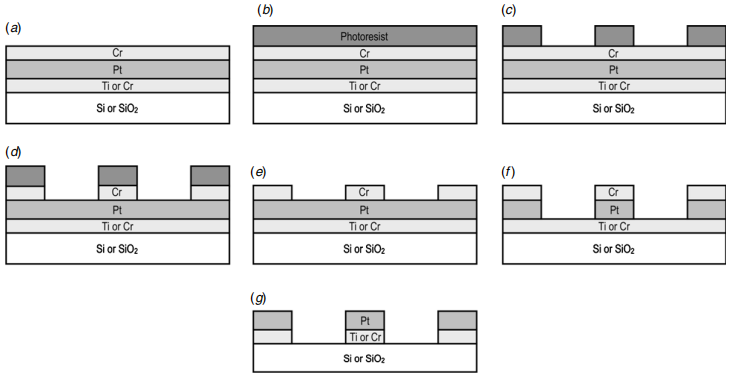


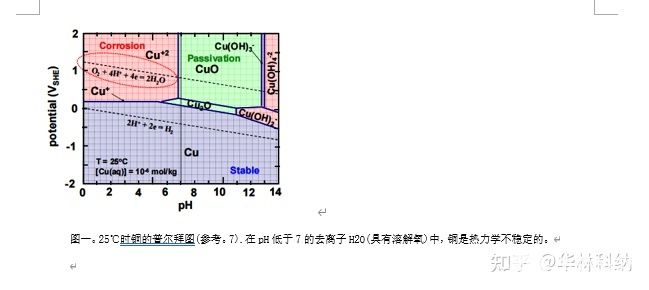



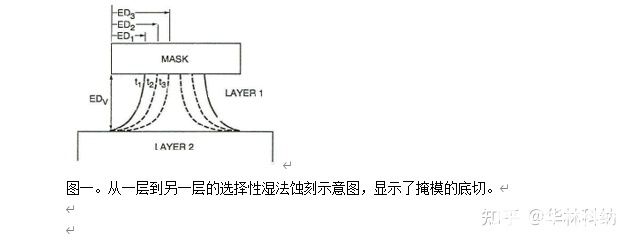






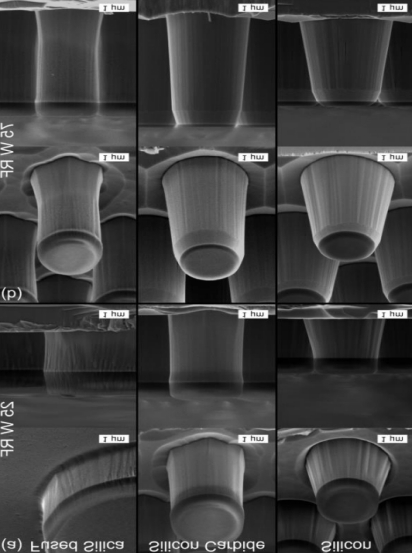

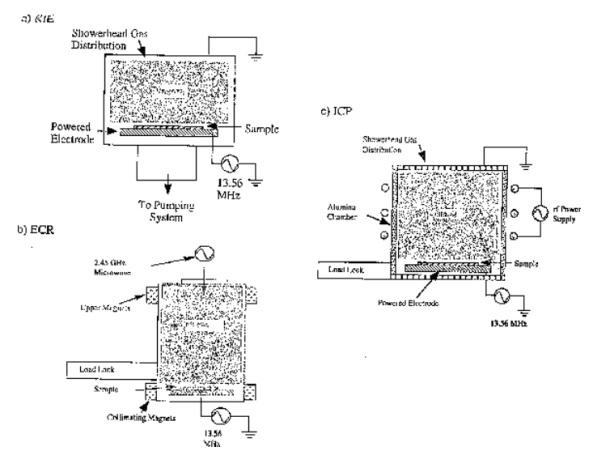
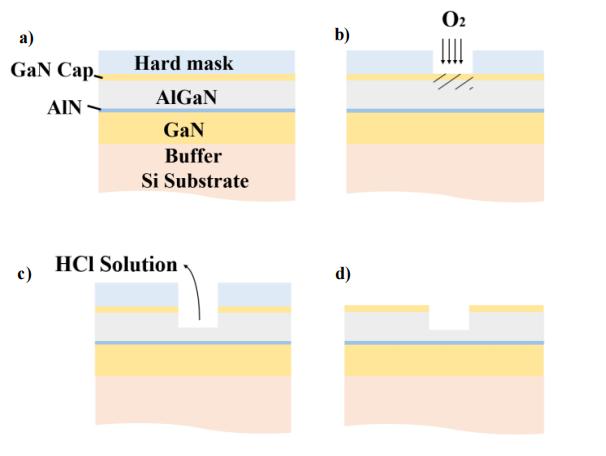
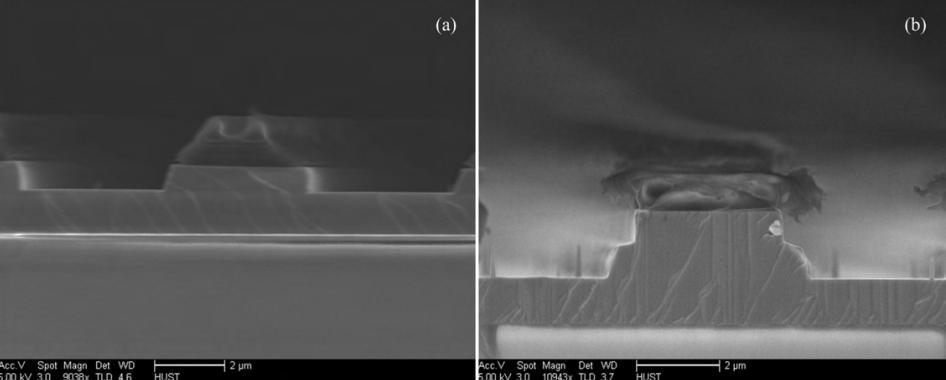
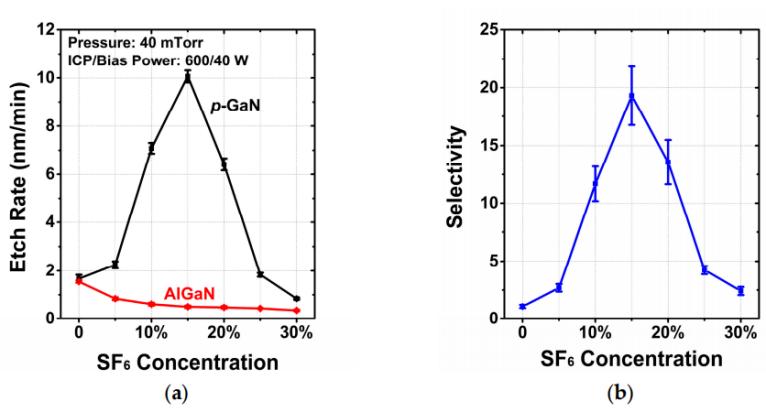
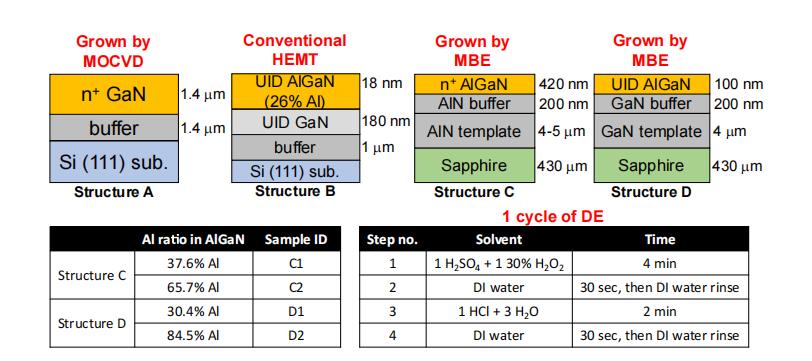
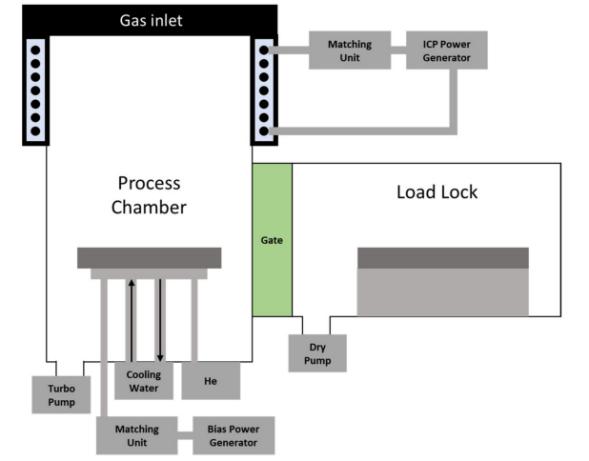










評論