系統級封裝SiP在PCB硬板上同樣具有獨特的優勢。當系統級封裝SiP把信號整合在硬板上后,硬板上所需要的節點只剩下8個,即只需在這8個節點焊上各自所需功能的線即可完成耳機組裝,使耳機成品集結更多的功能、更多不同的外形,讓消費者有更多的選擇方案。
2022-08-09 15:27:14 1494
1494 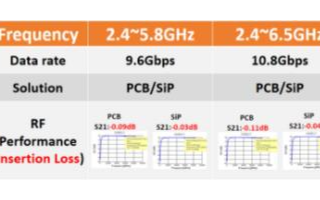
無論是采用Fan-in還是Fan-out,WLP晶圓級封裝和PCB的連接都是采用倒裝芯片形式,芯片有源面朝下對著印刷電路板,可以實現最短的電路徑,這也保證了更高的速度和更少的寄生效應。
2023-05-24 10:15:58 1532
1532 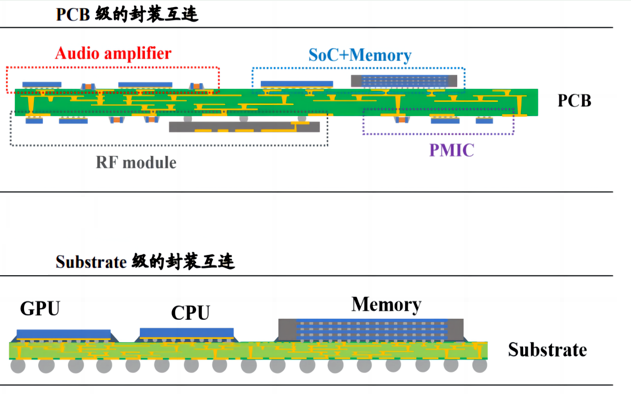
由于汽車應用中引入越來越多的特殊或安全功能,根據市場對于引入的新封裝或不同封裝的尺寸要求而頻繁地重新設計是十分困難的。對于上述諸多限制和要求,“采用緊湊式 SIP 的 QFN 封裝”可解決所有問題。
2013-09-17 12:07:53 5772
5772 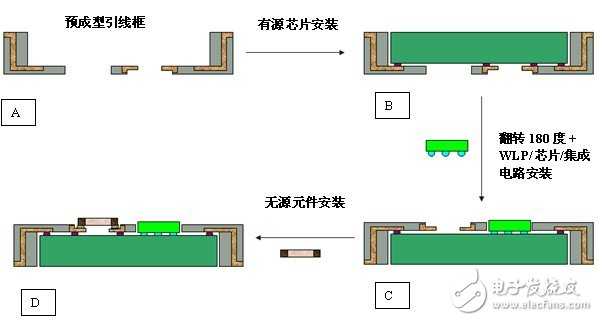
隨著物聯網時代來臨,全球終端電子產品漸漸走向多功能整合及低功耗設計,因而使得可將多顆裸晶整合在單一封裝中的SiP技術日益受到關注。除了既有的封測大廠積極擴大SiP制造產能外,晶圓代工業者與IC基板廠也競相投入此一技術,以滿足市場需求。
2016-06-16 10:14:08 2735
2735 集成到 SIP 中。從封裝發展的角度來看,因電子產品在體積、處理速度或電性特性各方面的需求考量下, SOC 曾經被確立為未來電子產品設計的關鍵與發展方向。但隨著近年來 SOC生產成本越來越高,頻頻遭遇技術障礙,造成 SOC 的發展面臨瓶頸,進而使 SIP 的發展越來越被業界重視。
2016-10-29 14:40:36 21354
21354 SiP的關注點在于:系統在封裝內的實現,所以系統是其重點關注的對象,和SiP系統級封裝對應的為單芯片封裝;先進封裝的關注點在于:封裝技術和工藝的先進性,所以先進性的是其重點關注的對象,和先進封裝對應的是傳統封裝。
2021-03-15 10:31:53 8490
8490 
常見的Fan-In(WLCSP)通常可以分為BOP(Bump On Pad)和RDL(Redistribution Layer)。BOP封裝結構簡單,Bump直接生長在Al pad上;如果Bump位置遠離Al pad,則需要通過RDL將Al pad與Bump相連。
2022-07-25 17:23:52 17387
17387 在IC封裝領域,是一種先進的封裝,其內涵豐富,優點突出,已有若干重要突破,架構上將芯片平面放置改為堆疊式封裝,使密度增加,性能大大提高,代表著鳳凰技術的發展趨勢,在多方面存在極大的優勢特性,體現在以下幾個方面。
2022-10-18 09:46:44 4823
4823 隨著電子信息技術的發展和社會的需求,電子產品迭代更新速度加快,逐漸向小型化、輕量化、高性能、多功能和低成本方向發展,而系統級封裝(SIP)因為具備設計靈活、短周期、兼容性好、低成本等特點開始脫穎而出,成為工程師必須優先了解的一種理想封裝技術。那么系統級封裝(SIP)是什么?有什么用?
2023-03-16 14:47:53 2893
2893 介紹了晶圓級封裝的基本流程。本篇文章將側重介紹不同晶圓級封裝方法所涉及的各項工藝。晶圓級封裝可分為扇入型晶圓級芯片封裝(Fan-In WLCSP)、扇出型晶圓級芯片封裝(Fan-Out WLCSP
2023-11-08 09:20:19 2758
2758 
在上篇文章中介紹了扇入型晶圓級芯片封裝(Fan-In WLCSP)、扇出型晶圓級芯片封裝(Fan-Out WLCSP)、重新分配層(RDL)封裝、倒片(Flip Chip)封裝,這篇文章著重介紹硅通孔(TSV)封裝工藝。
2023-11-08 10:05:53 1828
1828 
SiP(System in Package)技術是一種先進的封裝技術,SiP技術允許將多個集成電路(IC)或者電子組件集成到一個單一的封裝中。這種SiP封裝技術可以實現不同功能組件的物理集成,而這些組件可能是用不同的制造工藝制造的。
2024-02-19 15:22:19 334
334 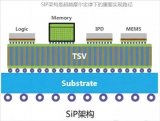
因為一些原因沒能參加2021 SIP封裝大會 , 有沒有大神能分享一下會議的具體資料 郵箱672463413@qq.com 在此跪謝
2021-10-25 12:10:26
的發展,對智能終端(如5G手機、可穿戴產品等)的智能化、便攜化、續航能力提出挑戰,需通過系統級封裝(SIP)來實現,集成遠算AI/傳感器等(更智能),芯片體積更小,給電池更大空間,宜特實驗室可滿足5G封裝測試的需求。`
2020-04-02 16:21:51
SIP封裝是基于SOC的一種新封裝技術,將一個或多個裸芯片及可能的無源元件構成的高性能模塊裝載在一個封裝外殼內, 包括將這些芯片層疊在一起,且具備一個系統的功能。
2019-10-08 14:29:11
本帖最后由 doris_ 于 2021-4-21 10:05 編輯
SIP技術封裝外形圖的位置度是如何制定的。
2020-12-16 11:45:12
地封裝在一起(例如CMOS的數字IC,和GaAsHBT射頻IC等)。從市場需求角度來看,以下因素在推動著SiP迅猛發展。它們是:●產品尺寸的小型化。將眾多IC芯片和零部件一同封裝在一個封裝內可以顯著地縮小
2018-08-23 09:26:06
)和多芯片模塊(MCM)不是SiP,但不同的供應商認為這可以是SiP。這對分析和預測SiP市場增加了挑戰。許多MCPs諸如堆疊芯片封裝(CSP)之類的器件組合,這種封裝產品會將閃存和RAM通過多個芯片
2020-08-06 07:37:50
LED封裝市場六大發展趨勢值得關注。 一、中國LED制造商加速發展,國內使用率持續上升 據LEDinside分析,2016年中國LED封裝市場上,國內產品使用率達到67%。日亞化學仍是中國LED封裝
2017-10-09 12:01:25
了AP+mobileDDR,某種程度上說SIP=SoC+DDR,隨著將來集成度越來越高,emmc也很有可能會集成到SiP中。從封裝發展的角度來看,因電子產品在體積、處理速度或電性特性各方面的需求考量下,SoC
2017-09-18 11:34:51
都將按照自身的規律不斷發展下去。封裝中系統(SiP)是近年來半導體封裝的重要趨勢,代表著未來的發展方向。封裝中系統在一個封裝中集成多個形式各異、相對獨立義緊密相連的模塊以實現完整強大的功能,具有較短
2018-11-23 17:03:35
SiP的途徑有助于在一個分歧的市場上加速支持多種需求。以同時,它還有助于設計人員將多種功能封裝于小至5.4 x 6.2 mm的設備(以聯發科的組件為例)中。 “整合式傳感器是一個值得觀察的發展趨勢,其
2016-08-09 17:19:41
、集成電路、片上系統 (SOC),發展到更為復雜的系統級封裝電路(SIP)。SIP使用微組裝和互連技術,能夠把各種集成電路如CMOS電路、GaAs電路、SiGe電路或者光電子器件、MEMS器件以及各類無源元件
2019-07-29 06:16:56
長時間以來,多芯片封裝(MCP)滿足了在越來越小的空間里加入更多性能和特性的需求。很自然地就會希望存儲器的MCP能夠擴展到包含如基帶或多媒體處理器等ASIC。但這實現起來會遇到困難,即高昂的開發
2018-08-27 15:45:50
據麥姆斯咨詢介紹,芯片及系統外形尺寸的發展趨勢是越做越小,嵌入式芯片封裝因此找到了新的需求。根據Yole的報告,日月光(ASE)、奧特斯(AT&S)、通用電氣(GE)、神鋼電機(Shinko
2019-02-27 10:15:25
如何往AD集成庫增加PCB封裝?
2019-09-16 10:28:13
以來迅速發展的新型微電子封裝技術,包括焊球陣列封裝(BGA)、芯片尺寸封裝(CSP)、圓片級封裝(WLP)、三維封裝(3D)和系統封裝(SIP)等項技術。介紹它們的發展狀況和技術特點。同時,敘述了
2018-09-12 15:15:28
先進封裝發展背景晶圓級三維封裝技術發展
2020-12-28 07:15:50
大家好!求SIP封裝廠家,謝謝!
2015-11-08 22:33:09
更高的水平,以滿足市場上多樣化、個性化的封裝需求。還要能夠把握未來的需求趨勢,在機械的生產制造上為企業的發展注入新鮮血液。 最后就是灌膠機行業要避免重復建設,要將資本投入到新技術、新產品的研發上。由于
2018-05-14 14:30:44
,20世紀最后二十年,隨著微電子、光電子工業的巨變,為封裝技術的發展創造了許多機遇和挑戰,各種先進的封裝技術不斷涌現,如BGA、CSP、FCIP、WLP、MCM、SIP等,市場份額不斷增加,2000年已達
2018-08-23 12:47:17
。放眼未來,越來越多的應用都將需要高電壓/高功率/高速器件,其將充分滿足工業及樓宇自動化、能源生成與配送以及汽車等市場領域的需求。封裝技術中的多芯片模塊/系統將增強這些應用的封裝與系統級集成。能源效率
2018-09-14 14:40:23
,工業產品,甚至消費類產品,尤其是便攜式也同樣要求微小型化。這一趨勢反過來又進一步促進微電子技術的微小型化。這就是近年來系統級封裝(SiP,System in Package)之所以取得了迅速發展的背景
2018-08-23 07:38:29
以來迅速發展的新型微電子封裝技術,包括焊球陣列封裝(BGA)、芯片尺寸封裝(CSP)、圓片級封裝(WLP)、三維封裝(3D)和系統封裝(SIP)等項技術。介紹它們的發展狀況和技術特點。同時,敘述了微電子
2023-12-11 01:02:56
封裝大致經過了如下發展進程: 結構方面:DIP封裝(70年代)->SMT工藝(80年代 LCCC/PLCC/SOP/QFP)->BGA封裝(90年代)->面向未來的工藝(CSP
2012-05-25 11:36:46
基板“供需不均”的現狀短時間之內不會改變。陶瓷封裝基板將會是一種更可行的選擇。是今后電子封裝材料可持續發展的重要方向。`
2021-03-31 14:16:49
蘋果在近日的發布會上提到了其芯片使用了SIP封裝,但你了解是什么SIP封裝嗎?
2019-08-01 06:32:13
大家有沒有關于SIP封裝設計的相關資料
2018-08-24 11:48:41
整個電子元件和系統正式運作時的熱量也會增加,陶瓷封裝基板作為具有高熱導率同時具備良好綜合性能的新型綠色封裝,已經成為今后電子封裝材料可持續發展的重要方向。斯利通將配合客戶需求,迎合市場導向,提供更加優秀的商品和更貼心的服務。
2021-01-20 11:11:20
論文綜述了自 1990 年以來迅速發展的先進封裝技術,包括球柵陣列封裝(BGA)、芯片尺寸封裝(CSP)、圓片級封裝(WLP)、三維封裝(3D)和系統封裝(SiP)等項新技術;同時,敘述了我國封
2009-12-14 11:14:49 28
28 系統級封裝(SiP)集成技術的發展與挑戰:摘要:系統級封裝集成技術是實現電子產品小型化和多功能化的重要手段。國際半導體技術發展路線已經將SiP 列為未來的重要發展方向。本文
2009-12-21 09:30:30 24
24 本文介紹了用于SiP器件制造的一組材料,該組材料在經過260℃回流后性能仍可達到JEDEC3級標準的規定。關鍵詞:系統級封裝SiP,芯片,模擬半導體目前系統級封裝(SiP)似乎在
2010-02-05 22:29:26 24
24
TO/SIP 封裝
2006-04-01 16:03:46 1263
1263 單列直插式封裝(SIP)原理
單列直插式封裝(SIP),引腳從封裝一個側面引出,排列成一條直線。通常,它們是通孔式的,管腳
2009-11-19 09:13:07 1263
1263 單列直插式封裝(SIP)是什么意思
單列直插式封裝(SIP),引腳從封裝一個側面引出,排列成一條直線。通常,它們是通孔式的,管腳
2010-03-04 15:25:31 5212
5212 SIP(封裝系統),SIP(封裝系統)是什么意思封裝概述 半導體器件有許多封裝型式,從DIP、SOP、QPF、PGA、BGA到CSP再到SIP,技術指標一代比一代先進,這些都是前
2010-03-26 17:04:25 19237
19237 目前全世界封裝的產值只占集成電路總值的10%,而SIP的出現很可能將打破目前集成電路的產業格局,改變封裝僅僅是一個后續加工廠的狀況。未來集成電路產業中也許會出現一批結合設計能力與封裝工藝的實體,掌握有自己品牌的產品和利潤。當SIP技術被封裝企業掌握后,封裝業的產值可能會出現一定幅度的提高。
2018-07-20 11:45:00 64585
64585 隨著物聯網時代來臨,全球終端電子產品漸漸走向多功能整合及低功耗設計,因而使得可將多顆裸晶整合在單一封裝中的SIP技術日益受到關注。除了既有的封測大廠積極擴大SIP制造產能外,晶圓代工業者與IC基板廠也競相投入此一技術,以滿足市場需求。
2018-03-14 13:35:00 34426
34426 
請哪位兄臺講一下sip封裝測試環境及方法?謝謝!
2018-05-21 21:51:32 261
261 關于先進封裝工藝的話題從未間斷,隨著移動電子產品趨向輕巧、多功能、低功耗發展,高階封裝技術也開始朝著兩大板塊演進,一個是以晶圓級芯片封裝WLCSP(Fan-In WLP、Fan-out WLP
2018-07-12 14:34:00 18590
18590 從蘋果iPhone7的拆解來看,iPhone7采用了SiP、WLCSP等先進封裝,如安華高的PA采用了SiP封裝,Skyworks的PA也是SiP封裝。在產品小型化推動下,SiP封裝技術滲透率加速
2019-10-24 14:36:21 7556
7556 各種電子系統的封裝密度不斷提高、功能日趨多樣化,目前現有單一材料的性能已不能滿足需求。未來電子封裝材料將會朝著多相復合化的方向持續發展。 (1)具有系列化性能的材料體系的研究 SIP會在一個封裝單元
2020-05-21 14:52:12 1478
1478 ,在IC芯片領域,SOC系統級芯片是最高級的芯片;在IC封裝領域,SIP系統級封裝是最高級的封裝。SIP涵蓋SOC,SOC簡化SIPSOC,與SIP是極為相似的,兩者均希望將一個包含邏輯組件、內存組件,甚至包含被動組件的系統,整合在一個單位中。然而就發展的方向來說,兩者卻是大大的不同:
2020-05-28 14:56:18 2557
2557 SIP是System in Package (系統級封裝、系統構裝)的簡稱,這是基于SoC所發展出來的種封裝技術,根據Amkor對SiP定義為“在一IC包裝體中,包含多個芯片或一芯片,加上被動組件
2020-07-30 18:53:00 14
14 如果說封測廠商在Fan-out技術方面正面對著來自制造端壓力,SiP技術則為封測廠商帶來了一份大禮。SiP封裝工藝不僅僅是將多功能芯片整合于一體,還將組裝模塊的體積大幅地縮小,甚至可以跳過PCB
2020-08-12 11:10:56 1621
1621 Chiplet SiP的 2.5D/3D封裝,以及晶圓級封裝,并且利用晶圓級技術在射頻特性上的優勢推進扇出型(Fan-Out)封裝。此外,我們也在開發部分應用于汽車電子和大數據存儲等發展較快的熱門封裝類型。”包旭升指出。
2020-09-17 17:43:20 9167
9167 如果說封測廠商在Fan-out技術方面正面對著來自制造端壓力,SiP技術則為封測廠商帶來了一份大禮。SiP封裝工藝不僅僅是將多功能芯片整合于一體,還將組裝模塊的體積大幅地縮小,甚至可以跳過PCB
2020-09-26 11:01:42 1066
1066 一、技術發展方向 半導體產品在由二維向三維發展,從技術發展方向半導體產品出現了系統級封裝(SiP)等新的封裝方式,從技術實現方法出現了倒裝(FlipChip),凸塊(Bumping),晶圓級封裝
2020-10-21 11:03:11 28156
28156 
日月光研發中心副總經理洪志斌博士在ICEP 2021線上研討會上全面解析系統級封裝SiP如何推動新系統集成,特別是嵌入式封裝(Embedded)、倒裝芯片封裝(Flip Chip)以及扇出型封裝
2021-05-20 16:27:20 2513
2513 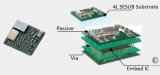
應對系統級封裝SiP高速發展期,環旭電子先進制程研發中心暨微小化模塊事業處副總經理趙健先生在系統級封裝大會SiP Conference 2021上海站上,分享系統級封裝SiP技術優勢、核心競爭力
2021-05-31 10:17:35 2851
2851 。 電源隔離模塊發展至今,其性能越來越強大,集成度越來越高。從傳統的SIP封裝、DIP封裝到采用SiP工藝的DFN封裝,封裝形式的多樣化,讓生產效率也變得更高。 本文將為好奇的小伙伴講解SIP封裝和采用SiP工藝的DFN封裝到底是什么?這兩個“sip”又有什么區別? 傳統SIP封裝
2021-09-22 15:12:53 7172
7172 系統級封裝SiP、扇出型封裝Fan Out以及2.5D/3D IC封裝等先進封裝不僅可以最大化封裝結構I/O及芯片I/O,同時使芯片尺寸最小化,實現終端產品降低功耗并達到輕薄短小的目標。
2022-03-23 10:09:08 5483
5483 本文分別從芯片設計技術和芯片封裝技術的維度,針對解決電子產品對芯片小型化、性能優、功能 強的要求,對 SOC 片上系統及 HIC、MCM、SIP 封裝技術的特點進行分析,并給出其相互關系,最終
2022-05-05 11:26:18 5
5 工藝成熟、操作簡單,雖然市場需求呈緩慢下降的趨勢,但今后仍有巨大的市場空間;(2)表面貼裝時代,兩邊或四邊引線封裝技術,如SOP、PLCC、QFP、QFN、DFN 等,此類封裝已發展成熟,由于其引腳密度
2022-05-09 11:17:25 5081
5081 SiP系統級封裝設計仿真技術資料分享
2022-08-29 10:49:50 15
15 系統級封裝 (SiP) 正迅速成為越來越多應用和市場的首選封裝選項,引發了圍繞新材料、方法和工藝的狂熱活動。
2022-10-28 16:16:26 742
742 高性能、高集成及微型化需求推動系統級封裝SiP不斷發展。從最初最簡單的SiP,經過不斷研發,整合天線,并逐步與扇出型封裝Fan Out及系統級封裝SiP整合,提供更高的集成能力與更強的性能。
2022-11-24 10:32:36 1282
1282 SiP封裝是將不同功能的裸芯片,包括CPU、GPU、存儲器等集成在一個封裝體內,從而實現一整個芯片系統。
2023-02-10 11:39:41 1761
1761 SiP系統級封裝產品按工藝或材料通常分為:塑料封裝SiP、陶瓷封裝SiP和金屬封裝SiP幾種類型和各自的特點。其中陶瓷封裝SiP也簡稱為陶封SiP,美國航空航天局NASA,歐洲太空局ESA采用
2023-02-10 16:50:57 2812
2812 SiP是一個非常寬泛的概念,廣義上看,它囊括了幾乎所有多芯片封裝技術,但就最先進SiP封裝技術而言,主要包括 2.5D/3D Fan-out(扇出)、Embedded、2.5D/3D Integration,以及異構Chiplet封裝技術。
2023-03-20 09:51:54 1037
1037 
系統級封裝 (SiP) 是一種用于將多個集成電路 (IC) 和無源元件捆綁到一個封裝中的方法,它們在該封裝下協同工作。這與片上系統 (SoC) 形成對比,而這些芯片上的功能集成到同一芯片中。
2023-03-27 11:46:45 649
649 SiP封裝是指將多個不同芯片集成在同一個封裝體內,形成一個器件系統,以實現多功能、小尺寸、高性能、低成本的目標。由于使用倒裝等不同的互連工藝,它可以分為FC-SiP和FC/WB-SiP等;含有芯片垂直方向堆疊的SiP稱為3D SiP。
2023-04-13 11:28:23 976
976 SIP(Single-Inline-Package),指的是單列直插封裝, 其典型特征是引腳從封裝體一側引出,排列成一條直線,目前常見的SIP封裝外形有SIP8、SIP9和SIP10,數字表示引腳
2023-05-19 09:50:25 1148
1148 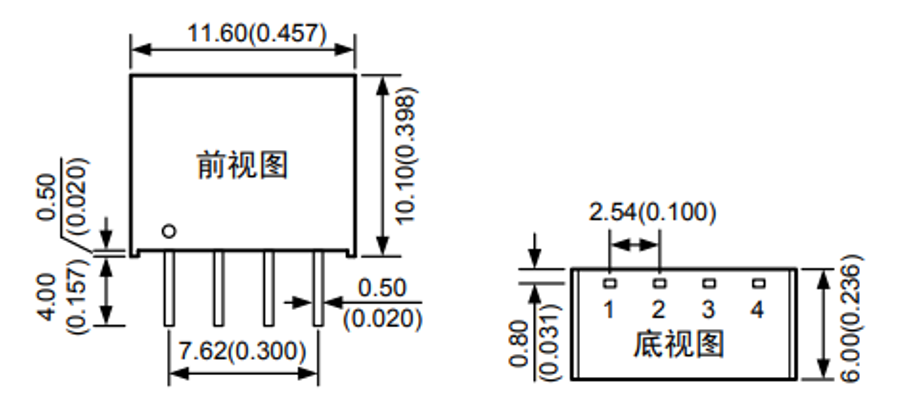
SiP系統級封裝(System in Package),先進封裝HDAP(High Density Advanced Package),兩者都是當今芯片封裝技術的熱點,受到整個半導體產業鏈的高度關注
2023-05-19 09:54:26 1326
1326 
系統級封裝 (SiP) 是一種用于將多個集成電路 (IC) 和無源元件捆綁到一個封裝中的方法,它們在該封裝下協同工作。這與片上系統 (SoC) 形成對比,而這些芯片上的功能集成到同一芯片
2023-05-19 10:23:40 2546
2546 
SiP封裝(System In Package系統級封裝)是將多種功能芯片,包括處理器、存儲器等功能芯片集成在一個封裝內,從而實現一個基本完整的功能,與SOC(System On Chip系統級芯片
2023-05-19 10:28:06 3144
3144 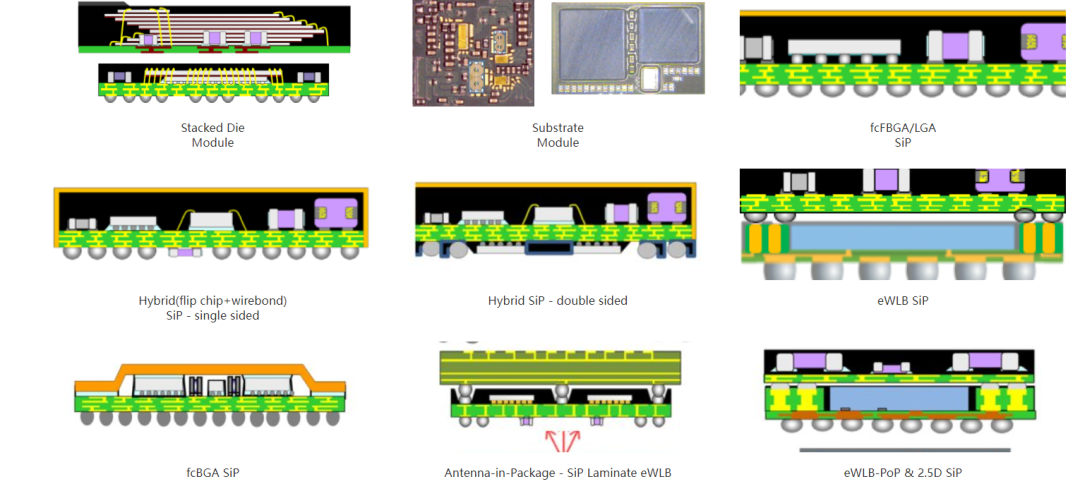
入無源元件(此時封裝形式多為QFP、SOP等),再到單個封裝體中加入多個芯片。疊層芯片以及無源器件,最后發展到一個封裝構成一個系統(此時的封裝形式多為BGA、CSP)。SIP是MCP進一步發展的產物
2023-05-19 10:31:05 829
829 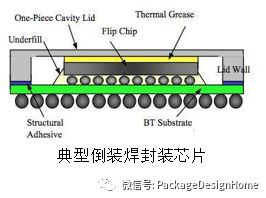
入無源元件(此時封裝形式多為QFP、SOP等),再到單個封裝體中加入多個芯片。疊層芯片以及無源器件,最后發展到一個封裝構成一個系統(此時的封裝形式多為BGA、CSP)。SIP是MCP進一步發展的產物
2023-05-19 10:31:30 933
933 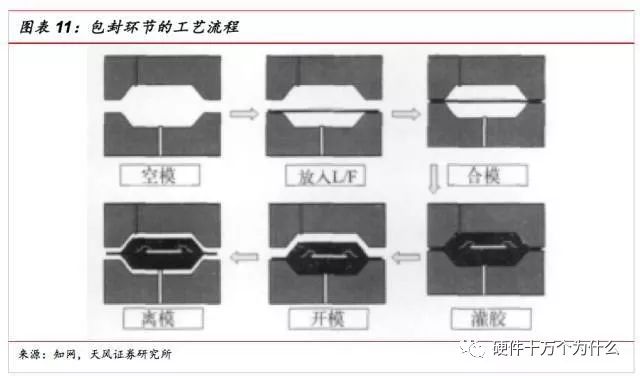
等,含有芯片垂直方向堆疊的SiP稱為3D SiP。
系統級封裝(SIP)技術從20世紀90年代初提出到現在,經過十幾年的發展,已經能被學術界和工業界廣泛接受,成為電子技術研究新熱點和技術應用的主要
2023-05-19 10:40:35 842
842 封裝測試是半導體生產流程中的重要一環,在電子產品向小型化、集成化方向發展的趨勢下,系統級封裝SIP(System In a Package系統級封裝)受到了半導體行業的青睞。燕麥科技積極布局半導體測試領域。
2023-05-19 10:48:29 1083
1083 
SiP封裝是指將多個不同芯片集成在同一個封裝體內,形成一個器件系統,以實現多功能、小尺寸、高性能、低成本的目標。由于使用倒裝等不同的互連工藝,它可以分為FC-SiP和FC/WB-SiP等;含有芯片垂直方向堆疊的SiP稱為3D SiP。
2023-05-19 11:31:16 616
616 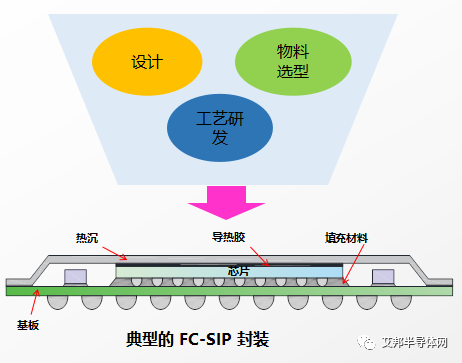
1 SiP技術的主要應用和發展趨勢 1. SiP技術的主要應用和發展趨勢
2.自主設計SiP產品介紹
3.高密度SiP封裝主要技術挑戰
4. SiP技術帶動MCP封裝工藝技術的發展
5. SiP技術促進BGA封裝技術的發展
6. SiP催生新的先進封裝技術的發展
2023-05-19 11:34:27 1207
1207 
SiP是(System In Package)的簡稱,中譯為系統級封裝。
2023-05-20 09:55:55 1811
1811 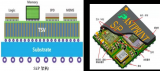
先進封裝技術以SiP、WLP、2.5D/3D為三大發展重點。先進封裝核心技術包括Bumping凸點、RDL重布線、硅中介層和TSV通孔等,依托這些技術的組合各廠商發展出了滿足多樣化需求的封裝解決方案,SiP系統級封裝、WLP晶圓級封裝、2.5D/3D封裝為三大發展重點。
2023-09-28 15:29:37 1614
1614 
SIP封裝并無一定型態,就芯片的排列方式而言,SIP可為多芯片模塊(Multi-chip Module;MCM)的平面式2D封裝,也可再利用3D封裝的結構,以有效縮減封裝面積;而其內部接合技術可以是單純的打線接合(Wire Bonding),亦可使用覆晶接合(Flip Chip)
2023-10-08 15:13:12 567
567 晶圓級封裝是指晶圓切割前的工藝。晶圓級封裝分為扇入型晶圓級芯片封裝(Fan-In WLCSP)和扇出型晶圓級芯片封裝(Fan-Out WLCSP),其特點是在整個封裝過程中,晶圓始終保持完整。
2023-10-18 09:31:05 1339
1339 
1、SiC MOSFET對器件封裝的技術需求
2、車規級功率模塊封裝的現狀
3、英飛凌最新SiC HPD G2和SSC封裝
4、未來模塊封裝發展趨勢及看法
2023-10-27 11:00:52 419
419 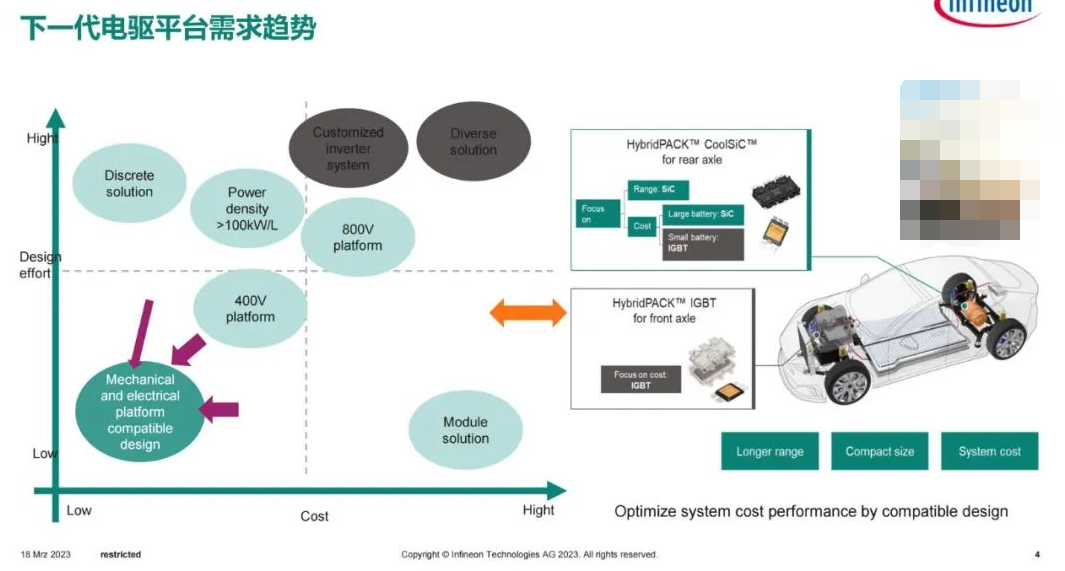
近日,臺積電在法人說明會上表示,由于人工智能(AI)芯片先進封裝需求持續強勁,目前產能無法滿足客戶的需求,供不應求的狀況可能延續到2025年。為了應對這一需求,臺積電今年將持續擴充先進封裝產能。
2024-01-22 15:59:49 332
332

 電子發燒友App
電子發燒友App









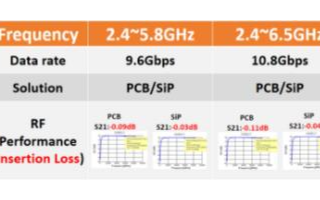
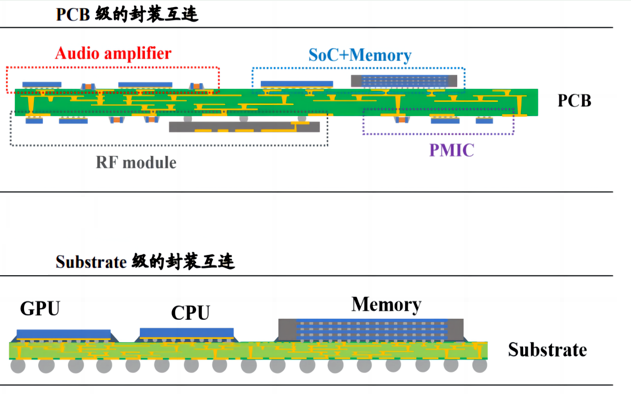
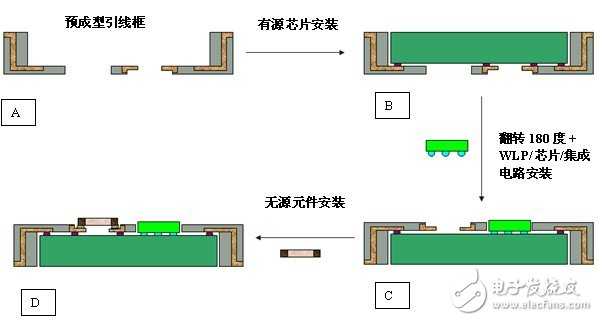



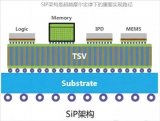


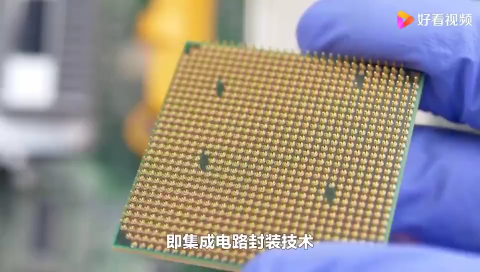
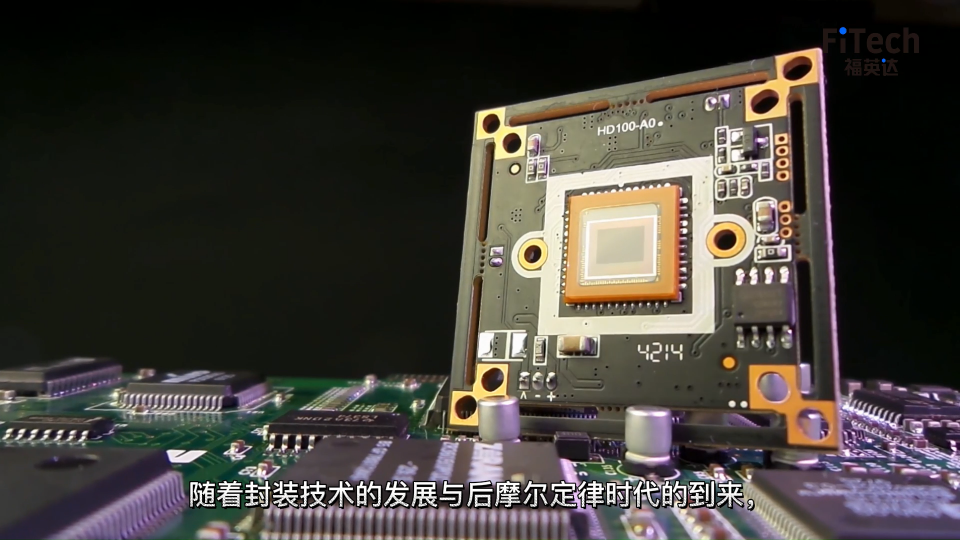


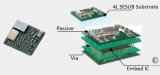

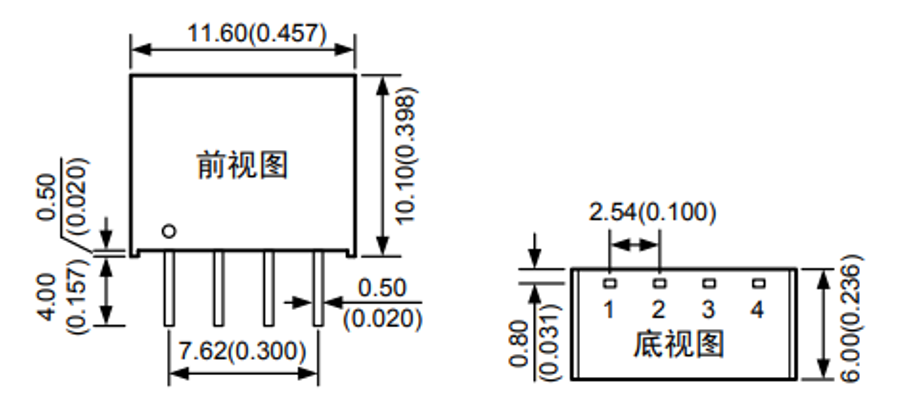


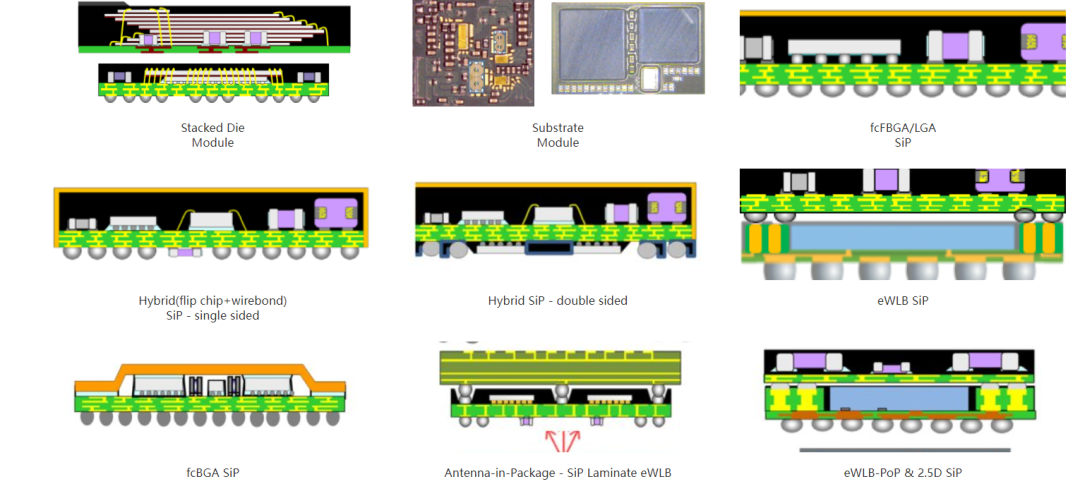
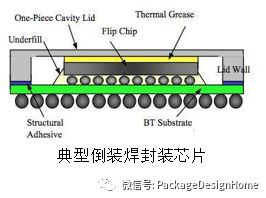
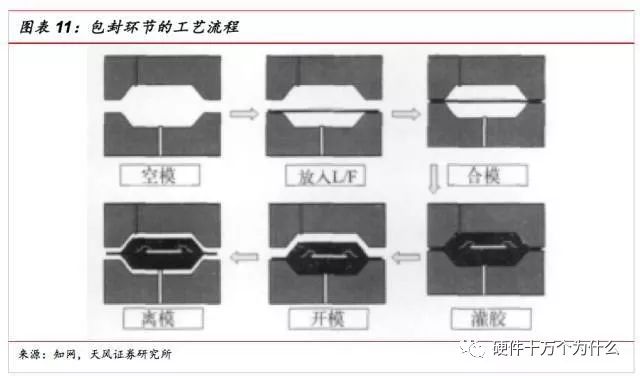

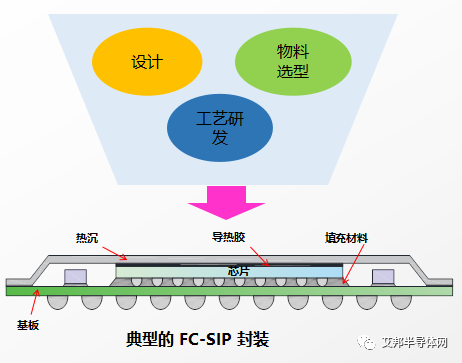

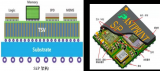


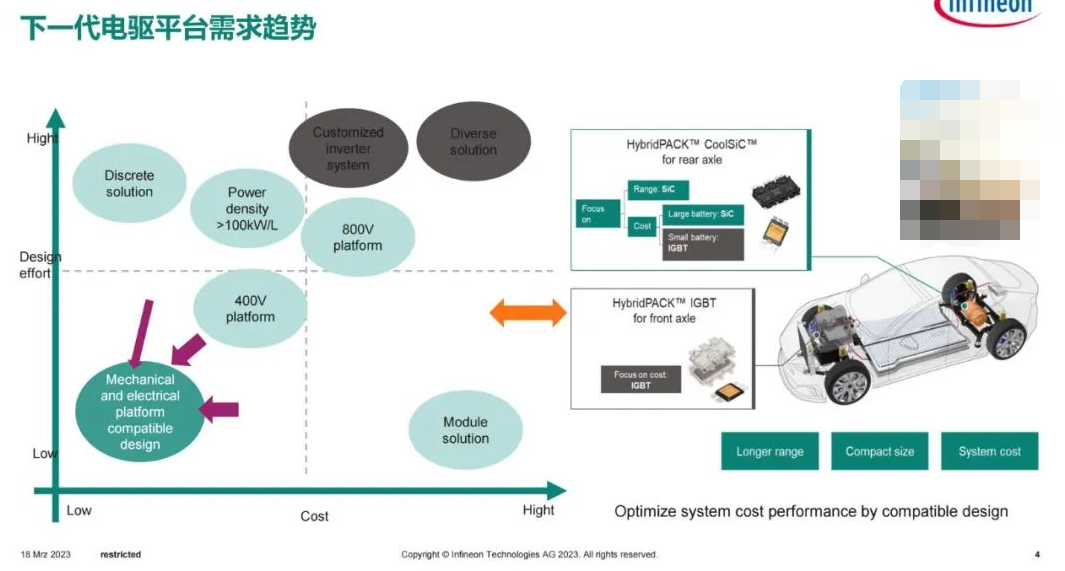










評論