在smt貼片加工中,BGA空洞是經常出現的一個問題。那么BGA空洞又是怎么形成的呢,又該如何去解決BGA空洞呢?
形成原因:1.焊點合金的晶體結構不合理。2.PCB板的設計錯誤。3.印刷時,助焊膏的沉積量過少或過多。4.所使用的回流焊工藝不合理。5.焊球在制作過程中夾雜的空洞。
解決辦法:
1、爐溫曲線設置:1)在升溫段,溫度變化率過快,快速逸出的氣體對BGA造成影響;2)升溫段的持續時間過短,升溫度結束后,本應揮發的氣體還未完全逸出,這部分的氣體在回流階段繼續逸出,影響助焊體系在回流階段發揮作用。
2.助焊膏潤濕焊盤的能力不足:助焊膏對焊盤的潤濕表現在它對焊盤的清潔作用。因助焊膏潤濕能力不足,無法將焊盤上的氧化層去除,或去除效果不理想,而造成虛焊。
3.回流階段助焊膏體系的表面張力過高:松香與表面活性劑的有效配合可使潤濕性能充分發揮。
4.助焊膏體系的不揮發物含量偏高:不揮發物含量偏高導致BGA焊球的熔化塌陷過程中BGA下沉受阻,造成不揮發物侵蝕焊點或焊點包裹不揮發物。
5.載體松香的選用:相對于普通錫膏體系選用具有較高軟化點的松香而言,對BGA助焊膏,由于其不需要為錫膏體系提供一個所謂的抗坍塌能力,選擇具有低軟化點的松香具有重要的意義。
在smt貼片加工中,BGA空洞的危害是引起電流的密集效應,同時降低焊點的機械強度。因此,減少BGA空洞是可以提高電路的安全性的。
推薦閱讀:http://m.elecfans.com/article/921648.html
責任編輯:gt
-
pcb
+關注
關注
4326文章
23160瀏覽量
399966 -
smt
+關注
關注
40文章
2927瀏覽量
69684 -
BGA
+關注
關注
5文章
549瀏覽量
47055
發布評論請先 登錄
相關推薦
BGA焊點空洞的形成與防止
BGA枕頭效應的形成原因和觀察方法
BGA焊接工藝及可靠性分析
SMT加工的BGA焊點出現空洞的原因分析
如何防止電鍍和焊接空洞
pcb如何防止電鍍和焊接空洞形成
pcb防止電鍍和焊接空洞的方法
BGA焊接產生不飽滿焊點的原因和解決方法





 BGA空洞的形成原理與解決方法介紹
BGA空洞的形成原理與解決方法介紹
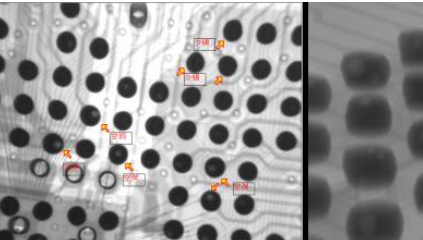
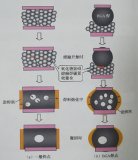











評論