化學機械拋光 (CMP) 是當今集成電路 (IC) 制造工藝中的關鍵作業(yè)。由于設計極其緊湊,并且 縮小到最先進的工藝技術節(jié)點,CMP 后的平面性變化可能會對制造成功產生重大影響。
為了減輕 CMP 工藝的負面影響,大多數 IC 制造商使用 CMP 建模來檢測前道工序 (FEOL) 和 后道工序 (BEOL) 層中的潛在弱點,作為其可制造性設計 (DFM) 流程的一部分。CMP 弱點分 析旨在尋找設計中經過 CMP 后出現缺陷的概率高于平均值的區(qū)域。不同材料在 CMP 工藝 下會表現出不同的腐蝕速率,因此芯片的密度平衡必須保持穩(wěn)定,以防止出現凸起和凹 陷,避免造成金屬互連短路和開路。CMP 分析會衡量版圖的各個方面,以確保在多層上構 建芯片時具有均勻的平面性。
高電介質金屬柵極 (HKMG) 技術和額外 CMP 步驟 [1, 2] 的引入,雙重和三重曝光導致的光刻 高成本,強焦深 (DOF) 要求,以及 CMP 模型的精度提高,都提升了業(yè)界對 CMP 建模的關注 度 [3-6]。
構建 CMP 模型
CMP 建模有很長的歷史,包括單材料和雙材料拋光的建模,以及眾多沉積和蝕刻工藝的建 模 [6]。CMP 建模背后的主要思路是:提取版圖上圖形的幾何屬性,在蝕刻和諸多沉積步驟 之后生成 CMP 前的表面輪廓,以及預測版圖上不同圖形的 CMP 后表面輪廓。
芯片被劃分為固定大小的重復單元,對于每個重復單元,提取并傳送圖形的平均幾何特征
(例如寬度、間距、圖形密度和周長),然后進行蝕刻、沉積和 CMP 仿真。利用有效的溝 槽逼近來模擬為每個重復單元定義的結構(圖 1)。一個重復單元代表一個具有給定幾何特 征的溝槽,它有兩個高度數據 —— ZT 和 ZNT,分別定義溝槽內材料的高度和溝槽外材料的 高度。
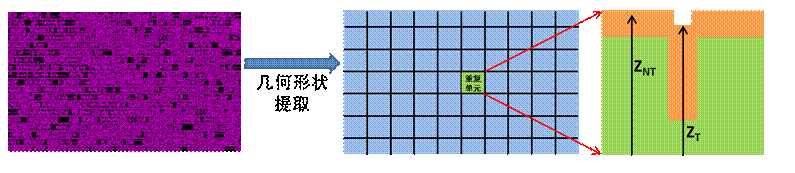
圖 1:幾何數據提取和 有效溝槽逼近。
在 CMP 仿真期間,蝕刻、沉積和拋光模型仿真 ZT 和 ZNT 數據的變化,以及每個重復單元的 幾何數據變化。拋光模型使用 CMP 前表面輪廓數據作為輸入,該數據由沉積模型或前一拋 光步驟產生。第一拋光步驟總是使用沉積后輪廓作為輸入。沉積后的表面輪廓不是平面性 的,含有變化。因此,為實現高質量 CMP 建模,必須有一組與制造商使用的沉積工藝相對 應的沉積模型,以產生用于 CMP 仿真的正確輸入輪廓。
CMP 建模的一個關鍵步驟是使用來自測試芯片的測量數據構建模型。CMP 測試芯片通常由 周期性放置的不同寬度的平行溝槽陣列塊組成,溝槽之間的間距也有差異(圖 2)。選擇 測試芯片的尺寸和結構的數量時,必須讓它能很好地覆蓋技術節(jié)點所支持的寬度、間距、 周長和圖形密度值,同時不違反設計規(guī)則檢查 (DRC)。常常使用原子力顯微鏡 (AFM) 掃描儀 或其他輪廓探查工具對測試圖形進行行掃描來收集腐蝕和凹陷數據,如圖 2 所示。知道疊 層信息和材料厚度后,便可將腐蝕和凹陷數據轉換成 ZT 和 ZNT 表面輪廓高度數據。

圖 2:CMP 測試芯片和 AFM 行掃描,含腐蝕和 凹陷定義。
由于 CMP 十分復雜且影響長遠,生成高質量的 CMP 前表面輪廓對于 CMP 精確建模至關重 要。即使采用先進的沉積工藝,已曝光晶圓的沉積后(CMP 前)輪廓也是不均勻的,可能 有很大差異,影響 CMP 后的表面上平面性。對三維 (3D) 原子力顯微鏡 (AFM) 和透射電子顯 微鏡 (TEM) 數據的分析表明,CMP 前輪廓高度對以下各項的底層圖形幾何形狀有復雜的依 賴關系:
■ 高密度等離子體 CVD (HDP-CVD)
■ 旋涂式電介質 (SOD)
■ 流動式 CVD (FCVD)
■ 增強型高縱橫比工藝 (eHARP)
FEOL 層的淺溝槽隔離 (STI) 和 CMP 建模表明 HPD-CVD 和 SOD 沉積模型成功應用于 CMP建模。
與此同時,為 FCVD 和 eHARP 工藝構建基于物理特性的模型或簡化模型則很困難,因為這些 工藝包含若干沉積和退火步驟以填充溝槽。我們研究了通過機器學習 (ML) 算法對測量數據進 行靈敏度分析,結果顯示這些工藝的沉積后表面輪廓主要取決于底層圖形幾何形狀,而長遠 影響是次要的。借助此信息,我們可以使用底層圖形的幾何特征作為輸入,將神經網絡 (NN) 回歸計算應用于 CMP 前表面輪廓的建模。然后,CMP 前輪廓用作 CMP 建模的輸入。
神經網絡配置
機器學習、神經網絡和深度學習在現代工業(yè)和生活的不同領域中有許多應用。它們“學 習”如何分析和預測不精確數據的能力,大大提高了語音識別和語言翻譯、基因組學和藥 物發(fā)現、計算機視覺、自動駕駛汽車以及許多其他領域的技術水平 [7]。
一種潛在的新用途是將神經網絡應 用于沉積后表面輪廓建模。該方法 的工作原理如下:利用 Calibre? CMP ModelBuilder 和 Calibre CMPAnalyzer 產品從版圖中提取圖形的局部幾何 特征(寬度、間距、圖形密度和周 長),并將其用作多層神經網絡的 輸入,以生成表面輪廓高度數據預 測(圖 3)。

圖 3:具有兩個隱藏層的多層前饋神經網絡。
神經網絡的輸入層獲取此幾何數據,網絡在輸出層上生成預測的腐蝕和凹陷數據。為簡便 起見,本文不考慮沉積后的任何幾何形狀變化。神經網絡經過高級學習算法的訓練,訓練 集由沉積后從 CMP 測試芯片收集到的測量結果構成。經過訓練的神經網絡在測試芯片或生 產設計上運行,以進行測試和驗證。我們考慮用含一個、兩個或更多隱藏層的神經網絡來 擬合腐蝕和凹陷數據。為將模型很好地泛化到未知數據,應該從最少數量的隱藏層和神經 元開始,然后持續(xù)增加數量以更好地擬合驗證數據,但應避免過擬合。針對我們的模型, 我們確定兩個隱藏層對于對所涉工藝的表面輪廓建模是最佳的,無需使用更深層架構(即 具有許多隱藏層的神經網絡)。
首先,我們利用神經網絡模擬 HDP-CVD 和 SOD 工藝的 CMP 前輪廓,Calibre CMP ModelBuilder 工具中提供了其簡化模型。使用測量數據,我們生成了用于訓練神經網絡的訓練集。接下 來,我們運用 Calibre CMP ModelBuilder 工具對測量數據和模型生成的仿真數據進行了驗證。 最后,我們將該神經網絡應用于 FCVD 和 eHARP 工藝的 CMP 前輪廓建模。
神經網絡在 CMP 輪廓建模中的應用
為了測試利用機器學習和神經網絡生成 CMP 模型的實用性和準確性,我們使用以下四種沉 積工藝進行了實驗:HDP-CVD、SOD、FCVD、eHARP。
HDP-CVD 工藝建模:HDP-CVD 工藝最初用于 STI,但如 今它與芯片制造中高縱橫比沉積工藝一起,廣泛用于 不同氧化物的沉積。在 HDP-CVD 期間,沉積和離子濺 射過程同時發(fā)生,因此有效區(qū)域上會出現三角形和梯 形形狀。這些幾何形狀隨著底層有效區(qū)域圖形幾何形 狀而變化,導致沉積的氧化物厚度有差異(圖 4)。

圖 4:HDP-CVD 后表面輪廓的橫截面 視圖。
從測試芯片的 AFM 行掃描數據收集腐蝕和凹陷數據,然后構建如下格式的訓練數據集(表 1) 用于神經網絡輸入。
編輯:hfy
-
集成電路
+關注
關注
5392文章
11622瀏覽量
363177 -
CMP
+關注
關注
6文章
151瀏覽量
26098 -
機器學習
+關注
關注
66文章
8438瀏覽量
133082
發(fā)布評論請先 登錄
相關推薦
高階API構建模型和數據集使用
如何構建神經網絡?
卷積神經網絡模型發(fā)展及應用
cmp是什么意思 cmp工藝原理
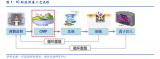




 如何構建CMP模型 神經網絡在CMP輪廓建模中的應用
如何構建CMP模型 神經網絡在CMP輪廓建模中的應用










評論