通過逐步的說明,本系列說明并向您展示了確保在當今最先進的節(jié)點中確保布局保真度所需的自對準模式創(chuàng)建的復雜性。第1部分介紹了SADP和SAQP。在本期的最后一部分中,我們將向您介紹自對準光刻蝕刻光刻的基本知識(SALELE)。
銷售
在“銷售”過程中,不添加任何虛擬金屬,并且僅在緊密的尖端到尖端間距位置處需要塊。圖1顯示了SALELE的分解過程。輸入目標(1a)分解為LE1_target和LE2_target(1b)。與SADP / SAQP流程一樣,所有目標形狀都必須具有對稱的光柵,并與軌道完美對齊。但是,SALELE流程不會將目標行轉換為SADP / SAQP之類的軌道。取而代之的是,僅將LE1_target形狀或LE2_target形狀上的目標線之間的緊密的尖端間距轉換為形狀,此處命名為LE1_Litho_Bias和LE2_Litho_Bias(形狀的尺寸略微增大,以考慮光刻工藝的偏差)(1c)。為了消除添加虛擬金屬(及其所產(chǎn)生的電容)的需要,目標形狀之間的較大間隙被簡單地保留了下來。
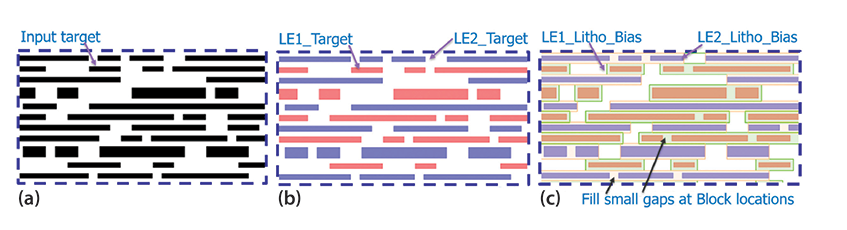
圖1SALELE分解過程:(a)輸入目標,(b)將輸入目標分解為LE1_target和LE2_target,(c)通過填充緊密的尖端到尖端位置的間隙將LE1_target和LE2_target轉換為最終的掩模形狀(這些間隙將稍后被阻止遮罩阻止)。
在下一步中,將塊形狀添加到尖端到尖端的緊密位置,以在目標形狀之間創(chuàng)建所需的隔離。SALELE進程使用兩個SAB掩碼,一個用于LE1_Target,另一個用于LE2_Target,每個掩碼都使用前面所述的相同SAB進程。SALELE過程有兩個間隙寬度約束。第一個是緊密的筆尖到筆尖的空間,它由塊形狀定義-該間隙寬度由可以打印的最小塊寬度定義。第二個約束是在不添加任何塊形狀的位置處的最小間隙寬度,這由金屬目標印刷過程的點對點光刻分辨率限制來定義,就像單個EUV掩模一樣。
SALELE + SAB過程需要打印四個遮罩:兩個目標遮罩(LE1和LE2)和兩個塊遮罩(LE1_block遮罩和LE2_block遮罩)。出于我們的目的,假定塊掩膜為EUV暗場掩膜。
讓我們仔細看一下SALELE制造過程的細節(jié)。由于復雜性,我們將分階段完成所有步驟(圖2-5)。
2a。打印(1c)中所示的LE1_Litho_Bias目標。使用PTD工藝,將圖案轉移到硬掩模上。執(zhí)行額外的蝕刻工藝以創(chuàng)建溝槽的所需寬度,減小溝槽之間的空間并平滑線邊緣粗糙度。
2b。將圖案轉移到基礎層。現(xiàn)在創(chuàng)建的圖案比2a中的圖案更寬,彼此之間的空間更小,從而為將在其內(nèi)部形成的間隔物騰出空間。使用ALD,進行保形沉積以構建第一側壁。
2c。自上而下蝕刻到LE_1溝槽內(nèi)邊緣的電介質(zhì)側壁。
2d。沉積另一個硬掩模并涂覆光致抗蝕劑。
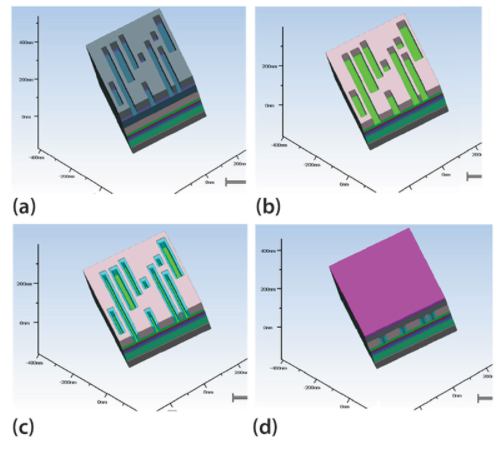
圖2SALELE的制造過程:(a)LE1溝槽的硬掩模開口,(b)額外的蝕刻以擴大LE1溝槽,(c)側壁沉積,(d)第二硬掩模和光刻膠涂層。使用SEMulator3D生成的圖像[10]
3a。在光刻膠上打印第一塊掩模圖案,然后將其轉移到第二個硬掩模上。為了去除光致抗蝕劑,去除未被側壁或阻擋掩模覆蓋的溝槽內(nèi)的材料,并去除阻擋掩模形狀的硬掩模。
3b。現(xiàn)在我們僅在防區(qū)遮罩位置具有底層(綠色材料)。
3c。分別沉積第三硬掩模和光刻膠。
3d。在光刻膠上打印第二塊掩模并將其轉移到其硬掩模上。
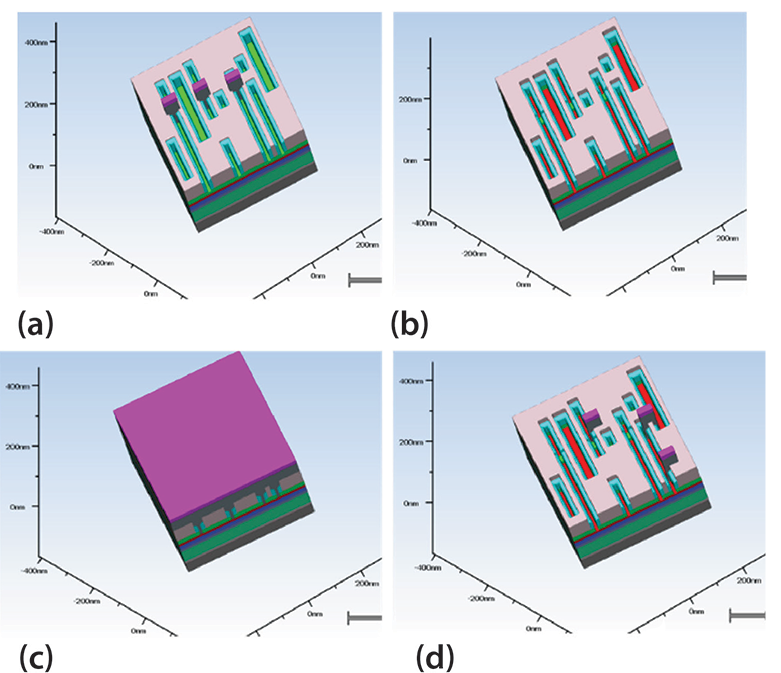
圖3SALELE的制造過程:(a)打印第一塊掩模并轉移到其硬掩模,(b)將塊掩模的形狀轉移到底層材料,(c)分別進行硬掩模和光刻膠沉積,(d)打印第二塊掩模和轉移到其硬掩膜。使用SEMulator3D生成的圖像[10]
4a。刻蝕溝槽內(nèi)的底層(紅色材料),除第一個阻隔掩模位置以外的所有位置都將其去除,除第二個阻隔掩模位置以外的所有位置均去除第三個硬掩模。
4b。去除光刻膠和硬掩模以露出第二塊掩模圖案。
4c。分別沉積硬掩模和光刻膠。
4d。要打印圖1c中所示的LE2_Litho_Bias目標,請使用PTD工藝將圖案轉移到光刻膠和其他硬掩模上。
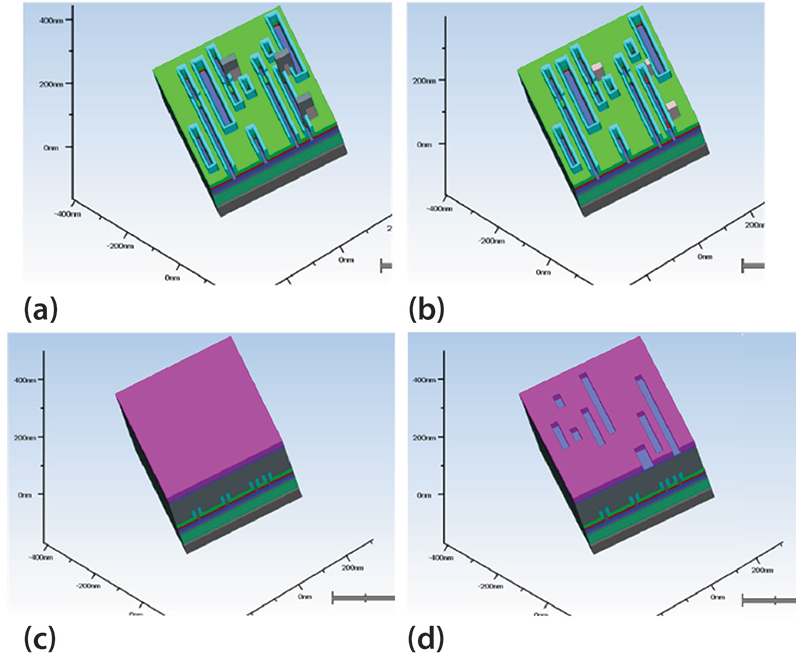
圖4SALELE的制造過程:(a)刻蝕溝槽內(nèi)的底層,(b)去除硬掩模后的第二塊掩模圖案,(c)分別沉積硬掩模和光刻膠,(d)將LE2轉移到光刻膠上。使用SEMulator3D生成的圖像[10]
5a。現(xiàn)在,我們有了LE_2溝槽,第二塊遮罩已位于溝槽內(nèi)部。
5b。去除硬掩模后的圖案。
5c。去除LE_2溝槽位置的底層(紅色材料)和第二塊掩模硬掩模。
5天除去側壁和硬掩膜。現(xiàn)在我們有了金屬目標形狀的最終溝槽(最終圖案)。未被底層覆蓋的所有物體都將填充金屬。
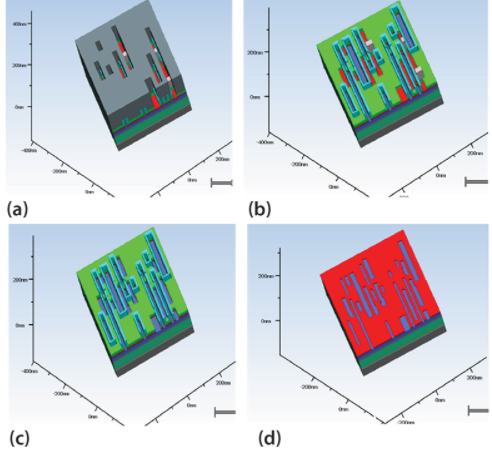
圖5SALELE的制造過程:(a)將LE2轉移到硬掩模上,(b)進行硬掩模圖案化后的圖案,(c)去除LE_2溝槽位置處的底層和硬掩模,(d)最終溝槽。使用SEMulator3D生成的圖像[10]
如圖6所示,第二金屬靶(LE2_Target)與LE1側壁(6a)自對準。只要這些側壁是不同的材料并且具有足夠的蝕刻靈敏度,LE2蝕刻工藝就不會影響側壁或使側壁之間的空間變大,如(6b)所示。另外,LE2_Litho_Bias目標可以比所需的最終目標大一點,從而降低了金屬電阻。
第二目標圖案是由側壁和LE2掩模共同定義的,這意味著即使LE2和LE1之間的對齊誤差很小,LE2和LE1之間的間距也由側壁的寬度定義,該寬度通過工藝定義是恒定的。如果LE2模式?jīng)]有任何相鄰的LE1形狀,則它可以比LE2目標寬,因為它是由LE2_Litho_Bias和LE1側壁定義的。結果,最終的LE2模式可能具有不一致的寬度(6b)。
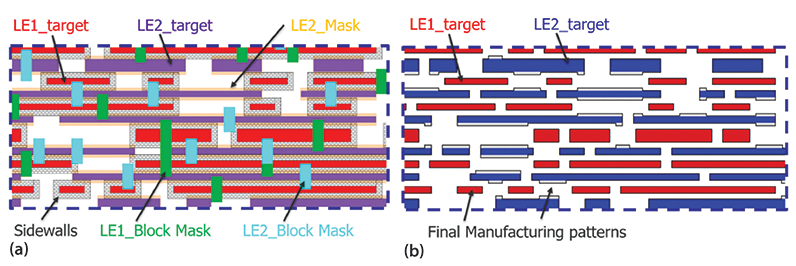
圖6SALELE自動對齊過程:(a)將LE2與LE1對齊,(b)最終制造的形狀。
自對準的多圖案工藝已成為最先進的工藝節(jié)點的必要條件。通過避免與DP / TP / QP LEn工藝和EUV單掩模光刻相關的未對準問題,它們提高了圖案保真度(并提高了產(chǎn)量)。當前使用三種形式的自調(diào)整流程-SADP,SAQP和SALELE。盡管SADP和SAQP僅依賴于目標遮罩和切割/遮罩遮罩,但SALELE流程結合了自對準多圖案和LELE流程的各個方面。
IMEC和Mentor在此次合作中提供的獨特觀點和經(jīng)驗為開發(fā)可用于生產(chǎn)的SALELE工藝做出了貢獻,該工藝比SADP / SAQP工藝具有一些有希望的優(yōu)勢,例如消除了偽金屬(及其附加電容) )。通過了解每個過程的細節(jié),代工廠和設計公司的工程師將能夠更好地選擇,實施和制造具有這些過程的設計,而不會影響成品率或性能。
Jae Uk Lee是計算光刻領域的高級研發(fā)工程師,包括源掩模優(yōu)化/光學接近度校正以及IMEC的可制造性設計。
Ryoung-han Kim博士是IMEC物理設計/設計自動化,OPC / RET和測試現(xiàn)場/卷帶式磁帶的主管。
David Abercrombie是西門子公司Mentor的高級物理驗證方法的程序經(jīng)理。
Rehab Kotb Ali是西門子Mentor的高級產(chǎn)品工程師,致力于先進的物理驗證技術。
Ahmed Hamed-Fatehy是西門子公司Mentor的RET產(chǎn)品的首席產(chǎn)品工程師。
編輯:hfy
-
PTD
+關注
關注
0文章
2瀏覽量
7627 -
光刻膠
+關注
關注
10文章
322瀏覽量
30346
發(fā)布評論請先 登錄
相關推薦
光刻掩膜技術介紹
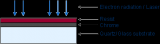
一文看懂光刻技術的演進

一文解讀光刻膠的原理、應用及市場前景展望

光刻掩膜和光刻模具的關系
光刻工藝的基本知識

微流控光刻掩膜制作
VCSEL激光在蝕刻和光刻中的應用與前景
光刻膠的保存和老化失效
刻蝕機是干什么用的 刻蝕機和光刻機的區(qū)別
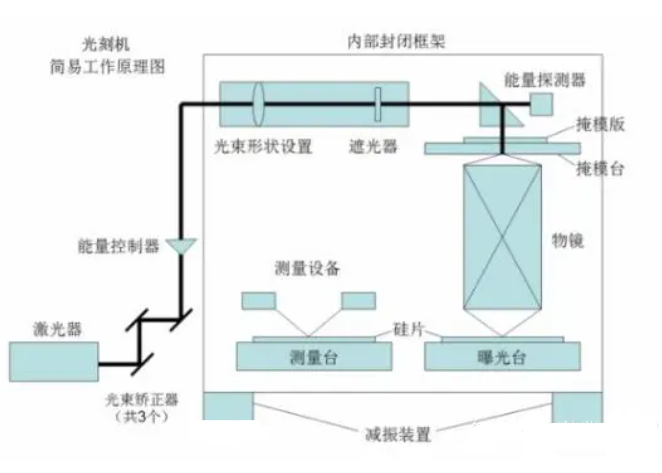
一文解析半導體設計電路的“光刻工藝”





 一文解析對準光刻蝕刻光刻的基本知識(SALELE)
一文解析對準光刻蝕刻光刻的基本知識(SALELE)


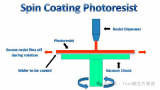










評論