在過去的幾年中,已經發(fā)布了許多涉及用于半導體器件的高級封裝體系結構的公告。這些架構為產品設計人員提供了極大的靈活性,使其能夠異構集成在封裝上不同硅工藝上優(yōu)化的不同IP,從而顯著提高性能。
對高級封裝的最近興趣是由對增加封裝上帶寬的需求,對來自多個代工廠的各種IP進行集成的需求以及對提高產量彈性的需求所驅動的。有機封裝是出色的異構集成主流平臺,可在緊湊的外形尺寸中實現(xiàn)空間轉換,并在物理上實現(xiàn)了封裝上的互連(電源效率高,帶寬高)(圖1)。
圖1英特爾Agilex FPGA提供了一個封裝上異構集成的示例。資料來源:英特爾
先進封裝的目標之一是開發(fā)越來越密集的橫向和縱向互連,以使用這些互連創(chuàng)建的管芯到管芯鏈接具有最小的功率損耗和延遲,同時又能確保信號完整性。本質上,重點是創(chuàng)建接近單片互連性能的封裝上互連,并且在封裝上創(chuàng)建的復合設備的行為就像一個虛擬的單片實體。
2D和3D架構
封裝上互連以及具有這些互連的更廣泛的封裝體系結構可以在封裝的xy平面中分為2D和3D(圖2)。
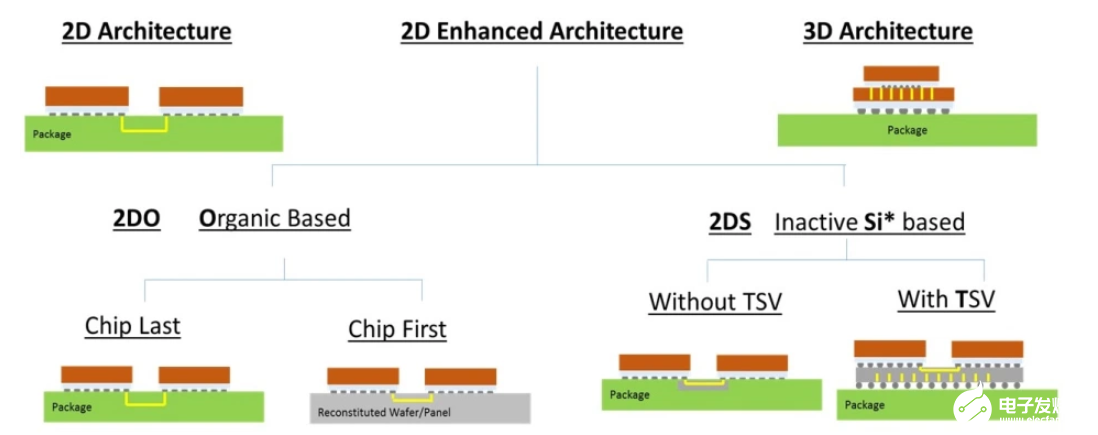
圖22D和3D架構的互連術語。資料來源:電子封裝協(xié)會,IEEE
2D架構定義為兩個或更多有源硅器件并排放置在封裝上并在封裝上互連的架構。如果互連是“增強型的”(互連密度比主流有機封裝更高,并且可以使用有機介質完成),則該體系結構還可以進一步細分為2D有機(2DO)體系結構。同樣,如果增強型體系結構使用無機介質(硅,玻璃或陶瓷中介層或橋接器),則該體系結構進一步細分為2DS體系結構。
3D架構被定義為兩個或更多有源硅器件在沒有封裝代理的情況下堆疊并互連的架構。在此定義中,短語“在沒有封裝代理的情況下互連”僅表示有源硅片之間的互連不通過封裝,因此它們的設計和性能不直接取決于封裝體系結構。
互連密度
物理互連密度可以通過兩個關鍵指標來捕獲(圖3)。線密度表示從芯片邊緣向外逃逸的導線數(shù)量,以進行側向的芯片到芯片互連,而面密度表示用于形成垂直連接的凸塊數(shù)量。
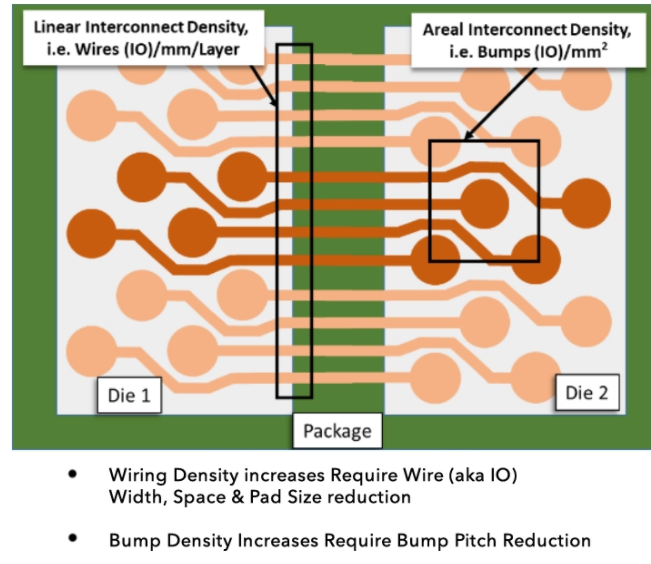
圖3可以通過這兩個關鍵指標來捕獲線性和區(qū)域互連密度。資料來源:英特爾
圖4和圖5描述了不同包裝技術的線性和平面密度的包絡線。如兩個圖所示,使用不同的互連體系結構,可以實現(xiàn)廣泛的互連密度。通常,使用硅后端布線的技術具有最高的布線密度,因為它們提供了更細,間距更緊密的布線(圖4)。

圖4該圖顯示了不同高級封裝體系結構的線性互連密度包絡。資料來源:英特爾
這些技術可以實現(xiàn)并行,寬且緩慢的芯片到芯片鏈接,并且需要特別注意鏈接設計,以解決布線密度增加帶來的信號完整性問題。隨著凸點間距的縮小,平面的凸點密度與凸點間距的平方的倒數(shù)成正比(圖5)。

圖5該圖顯示了面積互連密度與凸塊間距和架構的關系。資料來源:英特爾
如今,大多數(shù)面積的芯片到芯片和芯片到封裝的互連都使用焊料來形成接頭。隨著凸點間距的縮小,從焊料到使用Cu-Cu互連(約20-25μm)將有過渡,以實現(xiàn)持續(xù)的互連密度縮放。因此,工業(yè)上的重點是增加Cu-Cu互連的技術范圍。
互連密度縮放的一個常見的根本原因是需要增加封裝上裸片到裸片鏈路的帶寬。帶寬縮放速率可用于定義互連縮放路線圖。根據(jù)《異構集成路線圖2019年版》,互連技術擴展路線圖可實現(xiàn)鏈路帶寬的世代加倍。
圖6顯示了用于異構集成的高級包裝體系結構的一些示例。
圖6一些先進的軟件包體系結構在所有三個維度上提供了更多的分區(qū)機會和規(guī)模擴展。資料來源:英特爾
軟件包與系統(tǒng)設計師之間的協(xié)作
隨著高級包裝技術的發(fā)展,它們將通過異構集成提供更高的包裝性能,從而使性能越來越高的系統(tǒng)成為可能。通過加強包裝和系統(tǒng)設計人員之間的協(xié)作伙伴關系,可以更好地實現(xiàn)此系統(tǒng)性能。
下面列出了一些合作伙伴關系將如何幫助最大化系統(tǒng)性能的示例:
系統(tǒng)板的功能,材料和設計必須不斷發(fā)展以支持更高的速度和更高的帶寬信令。封裝和系統(tǒng)協(xié)同設計方法可創(chuàng)建功耗最大化,成本優(yōu)化的系統(tǒng)鏈接,從而最大程度地提高帶寬,從而有助于最大化系統(tǒng)性能。
可以預見,除了電氣鏈路之外,將來還將需要光子學和無線鏈路以最大程度地擴大覆蓋范圍和帶寬。開發(fā)和擴散這些不同的信令技術將需要協(xié)作以實現(xiàn)標準化的模塊化可擴展性。
將需要專注于開發(fā)有效的系統(tǒng)電源傳輸網絡。
符合系統(tǒng)尺寸和可靠性要求的整體系統(tǒng)冷卻方法將確保系統(tǒng)冷卻能力不會限制系統(tǒng)性能。
模塊化和可伸縮性將需要在系統(tǒng)級別使用的各種連接器技術中構建。
總之,當今有許多先進的包裝技術可用來提高包裝上異構集成IP的性能。這些技術著重于擴展互連密度,以幫助擴展封裝上芯片對芯片鏈接之間的帶寬并提高性能。軟件包與系統(tǒng)設計人員之間的緊密合作,以優(yōu)化軟件包系統(tǒng)集成,將有助于最大化系統(tǒng)性能。
RAVI MAHAJAN,英特爾研究員,是技術發(fā)展的組裝和測試未來技術的英特爾共同主任。
編輯:hfy
-
信號完整性
+關注
關注
68文章
1417瀏覽量
95635 -
系統(tǒng)設計
+關注
關注
0文章
154瀏覽量
21656 -
半導體器件
+關注
關注
12文章
766瀏覽量
32184
發(fā)布評論請先 登錄
相關推薦
英特爾IEDM 2024大曬封裝、晶體管、互連等領域技術突破

研究透視:芯片-互連材料

探索倒裝芯片互連:從原理到未來的全面剖析

柔性基板異質集成系統(tǒng)的印刷互連技術

芯片和封裝級互連技術的最新進展
TE推出AMPMODU互連系統(tǒng)產品特色是什么?-赫聯(lián)電子
日月光推出先進封裝平臺新技術:微間距芯粒互連技術
一文解析SiC功率器件互連技術
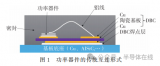




 高級封裝技術:創(chuàng)建接近單片互連性能的封裝上互連
高級封裝技術:創(chuàng)建接近單片互連性能的封裝上互連

















評論