為應(yīng)對摩爾定律的放緩,全球最大的芯片生產(chǎn)巨頭臺積電正在與谷歌等美國科技企業(yè)合作,以開發(fā)一種新的半導(dǎo)體封裝技術(shù)。新的架構(gòu)通過將不同類型的芯片堆疊,能夠使得芯片組變得小而強(qiáng)大。
芯片封裝是半導(dǎo)體生產(chǎn)制造過程中的最后一個(gè)步驟,傳統(tǒng)而言,它對技術(shù)的要求不如芯片制造的其他工序高。但現(xiàn)在芯片封裝正在成為行業(yè)新的戰(zhàn)場。
臺積電近期透露,公司正在使用一種命名為SoIC的3D堆疊技術(shù)來對芯片進(jìn)行垂直和水平層面的封裝。通過這種技術(shù),可以將多種不同類型的芯片(例如處理器,內(nèi)存和傳感器)堆疊并連接到同一個(gè)封裝中,從而使得整個(gè)芯片組更小,功能更強(qiáng)大,而且功耗更低。
根據(jù)研究機(jī)構(gòu)Yole Development的數(shù)據(jù),全球先進(jìn)芯片封裝產(chǎn)業(yè)2019年的規(guī)模達(dá)到290億美元,預(yù)計(jì)2019年至2025年之間的復(fù)合年增長率為6.6%,到2025年將達(dá)到420億美元的規(guī)模。該研究機(jī)構(gòu)還表示,在所有細(xì)分市場中,3D堆疊封裝將在同一時(shí)期內(nèi)以25%的速度增長,成為增長最快的細(xì)分領(lǐng)域。
據(jù)日經(jīng)新聞報(bào)道,谷歌和AMD將成為臺積電的這種全新封裝架構(gòu)的首批客戶,并正在幫助臺積電對新的芯片進(jìn)行測試和認(rèn)證。
臺積電于2016年正式進(jìn)入芯片封裝業(yè)務(wù),幫助蘋果iPhone開發(fā)更強(qiáng)大的芯片處理器和存儲芯片的封裝。伯恩斯坦研究公司(Bernstein Research)的研究分析顯示,直到今年,臺積電的大部分芯片封裝收入仍來自蘋果。
此外,幾乎全球所有的主要芯片開發(fā)商都是臺積電的客戶。臺積電為包括蘋果,華為,谷歌,高通,英偉達(dá)和博通等芯片開發(fā)商代工生產(chǎn)芯片。
主要服務(wù)于高端芯片廠商
通過推出全新的SoIC技術(shù),臺積電有望將高端客戶納入其芯片封裝的生態(tài)系統(tǒng)中,這是因?yàn)樾枰叨诵酒目蛻舾敢鉁y試新技術(shù)。比如蘋果,谷歌,AMD和英偉達(dá)等芯片開發(fā)巨頭都在競爭最高端的芯片市場。
根據(jù)臺積電上個(gè)月公布的財(cái)報(bào),公司預(yù)計(jì)包括先進(jìn)封裝和測試在內(nèi)的后端服務(wù)收入將在未來幾年內(nèi)以略高于公司平均水平的速度增長。2019年臺積電來自芯片封裝和測試服務(wù)的收入達(dá)到28億美元,約占其總收入346.3億美元的8%。
全球最大的兩個(gè)半導(dǎo)體制造商三星和英特爾也正在押注下一代芯片堆疊技術(shù)。但是與為眾多芯片設(shè)計(jì)商服務(wù)的臺積電不同,英特爾和三星主要生產(chǎn)供自己使用的芯片。不過三星也在積極擴(kuò)大其代工業(yè)務(wù),并將高通和英偉達(dá)視為主要客戶,這可能導(dǎo)致三星與臺積電有更直接的競爭。
“這些新的芯片堆疊技術(shù)需要先進(jìn)的芯片制造專業(yè)知識以及大量計(jì)算機(jī)模擬來實(shí)現(xiàn)精確的堆疊,因此傳統(tǒng)的芯片封裝供應(yīng)商很難介入。”深聰智能聯(lián)合創(chuàng)始人吳耿源對第一財(cái)經(jīng)記者表示。此前,臺積電芯片封裝服務(wù)大部分外包給了日月光、Amkor和Powertech以及中國的長江電子、通富微電和天水華天等廠商。
前段的晶圓制造廠商之所以能夠跨入后段封測,主要的驅(qū)動力來自于高端客戶對芯片性能需求。“相較于傳統(tǒng)的后段封測行業(yè),前段晶圓級別封測,更具有掌握終端客戶需求的優(yōu)勢。”前中芯國際市場部高管,深聰智能聯(lián)合創(chuàng)始人、CEO吳耿源對第一財(cái)經(jīng)記者表示。
吳耿源說道,臺積電早在十年前就已經(jīng)開始布局新的芯片封裝技術(shù)。“臺積電很早就意識到,芯片前段的制程技術(shù)發(fā)展非常迅速,而后段的封裝技術(shù)跟不上。”他表示,“但是經(jīng)過十年的發(fā)展,先進(jìn)封裝技術(shù)依然沒有達(dá)到預(yù)期的成熟度。”
吳耿源認(rèn)為,這主要是由于資本投入和回報(bào)不成正比所造成的。“先進(jìn)封裝制程需要很多資金的投入,對消費(fèi)性產(chǎn)品而言,晶圓制造看重的是投入產(chǎn)出比。”他對第一財(cái)經(jīng)記者表示,“從客戶的角度來看,他們需要評估先進(jìn)封測所獲得的性能回報(bào),能否抵消新增的單位成本。如果只有一些大的廠商能夠負(fù)擔(dān)得起,就會對技術(shù)的普及造成阻礙。”
中芯國際也在多年前瞄準(zhǔn)了中段晶圓級芯片封測技術(shù),并和長電科技成立合資公司,建立類似的先進(jìn)芯片封裝能力。“技術(shù)的發(fā)展仍需要時(shí)間,但我們?nèi)匀粦?yīng)該保持積極的態(tài)度。”吳耿源說道。
責(zé)編AJX
-
芯片
+關(guān)注
關(guān)注
456文章
51170瀏覽量
427245 -
半導(dǎo)體
+關(guān)注
關(guān)注
334文章
27703瀏覽量
222628 -
臺積電
+關(guān)注
關(guān)注
44文章
5685瀏覽量
166996
發(fā)布評論請先 登錄
相關(guān)推薦
半導(dǎo)體封裝的主要類型和制造方法
倒裝封裝(Flip Chip)工藝:半導(dǎo)體封裝的璀璨明星!

Chiplet,半導(dǎo)體的下一個(gè)前沿?

玻璃基板:半導(dǎo)體封裝領(lǐng)域的“黑馬”選手

半導(dǎo)體封裝技術(shù)的類型和區(qū)別
led封裝和半導(dǎo)體封裝的區(qū)別
PCB與半導(dǎo)體的橋梁:封裝基板的奧秘與應(yīng)用

半導(dǎo)體封裝材料全解析:分類、應(yīng)用與發(fā)展趨勢!

上海汽車芯片工程中心與功成半導(dǎo)體簽署重要戰(zhàn)略合作協(xié)議!





 芯片封裝或成半導(dǎo)體領(lǐng)域的下一個(gè)戰(zhàn)場
芯片封裝或成半導(dǎo)體領(lǐng)域的下一個(gè)戰(zhàn)場
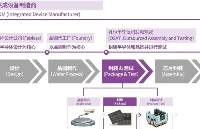










評論