晶圓切割(即劃片)是芯片制造工藝流程中一道不可或缺的工序,在晶圓制造中屬于后道工序。晶圓切割就是將做好芯片的整片晶圓按芯片大小分割成單一的芯片(晶粒)。
最早的晶圓是用切片系統進行切割(劃片)的,這種方法以往占據了世界芯片切割市場的較大份額,特別是在非集成電路晶圓切割領域。鉆石鋸片(砂輪)切割方法是較為常見的晶圓切割方法。新型切割方式有采用激光進行無切割式加工的。
晶圓切割工藝流程主要包括:繃片、切割、UV照射。
晶圓切割將一個晶圓上單獨的die通過高速旋轉的金剛石刀片切割開來,形成獨立的單顆的晶片,為后續工序做準備。晶圓切割需要用到特定的切割機刀片。
繃片是一個切割前的晶圓固定工序,在晶圓的背面貼上一層藍膜,并固定在一個金屬框架上,以利于后面切割。
切割過程中需要用去離子水(DI純水)沖去切割產生的硅渣和釋放靜電,去離子水由專業制備的小型設備「純水機」制備。
UV照射是用紫外線照射切割完的藍膜,降低藍膜的粘性,方便后續挑粒。
P.S.:OFweek君不是技術出身,現學現賣的這種概括文章,對于產業中的各種基礎概念無法做到非常準確的描述。若讀者朋友們對于文章內容準確性有異議,歡迎添加OFweek君微信(hepinggui2010)告知。若相關內容能形成完整的文章,OFweek君也可以署名文章投稿的形式,將相應內容發表在OFweek旗下各個內容平臺上。感謝大家的支持!
審核編輯:符乾江
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
相關推薦
在半導體制造領域,IC芯片的生產是一個極其復雜且精密的過程,劃片機作為其中關鍵的一環,發揮著不可或缺的作用。從工藝流程來看,在芯片制造的后端工序中,劃片機承擔著將晶
![的頭像]() 發表于
發表于 01-14 19:02
?139次閱讀
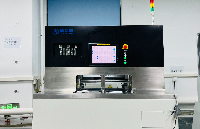
關鍵的概念,它們在晶圓的后段工藝中扮演著重要的角色。為了方便理解,我們可以把晶圓比作一塊大餅,而每一片芯片就像是從大餅上切下來的薄片,
![的頭像]() 發表于
發表于 01-03 11:33
?401次閱讀

的高精度,滿足現代半導體器件對尺寸和位置精度的極高要求。2.穩定的劃片質量:通過優化劃片工藝和參數設置,全自動晶圓
![的頭像]() 發表于
發表于 01-02 20:40
?108次閱讀

半導體晶圓制造是現代電子產業中不可或缺的一環,它是整個電子行業的基礎。這項工藝的流程非常復雜,包含了很多步驟和技術,下面將詳細介紹其主要的制造工藝流
![的頭像]() 發表于
發表于 12-24 14:30
?973次閱讀

一、概述
晶圓背面涂敷工藝是在晶圓背面涂覆一層特定的材料,以滿足封裝過程中的各種需求。這種工藝不
![的頭像]() 發表于
發表于 12-19 09:54
?355次閱讀

晶圓切割機在氧化鋯中的劃切應用主要體現在利用晶圓切割機配備的精密刀具和控制系統,對氧化鋯材料進行
![的頭像]() 發表于
發表于 12-17 17:51
?286次閱讀
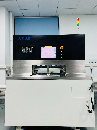
機的工作原理劃片機主要利用砂輪沿著晶圓上的預定路徑進行切割,將芯片分離。其關鍵在于精準定位、控制切口以及高效處理。通過精密的光學定位系統,劃片
![的頭像]() 發表于
發表于 12-11 16:46
?308次閱讀

晶圓經過前道工序后芯片制備完成,還需要經過切割使晶圓上的芯片分離下來,最后進行封裝。不同厚度晶圓
![的頭像]() 發表于
發表于 12-10 11:36
?443次閱讀
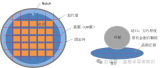
晶圓切割劃片技術作為半導體制造流程中的關鍵環節,其技術水平直接關聯到芯片的性能、良率及生產成本。
![的頭像]() 發表于
發表于 11-08 10:32
?770次閱讀

本文從硅片制備流程為切入點,以方便了解和選擇合適的硅晶圓,硅晶圓的制備工藝流程比較復雜,加工工序
![的頭像]() 發表于
發表于 10-21 15:22
?415次閱讀
在本系列第七篇文章中,介紹了晶圓級封裝的基本流程。本篇文章將側重介紹不同晶圓級封裝方法所涉及的各項工藝
![的頭像]() 發表于
發表于 08-21 15:10
?1915次閱讀

集成電路生產中,晶圓切割技術至關重要。傳統切割技術難以滿足大規模生產需求,精密切割設備應運而生。德國SycoTec提供多款高速電主軸,具有高
![的頭像]() 發表于
發表于 06-12 14:37
?518次閱讀

半導體晶圓(Wafer)是半導體器件制造過程中的基礎材料,而劃片是將晶圓上的芯片分離成單個器件的關鍵步驟。本文將詳細介紹半導體
![的頭像]() 發表于
發表于 05-06 10:23
?2207次閱讀

晶圓經過前道工序后芯片制備完成,還需要經過切割使晶圓上的芯片分離下來,最后進行封裝。
![的頭像]() 發表于
發表于 03-17 14:36
?2059次閱讀

(Sputtering)工藝、電鍍(Electroplating)工藝、光刻膠去膠(PR Stripping)工藝和金屬刻蝕(Metal Etching)工藝。 封裝完整
![的頭像]() 發表于
發表于 03-05 08:42
?1573次閱讀

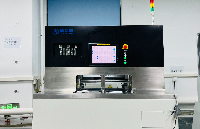





 如何做晶圓切割(劃片),晶圓切割的工藝流程
如何做晶圓切割(劃片),晶圓切割的工藝流程



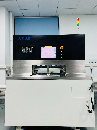

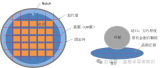
















評論