摘要
隨著越來越高的VLSIs集成度成為商業實踐,對高質量晶片的需求越來越大。對于表面上幾乎沒有金屬雜質、顆粒和有機物的高度潔凈的晶片來說,尤其如此。為了生產高清潔度的晶片,有必要通過對表面雜質行為的實驗和理論分析來建立晶片表面清潔技術。本文解釋了金屬和顆粒雜質在硅片表面的粘附機理,并提出了一些清洗方法。
介紹
LSI(大規模集成電路)集成密度的增加對硅片質量提出了更高的要求。更高質量的晶片意味著晶體精度、成形質量和表面質量的優異質量。必須考慮有關芯片尺寸增加和制造成本增加的問題。近年來已經討論了300毫米晶片的實際應用。300毫米晶圓需要極高的表面清潔度(參見圖1)。有機雜質以及傳統雜質(如金屬和顆粒)的質量標準已經開始制定。這些雜質產生于晶片制造設備、化學品、人體、潔凈室材料、無塵服裝和反應產物,并且經常沉積在晶片表面”。
它們導致互連故障和晶體缺陷,然后退化設備性能。為此,硅晶片的表面清潔度不斷提高。
為了滿足這些要求,重要的是從理論上分析發生在硅片表面上的現象,并根據理論分析的結果進行工藝設計。本報告特別討論了金屬和顆粒在晶片表面的粘附機理,并介紹了基于我們理論研究的新的清洗方法。
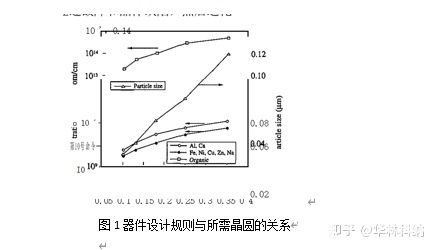
金屬在硅片表面的吸附機理
由于硅晶片表面上的鐵會導致晶體缺陷并降低器件性能,因此應該盡可能多地去除鐵。Henley等人指出,對于8 nm厚的柵極氧化物,需要10'0 cm '的鐵污染水平。像鐵一樣,其他金屬(例如,鎳、鉻、銅、鋅和鈉)會降低器件性能(或者改變晶體管閾值,誘發晶體缺陷以降低pn結泄漏和柵極氧化物完整性,或者加速氧化)。他們一定是以滿足不斷縮小的設備尺寸。為了去除這些金屬或控制它們在清洗溶液中的吸附,有必要了解它們在清洗溶液中的行為。
清洗溶液中的金屬吸附有兩種主要機制。一種是化學吸收,如金屬在堿性溶液中吸附到天然氧化物(SiO)上。另一種是酸性溶液中裸露硅的電化學吸附。為了理解這些機制,我們進行了離子平衡分析和電化學分析。
2.1離子平衡分析
NH,OH+HCO+HCO混合物(APM)也稱為“標準清洗溶液1 (SC-1 )”,是一種代表性的堿性清洗溶液,具有極其優異的顆粒去除能力,因此被廣泛使用。然而,如果清洗溶液中存在金屬離子,它們會吸附在晶片表面”。尤其是,當鐵以少于十億分之幾(ppb)的痕量存在時,會降低電性能如復合壽命、I。當它是從前一道工序中遺留下來的,或者當使用低純度的化學品時,就會產生嚴重的問題。
SC-1清洗液中的金屬吸附通常用金屬氧化物生成焓或絡合離子模型來解釋,但很少進行定量討論。根據化學平衡理論對這一問題進行了分析”。
在SC-1清洗液中,通過過氧化氫形成自然氧化物(SiO2)和通過堿蝕刻SiO2同時進行。由于這個原因,整個晶片的厚度慢慢地減小減少,但一定厚度的SiO,存在于晶圓片表面,與時間無關。在這種情況下,如果蝕刻速率足夠慢,并且金屬吸附和解吸反應足夠快,則在一氧化硅和溶液之間保持一定的金屬離子吸附平衡。實際上,由于SC-1清洗溶液對二氧化硅的蝕刻速率是每分鐘幾個單層,而金屬的吸附量在晶片浸沒后一秒鐘內達到恒定值,所以可以認為這種平衡是成立的。給定溫度下溶液中金屬離子濃度與吸附量的關系稱為“吸附等溫線”。圖2顯示了299氫氧化銨、31%過氧化氫和去離子水的1:1:5混合物在80℃溫度下的吸附等溫線。

結論
上面已經討論了金屬吸附和顆粒粘附機理。對這些粘附行為的分析有助于技術的發展,通過不斷增加VLSIs的集成密度來實現更高的清潔度。20世紀70年代提出的RCA清洗工藝支持了目前的半導體工業。300毫米晶圓的出現將改變用于提高晶圓表面清潔度的清潔方法。為了適應這種變化,有必要在原子水平上分析和控制硅片表面發生的反應。這種努力將導致技術突破的發現和半導體工業的進一步發展。
審核編輯 黃昊宇
-
硅晶片
+關注
關注
0文章
74瀏覽量
15251 -
清洗作業
+關注
關注
0文章
2瀏覽量
5878
發布評論請先 登錄
相關推薦
硅晶片清洗方式的詳細說明
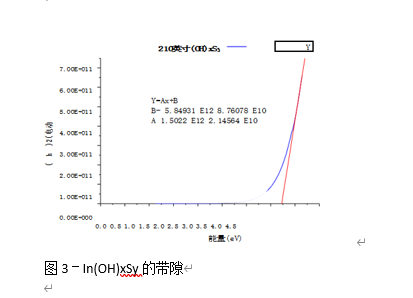
關于硅晶片研磨之后的清洗工藝介紹
半導體工藝—晶片清洗工藝評估
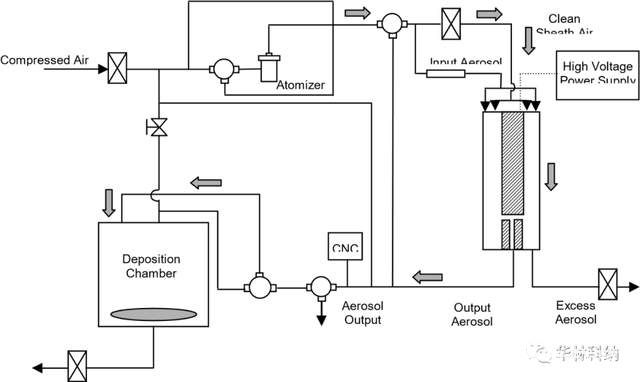
晶片清洗及其對后續紋理過程的影響

新型全化學晶片清洗技術詳解
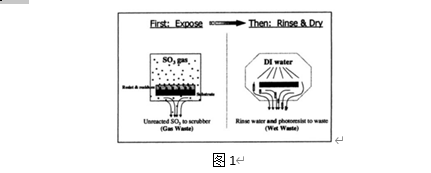
半導體制造過程中的硅晶片清洗工藝
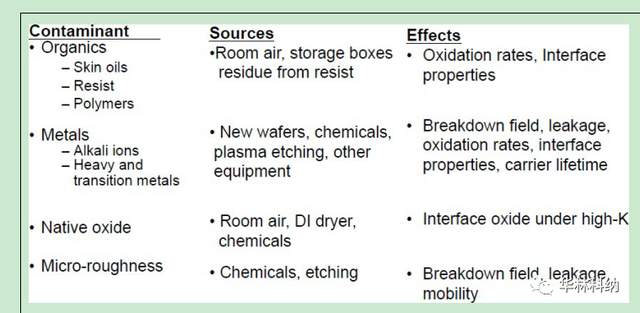
濕式化學清洗過程對硅晶片表面微粒度的影響

使用脈動流清洗毯式和圖案化晶片的工藝研究

不同的濕法晶片清洗技術方法





 硅晶片的清洗技術
硅晶片的清洗技術
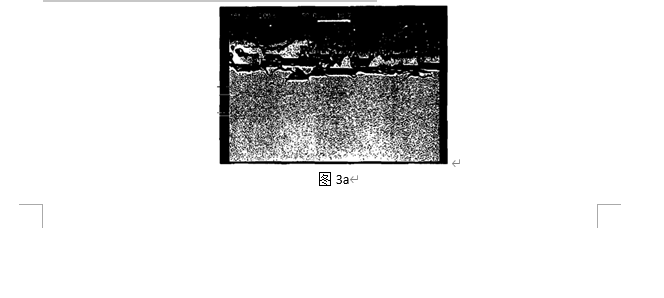
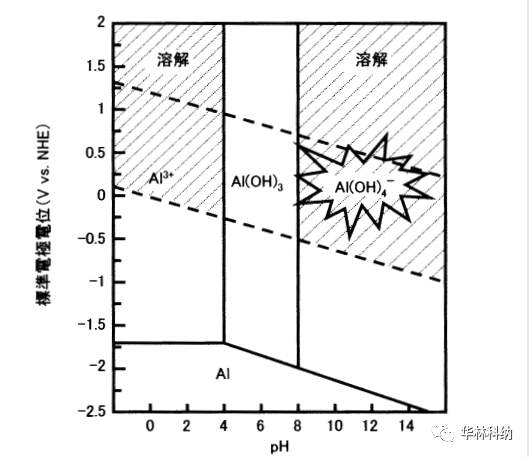
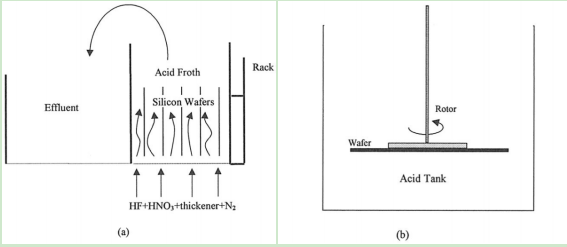











評論