電子元件和電路的適當熱管理是確保系統在所有操作條件下正確運行和可靠性的基本要求。當前電子設備逐漸小型化的趨勢以及對功率密度的需求不斷增加,將熱管理問題置于前臺,特別是對于最新一代的功率設備,例如由氮化鎵 (GaN) 和碳化硅 (SiC)。基于 GaN 和 SiC 的器件可以提供最新一代電源應用所需的高性能。然而,它們極高的功率密度應該得到適當的管理,這使得創新的熱管理技術成為一個需要考慮的關鍵方面。
為了充分發揮寬帶隙 (WBG) 半導體的潛力,設計人員必須了解使用這些材料所帶來的挑戰。在更高的開關頻率和更高的功率密度下運行,可以實現無源元件(電感器和電容器)的尺寸減小并制造更輕更小的系統。然而,這些較小的無源元件在較高頻率下工作的行為很難預測,并且可能會出現熱管理問題。WBG 半導體需要仔細設計,因為與硅基器件支持的溫度相比,它們在更高的溫度下工作。設計過程考慮了更大的熱應力,這會對系統的可靠性產生不利影響。
在“熱管理進展 2021 ”這一完全在線舉辦的活動中,GaN 和 SiC 技術的三位主要專家提供了有關熱模型、封裝、熱分析和熱界面材料技術的寶貴信息。該小組由電力電子新聞主編 Maurizio Di Paolo Emilio 主持,并邀請了來自 Efficient Power Conversion (EPC)、UnitedSiC 和 STMicroelectronics 等主要公司的行業名人。
總承包
EPC 的首席執行官兼聯合創始人 Alex Lidow 以提到芯片級 GaN 的熱管理開始了演講。據 Lidow 稱,EPC 基于 GaN 的功率器件已經生產了大約 11 年。在談話中,他說由于 GaN 器件比它們所取代的功率 MOSFET 小得多(小 5 到 10 倍),一個常見的誤解是它們會引起熱管理問題。令人驚訝的是,它們在散熱方面的效率提高了 5 到 10 倍。讓我們考慮進入 PC 板的設備的熱阻。Lidow 表示,這些設備面朝下(倒裝芯片)安裝,所有有源元件都在設備表面,而且它們真的很靠近 PC 板。從器件結到焊點底部的熱阻 (R θJB),具有相同的表面,在硅和 GaN 之間沒有太大區別。然而,正如 Lidow 所說,如果我們考慮相反的方向——從結到外殼的熱阻(R θJC ),或者通過側壁或背面離開器件的熱阻——它表明 GaN 大約是比具有相同管芯面積的硅器件高 6 倍的熱效率。因此,經常看到 PC 板上的器件面朝下放置。這些結果可以通過在基于 GaN 的功率器件和散熱器之間放置隔熱層來實現,如圖 1 所示。
“在隔熱材料和凝膠方面有了很大的改進;在短短幾年內,我們已經從大約 6 W/mK 一路上升到大約 17 W/mK,”Lidow 說。“我們的解決方案不僅允許從 PC 板到散熱器的熱傳導,而且還允許從設備側面傳導熱,這樣您就可以通過側壁冷卻獲得更大的好處。”
Lidow 評論說,在 4 毫米2代表性設備上執行的模擬顯示了 EPC 已經能夠通過實驗確認和實現的內容。特別是,更好的熱管理已經能夠在 6W 功耗下將熱阻降低到大約 3.9°C/W。
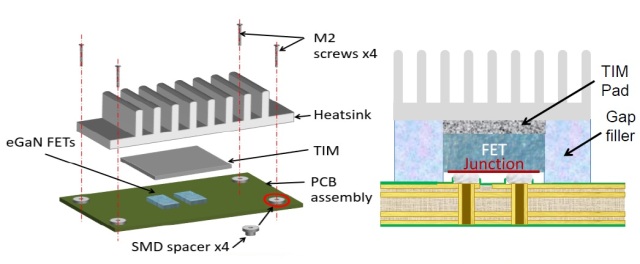
圖 1:結殼熱阻的減少
“我們為客戶提供了一種工具,可以讓設計師對整個系統進行熱建模,”Lidow 說。“可以配置各種元件,例如間隙填充物、隔熱墊、散熱器、散熱器和散熱孔。”
聯合碳化硅
UnitedSiC 的首席應用工程師 Jonathan Dodge 就熱管理的趨勢以及對 SiC 的考慮發表了演講。正如道奇所說,導通電阻的降低絕對是未來幾年將持續的趨勢,這將開辟一些有趣的應用,否則功率半導體將無法真正處理這些應用。“因此,我們還提高了每個分立器件的功率處理能力,”道奇說。
“碳化硅可以減小芯片尺寸,但芯片單位面積的功率仍然相關,這意味著我們更多地依賴于封裝和散熱器來提供熱質量,”他補充道。
在他的演講中,道奇強調了兩個應用分支,它們對熱管理提出了嚴峻的設計挑戰。第一個包括具有被動冷卻的固態斷路器和繼電器,而另一個包括需要更積極冷卻的大功率轉換器和電機驅動器。這兩種應用都需要一個能夠處理所需功率水平的封裝。廣泛使用的封裝(例如 TO-247)具有嚴重的局限性。它們的引腳很小,考慮到在電機驅動應用中,我們可能會運行超過 100 A RMS通過他們。然后,如圖 2 所示,有一個浪費的區域,因為與封裝相比,SiC 芯片的面積相對較小,但體積很大。道奇評論說,爬電距離和電氣間隙也是另一個問題,因為該封裝不是為我們現在使用的高電壓而設計的。這就是為什么許多設計師更喜歡帶有陶瓷隔離器的夾子安裝座,因為陶瓷不會磨損。
“我認為未來的趨勢實際上將是表面貼裝:它成本低、非常可靠,并且無論是頂部冷卻還是底部冷卻,”道奇說。“我們需要能夠處理多個表面貼裝設備、800 V 甚至更高電壓的隔離熱界面材料,并符合小型 SMT 組裝變化。”

圖 2:TO-247 封裝對最大電流有嚴格的限制。
STMicroelectronics 集團副總裁兼總經理 Salvatore Coffa 結束了本次會議,并討論了功率器件中的熱管理技術,并考慮了牽引逆變器應用的熱管理設計。
Coffa 指出,每當我們談論功率器件性能的創新時,我們都會看到向更高功率密度以及更低功率和傳導損耗的演變。這對于硅來說是正確的,對于像 SiC 和 GaN 這樣的 WBG 半導體來說更是如此。
“創新之路不僅是前端、材料、結構或設備的創新,而且封裝所扮演的角色越來越重要,”Coffa 說。
為了在 EV 動力總成的功率模塊中實現這一點,Coffa 表示,我們需要實現低靜態和動態損耗,提高熱阻 R th(流體結點),并在最終實現成本、性能和可靠性之間的優化權衡。應用。
Coffa 認為,電源模塊封裝設計的方法是基于仿真,使用諸如 CAD/CAE 建模之類的工具。這非常有幫助,因為它考慮了設備的屬性、損耗和熱機械約束。如圖 3 所示,Coffa 分析的這種方法允許從具有相關操作條件的初始包裝設計開始,通過功率損耗、熱機械問題和其他損壞的理論模型來估算產品壽命。Coffa 補充說,最終的包裝設計是根據拓撲或形態優化方法迭代流程的結果。并且所有模型都必須事先通過實驗進行校準和驗證,即使在不同的設計中也是如此。

圖 3:建模方法
“我們進行了大量 CAD/CAE 建模,將器件的電氣特性與熱材料的特性結合起來,我們還進行了大量實驗工作,以便從我們使用的材料中選擇合適的參數,”科法說。
用于電動汽車牽引逆變器的 SiC MOSFET 需要對芯片和封裝進行適當的協同設計,同時考慮到最終應用中的所有相關熱機械方面。專門為汽車領域設計的 SiC 功率器件被認為通常通過非常規的芯片連接技術進行安裝。新的 SiC 芯片專門設計為通過燒結組裝,底部和頂部都用于夾子燒結。在活性金屬釬焊上或直接在散熱器上燒結芯片,利用這種 WBG 材料的卓越電氣和熱性能,并在溫度波動下提供卓越的可靠性。
審核編輯:郭婷
-
半導體
+關注
關注
334文章
27712瀏覽量
222658 -
氮化鎵
+關注
關注
59文章
1646瀏覽量
116621 -
碳化硅
+關注
關注
25文章
2827瀏覽量
49275
發布評論請先 登錄
相關推薦
開關損耗更低、效率更高,增速超越SiC,GaN開始進軍光儲、家電市場
8英寸SiC投產進展加速,2025年上量

經緯恒潤熱管理系統研發服務全新升級
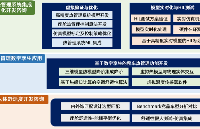
電力電子的熱管理未來趨勢與挑戰!

SiC和GaN器件的兩大主力應用市場

簡述智慧供熱管理服務平臺

soc設計中的熱管理技巧
北大王瑋教授團隊在芯片熱管理領域取得進展
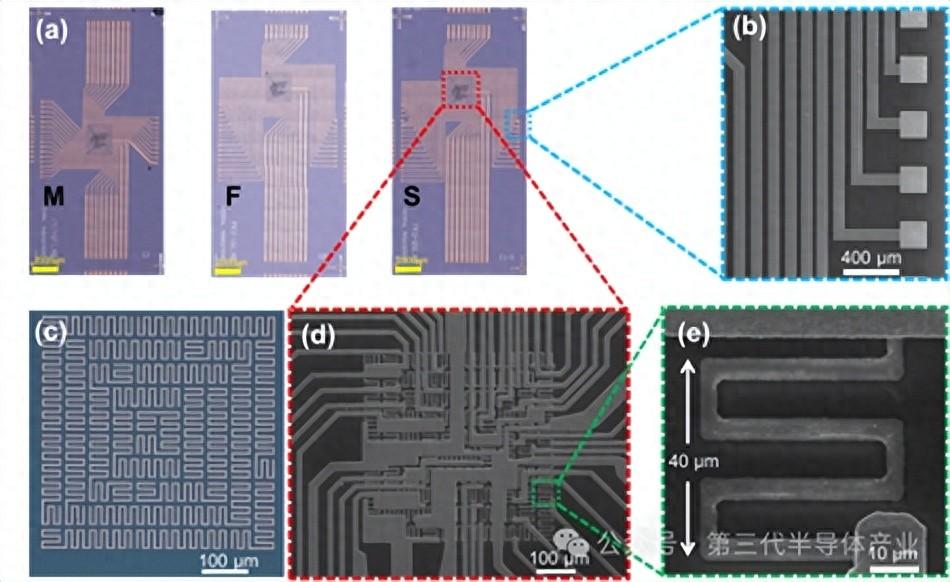
GaN/金剛石功率器件界面的熱管理
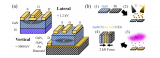




 GaN和SiC熱管理的進展
GaN和SiC熱管理的進展













評論