EUV 光刻是以波長(zhǎng)為 10-14nm 的極紫外光作為光源的芯片光刻技術(shù),簡(jiǎn)單來(lái)說(shuō),就是以極紫外光作“刀”,對(duì)芯片上的晶圓進(jìn)行雕刻,讓芯片上的電路變成人們想要的圖案。
如今,世界上最先進(jìn)的 EUV 光刻機(jī)可以做到的“雕刻精度”在 7nm 以下,比一根頭發(fā)的萬(wàn)分之一還要細(xì)。
提到極紫外光刻(EUV),人們傾向于把注意力集中在芯片工藝和光刻設(shè)備,但是他們往往會(huì)忽略另一個(gè)重要的方面:光從哪兒來(lái)? EUV 光刻技術(shù)已經(jīng)發(fā)展了 20 多年,直到幾年前這種技術(shù)是否能夠進(jìn)入工業(yè)化芯片生產(chǎn)還是一個(gè)開(kāi)放性的問(wèn)題。在研究過(guò)程中,人們發(fā)現(xiàn)所有懸而未決的技術(shù)挑戰(zhàn)中極紫外光是最大的難題。
光源是個(gè)很大的難題,需要足夠大的功率來(lái)生成EUV光。ASML的EUV光源采用激光等離子體的方式,原理是用準(zhǔn)分子激光轟擊靶材產(chǎn)生EUV。對(duì)準(zhǔn)分子激光的要求很高,如帶寬、輸出功率、穩(wěn)定性、維護(hù)難易度、波長(zhǎng)、相對(duì)波長(zhǎng)穩(wěn)定性、脈沖與脈沖之間的能量穩(wěn)定性、成本、安全性等等,最關(guān)鍵的是如何在高重復(fù)頻率下保持窄帶寬和無(wú)碎屑。
靶材對(duì)于EUV光源也非常重要,要能承受不間斷的全天候的準(zhǔn)分子激光器發(fā)出超高頻脈沖轟擊,還要求極小的碎屑尺寸和超低成本。ASML采用的是液滴靶技術(shù),液體錫從上向下滴落過(guò)程中會(huì)形成錫珠,用激光轟擊錫珠讓其化為等離子態(tài),產(chǎn)生EUV。
圖2:光從哪兒來(lái)
讓我們看一下 EUV 光刻整個(gè)過(guò)程的示意圖: 第一步: CO2激光脈沖被放大到非常高的功率,輸出超過(guò) 30kW 平均脈沖功率的激光數(shù),其脈沖峰值功率可高達(dá)幾兆瓦; 第二、三步: 不斷滴下的錫珠被激光束擊中成為一個(gè)發(fā)光的等離子體,發(fā)射出波長(zhǎng)為 13.5 nm 的 EUV 光; 第四、五步: 極紫外光聚焦后,通過(guò)反射透鏡首先傳輸?shù)焦饪萄谀I希缓笳丈涞骄A基片上。
對(duì)于每一個(gè)步驟,都需要非常復(fù)雜的技術(shù),接下來(lái)讓我們聚焦激光脈沖是如何產(chǎn)生以及如何放大的(第1-3步)的? 首先,我們需要產(chǎn)生短脈沖激光光束作為種子光,然后讓它經(jīng)過(guò)多級(jí)放大。實(shí)際上會(huì)有兩個(gè)脈沖——預(yù)脈沖和主脈沖。預(yù)脈沖首先擊中錫珠,使它變成正確的形狀;然后主脈沖將壓扁的錫珠轉(zhuǎn)化為等離子體,從而發(fā)射出珍貴的 EUV 光。
這里的難點(diǎn)在于放大階段會(huì)不斷增加它的功率,但必須確保兩個(gè)光束在錫珠上有正確的光學(xué)性能,尤其是正確的聚焦。每束脈沖激光都由非常微小的、緊湊的光粒子組成,緊緊地拋向錫珠。為了正確地?fù)糁兴鼈兊哪繕?biāo),它們必須在正確的瞬間到達(dá),不能過(guò)早或過(guò)晚;否則,沖擊力將無(wú)法壓平錫珠。在最壞的情況下,第二道激光脈沖射出的子彈沒(méi)有擊中目標(biāo),EUV 就會(huì)失敗。
以上過(guò)程每秒鐘進(jìn)行五萬(wàn)次。 為了讓激光束以極大的功率穩(wěn)定傳輸,系統(tǒng)的復(fù)雜性可想而知。 事實(shí)上,EUV 激光系統(tǒng)由大約 45 萬(wàn)個(gè)零件組成,重約 17 噸。為了確保這些零件正確組裝,僅檢查標(biāo)準(zhǔn)就多達(dá) 1000 多條,這還不包括模塊和子模塊額外的預(yù)檢標(biāo)準(zhǔn)。 從種子光發(fā)生器到錫珠有 500 多米的光路,這對(duì)所有零部件都提出了非常苛刻的要求,尤其是系統(tǒng)中包含的 400 多個(gè)光學(xué)元器件。
EUV 激光系統(tǒng)由大約 45 萬(wàn)個(gè)零件組成,重約 17 噸,線(xiàn)纜長(zhǎng)度超過(guò) 7000 米 作為該系統(tǒng)的光源,該激光器產(chǎn)生的等離子體溫度為 22萬(wàn)℃,比太陽(yáng)表面的溫度高 30 至 40 倍。
圖4:CO2 激光器中的受激混合氣體發(fā)出獨(dú)特的紅光——這就是 EUV 光最初的來(lái)源 EUV光刻過(guò)程中將現(xiàn)有浸入式193nm光刻中193nm波長(zhǎng)的短波紫外線(xiàn)換成了13.5nm的光,在光刻精密圖案方面自然更具優(yōu)勢(shì),能夠減少工藝步驟,提升良率,但實(shí)現(xiàn)難度非常大。荷蘭ASML公司是全球目前唯一能提供EUV光刻機(jī)的企業(yè),我們一起走進(jìn)它的光刻機(jī)看看吧。
EUV輻射被所有物質(zhì)甚至氣體強(qiáng)烈吸收,EUV的成像必須在真空中進(jìn)行,而且在EUV波段范圍內(nèi)沒(méi)有合適的透明材料來(lái)制造透鏡,即無(wú)法采用折射式光學(xué)系統(tǒng),必須采用反射式的光學(xué)系統(tǒng),并且每面反射鏡的最大反射率不會(huì)超過(guò)70%。EUV的光學(xué)系統(tǒng)即照明系統(tǒng)和投影系統(tǒng)利用有限個(gè)數(shù)的反射鏡作為光學(xué)元件,且這些反射鏡的面形是非球面的。
由于單純一種元素物質(zhì)無(wú)法在EUV波段達(dá)到高反射率,為了獲得EUV波段內(nèi)大于60%的反射率,EUV光刻成像系統(tǒng)的鏡面往往需要涂有多層膜涂層,所謂的多層膜是指高散射和低散射兩種材料交替沉積而成的一種人造涂層,高低散射材料的間距是幾納米甚至更小,從而使EUV可以像可見(jiàn)光那樣進(jìn)行反射、聚焦和成像。
ASML的EUV系統(tǒng)所用光學(xué)系統(tǒng)都來(lái)自卡爾蔡司。當(dāng)轉(zhuǎn)換成13.5nm的光后,這些光會(huì)在一種包含多個(gè)多層鏡面的復(fù)雜配置方案中反射。隨后這些光會(huì)經(jīng)過(guò)一個(gè)可編程的illuminator并抵達(dá)掩膜。最后光會(huì)在另外6個(gè)多層鏡面上反射并以6%的角度抵達(dá)晶圓。
以下為EUV光刻機(jī)內(nèi)部工作的全過(guò)程。分別是1.光源中的激光脈沖和錫珠,2.光經(jīng)過(guò)掩膜版,3.測(cè)量和曝光,4.晶圓移動(dòng)臺(tái),5.全光路,6.光刻機(jī)內(nèi)部。
在年初的 SPIE 高級(jí)光刻會(huì)議上,英特爾光刻硬件和解決方案總監(jiān) Mark Phillips 重申了公司打算在 2025 年將該技術(shù)部署到大批量生產(chǎn)中。雖然許多觀察家認(rèn)為這個(gè)時(shí)間表是激進(jìn)的,但該公司可能希望避免(或至少延遲)對(duì) EUV 多重圖案工藝的需求。
高數(shù)值孔徑 EUV 系統(tǒng)的好處可以用一個(gè)詞來(lái)概括——分辨率。將孔徑增加到 0.55,而不是當(dāng)前曝光系統(tǒng)中的 0.33,可以成比例地提高可實(shí)現(xiàn)的臨界尺寸,相對(duì)于 0.33 NA 系統(tǒng)的 13nm,0.5 NA EUV 可能低至 8nm。

不幸的是,目前還不存在量產(chǎn)的高數(shù)值孔徑 EUV 光刻機(jī)。在今年五月于 SPIE 上展示的工作中,ASML 和蔡司報(bào)告說(shuō),雖然開(kāi)發(fā)正在按計(jì)劃進(jìn)行,但預(yù)計(jì)要到 2023 年才能安裝第一個(gè)系統(tǒng)。從 0.33NA 到 0.55 NA 的轉(zhuǎn)變沒(méi)有最初引入 EUV 光刻那么激進(jìn),但光刻生態(tài)系統(tǒng)不僅包括對(duì)掃描儀的更改。為了在 2025 年之前將High NA 系統(tǒng)引入批量生產(chǎn),該行業(yè)將需要改進(jìn)光掩模、光刻膠疊層和圖案轉(zhuǎn)移工藝的其他方面。
正在組裝到系統(tǒng)框架中的 EUV 光學(xué)器件。
根本的挑戰(zhàn)是較大的數(shù)值孔徑會(huì)導(dǎo)致 EUV 光子以較低的入射角撞擊晶圓,從而降低焦深。這種較低的角度會(huì)加劇 3D 掩模效果,并使光刻機(jī)中潛像的形成復(fù)雜化。
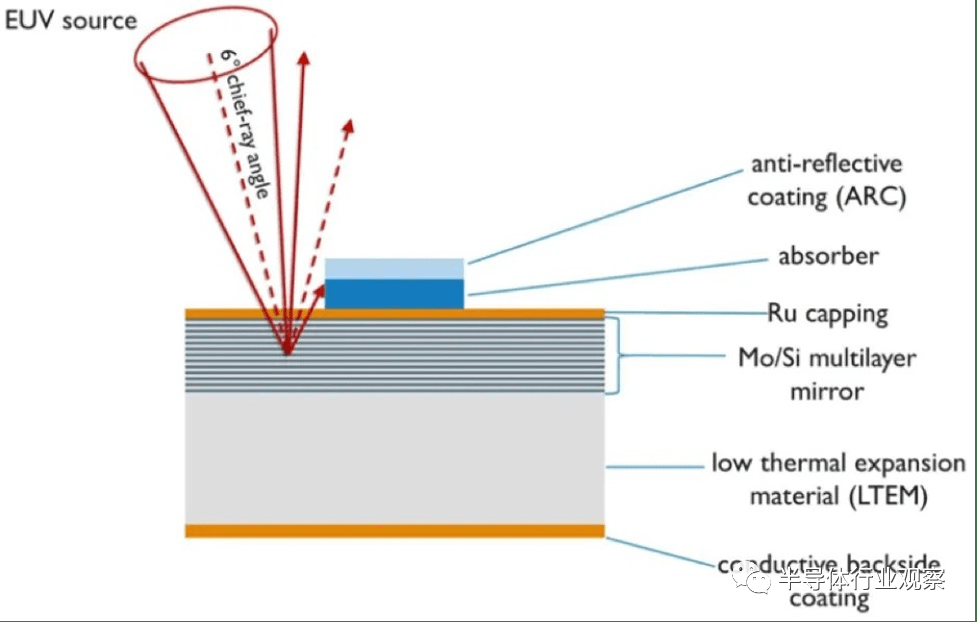
EUV 掩模的橫截面。
審核編輯:劉清
-
光刻機(jī)
+關(guān)注
關(guān)注
31文章
1158瀏覽量
47587 -
EUV
+關(guān)注
關(guān)注
8文章
608瀏覽量
86150 -
ASML
+關(guān)注
關(guān)注
7文章
721瀏覽量
41353
原文標(biāo)題:EUV 光刻技術(shù)的工作過(guò)程
文章出處:【微信號(hào):wc_ysj,微信公眾號(hào):旺材芯片】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
一文看懂EUV光刻

看一下射頻電路中的那些無(wú)源器件
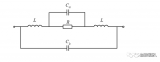
EUV熱潮不斷 中國(guó)如何推進(jìn)半導(dǎo)體設(shè)備產(chǎn)業(yè)發(fā)展?
光刻機(jī)工藝的原理及設(shè)備
EUV光刻工藝終于商業(yè)化 新一代EUV光刻工藝正在籌備
看一下SMART高速計(jì)數(shù)向?qū)У膽?yīng)用
EUV光刻機(jī)還能賣(mài)給中國(guó)嗎?

關(guān)于EUV光刻機(jī)的缺貨問(wèn)題





 看一下EUV光刻的整個(gè)過(guò)程
看一下EUV光刻的整個(gè)過(guò)程










評(píng)論