隨著技術發展,IC的線寬不斷縮小,集成度穩步提高,IC封裝逐步向著超多引腳、窄節距、超小型化方向發展。20世紀90年代中期,一種以球柵陣列封裝(Ball Grid Array,簡稱BGA)、芯片尺寸封裝(Chip Scale Package,簡稱CSP)為代表的新型IC高密度封裝形式問世,從而產生了一種新的封裝載體——封裝基板。
在高階封裝領域,封裝基板已取代傳統引線框架,成為芯片封裝中不可或缺的一部分,不僅為芯片提供支撐、散熱和保護作用,同時為芯片與PCB母板之間提供電子連接,起著“承上啟下”的作用;甚至可埋入無源、有源器件以實現一定系統功能。封裝基板在HDI板的基礎上發展而來,是適應電子封裝技術快速發展而向高端技術的延伸,作為一種高端的PCB,封裝基板具有高密度、高精度、高性能、小型化及薄型化等特點。
根據Prismark數據,2021年全球PCB行業產值為804.49億美元,同比增長23.4%,預計2021-2026年全球PCB行業的復合增長率為4.8%。下游應用中,通訊占比32%,計算機占比24%,消費電子占比15%,汽車電子占比10%,服務器占比10%。 從產品結構來看,IC封裝基板和HDI板雖然占比不高,分別占比17.6%和14.7%,但卻是主要的增長驅動因素。
2021年全球IC封裝基板行業整體規模達141.98億美元、同比增長39.4%,已超過柔性板成為印制電路板行業中增速最快的細分子行業。2021年中國IC封裝基板(含外資廠商在國內工廠)市場規模為23.17億美元、同比增長56.4%,仍維持快速增長的發展態勢。
預計2026年全球IC封裝基板、HDI板的市場規模將分別達到214.35/150.12億美元,2021-2026年的CAGR分別為8.6%/4.9%。預計2026年中國市場IC封裝基板(含外資廠商在國內工廠)市場規模將達到40.19億美元,2021-2026年CAGR為11.6%,高于行業平均水平。
封裝基板與傳統PCB的不同之處在于兩大核心壁壘:加工難度高、投資門檻高。從產品層數、厚度、線寬與線距、最小環寬等維度看,封裝基板未來發展將逐步精密化與微小化,而且單位尺寸小于150*150mm,是更高端的PCB,其中線寬/線距是產品的核心差異,封裝基板的最小線寬/線距范圍在10~130μm,遠遠小于普通多層硬板PCB的50~1000μm。
按照應用領域的不同,封裝基板分為存儲芯片封裝基板、微機電系統封裝基板、射頻模塊封裝基板、處理器芯片封裝基板和高速通信封裝基板等,主要應用于移動智能終端、服務/存儲等。按封裝工藝的不同,封裝基板分為引線鍵合封裝基板(WB)和倒裝封裝基板(FC)等,使用不同封裝工藝與封裝技術生產的封裝基板應用領域不同。引線鍵合(WB)使用細金屬線,利用熱、壓力、超聲波能量為使金屬引線與芯片焊盤、基板焊盤緊密焊合,實現芯片與基板間的電氣互連和芯片間的信息互通,主要應用于射頻模塊、存儲芯片、微機電系統器件封裝;
倒裝(FC)采用焊球連接芯片與基板,即在芯片的焊盤上形成焊球,然后將芯片翻轉貼到對應的基板上,利用加熱熔融的焊球實現芯片與基板焊盤結合,該封裝工藝已廣泛應用于CPU、GPU及Chipset等產品封裝。將封裝工藝與封裝技術結合起來,又可將封裝基板分為不同類型。
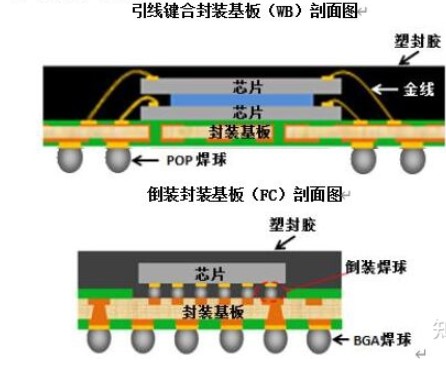
目前全球封裝基板廠商主要分布在日本、韓國和中國臺灣,根據Prismark和集微咨詢數據,2020年封裝基板市場格局較為分散,中國臺灣廠商欣興電子/南亞電路/景碩科技/日月光材料占比分別為15%/9%/9%/4%,產品主要有WB和FC封裝基板;日本廠商揖斐電/新光電氣/京瓷占比分別為11%/8%/5%,產品主要為FC封裝基板;韓國廠商三星電機/信泰電子/大德電子占比分別為10%/7%/5%,產品主要為FC封裝基板。按照FC基板材質又分為BT載板和ABF載板。
BT樹脂全稱為“雙馬來酰亞胺三嗪樹脂”,由日本三菱瓦斯公司研發,雖然BT樹脂專利期已過,但三菱瓦斯公司在BT樹脂研發和應用方面仍處于全球領先地位,BT樹脂主要生產廠商是三菱瓦斯和日立化成。BT樹脂具備高耐熱性(Tg)、抗濕性、低介電常數(Dk)和低散失因素(Df)等多種優勢,但是由于具有玻纖紗層,較ABF材質的FC基板更硬,且布線較麻煩,雷射鉆孔的難度較高,無法滿足細線路要求,但可以穩定尺寸,防止熱脹冷縮而影響線路良率,因此BT材質多用于對于可靠度要求較高的網絡芯片及可程式邏輯芯片。
目前,BT載板多用于手機MEMS芯片、通信芯片、內存芯片、射頻芯片、指紋識別芯片等產品,隨著LED芯片的快速發展,BT載板在LED芯片封裝上的應用也在快速發展。 ABF材料是由Intel主導研發的材料,用于導入Flip Chip等高階載板的生產。ABF是一種低熱膨脹系數、低介電損耗的熱固性薄膜,相比于BT基材,ABF材質可做線路較細、適合高腳數高傳輸的IC,多用于CPU、GPU、FPGA、ASIC等高運算性能芯片。ABF作為增層材料,銅箔基板上面直接附著ABF就可以作線路,也不需要熱壓合過程。
早期ABF載板應用在電腦、游戲機的CPU居多,隨著智能手機崛起和封裝技術改變,ABF產業曾陷入低潮,但在近年網絡速度提升與技術突破,高效能運算新應用浮上臺面,ABF需求再次放大。從產業的趨勢來看,ABF基材可以跟上半導體先進制程的發展,達到細線路、細線寬/線距的要求,未來市場成長潛力可期。
審核編輯:湯梓紅
-
pcb
+關注
關注
4326文章
23161瀏覽量
399991 -
IC封裝
+關注
關注
4文章
185瀏覽量
26820 -
基板
+關注
關注
2文章
287瀏覽量
23105
發布評論請先 登錄
相關推薦
全球半導體市場規模預測
無人叉車的市場規模怎么樣?適合使用agv的企業有哪些共同點?

液壓市場規模穩健增長,博科測試IPO上市迎發展良機
2024年AI IC市場規模預計達1100億美元
最新2024年全球激光加工市場規模將增至240.2億美元
全球半導體市場回暖:預計2024年市場規模將達6000億美元
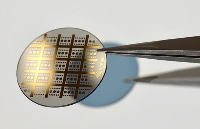
RFID電子標簽預計在2030年全球市場規模將達到75.1億美元

SoC芯片,市場規模大漲

2024年Q2全球芯片市場規模攀升至1500億美元
功率半導體市場迎飛躍,預測2035年市場規模將增4.7倍





 全球IC封裝基板行業市場規模分析
全球IC封裝基板行業市場規模分析











評論