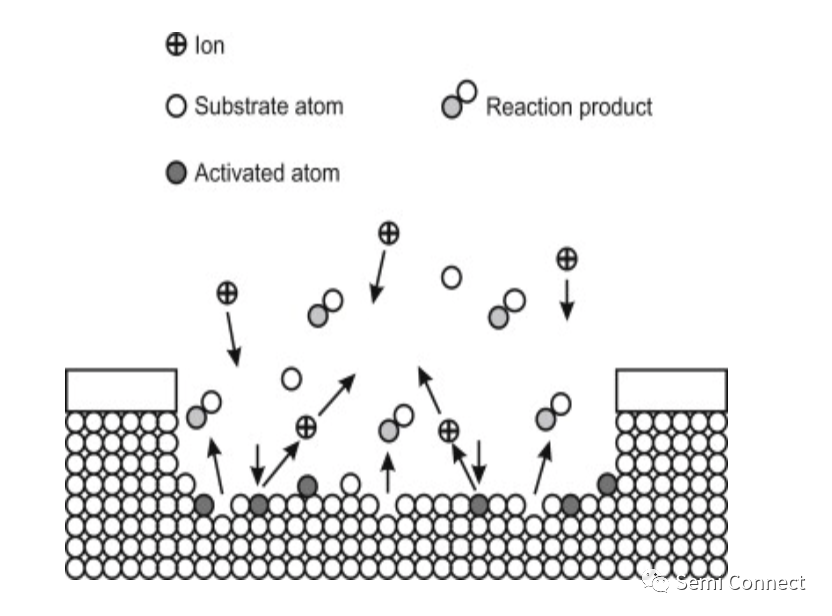
產(chǎn)業(yè)中的干法刻蝕主要是指等離子體刻蝕,即利用增強活性的等離子體對特定物質(zhì)進行刻蝕。大規(guī)模生產(chǎn)工藝中的設(shè)備系統(tǒng)采用的是低溫非平衡態(tài)等離子體。等離子體刻蝕主要采用兩種放電模式,即電容耦合放電 ( Capacitiviely Coupled Plasma, CCP)和電感耦合放電 (Inductively Coupled Plasma, ICP)。在電容耦合放電模式中,等離子體在兩塊平行板電容中通過外加 RF 電源產(chǎn)生和維持放電,通常的氣壓在數(shù)十毫托至數(shù)毫托,電離率小于 10^(-5)。在電感耦合放電模式中,一般在較低氣壓下(數(shù)十亳托),通過電感耦合輸入能量來產(chǎn)生和維持等離子體,通常電離率大于10^(-5),故又稱高密度等離子體。高密度等離子體源也可以通過電子回旋共振(Electron Cyclotron Resonance, ECR)和回旋波(Helicon Wave)放電得到。高密度等離子體通過外加 RF 或微波電源和基片上的射頻偏壓電源,獨立控制離子流量和離子轟擊能量,可以優(yōu)化刻蝕工藝的刻蝕率和選擇比,同時降低刻蝕損傷。
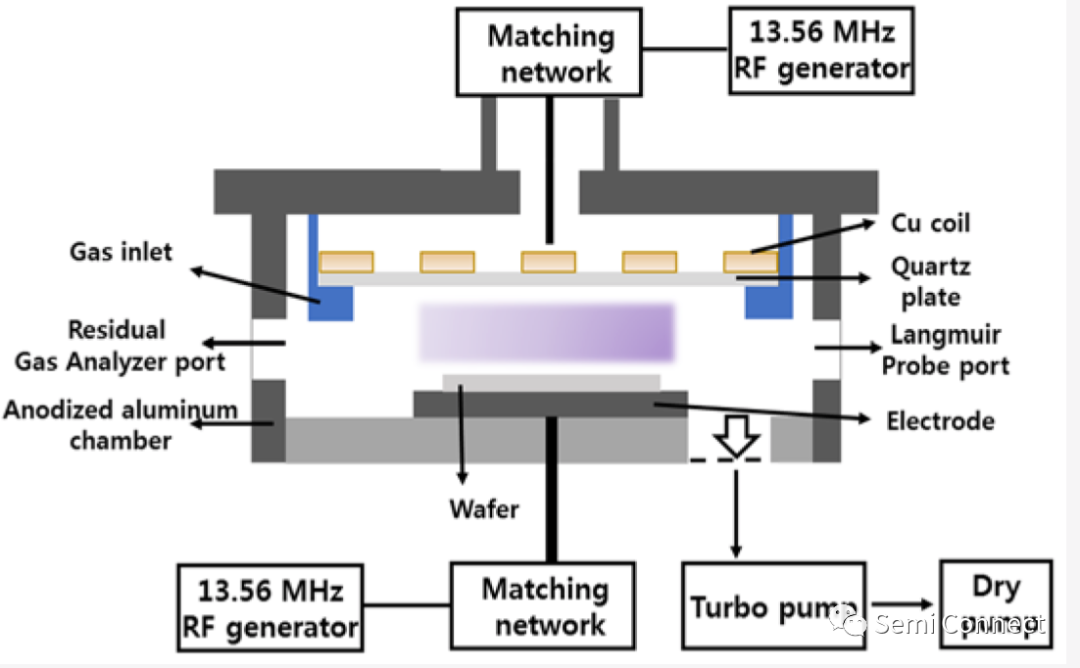
干法刻蝕工藝流程為,將刻蝕氣體注入真空反應(yīng)室,待壓力穩(wěn)定后,利用射頻輝光放電產(chǎn)生等離子體;受高速電子撞擊后分解產(chǎn)生自由基,并擴散到圓片表面被吸附。在離子轟擊作用下,被吸附的自由基與圓片表面的原子或分子發(fā)生反應(yīng),從而形成氣態(tài)副產(chǎn)品,該副產(chǎn)品從反應(yīng)室中被排出。干法刻蝕工藝可以分為如下 4類。
(1)物理濺射刻蝕:主要依靠等離子體中的載能離子轟擊被刻蝕材料的表面,濺射出的原子數(shù)量取決于入射粒子的能量和角度。當能量和角度不變時,不同材料的濺射率通常只有2~3倍的差異,因此沒有選擇性特征。反應(yīng)過程以各向異性為主。
(2)化學(xué)刻蝕:等離子體提供氣相的刻蝕原子和分子,與物質(zhì)表面產(chǎn)生化學(xué)反應(yīng)后產(chǎn)生揮發(fā)性氣體,例如: Si(固態(tài))+ 4F ——> SiF4(氣態(tài)) 光刻膠 + O(氣態(tài))——> CO2(氣態(tài))+ H2O(氣態(tài)) 這種純化學(xué)的反應(yīng)具有良好的選擇性,在不考慮晶格結(jié)構(gòu)時,呈現(xiàn)各向同性特征。
(3)離子能量驅(qū)動刻蝕:離子既是產(chǎn)生刻蝕的粒子,又是載能粒子。這種載能粒子的刻蝕效率比單純的物理或化學(xué)刻蝕要高一個量級以上。其中,工藝的物理和化學(xué)參數(shù)的優(yōu)化是控制刻蝕過程的核心。
(4) 離子-阻擋層復(fù)合刻蝕:主要是指在刻蝕過程中有復(fù)合粒子產(chǎn)生聚合物類的阻擋保護層。等離子體在刻蝕工藝過程中需要有這樣的保護層來阻止側(cè)壁的刻蝕反應(yīng)。例如,在Cl 和Cl2刻蝕中加入C,可以在刻蝕中產(chǎn)生氯碳化合物層來保護側(cè)壁不被刻蝕。 干法清洗 (Dry Cleaning)主要是指等離子體清洗。通過等離子體中的離子轟擊被清洗表面,加上激活狀態(tài)的原子、分子與被清洗表面相互作用,從而實現(xiàn)去除和灰化光刻膠。與干法刻蝕不同的是,干法清洗工藝參數(shù)中通常不包括方向的選擇性,因此工藝設(shè)計相對較為簡單。大生產(chǎn)工藝中,主要采用氟基氣體和氧或氫為反應(yīng)等離子體的主體,此外加入含有一定數(shù)量的氬等離子體,可以增強離子轟擊效果,從而提高清洗效率。
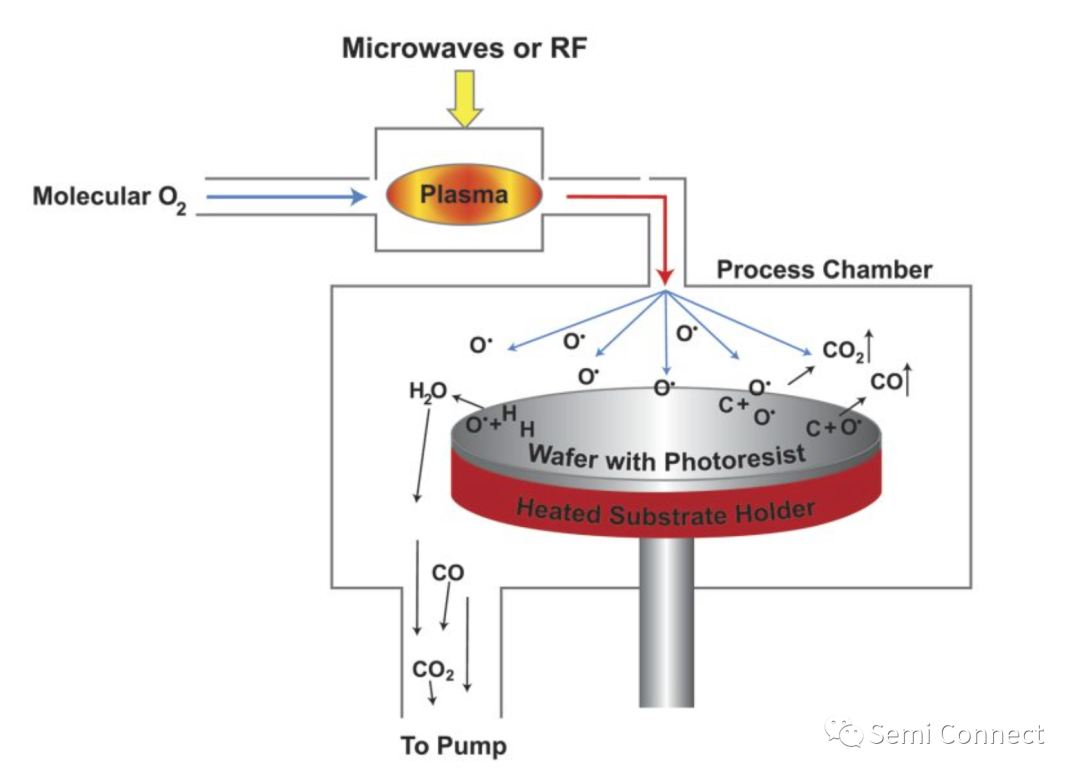
在等離子干法清洗工藝中,通常采用遠程等離子體 (Remote Plasma)的方法。這是因為清洗工藝中希望降低等離子體的轟擊效果,以控制離子轟擊引起的損傷;而化學(xué)自由基的反應(yīng)得到增強,則可以提高清洗的效率。遠程等離子體可以利用微波在反應(yīng)腔室外生成穩(wěn)定且高密度的等離子體,產(chǎn)生大量的自由基進入反應(yīng)腔體實現(xiàn)清洗需要的反應(yīng)。產(chǎn)業(yè)中干法清洗氣源大多采用氟基氣體,如NF3等,在微波等離子體中有99%上的 NF3被分解。干法清洗工藝中幾乎沒有離子轟擊效應(yīng),故有利于保護硅片免受損傷及延長反應(yīng)腔體壽命。
審核編輯 :李倩
-
等離子體
+關(guān)注
關(guān)注
0文章
126瀏覽量
14275 -
刻蝕
+關(guān)注
關(guān)注
2文章
192瀏覽量
13178
原文標題:干法刻蝕和清洗(Dry Etch and Cleaning)
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
干法刻蝕的概念、碳硅反應(yīng)離子刻蝕以及ICP的應(yīng)用

后段刻蝕工藝(BEOL ETCH)詳解
半導(dǎo)體濕法和干法刻蝕
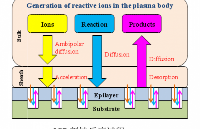
干法刻蝕時側(cè)壁為什么會彎曲
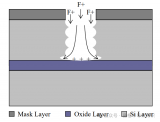
芯片制造中的濕法刻蝕和干法刻蝕

干法刻蝕側(cè)壁彎曲的原因及解決方法

晶圓表面溫度對干法刻蝕的影響

干法刻蝕工藝的不同參數(shù)
為什么干法刻蝕又叫低溫等離子體刻蝕

半導(dǎo)體干法刻蝕技術(shù)解析

半導(dǎo)體芯片制造技術(shù)之干法刻蝕工藝詳解
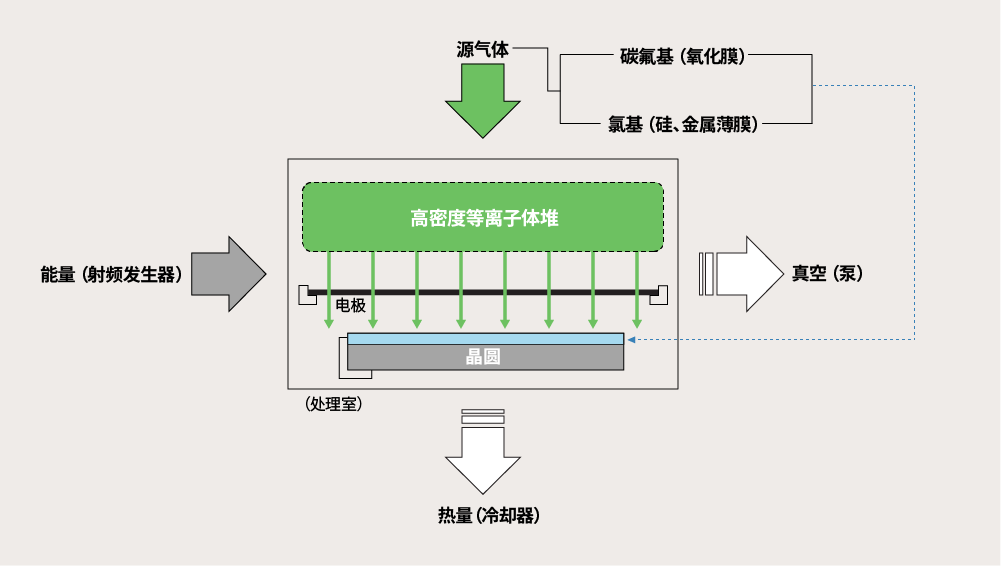




 干法刻蝕和清洗(Dry Etch and Cleaning)
干法刻蝕和清洗(Dry Etch and Cleaning)

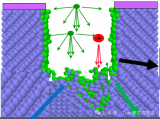

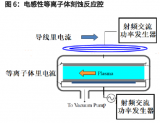










評論