雙鑲嵌 (Dual-Damascene)和多層金屬互連接 (Multi-Interconnection)通孔-1(V1)和金屬-2 (M2)互連的形成是通過雙鑲嵌 (Dual -Damascene)工藝實現的,如圖所示。
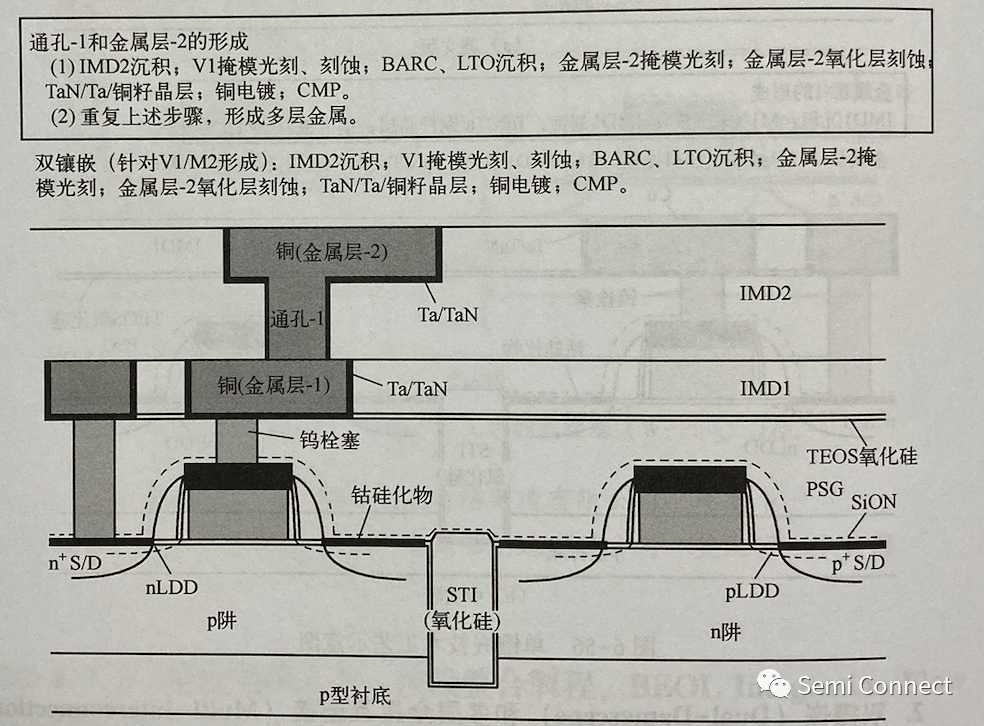
雙鑲嵌工藝分為先通孔 (Via-First) 和先溝槽(Trench-First)兩種技術。以先通孔技術為例,首先沉積IMD2層(如 SiCN層,厚度約為 50nm,含碳低kPECVD 氧化硅黑金剛石層厚度約為 600nm),然后形成V1的圖形并進行刻蝕。多層IMD1 的主要作用是提供良好的密封和覆蓋更加多孔的低k介質。 為了平坦化,需要在通孔中填充底部抗反射涂層 (Bottom-Ani-Rellective Coatings, BARC),并沉積一層 LTO (Low Temperature Oxide)。隨后形成M2 的圖形并刻蝕氧化物,去除 BARC 并清洗后,沉積 Ta / TaN 阻擋層和 Cu 籽晶層,隨后進行 Cu 填充(使用 ECP 法),并進行 CMP 平坦化,這樣 M2 互連就形成了。 通過重復上述步驟,可以實現多層銅互連。相應的,先溝槽技術的雙鑲嵌工藝就是先實施 M2 溝槽制備再形成 V1 的圖形并刻蝕氧化物,然后沉積阻擋層和籽晶層,最后進行 Cu 填充和 CMP 平坦化。
審核編輯 :李倩
-
工藝
+關注
關注
4文章
603瀏覽量
28894 -
金屬
+關注
關注
1文章
604瀏覽量
24356
原文標題:后段集成工藝(BEOL Integration Flow)- 2
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
AMD Versal自適應SoC器件Advanced Flow概覽(下)

集成電路新突破:HKMG工藝引領性能革命

FinFet Process Flow-源漏極是怎樣形成的
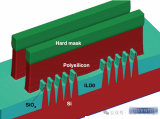
AMD Versal自適應SoC器件Advanced Flow概覽(上)

后段刻蝕工藝(BEOL ETCH)詳解
大馬士革銅互連工藝詳解

U50的AMD Vivado Design Tool flow設置

晶合集成28納米邏輯工藝通過驗證
ERAY (FlexRay) 模塊卡在INTEGRATION_LISTEN狀態,為什么?
什么數據集成(Data Integration):如何將業務數據集成到云平臺?
通過工藝建模進行后段制程金屬方案分析





 后段集成工藝(BEOL Integration Flow)- 2
后段集成工藝(BEOL Integration Flow)- 2

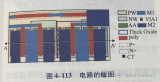










評論