來源:
集成電路封測是集成電路產品制造的后道工序,包含封裝與測試兩個主要環節。集成電路封裝是指將集成電路與引腳相連接以達到連接電信號的目的,并使用塑料、金屬、陶瓷、玻璃等材料制作外殼保護集成電路免受外部環境的損傷。集成電路封裝不僅起到集成電路芯片內鍵合點與外部進行電氣連接的作用,也為集成電路提供了一個穩定可靠的工作環境,使集成電路能夠發揮正常的功能,并保證其具有高穩定性和可靠性。集成電路封裝質量的好壞,對集成電路總體性能影響較大。 一、集成電路封裝的分類 由于不同集成電路產品電性能、尺寸、應用場景等因素各不相同,因此造成封裝形式多樣復雜。根據是否具有封裝基板以及封裝基板的材質,集成電路封裝產品可以分為四大類,即陶瓷基板產品、引線框架基板產品、有機基板產品和無基板產品。其中陶瓷基板產品、引線框架基板產品和有機基板產品都可以分為倒裝封裝和引線鍵合封裝兩種方式,而無基板產品又可具體分為扇出型封裝(Fan-out)和扇入型晶圓級芯片尺寸封裝(Fan-inWLCSP)兩類。
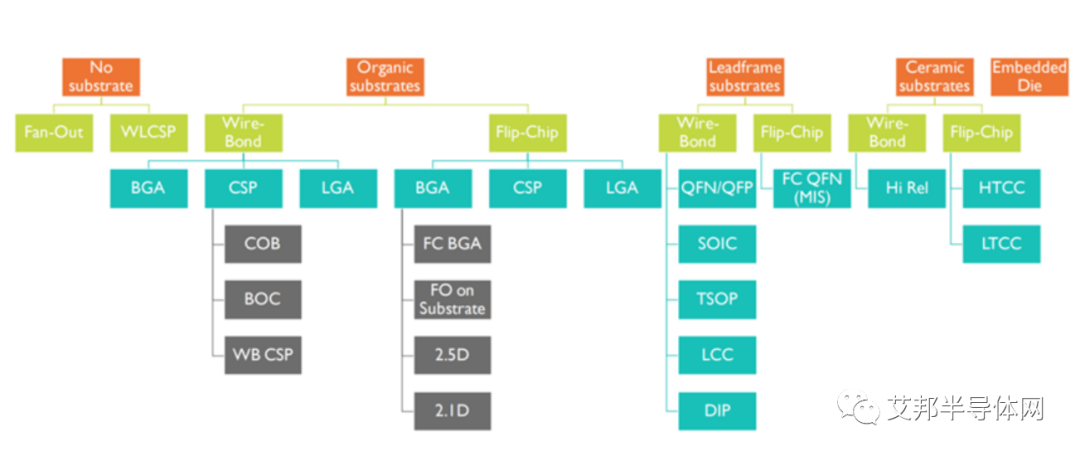
△集成電路封裝形式的分類,來源:Yole 在業內,先進封裝技術與傳統封裝技術主要以是否采用焊線(即引線焊接)來區分,傳統封裝一般利用引線框架作為載體,采用引線鍵合互連的形式進行封裝,即通過引出金屬線實現芯片與外部電子元器件的電氣連接;而先進封裝主要是采用倒裝等鍵合互連的方式來實現電氣連接。先進封裝利用先進的設計思路和先進的集成工藝,對芯片進行封裝級重構,并且能有效提升系統的功能密度。相較于傳統封裝形式,先進封裝的主要優點有封裝集成度高、封裝體積小、內部連接短,且系統性強、功率密度高等,迎合了集成電路微小化、復雜化、集成化的發展趨勢。
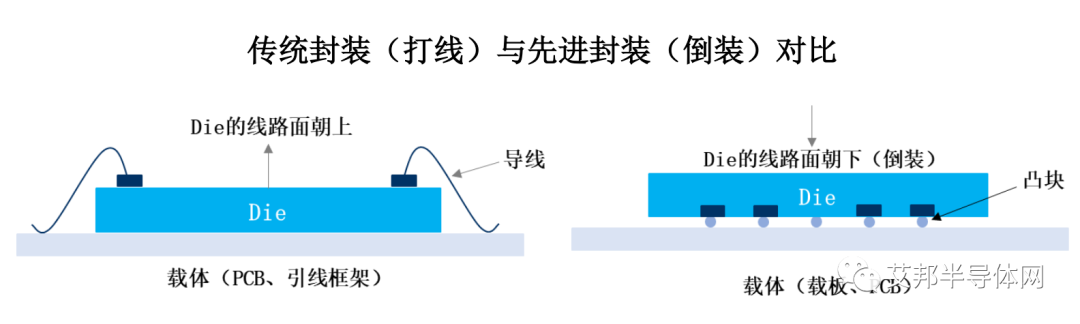
二、集成電路封裝技術的演變 集成電路封裝技術經過數十年來的發展和演變,總體可歸納為從有線連接到無線連接、從芯片級封裝到晶圓級封裝、從二維封裝到三維封裝,具體的技術演變可大致分為以下五個階段:
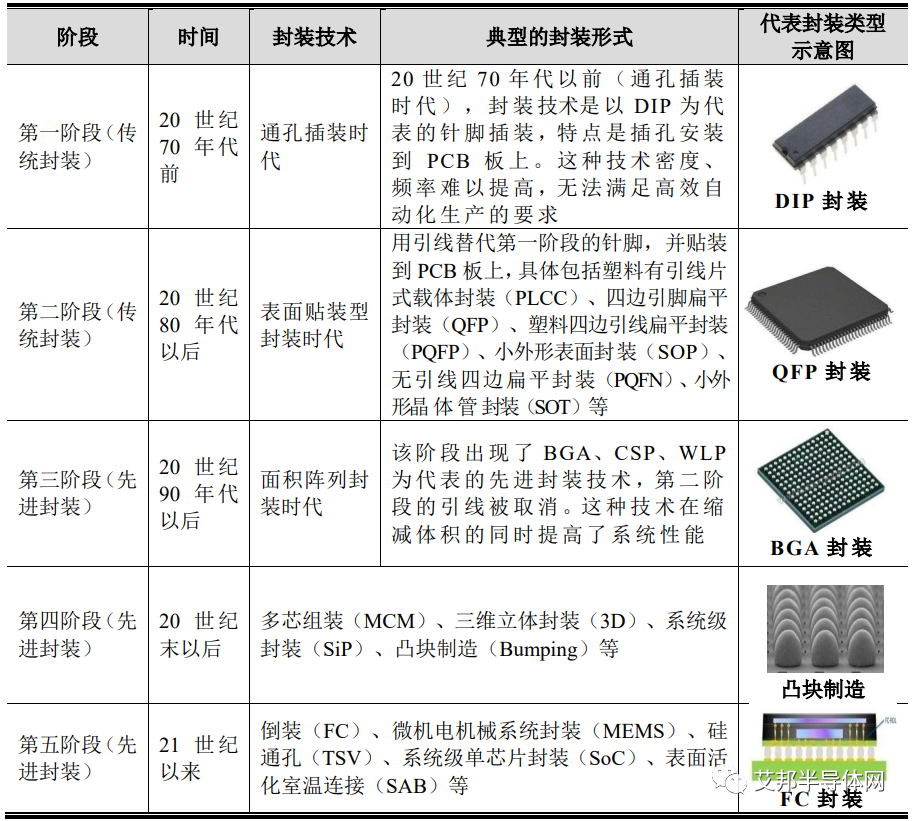
從第三階段起的封裝技術可統稱為先進封裝技術。目前全球半導體封裝的主流仍處在第三階段的成熟期和快速發展期,CSP、BGA、WLP等主要先進封裝技術進入大規模生產階段,同時向以系統級封裝(SiP)、倒裝(FC)、凸塊制造(Bumping)、硅通孔(TSV)為代表的第四、第五階段發展。而中國大陸封裝企業目前大多數以第一、第二階段的傳統封裝技術為主,例如DiP、SOP等,產品定位中低端,技術水平較國外領先企業具有一定差距。
-
集成電路
+關注
關注
5392文章
11622瀏覽量
363183 -
封裝
+關注
關注
127文章
7992瀏覽量
143406
原文標題:集成電路封裝的分類與演進
文章出處:【微信號:wc_ysj,微信公眾號:旺材芯片】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦




 集成電路封裝的分類與演進
集成電路封裝的分類與演進
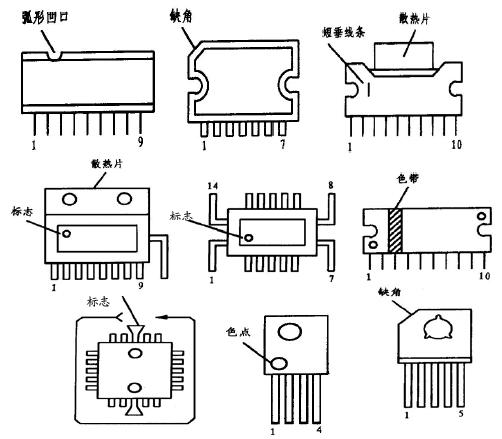











評論