引言
反應離子蝕刻 (RIE)是一種干法蝕刻工藝,與半導體工業中使用的互補金屬氧化物半導體(CMOS)方法兼容。在不希望濕法蝕刻造成金屬污染或濕法蝕刻無法提供所需方向性的情況下,RIE通常用于從基板上去除硅。RIE使用與硅反應形成揮發性物質的活性氣體,揮發性物質被抽走,從而去除硅。該反應是準各向同性的,因為硅的去除通常在所有方向幾乎均等地發生。由于在創建納米孔或溝槽等高縱橫比結構時不希望出現各向同性,因此需要額外的步驟來使蝕刻工藝各向異性。
實驗
為了測試不同的蝕刻參數,蝕刻和分析了所謂的“easycleave”結構。如圖1所示,Easycleave 是一塊1 cm x 2 cm 的硅晶片,帶有50 nm 厚的帶有孔陣列的鉻蝕刻掩模。孔徑在原始晶格的軸之間以84.5°的角度排列。這種非 90° 角確保沿著晶圓晶面的切割總是會穿過一些孔隙,因此得名 easycleave。蝕刻掩模由11種不同直徑的圓形孔陣列組成。對于每個直徑,最多有7個不同孔間距的陣列。因此,easycleave掩模提供了廣泛的結構參數來嚴格測試蝕刻程序和參數。(江蘇英思特半導體科技有限公司)
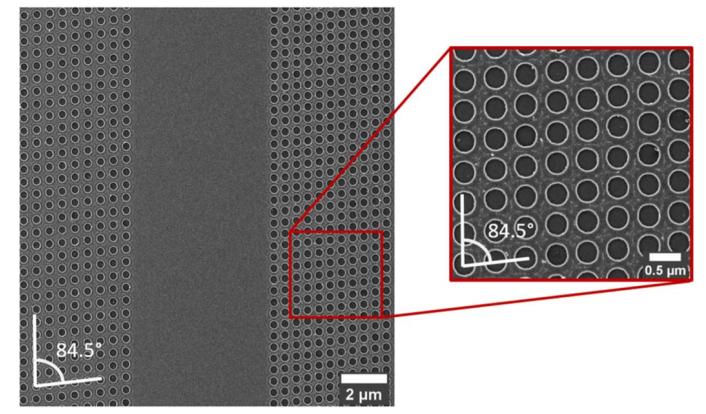
圖1。一個易切割樣品的掃描電鏡圖像
由于蝕刻儀器專為使用4英寸晶圓而設計,因此有必要使用載體晶圓來固定易切割樣品。載體晶圓(110,p摻雜硅,4 英寸,500 nm厚)涂有一層正光刻膠,該光刻膠以4000 rpm 的速度旋涂,并在 120 °C 下硬烘烤10分鐘。光致抗蝕劑可防止載體晶圓被蝕刻,從而避免因高硅負載而產生的不必要的蝕刻現象,并確保晶圓的可重復使用性。
結果和討論
如圖2(a)和3所示,孔變寬發生在納米孔長度的中間部分,并且可能發生在沒有掩模底切或錐形的納米孔中。在較寬的納米孔中,例如 500 nm 直徑,這種現象主要表現為孔中間部分的粗糙外觀,如圖2(a) 中突出顯示的那樣。在較小直徑的納米孔中,這種粗糙度使孔的中間部分變寬,直徑大于掩模的直徑。這種粗糙度和加寬僅影響納米孔的中間部分。(江蘇英思特半導體科技有限公司)
在整個研究中觀察到的所有情況下,扇貝都可以在孔的底部看到,并且通常直徑已經恢復到面具的直徑甚至更小。為了闡明在蝕刻過程中何時開始形成這種粗糙度,循環數從N= 200 逐漸減少,其中粗糙度在10到12個扇貝后開始,減少到N= 50。即使通過N= 50個循環,在10到12個扇貝之后,粗糙度遮蓋了扇貝。這表明粗糙度不僅是由創建高縱橫比結構所需的較長蝕刻時間引起的偽影,而且在蝕刻過程中相對較早地出現。
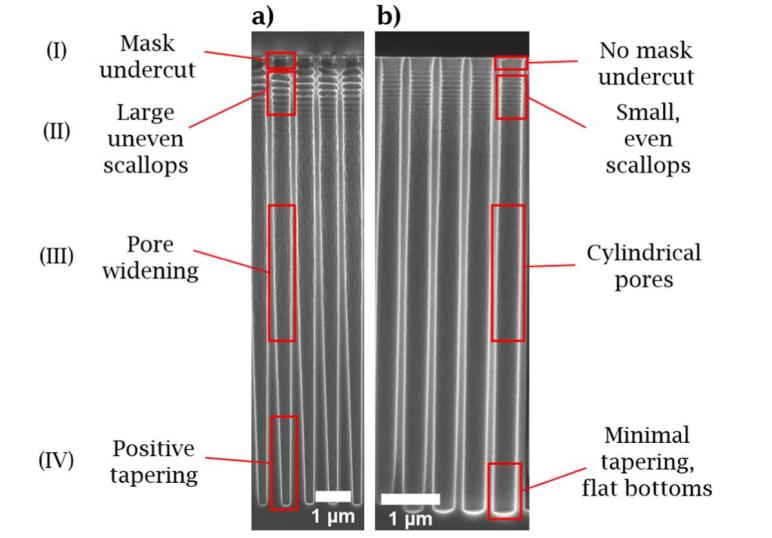
圖2。(a)對d = 360 nm掩模直徑的掃描電鏡圖像,(b)用d = 360 nm掩模直徑測量的孔隙圖像。
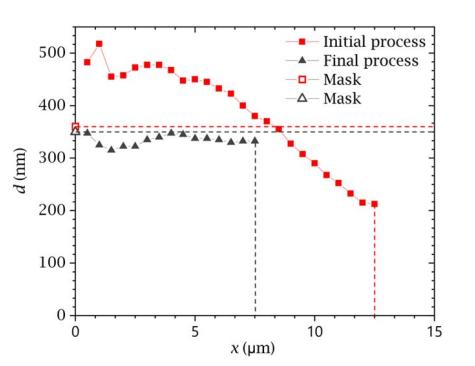
圖3 納米孔的直徑d與納米孔內的深度x的μm相比
結論
在這項工作中,研究并優化了蝕刻工藝以在硅中蝕刻圓柱形納米孔,直徑在280和500 nm之間,深度約為7 μ m,這些樣品非常適合用于實現硅納米光子學的納米結構。
與完美圓柱體的剩余偏差在公差范圍內以創建具有高反射率和明確定義的光子帶隙的光子晶體。稍短的長度對于我們的應用來說仍然足夠,并且可以通過增加循環次數來進一步改進,盡管這樣做需要進一步優化。目前的優化是通過操縱多個蝕刻參數并將2步工藝轉移到3步DREM Bosch工藝來實現的。在未來的工作中,可以通過使用對硅具有化學惰性的氣體(例如氬氣)來進一步改進三步法,以確保去除碳氟化合物,但不會對硅進行化學蝕刻,從而真正分離去除和蝕刻步驟。以指數方式而不是線性方式調整參數的能力也會提供更多的自由度。我們預見到轉向4步DREAM(存款、移除)添加氧等離子體步驟以通過形成氧化硅層進一步保護壁,還可以提供更多途徑來進一步改善和擴展納米結構的 RIE。(江蘇英思特半導體科技有限公司)
江蘇英思特半導體科技有限公司主要從事濕法制程設備,晶圓清潔設備,RCA清洗機,KOH腐殖清洗機等設備的設計、生產和維護。
審核編輯黃宇
-
半導體
+關注
關注
334文章
27703瀏覽量
222624 -
蝕刻
+關注
關注
9文章
419瀏覽量
15508
發布評論請先 登錄
相關推薦
高頻高精度圓柱形音圈電機
我國研制出超大容量圓柱形400Ah鋰電池
《仿真分析小技巧9》---圓柱形器件的精確計算
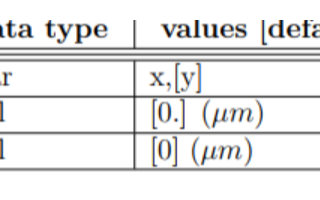
反應離子蝕刻的實用方法報告
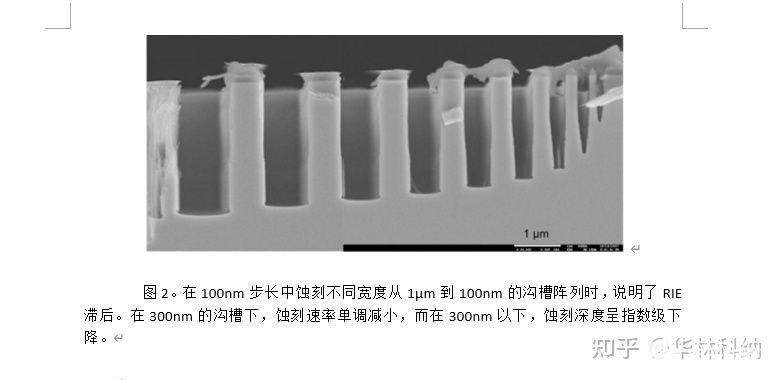
Mighty Mouse微型圓柱形連接器和電纜
4680圓柱形鋰電池的優缺點
同茂圓柱形音圈電機中動磁式和動圈式怎么區分





 光子晶體用硅中圓柱形納米孔的深反應離子蝕刻
光子晶體用硅中圓柱形納米孔的深反應離子蝕刻















評論