倒裝芯片工藝是指通過在芯片的I/0 焊盤上直接沉積,或者通過 RDL 布線后沉積凸塊(包括錫鉛球、無鉛錫球、銅桂凸點(diǎn)及金凸點(diǎn)等),然后將芯片翻轉(zhuǎn),進(jìn)行加熱,使熔融的焊料與基板或框架相結(jié)合,將芯片的 I/0 扇出成所需求的封裝過程。倒裝芯片封裝產(chǎn)品示意圖如圖所示。

倒裝芯片技術(shù)于 20 世紀(jì) 60年代由 IBM 率先研發(fā)出來,20 世紀(jì)90 年代后期形成規(guī)模化量產(chǎn),主要應(yīng)用于高端領(lǐng)域產(chǎn)品(如 CPU、GPU 等)。隨著銅柱凸點(diǎn)技術(shù)的出現(xiàn),結(jié)合消費(fèi)類智能電子產(chǎn)品 (如手機(jī)、可穿戴產(chǎn)品等)的快速發(fā)展及產(chǎn)品性能的需求,越來越多的產(chǎn)品從傳統(tǒng)的引線鍵合封裝轉(zhuǎn)向了倒裝芯片封裝。
與傳統(tǒng)的引線鍵合工藝相比,倒裝芯片封裝工藝具有如下優(yōu)點(diǎn)。
(1)VO 密度高。
(2) 由于采用了凸點(diǎn)結(jié)構(gòu),互連長(zhǎng)度大大縮短,互連線電阻、電感更小,封裝的電性能得到極大的改善
(3) 芯片中產(chǎn)生的熱量可通過焊料凸點(diǎn)直接傳輸?shù)椒庋b襯底上,因此芯片溫度會(huì)降低。
倒裝芯片包括許多不同的工藝方法。目前,業(yè)界倒裝芯片的凸點(diǎn)技術(shù)主要有金凸點(diǎn)、錫凸點(diǎn)及銅柱凸點(diǎn),對(duì)應(yīng)的焊接工藝主要為超聲波熱壓焊、回流焊及熱壓焊。由于技術(shù)的發(fā)展和產(chǎn)品的不同,底部填充工藝主要分為毛細(xì)底部填充、塑封底部填充、非導(dǎo)電型膠水(NCP)或膠膜 (NCF)底部填充。圖所示為凸點(diǎn)示意圖。
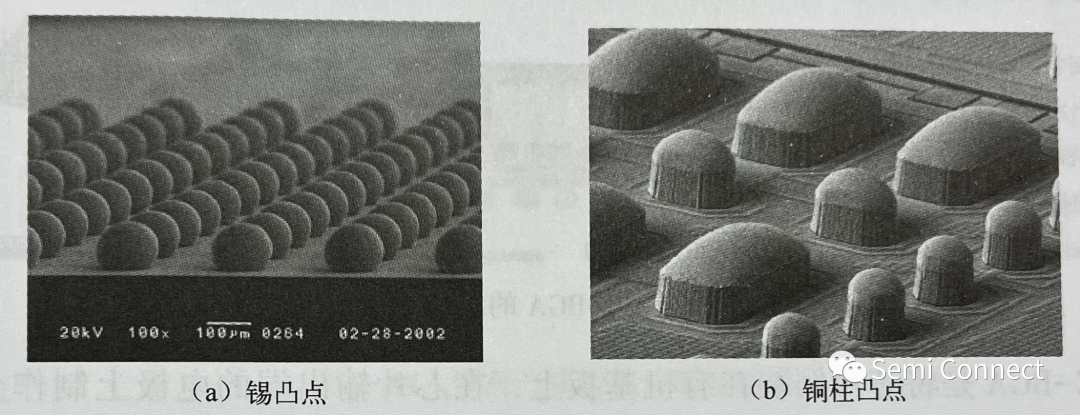
隨著圓片 CMOS 工藝不斷向 16nm、10nm、7nm 等高密度方向發(fā)展,對(duì)芯片V0的密度和性能要求越來越高,這都需要產(chǎn)品采用倒裝工藝來滿足芯片的需求。倒裝芯片對(duì)高密度微凸點(diǎn)技術(shù)、小節(jié)距倒裝芯片鍵合技術(shù)及底部填充技術(shù)等方面的封裝工藝及可靠性的要求也越來越高。每種工藝方法都有不同之處,且應(yīng)用范圍也有所不同。例如,就電路板或基板類型的選擇而言,無論它是有機(jī)材料、陶瓷材料還是柔性材料,都決定著組裝材料(包括凸點(diǎn)類型、焊劑底部填充材料等)的選擇,而且在一定程度上還決定著所需設(shè)備的選擇。因此,未來倒裝芯片的封裝需要結(jié)合產(chǎn)品應(yīng)用、芯片設(shè)計(jì)、封裝設(shè)計(jì)、封裝材料、封裝設(shè)備及封裝工藝來共同選擇工藝組合,以找到最優(yōu)的封裝方案。
如今,倒裝芯片技術(shù)已廣泛應(yīng)用于消費(fèi)類電子領(lǐng)域,未來在物聯(lián)網(wǎng)、汽車電子、大數(shù)據(jù)等方面的應(yīng)用也會(huì)更廣泛,倒裝芯片封裝被認(rèn)為是推進(jìn)低成本高密度便攜式電子設(shè)備制造所必需的一項(xiàng)工藝。
審核編輯:湯梓紅
-
芯片
+關(guān)注
關(guān)注
456文章
51170瀏覽量
427250 -
CMOS
+關(guān)注
關(guān)注
58文章
5735瀏覽量
236090 -
焊盤
+關(guān)注
關(guān)注
6文章
557瀏覽量
38216 -
倒裝芯片
+關(guān)注
關(guān)注
1文章
92瀏覽量
16310 -
封裝工藝
+關(guān)注
關(guān)注
3文章
58瀏覽量
8012
原文標(biāo)題:倒裝芯片工藝,覆晶製程, Flip Chip Process
文章出處:【微信號(hào):Semi Connect,微信公眾號(hào):Semi Connect】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
什么是倒裝芯片 倒裝芯片技術(shù)的優(yōu)點(diǎn) 倒裝芯片封裝工藝流程

倒裝晶片的組裝工藝流程
倒裝芯片與表面貼裝工藝
倒裝芯片的特點(diǎn)和工藝流程
芯片封裝工藝流程是什么
芯片倒裝Flip Chip封裝工藝簡(jiǎn)介

淺談芯片倒裝Flip Chip封裝工藝
淺談FCCSP倒裝芯片封裝工藝

倒裝封裝(Flip Chip)工藝:半導(dǎo)體封裝的璀璨明星!





 淺談倒裝芯片封裝工藝
淺談倒裝芯片封裝工藝













評(píng)論