高電流的硅或錯離子注入將嚴重破壞單晶體的晶格結構,并在晶圓表面附近產生非晶態層。硅或錯的非晶態注入過程可以完全消除通道效應,因為在非晶態襯底中,摻雜物界面的分布輪廓由離子注入形成,一般遵循高斯分布,這是可以預測、重復和控制的。
這種預先非晶態注入的方式增加了額外的離子注入步驟,使生產成本增加。當特征尺寸不斷縮小時,熱退火的熱積存也減少了。對于納米節點技術,可能沒有足夠的熱積存通過退火恢復預非晶注入引起的晶體損傷,殘留的缺陷可能導致結的漏電。
損傷與熱退火
離子注入過程中,離子因為與晶格原子碰撞逐漸失去能量,同時會將能量轉移給碰撞原子。這些轉移的能量會使碰撞原子從晶格的束縛能中釋放出來,通常的束縛能為25eV左右。這些自由原子在襯底內運行時會與其他的晶格原子產生碰撞,并通過轉移足夠的能量將碰撞原子從晶格碰離出來。這些過程將持續進行,直到沒有任何一個自由原子有足夠的能量把其他的晶格原子釋放岀來為止。高能量的離子可以使數千晶格原子的位置偏離。高能量的注入離子所產生的損傷如下圖所示。
由單一離子造成的損傷可以在室溫下通過襯底內原子的熱運動很快自我退火而消除。然而在離子注入過程中,離子總數非常大,以至于單晶襯底中靠近表面部分造成大量的晶格損傷,進而使單晶硅變成非晶態,退火過程無法在短時間內修復晶體的損傷。損傷的效應與劑量、能量和離子的質量有關,會隨劑量與離子能量的增大而增加。如果注入的劑量過高,靠近襯底表面的離子射程內,襯底的晶體結構會完全被破壞而變成非晶態。
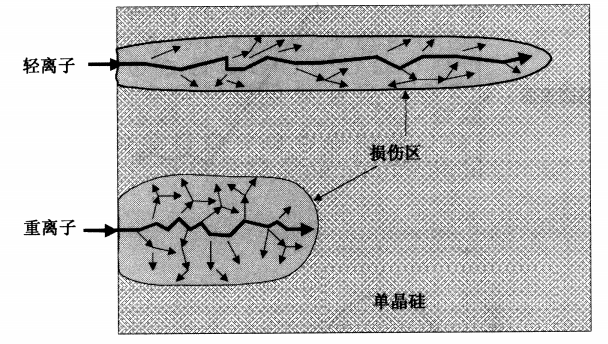
為了達到元器件設計的要求,晶格損傷必須在熱退火過程中修復成單晶結構并激活摻雜物。只有當摻雜物原子在單晶體晶格位置時,才能有效提供電子或空穴作為電流的主要載體。高溫過程中,原子能從熱能中獲得能量并進行快速熱運動。當運動到單晶晶格中具有最低自由能的位置時,就將停留在此位置。
因為在沒有被破壞的襯底下是單晶硅,所以被破壞的非晶態層中的硅與摻雜物原子,將在靠近單晶硅界面位置通過落入晶格位置且被晶格能束縛后重建單晶結構。下圖說明了在熱退火過程中的晶體復原及摻雜物的激活情況。

高溫過程中,單晶體的熱退火、摻雜物原子的激活和摻雜物原子的擴散將同時發生。當集成電路的圖形尺寸縮小到深亞微米時,將只有極小的空間使摻雜物原子擴散,因此必須在加熱退火過程中將摻雜物的擴散減到最小。
摻雜物原子在非晶硅中具有不受限制的自由熱移動,比在單晶體晶格中的擴散快,這是因為單晶體晶格的束縛能將嚴重限制摻雜物原子的運動。當溫度較低時,擴散過程將快于退火過程;而當溫度較高時,例如高于1000攝氏度,退火過程比擴散過程快,這是因為退火的激活能(約5eV)比擴散的激活能(3?4eV)高。
審核編輯:劉清
-
單晶硅
+關注
關注
7文章
191瀏覽量
28364
原文標題:半導體行業(一百七十六)之離子注入工藝(六)
文章出處:【微信號:FindRF,微信公眾號:FindRF】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
離子注入工藝的設計與計算簡介
退火工藝(Thermal Annealing)介紹
6.1.6 離子注入及后續退火過程中的缺陷行成∈《碳化硅技術基本原理——生長、表征、器件和應用》





 離子注入工藝的損傷與熱退火
離子注入工藝的損傷與熱退火



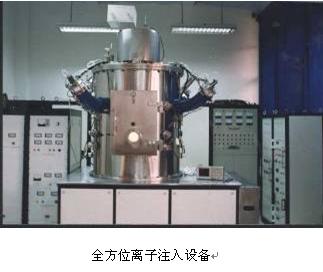

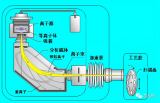











評論