01GaN 異質(zhì)襯底外延生長方法
由于GaN在高溫生長時(shí)N的離解壓很高,很難得到大尺寸的GaN單晶材料,因此,為了實(shí)現(xiàn)低成本、高效、高功率的GaN HEMTs器件,研究人員經(jīng)過幾十年的不斷研究,并不斷嘗試?yán)貌煌耐庋由L方法在Si襯底上實(shí)現(xiàn)高質(zhì)量的外延生長GaN基材料。GaN材料的生長是在高溫下,通過TMGa分解出的Ga與NH3的化學(xué)反應(yīng)實(shí)現(xiàn)的,生長GaN需要一定的生長溫度,且需要一定的NH3分壓。
當(dāng)前GaN的外延生長方法有:氫化物外延生長法(HVPE)]、分子束外延(MBE)和金屬有機(jī)化學(xué)氣相沉積法(MOCVD),其特點(diǎn)如下表2-1所示。
1.1 金屬有機(jī)物氣相沉積法(MOCVD)
MOCVD(金屬有機(jī)物氣相沉積法)是在氣相外延生長的基礎(chǔ)上發(fā)展起來的一種新型氣相外延生長技術(shù)。在采用MOCVD法制備GaN單晶的傳統(tǒng)工藝中,通常以三甲基鎵作為鎵源,氨氣作為氮源,以Si作為襯底,并用氫氣和氮?dú)獾幕旌蠚怏w作為載氣,將反應(yīng)物載入反應(yīng)腔內(nèi),加熱到一定溫度下使其發(fā)生反應(yīng),能夠在襯底上生成GaN的分子團(tuán),在襯底表面上吸附、成核、生長,最終形成一層GaN單晶薄膜。采用MOCVD法制備的產(chǎn)量大,生長周期短,適合用于大批量生產(chǎn),但生長完畢后需要進(jìn)行退火處理,最后得到的薄膜可能會(huì)存在裂紋,會(huì)影響產(chǎn)品的質(zhì)量。
1.2 分子束外延法(MBE)
用MBE法(分子束外延法)制備GaN與MOCVD法類似,主要的區(qū)別在于鎵源的不同。MBE法的鎵源通常采用Ga的分子束,NH3作為氮源,制備方法與MOCVD法相似,也是在襯底表面反應(yīng)生成GaN。用該方法可以在較低的溫度下實(shí)現(xiàn)GaN的生長,一般為700 ℃左右。較低的溫度可以有效減少反應(yīng)設(shè)備中NH3的揮發(fā)程度,但低溫使得分子束與NH3的反應(yīng)速率減小。較小的反應(yīng)速率可以在制備過程中對生成GaN 膜的厚度進(jìn)行精確控制,有利于對該工藝中的生長機(jī)理進(jìn)行深入研究,但對于外延層較厚的膜來說反應(yīng)時(shí)間會(huì)比較長,在生產(chǎn)中發(fā)揮的效率欠佳,因此該方法只能用于一次制備少量的GaN薄膜,尚不能用于大規(guī)模生產(chǎn)。
1.3 氫化物氣相外延法(HVPE)
HVPE(氫化物氣相外延法)與上述兩種方法的區(qū)別還是在于鎵源,此方法通常以鎵的氯化物GaCl3個(gè)為鎵源,NH3個(gè)為氮源,在襯底上以1000 ℃左右的溫度生長出GaN晶體。用此方法生成的GaN晶體質(zhì)量比較好,且在較高的溫度下生長速度快,但高溫反應(yīng)對生產(chǎn)設(shè)備,生產(chǎn)成本和技術(shù)要求都比較高。
采用以上傳統(tǒng)方法制備GaN薄膜,對其質(zhì)量好壞的主要影響因素是Si與薄膜晶格的相配程度。欲制備無缺陷的薄膜,首先要滿足兩者之間盡量小的晶格失配度;其次,兩者的線膨脹系數(shù)也要相近。
表1-1 GaN外延生長方法的優(yōu)缺點(diǎn)
| 氫化物氣相外延法 | 在金屬鎵上流過HCl,形成GaCl蒸汽,當(dāng)他流到襯底上,與氨氣反應(yīng),沉積形成GaN。 | ①生長速度快②可以比較精確地控制膜厚 | ①高溫反應(yīng)對生產(chǎn)設(shè)備、生產(chǎn)成本和技術(shù)要求都比較高。 |
| 金屬有機(jī)物氣相沉積法 | 氣體或者固體分子在高溫下熱裂解生成團(tuán)簇,通過載氣擴(kuò)散到基片上,在催化劑的作用下排列、反應(yīng)、生長、沉積。 | ①適合于工業(yè)化生產(chǎn)②GaN晶體質(zhì)量好 | ①過程比較復(fù)雜②反應(yīng)速率影響因素多③溫度高,原材料消耗大 |
| 分子束外延法 | 在真空中億原子束或分子束濺落到襯底上,并在襯底上按一定的結(jié)構(gòu)有序排列,形成晶體薄膜。 | ①生長溫度低②生長反應(yīng)過程簡單③實(shí)時(shí)監(jiān)控生長表面的結(jié)構(gòu)、成分和膜厚,均勻性較好 | ①生長速率慢②不能滿足大規(guī)模商業(yè)化生產(chǎn)的要求③采用等離子體輔助方式時(shí),容易造成高能離子對于薄膜的損傷 |
| 制備方法 | 外延生長過程 | 優(yōu)點(diǎn) | 缺點(diǎn) |
|---|
經(jīng)過分析了不同的GaN外延生長方法,雖然分子束外延技術(shù)可以在較低的溫度下實(shí)現(xiàn)GaN的生長,其生長反應(yīng)過程簡單,可以實(shí)時(shí)監(jiān)控生長表面的結(jié)構(gòu)、成分和膜厚,生長溫度低,均勻性較好,但是由于這種方法的生長速率較慢,可以精確地控制膜厚,不能滿足大規(guī)模商業(yè)化生產(chǎn)的要求,而且當(dāng)采用等離子體輔助方式時(shí),容易造成高能離子對于薄膜的損傷。而金屬有機(jī)化學(xué)氣相沉積法的生長速率適中,可以比較精確地控制膜厚,特別適合于工業(yè)化生產(chǎn)GaN基外延材料,這種方法目前已經(jīng)成為使用最多、外延生長材料和器件質(zhì)量最高的方法。
02異質(zhì)外延生長的基本模式
一般來講,異質(zhì)外延有三種生長模式:Frank-van der Merwe 生長模式(層狀生長模式)、Volmer-Weber生長模式(島狀生長模式)和Stranski-Krastanow生長模式(先層狀生長再島狀生長)^[30-32]^,這三種生長模式如圖4-1所示。
2.1 Frank-van der Merwe 生長模式
層-層生長模式一般發(fā)生于晶格常數(shù)比較匹配,晶格失配較小,襯底與外延層之間的鍵能較高的兩種異質(zhì)材料之間。當(dāng)外延層材料的的表面自由能σF與界面能σ我之和遠(yuǎn)小于襯底材料的表面自由能σ秒時(shí),襯底材料將非常強(qiáng)烈地趨于完全覆蓋襯底表面(即層-層生長模式),也就是外延層與襯底浸潤,因?yàn)榇松L模式會(huì)使整個(gè)體系的總表面自由能降低。于是沉積物質(zhì)會(huì)先在襯底表面二維成核再擴(kuò)展成層,然后在一層生長結(jié)束后再進(jìn)行下一層的生長,如此按逐層生長的模式進(jìn)行。
2.2 Volmer-Weber 生長模式
當(dāng)p秒<σF+p我時(shí),外延層與襯底表面不能形成浸潤層,為了使表面能降低以使外延層材料的表面面積最小化,外延層材料會(huì)在襯底表面形成許多三維小島。隨著外延層材料沉積的繼續(xù)進(jìn)行,這些眾多的小島逐漸長大形成柱狀島,并彼此匯聚,最終形成表面粗糙的薄膜。在島狀結(jié)構(gòu)中會(huì)有釋放應(yīng)變產(chǎn)生的失配位錯(cuò),島與島之間存在著小角度的取向差別,在彼此匯聚時(shí)會(huì)產(chǎn)生位錯(cuò)密度很高的邊界層。
2.3 Stranski-Krastanow生長模式
當(dāng)外延層材料的表面自由能σF與界面能σ我之和略大于或者略小于襯底材料表面自由能σ小號時(shí),外延生長會(huì)大大依賴于襯底與外延層之間的晶格匹配情況。GaN在藍(lán)寶石襯底上的異質(zhì)外延生長就屬于此種情況。一開始生長時(shí)外延層材料與襯底浸潤,先形成幾個(gè)原子層厚度的浸潤層。隨著沉積的進(jìn)行,應(yīng)變逐漸積累,最后會(huì)通過形成三維島的形式來釋放應(yīng)力。由于應(yīng)變能不是通過形成位錯(cuò)來釋放的,所以小島中不含有位錯(cuò)。
-
薄膜
+關(guān)注
關(guān)注
0文章
300瀏覽量
29738 -
晶體
+關(guān)注
關(guān)注
2文章
1369瀏覽量
35544 -
單晶
+關(guān)注
關(guān)注
1文章
61瀏覽量
14177 -
GaN
+關(guān)注
關(guān)注
19文章
1965瀏覽量
74238
原文標(biāo)題:GaN 外延生長方法及生長模式
文章出處:【微信號:半導(dǎo)體封裝工程師之家,微信公眾號:半導(dǎo)體封裝工程師之家】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
《炬豐科技-半導(dǎo)體工藝》GaN 基板的表面處理
硅基GaN藍(lán)光LED外延材料轉(zhuǎn)移前后性能
氮化鎵外延片的工藝及分類介紹
淺談GaN 異質(zhì)襯底外延生長方法
三種碳化硅外延生長爐的差異
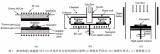
SiC外延生長技術(shù)的生產(chǎn)過程及注意事項(xiàng)

一文詳解SiC單晶生長技術(shù)
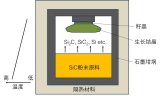
SiGe外延工藝及其在外延生長、應(yīng)變硅應(yīng)用及GAA結(jié)構(gòu)中的作用

8英寸單片高溫碳化硅外延生長室結(jié)構(gòu)

高溫大面積碳化硅外延生長裝置及處理方法

用于半導(dǎo)體外延片生長的CVD石墨托盤結(jié)構(gòu)





 GaN外延生長方法及生長模式
GaN外延生長方法及生長模式
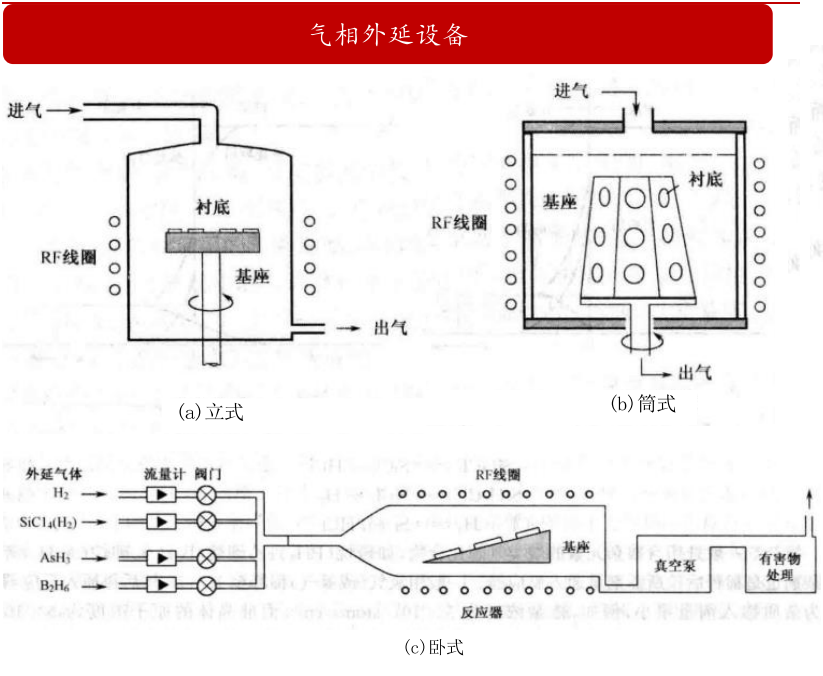










評論