本應(yīng)用筆記說(shuō)明用于從印刷電路板(PCB)移除引線框芯片級(jí)封裝(LFCSP)的建議程序。LFCSP符合JEDEC MO-220和MO-229外形要求。
封裝描述
LFCSP是一種基于引線框的塑封封裝,其尺寸接近芯片的大小,因而被稱為"芯片級(jí)"(參見(jiàn)圖1)。 封裝內(nèi)部的互連通常是由線焊實(shí)現(xiàn)。
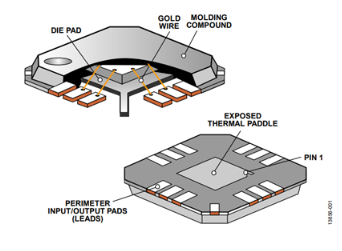
圖1. LFCSP等比截面圖
外部電氣連接是通過(guò)將外圍引腳焊接到PCB來(lái)實(shí)現(xiàn)。除引腳外,LFCSP常常還有較大的裸露熱焊盤(pán),可將其焊接到PCB以改善散熱。
LFCSP器件返修
將LFCSP器件裝配到PCB上之后,若發(fā)現(xiàn)缺陷,應(yīng)當(dāng)返修以移除不良器件,并換上工作正常的器件。移除器件之前,注意必須加熱不良器件,直至引腳和裸露焊盤(pán)(如有焊接)下方的焊料液化,從而更容易從電路板上移除不良器件。
常規(guī)返修流程包括以下步驟:
準(zhǔn)備板子
移除器件
清潔PCB焊盤(pán)
涂敷焊膏
器件對(duì)齊和貼片
固定器件
檢查
關(guān)于第3步到第7步的詳細(xì)說(shuō)明,請(qǐng)參見(jiàn)AN-772應(yīng)用筆記。
移除器件和分層
移除器件時(shí),可能會(huì)在LFCSP和/PCB上產(chǎn)生機(jī)械應(yīng)力。應(yīng)小心移除不良器件,不僅要避免損傷PCB或鄰近器件,還要避免損傷不良器件本身,尤其是若用戶打算對(duì)不良器件進(jìn)行故障分析。LFCSP器件上若有過(guò)大應(yīng)力(例如將器件加熱到額定峰值溫度以上或過(guò)度暴露于高溫下),可能導(dǎo)致封裝分層或外部物理?yè)p壞(參見(jiàn)圖2至圖4)。對(duì)于要做進(jìn)一步分析的器件,移除不當(dāng)所引起的分層會(huì)加大找出真正故障機(jī)制的難度。因此,為了進(jìn)行有效的故障分析,妥善移除不良器件是十分必要的。

圖2. 移除不當(dāng)引起LFCSP芯片焊盤(pán)分層(通過(guò)掃描聲學(xué)顯微鏡觀測(cè))

圖3. LFCSP的低放大率側(cè)視圖顯示返修設(shè)置過(guò)大引起的損傷(塑封材料鼓出)
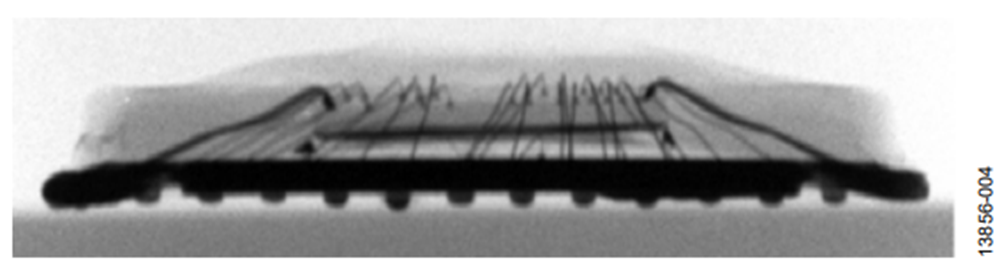
圖4. LFCSP的X射線圖像顯示返修設(shè)置過(guò)大引起的內(nèi)部損傷(芯片翹起)
板準(zhǔn)備
強(qiáng)烈建議在返修開(kāi)始前對(duì)PCB組件進(jìn)行干烘,以消除殘留水分。若不消除,在回流期間,殘留水分可能會(huì)因?yàn)?爆米花效應(yīng)"而損傷器件。在125°C下烘烤PCB組件至少4小時(shí),只要這些條件不超過(guò)PCB上其他器件的額定限值。如果這些條件超過(guò)其他器件的額定限值,則應(yīng)使用聯(lián)合行業(yè)標(biāo)準(zhǔn)IPC/JEDEC J-STD-033中說(shuō)明的備選烘烤條件。
移除器件
可使用不同的工具來(lái)移除器件。為了移除器件,可能要加熱器件,直至焊料回流,然后在焊料仍處于液態(tài)時(shí)通過(guò)機(jī)械手段移除器件。可編程熱空氣返修系統(tǒng)可提供受控溫度和時(shí)間設(shè)置。
返修時(shí)應(yīng)遵循器件裝配所用的溫度曲線。返修溫度不得超過(guò)濕度靈敏度等級(jí)(MSL)標(biāo)簽上規(guī)定的峰值溫度。加熱時(shí)間可以縮短(例如針對(duì)液化區(qū)),只要實(shí)現(xiàn)了焊料完全回流即可。焊料回流區(qū)處于峰值溫度的時(shí)間應(yīng)小于60秒。拾取工具的真空壓力應(yīng)小于0.5 kg/cm2,以防器件在達(dá)到完全回流之前頂出,并且避免焊盤(pán)浮離。請(qǐng)勿再使用從PCB上移除的器件。
控制返修溫度以免損壞LFCSP器件和PCB。注意,用耐熱帶蓋住器件周?chē)膮^(qū)域可提供進(jìn)一步的保護(hù)。此外,建議加熱PCB下方以降低PCB上下兩面的溫差,使板彎曲最小。
定義返修工具設(shè)置時(shí),應(yīng)標(biāo)定溫度曲線。首次返修特定器件時(shí),這種標(biāo)定尤其重要。還需要利用不同的主體尺寸、PCB材料、配置、厚度等對(duì)LFCSP器件進(jìn)行標(biāo)定,因?yàn)樗鼈兛赡苡胁煌臒豳|(zhì)量。標(biāo)定必須包括對(duì)溫度、時(shí)間和設(shè)備工具的其他設(shè)置進(jìn)行監(jiān)控(參見(jiàn)圖5)。可將熱電偶裝配到板組件的不同部分,如LFCSP器件上部和PCB上部(參見(jiàn)圖6)。分析溫度-時(shí)間曲線數(shù)據(jù),從評(píng)估中獲得器件移除的有效參數(shù)。

圖5. 器件移除評(píng)估的簡(jiǎn)化流程圖
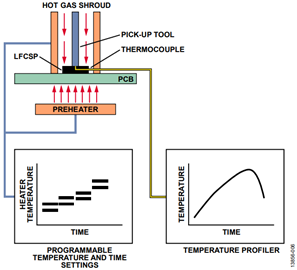
圖6. 器件移除標(biāo)定設(shè)置示例圖
審核編輯:郭婷
-
電路板
+關(guān)注
關(guān)注
140文章
4997瀏覽量
98878 -
LFCSP
+關(guān)注
關(guān)注
1文章
15瀏覽量
14547 -
PCB
+關(guān)注
關(guān)注
1文章
1825瀏覽量
13204
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
從PCB移除引線框芯片級(jí)封裝(LFCSP)的詳細(xì)步驟
引線框芯片級(jí)封裝的建議返修程序
基于LFCSP和法蘭封裝的RF放大器熱管理計(jì)算
引腳架構(gòu)芯片級(jí)封裝(LFCSP)設(shè)計(jì)與制造指南

AN-772引腳架構(gòu)芯片級(jí)封裝(LFCSP)設(shè)計(jì)與制造指南
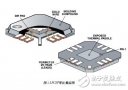
引線框芯片級(jí)封裝(LFCSP)的建議返修程序
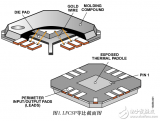
關(guān)于引線框芯片級(jí)封裝(LFCSP)的建議返修程序的分析和應(yīng)用
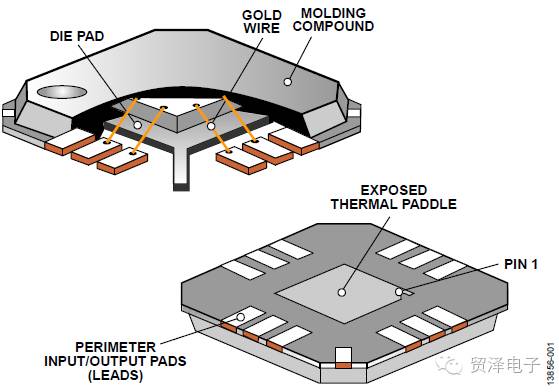
歐菲光成功研發(fā)半導(dǎo)體封裝用高端引線框架
AN-772: 引腳架構(gòu)芯片級(jí)封裝(LFCSP)設(shè)計(jì)與制造指南

什么是引線框架 半導(dǎo)體引線框架的生產(chǎn)工藝
等離子清洗機(jī)在陶瓷封裝、引線框架、芯片鍵合、引線鍵合的應(yīng)用





 AN-1389:引線框芯片級(jí)封裝(LFCSP)的建議返修程序
AN-1389:引線框芯片級(jí)封裝(LFCSP)的建議返修程序
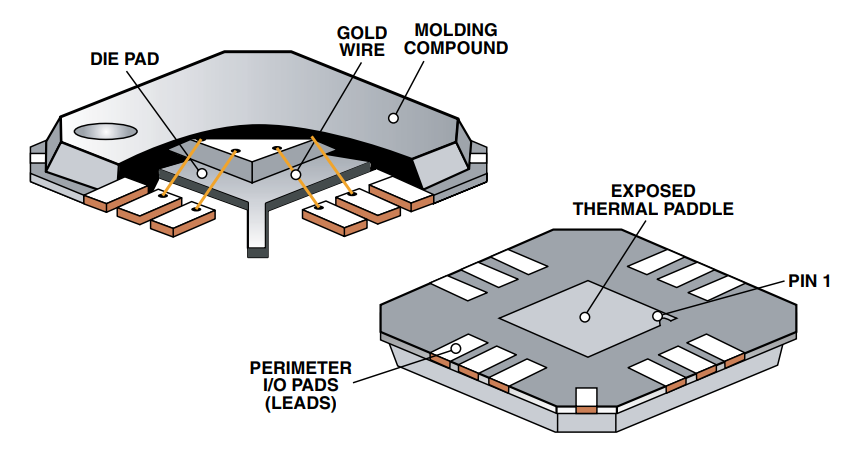










評(píng)論