電子集成技術(shù)分為三個(gè)層次,芯片上的集成,封裝內(nèi)的集成,PCB板級(jí)集成,其代表技術(shù)分別為SoC,SiP和PCB(也可以稱為SoP或者SoB)
芯片中的整合主要是2D,晶體管采用平鋪方式整合在晶圓平面內(nèi);類似地,PCB中的集成主要由2D來(lái)完成,電子元器件平放在PCB的表面,所以,兩者均屬2D集成范疇。而且對(duì)于封裝內(nèi)部集成來(lái)說情況要復(fù)雜很多。
電子集成技術(shù)分類的兩個(gè)重要判據(jù):1.物理結(jié)構(gòu),2.電氣連接(電氣互連)。
目前先進(jìn)封裝中按照主流可分為2D封裝、2.5D封裝、3D封裝三種類型。

2D封裝
芯片中的整合主要是2D,晶體管采用平鋪方式整合在晶圓平面內(nèi);2D封裝方面包含F(xiàn)OWLP,FOPLP和其他技術(shù)。
物理結(jié)構(gòu):所有芯片和無(wú)源器件均安裝在基板平面,芯片和無(wú)源器件和 XY 平面直接接觸,基板上的布線和過孔均位于 XY 平面下方;
電氣連接:均需要通過基板(除了極少數(shù)通過鍵合線直接連接的鍵合點(diǎn))
臺(tái)積電的InFO:
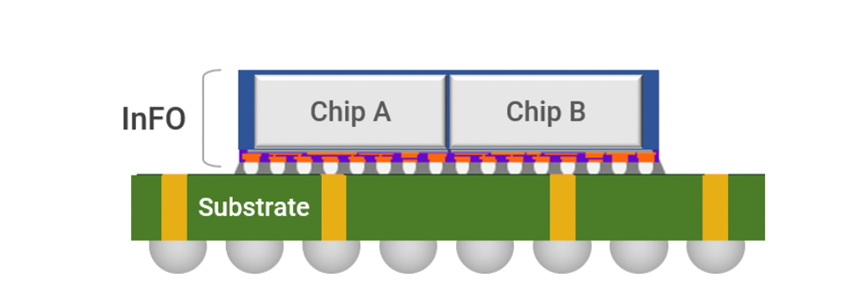
臺(tái)積電在2017年開發(fā)的InFO技術(shù)。InFO技術(shù)與大多數(shù)封裝廠的Fan-out類似,可以理解為多個(gè)芯片F(xiàn)an-out工藝的集成,主要區(qū)別在于去掉了silicon interposer,使用一些RDL層進(jìn)行串連(2016年推出的iPhone7中的A10處理器,采用臺(tái)積電16nm FinFET工藝以及InFO技術(shù))。
日月光的eWLB:與臺(tái)積的InFO類似,都屬于Fan-out技術(shù)
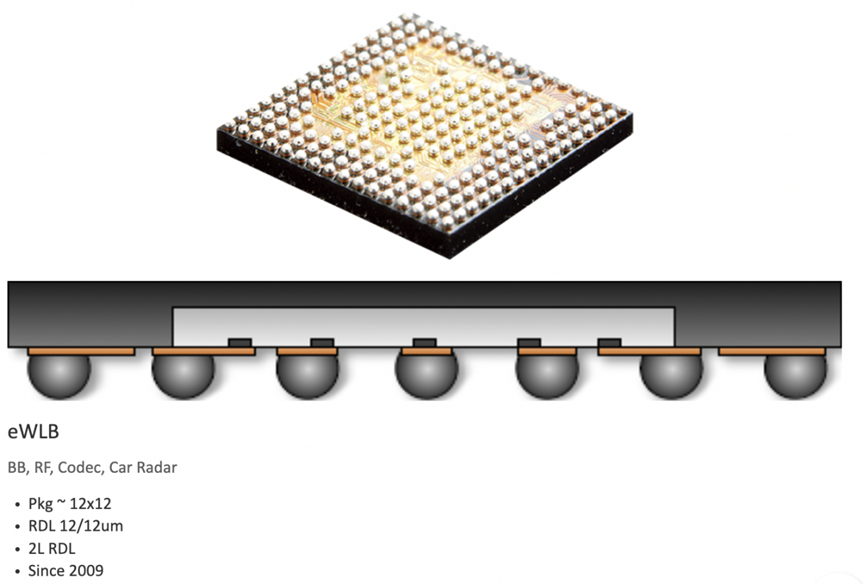
另外,還有一種2D+ 集成
2D+集成是指的傳統(tǒng)的通過鍵合線連接的芯片堆疊集成。也許會(huì)有人問,芯片堆疊不就是3D嗎,為什么要定義為2D+集成呢?
主要基于以下兩點(diǎn)原因:
1)3D集成目前在很大程度上特指通過3D TSV的集成,為了避免概念混淆,我們定義這種傳統(tǒng)的芯片堆疊為2D+集成;
2)盡管物理結(jié)構(gòu)為3D,但是它們的電氣互連都要經(jīng)過基板,即首先要經(jīng)過鍵合線與基板鍵合,再將電氣互連于基板。這一點(diǎn)與2D集成一樣,與2D集成相比,改進(jìn)了結(jié)構(gòu)堆疊,可以節(jié)約封裝空間,所以被稱為2D+集成。
物理結(jié)構(gòu):所有芯片及無(wú)源器件都地在XY平面之上,有些芯片與基板沒有直接接觸,基板中布線及過孔都在XY平面之下;
電氣連接:均需要通過基板(除了極少數(shù)通過鍵合線直接連接的鍵合點(diǎn))
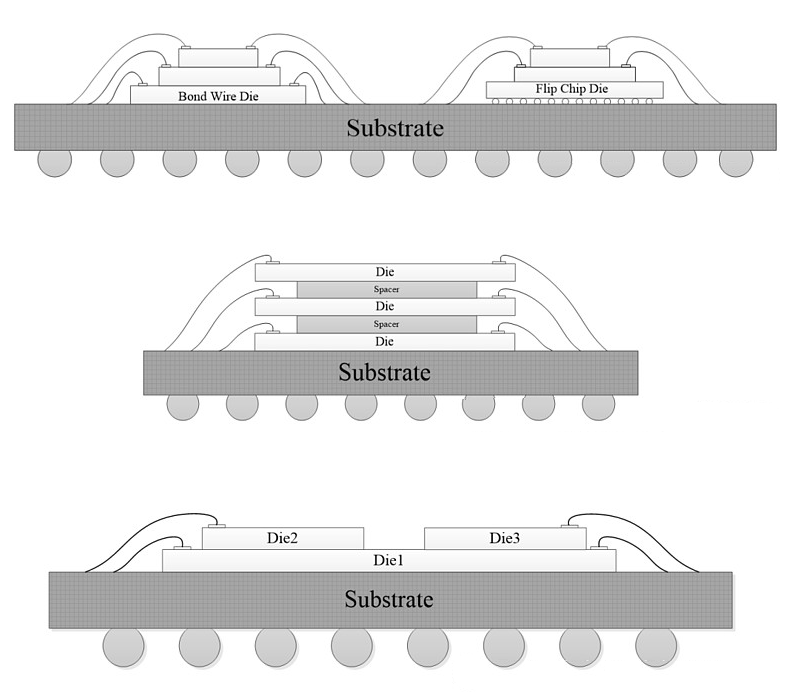
2.5D封裝:
2.5D封裝通常是指既有2D的特點(diǎn),又有部分3D的特點(diǎn),其中的代表技術(shù)包括英特爾的EMIB、臺(tái)積電的CoWoS、三星的I-Cube。
物理結(jié)構(gòu):所有芯片和無(wú)源器件均XY平面上方,至少有部分芯片和無(wú)源器件安裝在中介層上(Interposer),在XY平面的上方有中介層的布線和過孔,在XY平面的下方有基板的布線和過孔。
電氣連接:中介層(Interposer)可提供位于中介層上的芯片的電氣連接。
2.5D集成的關(guān)鍵在于中介層Interposer,一般會(huì)有幾種情況,
1)中介層是否采用硅轉(zhuǎn)接板,
2)中介層是否采用TSV,
3)采用其他類型的材質(zhì)的轉(zhuǎn)接板;
在硅轉(zhuǎn)接板上,我們將穿越中介層的過孔稱之為TSV,對(duì)于玻璃轉(zhuǎn)接板,我們稱之為TGV
所謂的TSV 指的是:
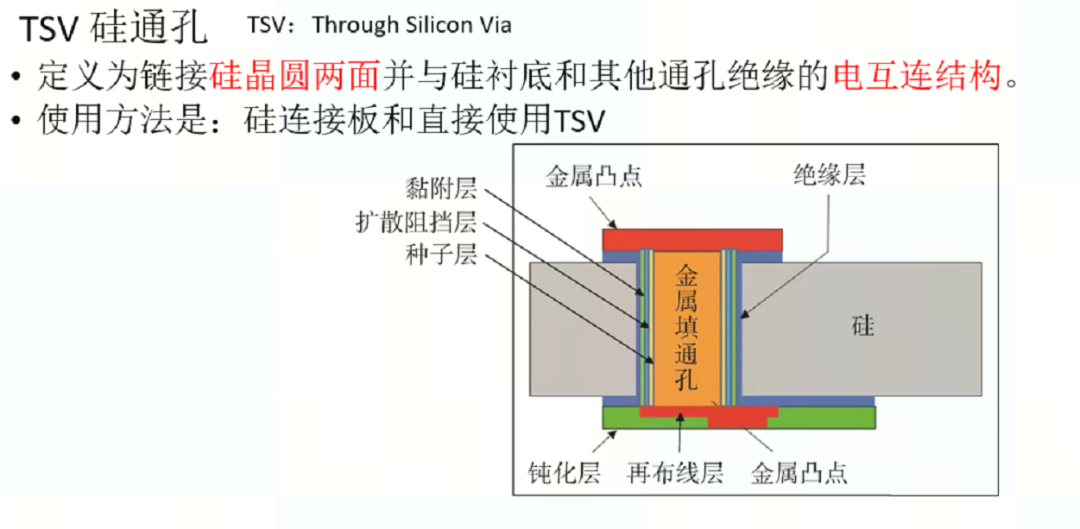
硅中介層具有TSV集成方式為2.5D集成技術(shù)中最為普遍的方式,芯片一般用MicroBump與中介層連接,硅基板做中介層使用Bump與基板連接,硅基板的表面采用RDL接線,TSV是硅基板上,下表面電連接通道,該2.5D集成方式適用于芯片尺寸相對(duì)較大的場(chǎng)合,當(dāng)引腳密度較大時(shí),通常采用FlipChip方式將芯片裝夾到硅基板中。
有TSV的2.5D集成示意圖:
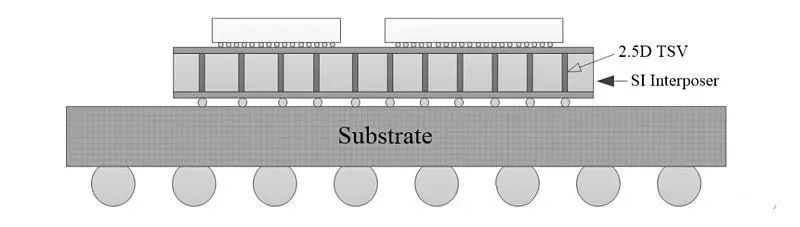
硅中介層無(wú)TSV的2.5D集成的結(jié)構(gòu)一般如下圖所示,有一顆面積較大的裸芯片直接安裝在基板上,該芯片和基板的連接可以采用Bond Wire或者Flip Chip兩種方式,大芯片上方由于面積較大,可以安裝多個(gè)較小的裸芯片,但小芯片無(wú)法直接連接到基板,所以需要插入一塊中介層(Interposer),若干裸芯片安裝于中介層之上,中介層具有RDL布線可以從中介層邊緣引出芯片信號(hào),再經(jīng)Bond Wire與基板相連。這種中介層一般無(wú)需TSV,僅需在Interposer的上層布線來(lái)實(shí)現(xiàn)電氣互連,Interposer采用Bond Wire和封裝基板連接。
無(wú)TSV的2.5D集成示意圖:

英特爾的EMIB:
概念與2.5D封裝類似,但與傳統(tǒng)2.5D封裝的區(qū)別在于沒有TSV。也正是這個(gè)原因,EMIB技術(shù)具有正常的封裝良率、無(wú)需額外工藝和設(shè)計(jì)簡(jiǎn)單等優(yōu)點(diǎn)。
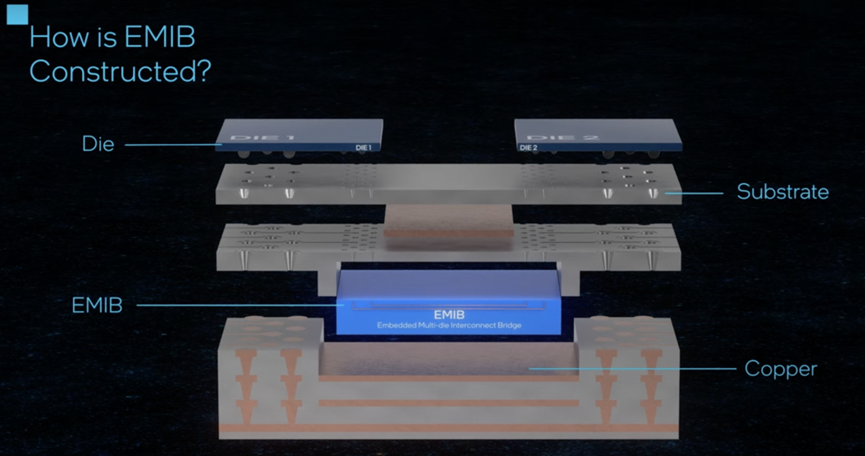
臺(tái)積電的CoWoS技術(shù)
臺(tái)積電的CoWoS技術(shù)也是一種2.5D封裝技術(shù)。根據(jù)中介層的不同可以分為三類,一種是CoWoS_S使用Si襯底作為中介層,另一種是CoWoS_R使用RDL作為中介層,第三種是CoWoS_L使用小芯片(Chiplet)和RDL作為中介層。
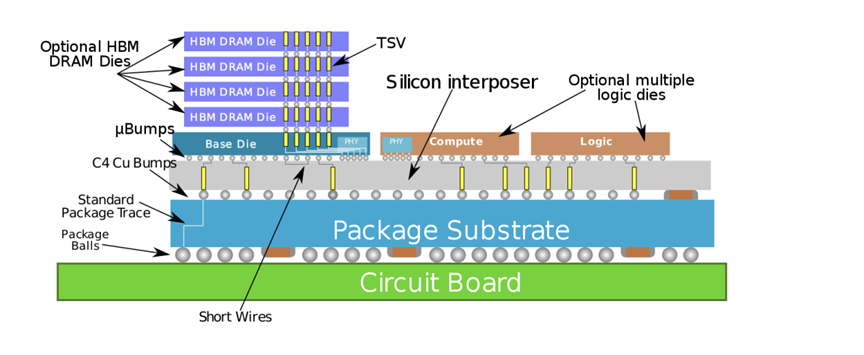
臺(tái)積電InFO(2D)與CoWoS(2.5D)之間的區(qū)別在于,CoWoS針對(duì)高端市場(chǎng),連線數(shù)量和封裝尺寸都比較大;InFO針對(duì)性價(jià)比市場(chǎng),封裝尺寸較小,連線數(shù)量也比較少。
第一代CoWoS主要用于大型FPGA。CoWoS-1的中介層芯片面積高達(dá)約800mm2,非常接近掩模版限制。第二代CoWoS通過掩模拼接顯著增加了中介層尺寸。臺(tái)積電最初符合1200mm2的要求,此后將中介層尺寸增加到1700mm2。這些大型封裝稱為CoWoS-XL2。
最近,臺(tái)積電公布的第五代CoWoS-S的晶體管數(shù)量將增加20倍,中介層面積也會(huì)提升3倍。第五代封裝技術(shù)還將封裝8個(gè)128G的HBM2e內(nèi)存和2顆大型SoC內(nèi)核。
長(zhǎng)電科技XDFOI技術(shù):
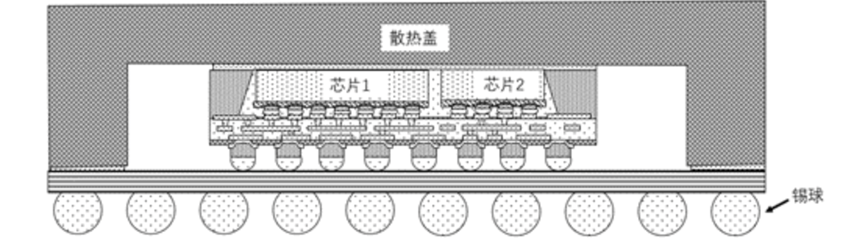
與2.5D TSV封裝技術(shù)相比,它具有高性能,高可靠性和低成本的特點(diǎn)。這種解決方案可以實(shí)現(xiàn)多層布線層而線寬或者線距可達(dá)2um。此外,本發(fā)明還利用極窄節(jié)距凸塊互連技術(shù)具有較大封裝尺寸,可以集成多個(gè)芯片,高帶寬內(nèi)存以及無(wú)源器件等。
三星的I-Cube
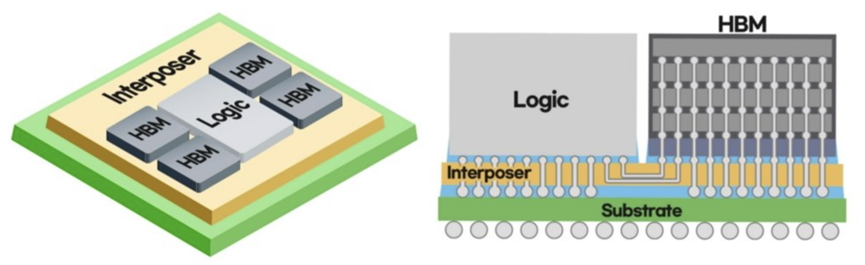
三星的具有的先進(jìn)封裝包括I-Cube、X-Cube、R-Cube和H-Cube四種方案。其中,三星的I-Cube同樣也屬于2.5D封裝。
3D封裝:
3D封裝和2.5D封裝的主要區(qū)別在于:2.5D封裝是在Interposer上進(jìn)行布線和打孔,而3D封裝是直接在芯片上打孔和布線,電氣連接上下層芯片。3D集成目前在很大程度上特指通過3D TSV的集成。
3D集成和2.5D集成的主要區(qū)別在于:2.5D集成是在中介層Interposer上進(jìn)行布線和打孔,而3D集成是直接在芯片上打孔(TSV)和布線(RDL),電氣連接上下層芯片。
物理結(jié)構(gòu):所有芯片及無(wú)源器件都位于XY平面之上且芯片相互疊合,XY平面之上設(shè)有貫穿芯片TSV,XY平面之下設(shè)有基板布線及過孔。
電氣連接:芯片采用TSV與RDL直接電連接
3D集成多適用于同類型芯片堆疊,將若干同類型芯片豎直疊放,并由貫穿芯片疊放的TSV相互連接而成,見下圖。類似的芯片集成多用于存儲(chǔ)器集成,如DRAM Stack和FLASH Stack。
同類芯片的3D集成示意圖:

不同類別芯片進(jìn)行3D集成時(shí),通常會(huì)把兩個(gè)不同芯片豎直疊放起來(lái),通過TSV進(jìn)行電氣連接,與下面基板相互連接,有時(shí)還需在其表面做RDL,實(shí)現(xiàn)上下TSV連接。

臺(tái)積電的SoIC技術(shù):
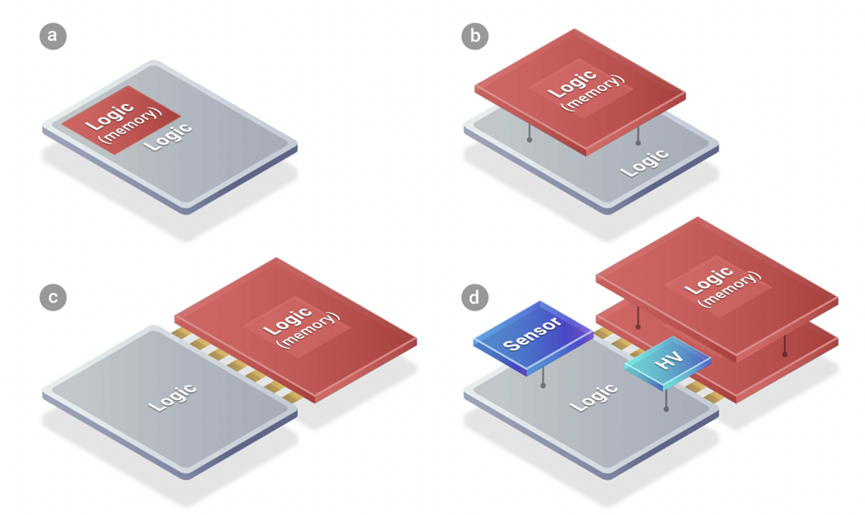
臺(tái)積電SoIC技術(shù)屬于3D封裝,是一種晶圓對(duì)晶圓(Wafer-on-wafer)的鍵合技術(shù)。SoIC技術(shù)就是利用TSV技術(shù)來(lái)實(shí)現(xiàn)無(wú)凸起鍵合結(jié)構(gòu)并將許多不同特性的臨近芯片集成到一起并且其中最為關(guān)鍵的、最為神秘的是接合的物質(zhì),被稱為機(jī)密材料,價(jià)值達(dá)十億美元。
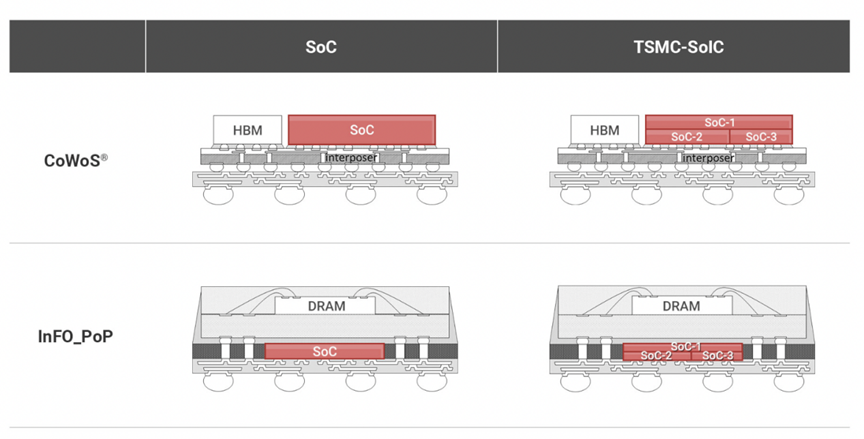
SoIC技術(shù)將同質(zhì)和異質(zhì)小芯片集成到單個(gè)類似SoC的芯片中,具有更小尺寸和更薄的外形,可以整體集成到先進(jìn)的WLSI(又名CoWoS和InFO)中。從外觀上看,新集成的芯片就像一個(gè)通用的SoC芯片,但嵌入了所需的異構(gòu)集成功能。
英特爾的Foveros技術(shù):
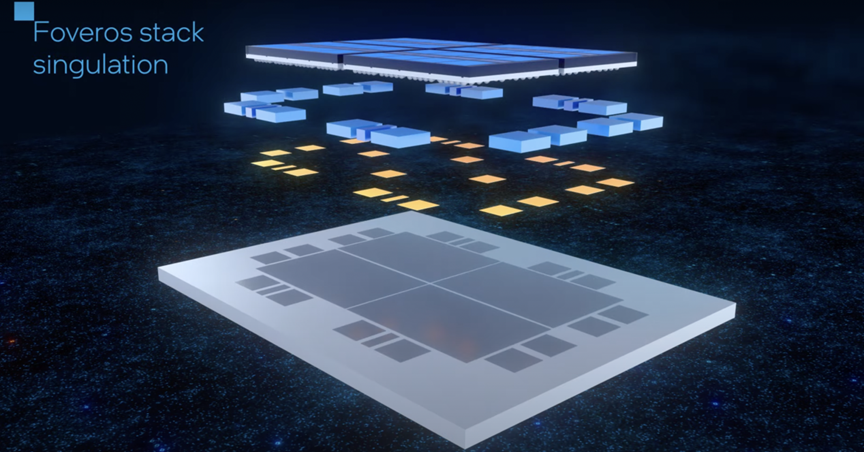
由3D Foveros結(jié)構(gòu)可知,最下半部分為封裝基底,上面放置有底層芯片作為主動(dòng)中介層。中介層中存在大量TSV 3D硅穿孔負(fù)責(zé)聯(lián)通上、下層焊料凸起使上層芯片、模塊等與系統(tǒng)進(jìn)行通訊。
三星的X-Cube 3D封裝技術(shù):
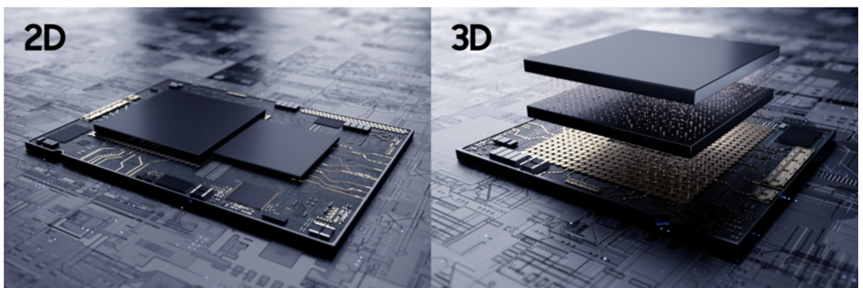
使用TSV工藝,目前三星的X-Cube測(cè)試芯片已經(jīng)能夠做到將SRAM層堆疊在邏輯層之上,通過TSV進(jìn)行互聯(lián),制程是他們自家的7nm EUV工藝。
長(zhǎng)電科技的擴(kuò)展eWLB:
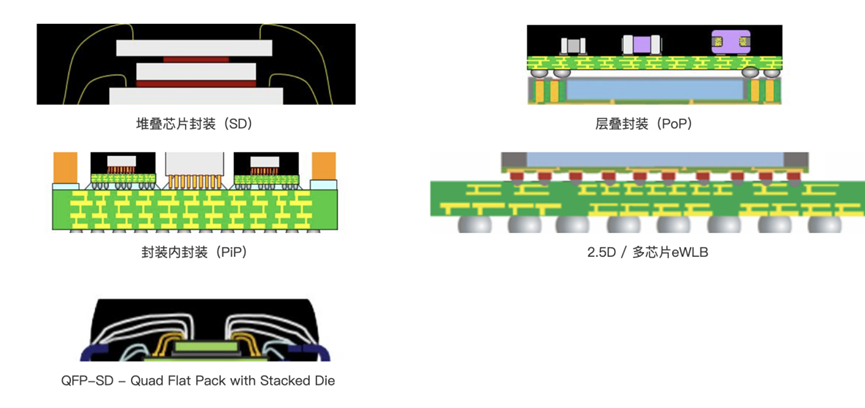
長(zhǎng)電科技以eWLB為核心的中介層可以在成熟低損耗封裝結(jié)構(gòu)下進(jìn)行高密度互連,從而提供更加有效的散熱以及更加快速的處理。3D eWLB互連(包括硅分割)采用獨(dú)特的面對(duì)面鍵合方式,不需要昂貴的TSV互連以及高帶寬3D集成。
華天科技的3D-eSinC解決方案:
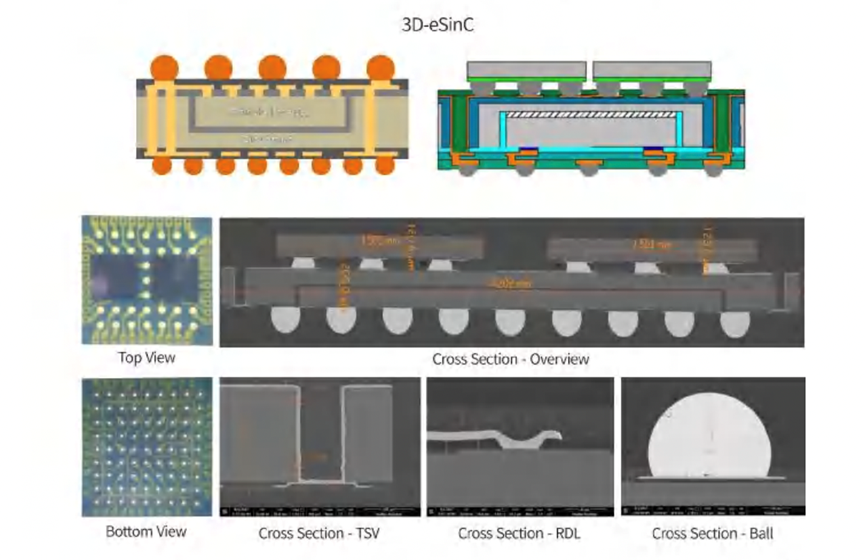
華天科技稱,2022年將開展2.5D Interpose FCBGA、FOFCBGA、3D FOSiP等先進(jìn)封裝技術(shù),以及基于TCB工藝的3D Memory封裝技術(shù),Double Sidemolding射頻封裝技術(shù)、車載激光雷達(dá)及車規(guī)級(jí)12英寸晶圓級(jí)封裝等技術(shù)和產(chǎn)品的研發(fā)。
4D 集成:
物理結(jié)構(gòu):多塊基板采用非平行的方式進(jìn)行安裝,且每一塊基板上均設(shè)有元器件,元器件的安裝方式具有多樣化。
電氣連接:基板間采用柔性電路或焊接的方式相連,基板中芯片的電氣連接多樣化。
基于剛?cè)峄宓?D集成示意圖:
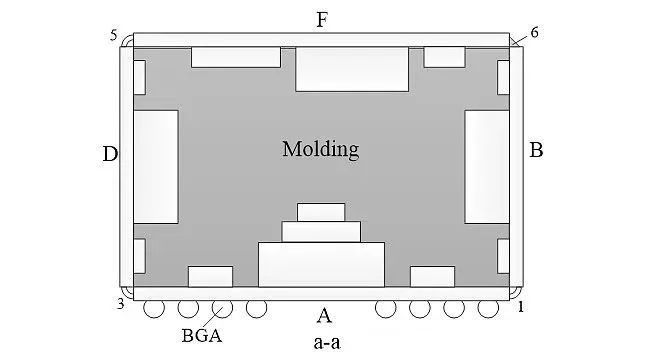
4D集成定義主要是關(guān)于多塊基板的方位和相互連接方式,因此在4D集成也會(huì)包含有2D,2D+,2.5D,3D的集成方式
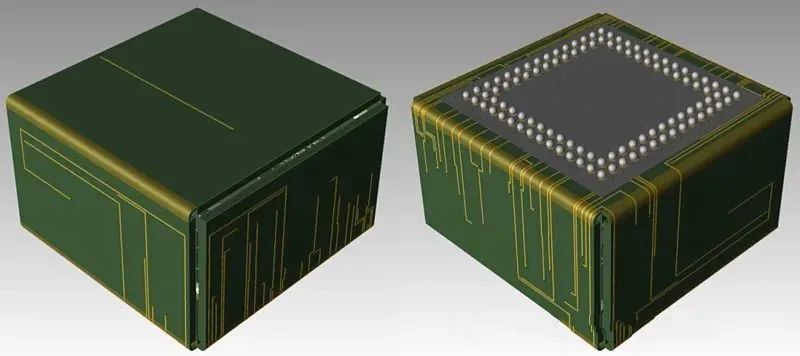
-
芯片
+關(guān)注
關(guān)注
456文章
51192瀏覽量
427300 -
封裝
+關(guān)注
關(guān)注
127文章
7997瀏覽量
143413 -
先進(jìn)封裝
+關(guān)注
關(guān)注
2文章
427瀏覽量
286
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
2.5D/3D封裝技術(shù)升級(jí),拉高AI芯片性能天花板
LITESTAR 4D在建筑外墻照明中的應(yīng)用
AN-1249:使用ADV8003評(píng)估板將3D圖像轉(zhuǎn)換成2D圖像

先進(jìn)封裝技術(shù)-19 HBM與3D封裝仿真

技術(shù)前沿:半導(dǎo)體先進(jìn)封裝從2D到3D的關(guān)鍵

LITESTAR 4D在建筑外墻照明中的應(yīng)用
技術(shù)資訊 | 2.5D 與 3D 封裝

一文理解2.5D和3D封裝技術(shù)

探秘2.5D與3D封裝技術(shù):未來(lái)電子系統(tǒng)的新篇章
3D封裝熱設(shè)計(jì):挑戰(zhàn)與機(jī)遇并存

通過2D/3D異質(zhì)結(jié)構(gòu)精確控制鐵電材料弛豫時(shí)間

4D毫米波雷達(dá)的拆解報(bào)告分享
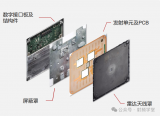
2.5D與3D封裝技術(shù):未來(lái)電子系統(tǒng)的新篇章
有了2D NAND,為什么要升級(jí)到3D呢?





 【半導(dǎo)光電】先進(jìn)封裝-從2D,3D到4D封裝
【半導(dǎo)光電】先進(jìn)封裝-從2D,3D到4D封裝











評(píng)論