劃片工藝:根據晶圓工藝制程及對產品需求的不同,一片晶圓通常由幾百至數萬顆小芯片組成,業內大部分晶圓的Dice之間有著40um-100um不等的間隙區分,此間隙被稱為切割道,而圓片上99%的芯片都具有獨立的性能模塊(1%為邊緣dice,具備使用性能),為將小芯片分 離成單顆dice,就需要使用切割工藝對圓片進行切割(Die Sawing)。目前,業內主要切割工藝有兩種:刀片切割和激光切割。
刀片切割: 刀片在設備主軸高速運轉帶動下,刀片上的金剛石顆粒將工作盤上的晶圓從切割街區進行擊穿,并在刀片”碎屑口袋”與切割沖洗水
的作用下,將產品碎屑及時移除,避免造成背面硅粉滲透及附著表面造成的品質異常。
激光切割:激光切割主要作用是開槽, 開完槽之后就用刀片進行切穿,激光切割對刀片切割起到補充的作用,主要應用于超薄晶圓切割。
劃片機:劃片機作為半導體芯片后道工序的加工設備,用于晶圓的劃片、分割或開槽等微細加工,切割的質量與效率直接影響到芯片的質量和生產成本。劃片機種類分為砂輪劃片機與激光劃片機,分別對應刀片切割工藝與激光切割工藝。
砂輪劃片機是綜合了水氣電、空氣靜壓高速主軸、精密機械傳動、傳感器及自動化控制等技術的精密數控設備。其特點為切割成本低、效率高,適用于100um以上的較厚晶圓的切割,是當前主流切割方式。
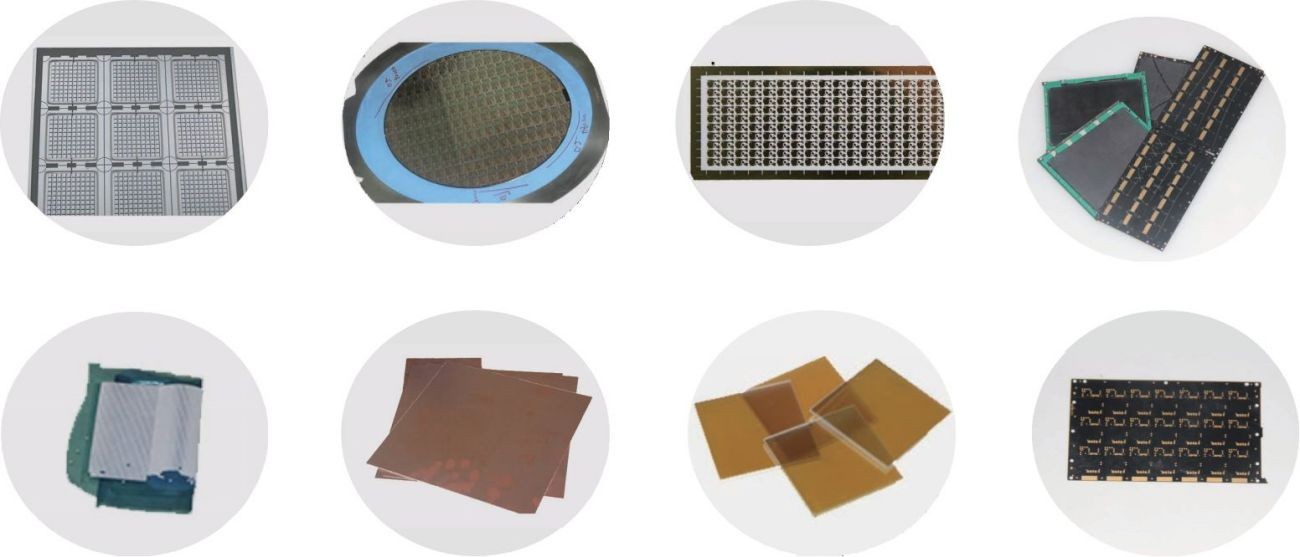
激光劃片機是利用高能激光束照射在工件表面,使被照射區域局部熔化、氣化、從而達到劃片的目的。其特點為切割精度高、切割速度快,盱100μm以下的較薄晶圓的切割。激光切割機己推出20余年,約占整個劃片機市場的20%左右。
隨著集成電路超大規模化的發展趨勢,器件的設計原則開始追求微細化,在提高元件工作速度的同時,減小芯片的面積,其對劃片機的工藝要求越發精細化。目前晶圓的線寬已經發展到5μm以下,甚至達到1μm左右,晶圓上集成電路的排布愈發密集,對于切割精度的要求大大提升。當前激光切割技術不斷向高功率、高精度的方向發展,新型全自動激光劃片機陸續被制造,對于切割效率和切割精度都能兼顧,未來有望持續發展。
-
劃片機
+關注
關注
0文章
155瀏覽量
11165 -
切割
+關注
關注
0文章
76瀏覽量
16029
發布評論請先 登錄
相關推薦
劃片機:光通訊器件劃切領域的科技先鋒

BJX8160劃片機:Mini Micro LED切割領域的精密專家

博捷芯MIP專機:精密劃片技術的革新者





 【博捷芯】劃片機的兩種切割工藝
【博捷芯】劃片機的兩種切割工藝
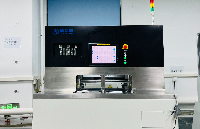

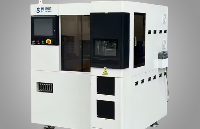
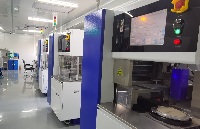



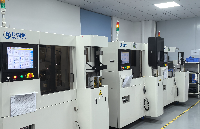

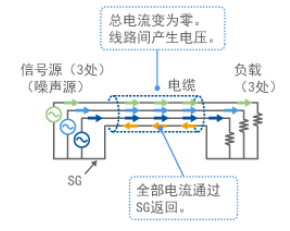










評論