多年來,單片芯片定義了半導體創新。新的微處理器定義了新的市場,新的圖形處理器和手機芯片也是如此。到達下一個節點是目標,當晶圓廠運送工作部件時,就宣告勝利了。然而,這種情況正在改變。
現在,半導體創新是由一系列與新封裝方法緊密集成的芯片驅動的,所有芯片都運行高度復雜的軟件。這些變化的影響是巨大的。深厚的技術技能、基礎設施投資和生態系統協作都是必需的。但所有這些如何結合在一起以促進下一件大事的發明呢?讓我們看看臺積電如何重新定義代工廠以實現下一代產品。
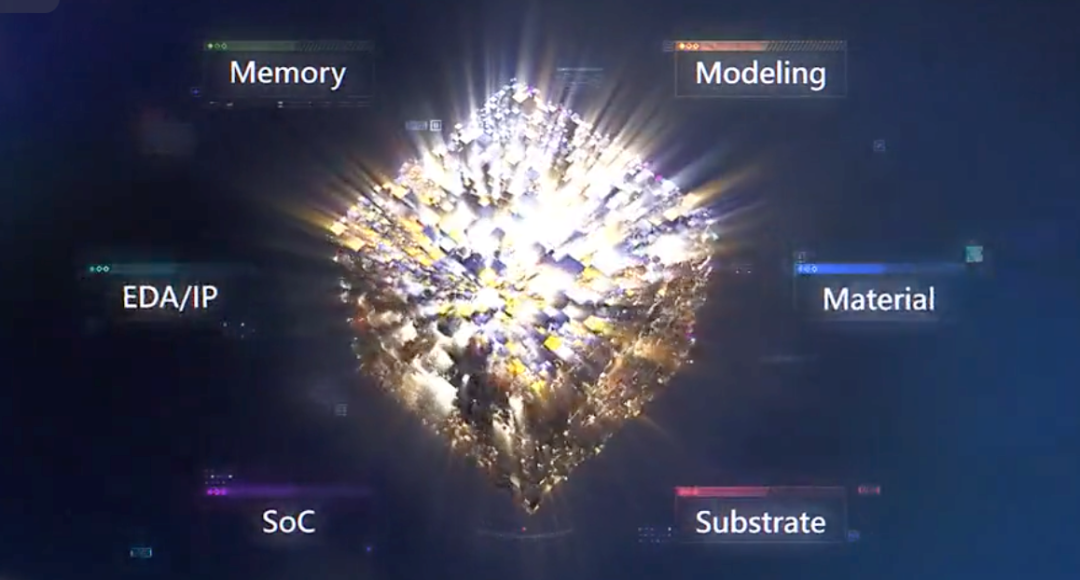
什么是晶圓代工廠?
代工廠的傳統范圍是晶圓制造、測試、封裝和批量交付工作單片芯片。支持技術包括實現工藝節點的工廠、PDK、經過驗證的 IP 和 EDA 設計流程。有了這些功能,新產品就可以通過新的單片芯片來實現。幾十年來,所有這些都運作良好。但現在,新產品架構的復雜性因通常支持人工智能功能的軟件堆棧而放大,需要的不僅僅是單個單片芯片。這種從單片芯片解決方案的轉變有很多原因,其結果是多芯片解決方案的顯著增長。
關于這種創新范式的轉變已經有很多文章。由于時間關系,這里就不展開了。有許多信息來源可以解釋這種轉變的原因。這是對正在發生的事情的一個很好的總結。
所有這一切的底線是產品創新的定義發生了重大變化。幾十年來,該代工廠提供了推動創新所需的技術——新工藝中的新芯片。如今的要求要復雜得多,包括提供新系統功能各個部分的多個芯片(或小芯片)。這些設備通常會加速人工智能算法。有些正在感測環境,或執行混合信號處理,或與云通信。其他公司正在提供大規模的本地存儲陣列。
所有這些功能必須以密集封裝的形式提供,以適應改變世界的新產品所需的外形尺寸、功耗、性能和延遲。這里要提出的問題是晶圓代工廠現在怎么樣了?為所有這些創新提供支持技術需要比過去更多的東西。代工廠現在是否成為更復雜價值鏈的一部分,或者是否有更可預測的方式?一些組織正在加緊行動。讓我們看看臺積電如何重新定義代工廠以實現下一代產品。
下一代產品的支持技術
需要新材料和新制造方法來實現下一代產品所需的密集集成。TSMC 已開發出一整套此類技術,并以名為 TSMC 3DFabric的集成封裝形式提供。
芯片堆疊是通過稱為 TSMC-SoIC(集成芯片系統)的前端工藝完成的。晶圓上芯片 (CoW) 和晶圓上晶圓 (WoW) 功能均可用。轉向后端先進封裝,有兩種技術可用。InFO(集成扇出)是一種chip first的方法,可提供重新分布層 (RDL) 連接,并可選擇使用本地硅互連。CoWoS(基板上晶圓芯片)是一種chip last方法,可提供具有可選本地硅互連的硅中介層或 RDL 中介層。
所有這些功能都在一個統一的封裝中提供。臺積電顯然正在擴大代工的含義。臺積電還與 IP、基板和內存供應商合作,提供集成的交鑰匙服務,為先進封裝提供端到端技術和后勤支持。生態系統搭配是成功的關鍵因素。所有供應商必須有效合作,實現下一件大事。臺積電擁有建立強大生態系統來實現這一目標的歷史。
前面我提到了基礎設施投資。臺積電憑借智能封裝工廠再次領先。此功能廣泛使用人工智能、機器人技術和大數據分析。包裝曾經是鑄造過程中的事后想法。它現在已成為創新的核心,進一步擴展了晶圓廠的含義。
邁向完整的解決方案
到目前為止討論的所有功能使我們非常接近完全集成的創新模型,這種模型真正擴展了代工廠的交付能力。但還需要一件作品才能完成這幅畫。可靠、集成良好的技術是成功創新的關鍵要素,但此過程的最后一英里是設計流程。您需要能夠定義將使用哪些技術、如何組裝這些技術,然后構建和驗證半導體系統的模型,并在構建之前驗證其是否有效。
要實現這一目標,需要使用多個供應商提供的工具,以及更多供應商提供的 IP 和材料模型。這一切都需要以統一、可預測的方式進行。對于先進的多芯片設計,還有更多的問題需要解決。有源和無源芯片的選擇、它們的連接方式(水平(2.5D)和垂直(3D))以及它們如何相互連接只是需要考慮的幾個新項目。
臺積電在最近的 OIP 生態系統論壇上的聲明給我留下了深刻的印象來解決最后一英里的問題。我們可以點擊以下視頻,查看 Jim Chang 對于3D Fabric的演講。
-
臺積電
+關注
關注
44文章
5686瀏覽量
167002 -
微處理器
+關注
關注
11文章
2274瀏覽量
82776 -
晶圓代工
+關注
關注
6文章
861瀏覽量
48655
原文標題:臺積電,重新定義晶圓代工
文章出處:【微信號:today_semicon,微信公眾號:今日半導體】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
臺積電進入“晶圓代工2.0”,市場規模翻倍,押注先進封測技術

被臺積電拒絕代工,三星芯片制造突圍的關鍵在先進封裝?

三星電子晶圓代工副總裁:三星技術不輸于臺積電
臺積電引領全球晶圓代工熱潮,明年產值料增逾二成
晶圓出貨量增長!臺積電Q2營收飆漲,四大芯片代工廠財報有何亮點?

三星晶圓代工發力,挑戰臺積電地位
臺積電進入晶圓代工2.0時代





 臺積電,重新定義晶圓代工
臺積電,重新定義晶圓代工












評論