碳化硅作為第三代半導(dǎo)體經(jīng)典的應(yīng)用,具有眾多自身優(yōu)勢(shì)和技術(shù)優(yōu)勢(shì),它所制成的功率器件在生活中運(yùn)用十分廣泛,越來(lái)越無(wú)法離開(kāi),因此使用碳化硅產(chǎn)品的穩(wěn)定性在一定程度上也決定了生活的質(zhì)量。作為高尖精的產(chǎn)品,芯片的可靠性測(cè)試貫徹始終,從設(shè)計(jì)到選材再到最后的出產(chǎn),那研發(fā)過(guò)程中具體需要做哪些測(cè)試呢
芯片研發(fā)環(huán)節(jié)的可靠性測(cè)試
對(duì)于半導(dǎo)體企業(yè),進(jìn)行可靠性試驗(yàn)是提升產(chǎn)品質(zhì)量的重要手段。在進(jìn)行工業(yè)級(jí)產(chǎn)品可靠性驗(yàn)證時(shí),HTGB、H3TRB、TC、HTRB、AC/PCT、IOL試驗(yàn)就是驗(yàn)證器件可靠性的主要項(xiàng)目:
HTGB(高溫門(mén)極偏置測(cè)試)
高溫門(mén)極偏置測(cè)試是針對(duì)碳化硅MOS管的最重要的實(shí)驗(yàn)項(xiàng)目。在高溫環(huán)境下對(duì)門(mén)極長(zhǎng)期施加電壓會(huì)促使門(mén)極的性能加速老化,且MOSFET的門(mén)極長(zhǎng)期承受正電壓,或者負(fù)電壓,其門(mén)極的門(mén)檻值VGSth會(huì)發(fā)生漂移。
H3TRB(高壓高溫高濕反偏測(cè)試)
AEC-Q101中只有H3TRB這個(gè)類(lèi)別,其缺點(diǎn)是反壓過(guò)低,只有100V。主要是針對(duì)高溫高電壓環(huán)境下的失效的加速實(shí)驗(yàn)。高濕環(huán)境是對(duì)分立器件的封裝樹(shù)脂材料及晶片表面鈍化層的極大考驗(yàn),樹(shù)脂材料是擋不住水汽的,只能靠鈍化層,3種應(yīng)力的施加使早期的缺陷更容易暴露出來(lái)。
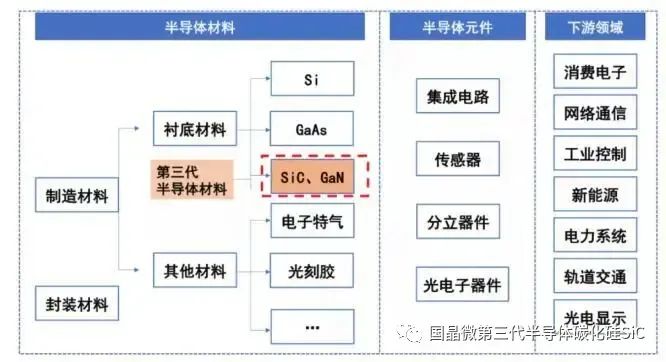
TC(溫度循環(huán)測(cè)試)
綁定線(xiàn)、焊接材料及樹(shù)脂材料受到熱應(yīng)力均存在老化和失效的風(fēng)險(xiǎn)。溫度循環(huán)測(cè)試把被測(cè)對(duì)象放入溫箱中,溫度在-55℃到150℃之間循環(huán)(H等級(jí)),這個(gè)過(guò)程是對(duì)封裝材料施加熱應(yīng)力,評(píng)估器件內(nèi)部各種不同材質(zhì)在熱脹冷縮作用下的界面完整性;此項(xiàng)目標(biāo)準(zhǔn)對(duì)碳化硅功率模塊而言很苛刻,尤其是應(yīng)用于汽車(chē)的模塊。
HTRB(高溫反偏測(cè)試)
HTRB是分立器件可靠性最重要的一個(gè)試驗(yàn)項(xiàng)目,其目的是暴露跟時(shí)間、應(yīng)力相關(guān)的缺陷,這些缺陷通常是鈍化層的可移動(dòng)離子或溫度驅(qū)動(dòng)的雜質(zhì)。半導(dǎo)體器件對(duì)雜質(zhì)高度敏感,制造過(guò)程中有可能引入雜質(zhì),雜質(zhì)在強(qiáng)電場(chǎng)作用下會(huì)呈現(xiàn)加速移動(dòng)或擴(kuò)散現(xiàn)象,最終雜質(zhì)將擴(kuò)散至半導(dǎo)體內(nèi)部導(dǎo)致失效。同樣的晶片表面鈍化層損壞后,雜質(zhì)可能遷移到晶片內(nèi)部導(dǎo)致失效。
HTRB試驗(yàn)可以使這些失效加速呈現(xiàn),排查出異常器件。半導(dǎo)體器件在150℃的環(huán)境溫箱里被施加80%的反壓,會(huì)出現(xiàn)漏電現(xiàn)象。如果在1000小時(shí)內(nèi)漏電參數(shù)未超出規(guī)格底線(xiàn),且保持穩(wěn)定不發(fā)生變化,說(shuō)明器件設(shè)計(jì)和封裝組合符合標(biāo)準(zhǔn)。
AC/PCT(高溫蒸煮測(cè)試)
高溫蒸煮測(cè)試是把被測(cè)對(duì)象放進(jìn)高溫高濕高氣壓的環(huán)境中,考驗(yàn)晶片鈍化層的優(yōu)良程度及樹(shù)脂材料的性能。被測(cè)對(duì)象處于凝露高濕氣氛中,且環(huán)境中氣壓較高,濕氣能進(jìn)入封裝內(nèi)部,可能出現(xiàn)分層、金屬化腐蝕等缺陷。
IOL(間歇工作壽命測(cè)試)
間歇工作壽命測(cè)試是一種功率循環(huán)測(cè)試,將被測(cè)對(duì)象置于常溫環(huán)境Ta=25℃,通入電流使其自身發(fā)熱結(jié)溫上升,且使Tj≧100℃,等其自然冷卻至環(huán)境溫度,再通入電流使其結(jié)溫上升,不斷循環(huán)反復(fù)。此測(cè)試可使被測(cè)對(duì)象不同物質(zhì)結(jié)合面產(chǎn)生應(yīng)力,可發(fā)現(xiàn)綁定線(xiàn)與鋁層的焊接面斷裂、芯片表面與樹(shù)脂材料的界面分層、綁定線(xiàn)與樹(shù)脂材料的界面分層等缺陷。對(duì)于材質(zhì)多且材質(zhì)與材質(zhì)接觸面比較多的模塊,此通過(guò)此項(xiàng)目難度較高。
以上每種可靠性試驗(yàn)都對(duì)應(yīng)著某種失效模式,可歸納為環(huán)境試驗(yàn)、壽命試驗(yàn)、篩選試驗(yàn)、現(xiàn)場(chǎng)使用試驗(yàn)、鑒定試驗(yàn)五大類(lèi),是根據(jù)環(huán)境條件、試驗(yàn)項(xiàng)目、試驗(yàn)?zāi)康摹⒃囼?yàn)性質(zhì)的不同,試驗(yàn)方法的不同分類(lèi)。
這是產(chǎn)品在投入市場(chǎng)前必須進(jìn)行可靠性試驗(yàn)。可靠性試驗(yàn)將失效現(xiàn)象復(fù)現(xiàn)出來(lái)排除隱患,避免在使用過(guò)程中出現(xiàn)可避免的失效。
審核編輯:湯梓紅
-
芯片
+關(guān)注
關(guān)注
456文章
51170瀏覽量
427261 -
半導(dǎo)體
+關(guān)注
關(guān)注
334文章
27703瀏覽量
222638 -
可靠性測(cè)試
+關(guān)注
關(guān)注
1文章
90瀏覽量
14236 -
碳化硅
+關(guān)注
關(guān)注
25文章
2824瀏覽量
49274
原文標(biāo)題:器件研發(fā)過(guò)程中的可靠性測(cè)試-國(guó)晶微半導(dǎo)體
文章出處:【微信號(hào):國(guó)晶微第三代半導(dǎo)體碳化硅SiC,微信公眾號(hào):國(guó)晶微第三代半導(dǎo)體碳化硅SiC】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦

芯片為什么要進(jìn)行可靠性測(cè)試呢! #芯片 #天天漲知識(shí) #芯片制造 #天天看科普#硬聲創(chuàng)作季
SDRAM芯片可靠性驗(yàn)證
GaN可靠性的測(cè)試
如何對(duì)嵌入式軟件進(jìn)行可靠性測(cè)試
碳化硅研發(fā)過(guò)程中具體需要做哪些測(cè)試呢?
碳化硅功率器件可靠性之芯片研發(fā)及封裝篇
芯片可靠性測(cè)試要求及標(biāo)準(zhǔn)解析

芯片研發(fā)過(guò)程中的可靠性測(cè)試——碳化硅功率器件

激光器芯片的壽命可靠性測(cè)試
幾種常見(jiàn)的芯片可靠性測(cè)試方法





 芯片研發(fā)環(huán)節(jié)的可靠性測(cè)試
芯片研發(fā)環(huán)節(jié)的可靠性測(cè)試










評(píng)論