來源:內(nèi)容由半導(dǎo)體芯聞(ID:MooreNEWS)
先進(jìn)半導(dǎo)體封裝的凸塊技術(shù)已取得顯著發(fā)展,以應(yīng)對(duì)縮小接觸間距和傳統(tǒng)倒裝芯片焊接相關(guān)限制帶來的挑戰(zhàn)。該領(lǐng)域的一項(xiàng)突出進(jìn)步是 3D Cu-Cu 混合鍵合技術(shù),它提供了一種變革性的解決方案。
隨著焊料凸點(diǎn)間距縮小,會(huì)出現(xiàn)一些問題。凸塊高度和接合表面積的降低使得建立可靠的電氣連接變得越來越困難,因此需要精確的制造工藝來避免錯(cuò)誤。關(guān)鍵的共面性和表面粗糙度變得至關(guān)重要,因?yàn)榧词故俏⑿〉牟灰?guī)則性也會(huì)影響成功的粘合。
制造面臨一些障礙,例如由于銅柱和凸塊直徑較小而導(dǎo)致蝕刻困難,從而更有可能發(fā)生底切。隨著有效確保均勻性和控制共面性變得更加困難,電化學(xué)沉積 (ECD) 電鍍變得更加復(fù)雜。此外,隨著凸塊尺寸不斷縮小,接合質(zhì)量對(duì)凸塊共面性、表面粗糙度和硬度等因素的敏感性使得對(duì)溫度、時(shí)間和壓力等參數(shù)的調(diào)整變得復(fù)雜。
傳統(tǒng)的倒裝芯片接合方法僅限于 50μm 或 40μm 的間距,由于熱膨脹不匹配導(dǎo)致翹曲和芯片移位,因此會(huì)遇到可靠性問題。為了應(yīng)對(duì)這些挑戰(zhàn),半導(dǎo)體行業(yè)正在轉(zhuǎn)向熱壓接合 (TCB),以實(shí)現(xiàn)先進(jìn)的細(xì)間距接合應(yīng)用,包括小至 10μm 的間距。TCB 為實(shí)現(xiàn)不斷發(fā)展的半導(dǎo)體封裝領(lǐng)域所需的精度和可靠性提供了一條有前途的途徑,從而突破了電子設(shè)備小型化和性能的界限。
然而,當(dāng)接觸間距減小到 10 微米左右時(shí),出現(xiàn)了一些問題。焊球尺寸的減小會(huì)增加金屬間化合物 (IMC) 形成的風(fēng)險(xiǎn),從而降低導(dǎo)電性和機(jī)械性能。此外,在回流焊過程中,焊球接觸并導(dǎo)致橋接故障的可能性可能會(huì)導(dǎo)致芯片故障。這些限制在高性能組件封裝場(chǎng)景中變得越來越成問題。
為了克服這些問題,銅-銅混合鍵合技術(shù)成為了游戲規(guī)則的改變者。這項(xiàng)創(chuàng)新技術(shù)涉及在介電材料之間嵌入金屬觸點(diǎn),并使用熱處理來實(shí)現(xiàn)銅原子的固態(tài)擴(kuò)散,從而消除與焊接相關(guān)的橋接問題。
混合鍵合相對(duì)于倒裝焊接的優(yōu)點(diǎn)是顯而易見的。
首先,它實(shí)現(xiàn)了超細(xì)間距和小觸點(diǎn)尺寸,有利于高 I/O 數(shù)量。這對(duì)于現(xiàn)代半導(dǎo)體封裝至關(guān)重要,因?yàn)樵O(shè)備需要越來越多的連接來滿足性能需求。
其次,與通常依賴底部填充材料的倒裝焊接不同,銅-銅混合鍵合不需要底部填充,從而減少了寄生電容、電阻和電感以及熱阻。
最后,銅-銅混合鍵合中鍵合連接的厚度減小,幾乎消除了倒裝芯片技術(shù)中 10-30 微米厚度的焊球,為更緊湊、更高效的半導(dǎo)體封裝開辟了新的可能性。
銅-銅混合鍵合技術(shù)為先進(jìn)半導(dǎo)體封裝帶來了巨大的前景,但它也帶來了一系列挑戰(zhàn),需要?jiǎng)?chuàng)新的解決方案來實(shí)現(xiàn)未來的發(fā)展。
目前Cu-Cu混合鍵合有三種方式。晶圓到晶圓(W2W)工藝是最常用的,而芯片到晶圓(D2W)或芯片到晶圓(C2W)工藝正在深入研究開發(fā)中,因?yàn)樗梢詽M足更多需要集成不同尺寸的應(yīng)用。
對(duì)于所有這三種方式,制造中的一個(gè)關(guān)鍵方面是鍵合環(huán)境,其中通過化學(xué)機(jī)械拋光 (CMP) 優(yōu)化實(shí)現(xiàn)平坦且清潔的電介質(zhì)表面至關(guān)重要。此外,開發(fā)能夠承受較低退火溫度和較短持續(xù)時(shí)間的介電材料對(duì)于最大限度地減少鍵合過程中晶圓變形和翹曲的可能性至關(guān)重要。優(yōu)化的銅溶液電化學(xué)沉積 (ECD) 還可以減少退火時(shí)間并降低退火溫度,從而提高效率。
就 D2W/C2W 工藝而言,解決與芯片分割和邊緣效應(yīng)相關(guān)的挑戰(zhàn)以及最大限度地減少芯片和晶圓上的污染將是關(guān)鍵。需要高精度貼片機(jī)來確保精確的芯片貼裝,并將公差縮小至低至 0.2μm。為了適應(yīng)潛在的放置錯(cuò)誤,必須使用更大的銅焊盤。此外,先進(jìn)的薄晶圓處理技術(shù)將在確保銅-銅混合鍵合的成功實(shí)施方面發(fā)揮重要作用。
銅-銅混合鍵合的未來發(fā)展可能會(huì)集中在改進(jìn)和優(yōu)化工藝的這些關(guān)鍵方面。這包括 CMP、介電材料、ECD 解決方案和拾放機(jī)械方面的進(jìn)步,以及處理薄晶圓方面的創(chuàng)新。克服這些挑戰(zhàn)將為先進(jìn)半導(dǎo)體封裝中更廣泛采用銅-銅混合鍵合鋪平道路,從而能夠創(chuàng)建更小、更強(qiáng)大且節(jié)能的電子設(shè)備。
審核編輯:湯梓紅
-
半導(dǎo)體
+關(guān)注
關(guān)注
334文章
27703瀏覽量
222628 -
3D
+關(guān)注
關(guān)注
9文章
2910瀏覽量
107995 -
封裝
+關(guān)注
關(guān)注
127文章
7992瀏覽量
143403 -
焊接
+關(guān)注
關(guān)注
38文章
3226瀏覽量
60119
原文標(biāo)題:3D cu-cu鍵合,封裝新革命?
文章出處:【微信號(hào):深圳市賽姆烯金科技有限公司,微信公眾號(hào):深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
3D顯示技術(shù)的發(fā)展現(xiàn)狀及未來趨勢(shì)
研發(fā)的銅混合鍵合工藝正推動(dòng)下一代2.5D和3D封裝技術(shù)

BOE濕蝕對(duì)三維集成中銅模式直接鍵界面特性的影響
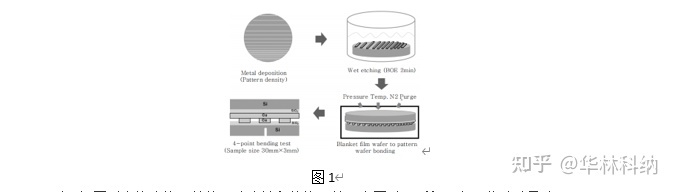
先進(jìn)封裝中銅-銅低溫鍵合技術(shù)研究進(jìn)展

混合鍵合技術(shù)大揭秘:優(yōu)點(diǎn)、應(yīng)用與發(fā)展一網(wǎng)打盡

先進(jìn)封裝中銅-銅低溫鍵合技術(shù)研究進(jìn)展

混合鍵合技術(shù):開啟3D芯片封裝新篇章

混合鍵合,成為“芯”寵

揭秘3D集成晶圓鍵合:半導(dǎo)體行業(yè)的未來之鑰

從發(fā)展歷史、研究進(jìn)展和前景預(yù)測(cè)三個(gè)方面對(duì)混合鍵合(HB)技術(shù)進(jìn)行分析

Cu-Cu Hybrid Bonding技術(shù)在先進(jìn)3D集成中的應(yīng)用

微電子封裝用Cu鍵合絲,挑戰(zhàn)與機(jī)遇并存





 3D Cu-Cu混合鍵合技術(shù)的優(yōu)點(diǎn)和未來發(fā)展
3D Cu-Cu混合鍵合技術(shù)的優(yōu)點(diǎn)和未來發(fā)展












評(píng)論