InAs/GaSb超晶格光敏芯片與讀出電路采用倒裝互連的形式構(gòu)成紅外探測器芯片。紅外光透過GaSb襯底后,被InAs/GaSb光敏材料吸收而轉(zhuǎn)換為電信號;經(jīng)互連電路的讀出、轉(zhuǎn)換、放大和除噪聲處理后實(shí)現(xiàn)光電信號輸出。因此,入射到光敏芯片上的紅外光越強(qiáng),探測器輸出的電信號也越強(qiáng),探測器成像效果就越好。
但是,探測器正常工作時(shí)要降溫到77 K。在此溫度下,較厚GaSb襯底的紅外透過率低,透過的紅外光少,影響探測器的成像質(zhì)量。其次,探測器制備過程在襯底表面留下明顯的加工損傷,這些損傷也會影響器件的成像效果。因此迫切需要開發(fā)高表面質(zhì)量探測器背減薄技術(shù)。
紅外探測器芯片背減薄的主要方式有機(jī)械切削、機(jī)械拋光、機(jī)械化學(xué)拋光和化學(xué)拋光等。機(jī)械拋光會在襯底表面留下一定深度的損傷層,需要結(jié)合機(jī)械化學(xué)拋光或化學(xué)拋光去除。而GaSb材料活性大、帶隙小,Sb基氧化物具有鈍化作用,使得GaSb的純化學(xué)拋光難以進(jìn)行。
據(jù)麥姆斯咨詢報(bào)道,近期,中國電子科技集團(tuán)有限公司第十一研究所的科研團(tuán)隊(duì)在《紅外》期刊上發(fā)表了以“InAs/GaSb Ⅱ類超晶格紅外探測器背減薄技術(shù)研究”為主題的文章。該文章第一作者為王曉乾,主要從事超晶格紅外探測器方面的研究工作。
本文采用機(jī)械拋光和機(jī)械化學(xué)拋光相結(jié)合的工藝減薄襯底,并系統(tǒng)研究機(jī)械化學(xué)拋光過程中拋光液pH值對襯底表面質(zhì)量的影響。
實(shí)驗(yàn)
如圖1所示,實(shí)驗(yàn)片為倒裝互連后的紅外探測器芯片。從圖1(a)中可以看出,減薄前的探測器芯片的襯底厚度較大,且表面存在很多機(jī)械損傷。經(jīng)背減薄后,探測器芯片的襯底厚度明顯減小,表面的損傷也得到去除。
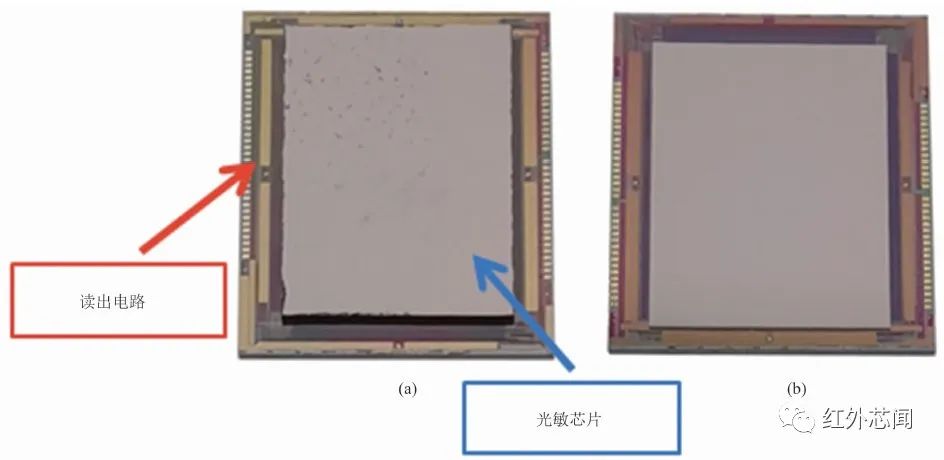
圖1 倒裝互連后的探測器芯片(樣品 A):(a)減薄前;(b)減薄后
互連芯片的背減薄由粗拋光和精拋光兩個(gè)過程完成。粗拋光選擇磨料尺寸為3 μm的機(jī)械拋光,在機(jī)械作用下快速去除襯底。考慮到GaSb材料硬而脆,機(jī)械加工困難,單一機(jī)械磨削會在襯底表面留下劃痕,所以粗拋光后要預(yù)留20 μm厚的襯底進(jìn)行精拋光。精拋光是通過機(jī)械化學(xué)拋光方式消除粗拋光帶來的機(jī)械損傷。
機(jī)械化學(xué)拋光液由雙氧水、磷酸、氫氧化鈉和0.5 μm氧化鋁磨料構(gòu)成。實(shí)驗(yàn)選擇PM5型拋光機(jī),拋光過程示意圖如圖2所示。樣品在粗拋光和精拋光工藝過程后,利用測厚顯微鏡測量減薄后的芯片高度,保證減薄后的襯底厚度剩余40 μm左右。
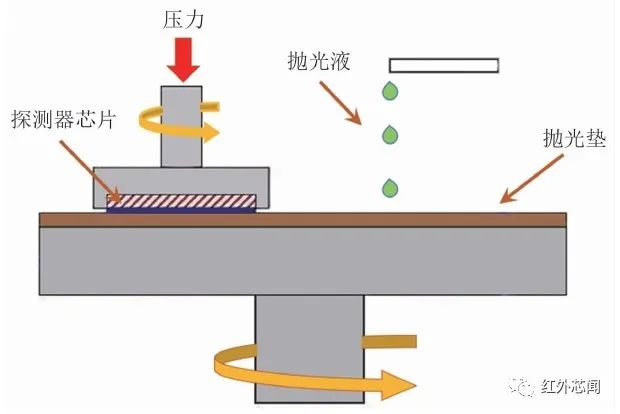
圖2 拋光工藝示意圖
粗拋光削減了大部分襯底厚度,精拋光則用于去除機(jī)械損傷,改善表面質(zhì)量。機(jī)械化學(xué)拋光是拋光液中氧化劑的化學(xué)腐蝕和磨料的機(jī)械磨削共同作用的結(jié)果,襯底的表面質(zhì)量取決于該過程中化學(xué)作用與機(jī)械作用的相對強(qiáng)度。在保證拋光過程中壓力和轉(zhuǎn)速一定的情況下,通過磷酸溶液調(diào)配機(jī)械化學(xué)拋光液的pH值,調(diào)控拋光過程的化學(xué)作用強(qiáng)度,從而研究不同pH值拋光液對GaSb襯底的拋光效果。拋光液的pH值與加入酸含量的關(guān)系見表1。利用檢測顯微鏡和原子力顯微鏡表征機(jī)械化學(xué)拋光后襯底的表面情況,初步判斷不同pH值拋光液的化學(xué)作用與機(jī)械作用的相對大小。利用X射線雙晶衍射法測試樣品的損傷層,進(jìn)一步確定不同pH值拋光液的拋光效果。
表1 拋光液pH值與磷酸體系溶液比例的關(guān)系

結(jié)果與討論
圖3為聚焦離子束掃描電子顯微鏡(FIB-SEM)得到的微區(qū)解剖圖像。可以看出,背減薄后的襯底厚度剩余42 μm左右。保留一定厚度的襯底,一方面能夠滿足探測紅外光透過的要求,另一方面還能為深臺面結(jié)構(gòu)的光敏芯片提供足夠支撐,保障芯片在開關(guān)機(jī)過程溫度沖擊下的穩(wěn)定。
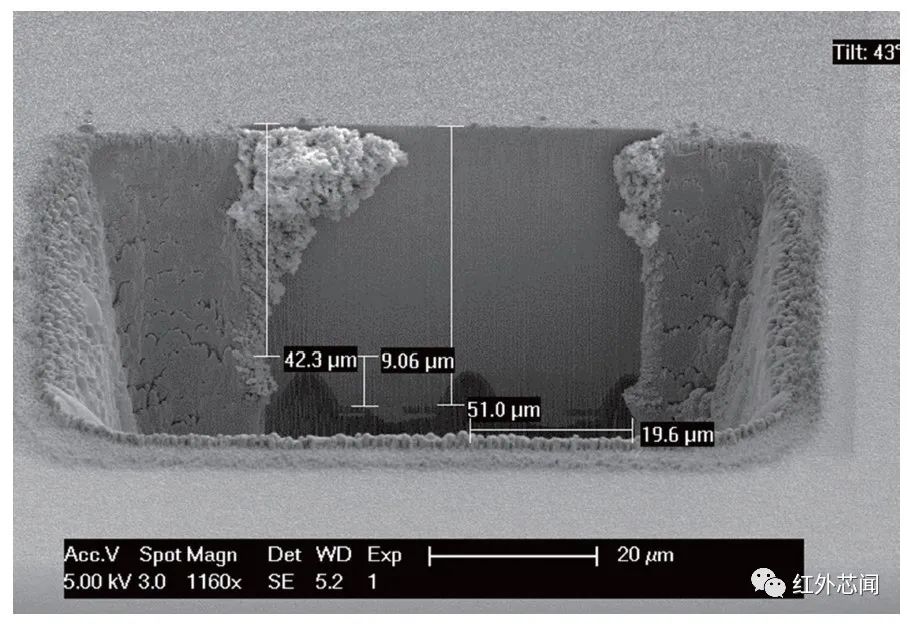
圖3 背減薄后襯底厚度的FIB-SEM圖像
利用放大100倍的檢測顯微鏡觀察襯底表面(結(jié)果見圖4)。其中沒有添加磷酸溶液的拋光液的pH值為11.8,精拋光后襯底表面存在較多的腐蝕坑。由于機(jī)械化學(xué)拋光液與襯底作用,造成了過度腐蝕,在機(jī)械剝離作用下形成腐蝕坑。添加1%的磷酸體系溶液后,拋光液的pH值為10.2。此時(shí)襯底表面上的腐蝕坑數(shù)量明顯減少。當(dāng)添加1.4%的磷酸體系溶液后,拋光液的pH值為9.4。此時(shí)襯底表面平整光滑,沒有出現(xiàn)明顯的腐蝕坑,且表面也沒有明顯的機(jī)械劃痕,說明機(jī)械與化學(xué)作用接近,具有很好的拋光效果。當(dāng)pH值低于8.3后,襯底表面出現(xiàn)一些明顯的劃痕,此時(shí)的機(jī)械作用較強(qiáng),機(jī)械摩擦產(chǎn)生劃痕。

圖4 不同pH值拋光液拋光后的表面形貌圖(放大100倍):(a)pH值為11.8;(b)pH值為10.2;(c)pH值為9.4;(d)pH值為8.3
利用X射線雙晶衍射法表征襯底損傷情況。測試結(jié)果列于表2中。可以看出,經(jīng)pH值為9.4的機(jī)械化學(xué)拋光液拋光過的樣品表面的加工損傷層最小,而隨著拋光液pH值的降低,機(jī)械作用增強(qiáng),機(jī)械作用相對強(qiáng)度增大,在襯底表面留下的機(jī)械劃痕增多,表面損傷程度呈現(xiàn)增加趨勢。而拋光液pH值過高時(shí),存在化學(xué)腐蝕坑也使得襯底表面損傷程度較高。結(jié)合檢測顯微鏡結(jié)果可以判斷,當(dāng)拋光液pH值為9.4時(shí),更有利于獲得高質(zhì)量的襯底表面。利用原子力顯微鏡(AFM)表征拋光液(pH值為9.4)拋光后的襯底表面,獲得的立體形貌如圖5所示。可以看出,襯底表面粗糙度降低到2.6 nm。
表2 不同pH值拋光液對襯底的損傷


圖5 AFM立體形貌
將該探測器芯片封裝到微杜瓦內(nèi),測試減薄后紅外探測器的光譜透過和成像情況(結(jié)果見圖6)。從圖6(a)中可以看出,背減薄前,探測器的光譜透過率均低于20%;背減薄后,探測器的光譜透過率有了明顯增加,其中4.5~5.4 μm波段的透過率提升66%左右,5.4~10 μm波段的透過率提升25%左右。從圖6(b)中可以看出,紅外圖像層次較分明,輪廓清晰,圖像表面沒有出現(xiàn)多余的線條和污點(diǎn),說明InAs/GaSb Ⅱ類超晶格紅外探測器件的背減薄工藝適配性好;機(jī)械化學(xué)拋光液的pH值為9.4時(shí),獲得了高表面質(zhì)量的GaSb襯底,進(jìn)而實(shí)現(xiàn)了高成像品質(zhì)的紅外探測器組件。

圖6 探測器組件封裝測試:(a)光譜透過率曲線;(b)成像效果圖
結(jié)束語
本文主要研究了InAs/GaSb Ⅱ類超晶格紅外探測器芯片背減薄后的襯底情況。結(jié)果表明,機(jī)械化學(xué)拋光液的pH值顯著影響機(jī)械化學(xué)拋光過程的化學(xué)作用強(qiáng)度。當(dāng)pH值較高時(shí),化學(xué)腐蝕作用明顯,在襯底表面留下明顯的腐蝕坑。當(dāng)pH低于一定值時(shí),化學(xué)腐蝕作用變差,機(jī)械作用相對增大,在襯底表面留下機(jī)械劃痕。腐蝕坑和機(jī)械劃痕的存在,都使得襯底表面損傷較大。而當(dāng)拋光液的pH值為9.4時(shí),機(jī)械作用強(qiáng)度與化學(xué)腐蝕強(qiáng)度相匹配,拋光后樣品表面損傷小,粗糙度小,探測器組件成像效果好。
機(jī)械拋光結(jié)合機(jī)械化學(xué)拋光的背減薄工藝,不僅可以實(shí)現(xiàn)襯底厚度的快速去除,而且還可以獲得高質(zhì)量襯底表面,為探測器組件的高品質(zhì)成像提供支持。該工藝為Ⅱ類超晶格材料在紅外探測領(lǐng)域的產(chǎn)業(yè)化發(fā)展奠定了重要基礎(chǔ)。但是,這種背減薄工藝過程中長時(shí)間受外加壓力作用,對探測器芯片的結(jié)構(gòu)穩(wěn)定性有一定影響,在成品率提升方面還有優(yōu)化空間。
審核編輯:劉清
-
紅外探測器
+關(guān)注
關(guān)注
5文章
290瀏覽量
18157 -
光譜儀
+關(guān)注
關(guān)注
2文章
978瀏覽量
30929 -
電信號
+關(guān)注
關(guān)注
1文章
840瀏覽量
20673
原文標(biāo)題:InAs/GaSb Ⅱ類超晶格紅外探測器背減薄技術(shù)研究
文章出處:【微信號:MEMSensor,微信公眾號:MEMS】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
雷達(dá)探測器的工作原理 雷達(dá)探測器與激光探測器區(qū)別
被動紅外探測器的特點(diǎn)和安裝使用要求
被動紅外探測器接線方法
被動紅外探測器與主動紅外探測器的原理比較
被動紅外探測器和主動紅外探測器的區(qū)別
防盜報(bào)警探測器有哪幾種類型?其基本工作原理是什么?

基于米氏超構(gòu)表面的像素集成長波多光譜Ⅱ類超晶格探測器
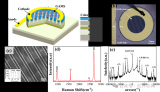
非制冷紅外探測器的敏感材料

中科愛畢賽思紅外光電探測技術(shù),打破高端市場“卡脖子”困境

可變冷光闌紅外探測器研究進(jìn)展和關(guān)鍵技術(shù)分析綜述
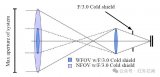
銻化物超晶格紅外探測器研究進(jìn)展與發(fā)展趨勢綜述
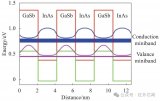




 InAs/GaSb Ⅱ類超晶格紅外探測器背減薄技術(shù)工作研究
InAs/GaSb Ⅱ類超晶格紅外探測器背減薄技術(shù)工作研究
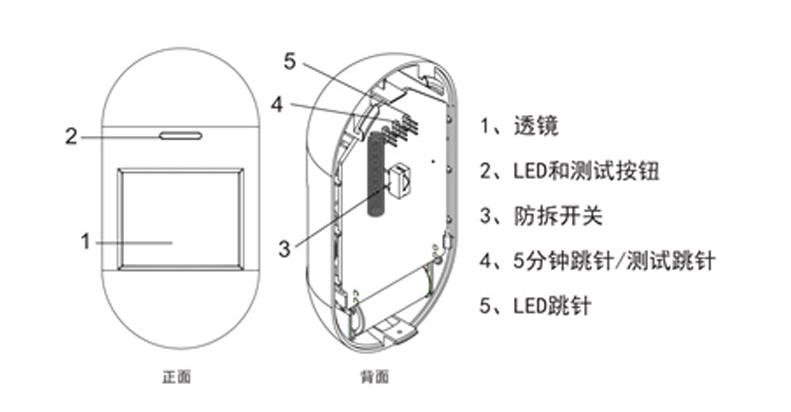
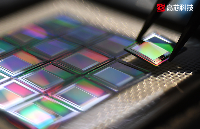
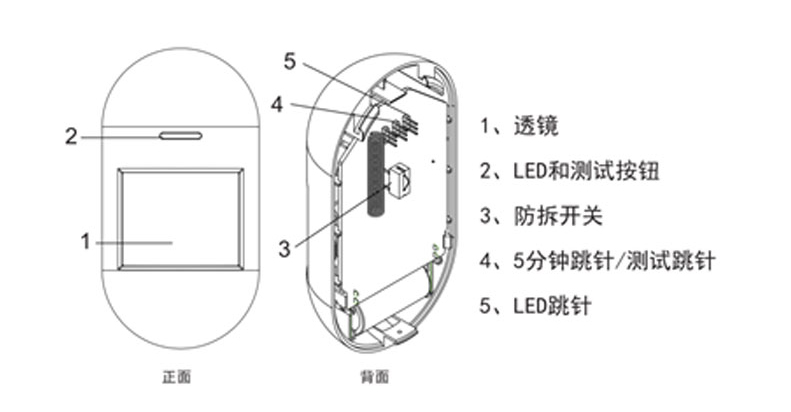










評論