IGBT的結構中絕大部分區域是低摻雜濃度的N型漂移區,其濃度遠遠低于P型區,當IGBT柵極施加正向電壓使得器件開啟后,集電極、漂移區以及發射極(通過溝道,后文在MOS溝道效應時再詳細討論開啟過程)會形成一個PIN結構,其中I是intrinsic的首字母,表示這個區域的摻雜濃度很低。

如上圖所示,陽極對應IGBT中的集電極,陰極對應IGBT中的發射極。當陰極施加正電壓時,PIN處于關斷狀態,根據前面的分析,阻斷狀態下主要由摻雜濃度更低I區域承受電壓,不再贅述。重點關注陽極施加正電壓,PIN處于開通狀態的內部載流子工作情況。
在前面,我們討論了半導體內部的存在固有的復合率,且隨著載流子濃度的增加而增加。當PIN結構處于開啟狀態時,空穴從陽極、電子從陰極注入,所以器件內部的載流子濃度相應增高,從而載流子復合率也會上升。當器件處于穩態時,載流子的注入與載流子的復合應處于平衡狀態。
假設處于穩態時的電流密度為 (電流回路中處處相同),空穴濃度分布
(電流回路中處處相同),空穴濃度分布 ,電子濃度分布為
,電子濃度分布為 。根據電中性原則,
。根據電中性原則,  。由此,只需要推導出任意一種載流子濃度分布即可。下面以電子濃度為例做簡要推導。
。由此,只需要推導出任意一種載流子濃度分布即可。下面以電子濃度為例做簡要推導。
穩態狀況下的載流子濃度不隨時間變化,即 ,所以連續性方程可表達為:
,所以連續性方程可表達為:

 大注入下的載流子壽命。上式左邊第一項為復合電流,第二項為擴散電流, 具體可參見第一章的微觀電流,并利用了電中性條件下電場
大注入下的載流子壽命。上式左邊第一項為復合電流,第二項為擴散電流, 具體可參見第一章的微觀電流,并利用了電中性條件下電場 。
。
需要注意的是,這里所采用的擴散系數 不同于自由電子的擴散系數
不同于自由電子的擴散系數 ,
,  被稱為雙極型擴散系數,其物理解釋如下:
被稱為雙極型擴散系數,其物理解釋如下:
半導體中電子和空穴總是成對產生,但是由于其質量的不同,導致其遷移率不同(電子遷移率約為空穴的三倍),從而在相同電場或者相同濃度梯度下,電子比空穴的運動速度更快,導致電子空穴對很快產生空間距離,根據異性電荷相吸的原理,空穴會受到一個與運動速度方向相同的庫侖力,加快其運動速度,相反,電子會受到一個與運動速度方向相反的庫侖力,降低其運動速度。整體表現為,電子的遷移率和擴散系數減小,而空穴的遷移率和擴散系數增大。

所以,在雙極型器件工作過程中,電子的遷移率會降低,而空穴的遷移率會升高,新定義雙極性遷移率和雙極性擴散系數來表征這個綜合效應,表達式如下(推導略),

由此,在穩態狀況下,雙極性器件的載流子遷移率為0,即沒有漂移運動,其運動完全來自于擴散運動。
需要注意的是,上述表征是電子和空穴的綜合效應,單獨的電子和空穴是存在漂移運動的, 即電子和空穴的漂移運動相互抵消 。
回到擴散方程,其在一維空間的表達式為:

令,  ,上述二階微分方程的特征解為,
,上述二階微分方程的特征解為,

系數A和B的求解可借助陽極和陰極邊界條件,顯然,陰極界面 的空穴電流為0,而陽極界面
的空穴電流為0,而陽極界面 的電子電流為0。
的電子電流為0。

上式推導利用了 ,以及愛因斯坦關系式
,以及愛因斯坦關系式
將電場強度表達式代入 的電子電流表達式,即可得到電流與電荷濃度的關系,即為
的電子電流表達式,即可得到電流與電荷濃度的關系,即為 的邊界條件,
的邊界條件,

同理,在 的邊界條件,
的邊界條件,

利用這兩個邊界條件,同時利用電中性條件, ,并近似認為電子的遷移率是空穴遷移率的3倍,可以得到載流子濃度與電流的關系如下(詳細推導過程略去),
,并近似認為電子的遷移率是空穴遷移率的3倍,可以得到載流子濃度與電流的關系如下(詳細推導過程略去),


顯然載流子在I區的濃度分布是非對稱的,因為電子遷移率更大的緣故,載流子濃度最低值靠近陰極。
文末總結
1.穩態狀況下的載流子濃度不隨時間變化,可表達:

2.半導體中電子和空穴總是成對產生,但是由于其質量的不同,導致其遷移率不同。
3.利用了 ,以及愛因斯坦關系式,可得到電流與電荷濃度的關系,在
,以及愛因斯坦關系式,可得到電流與電荷濃度的關系,在 的邊界條件:
的邊界條件:

在 的邊界條件:
的邊界條件:

4.得到載流子濃度與電流的關系如下:

-
半導體
+關注
關注
334文章
27711瀏覽量
222651 -
MOS管
+關注
關注
108文章
2439瀏覽量
67573 -
IGBT
+關注
關注
1269文章
3834瀏覽量
250080 -
PIN
+關注
關注
1文章
305瀏覽量
24435 -
載流子
+關注
關注
0文章
134瀏覽量
7693
發布評論請先 登錄
相關推薦
IGBT的物理結構模型—PIN&MOS模型(3)

IGBT并聯技術分析
請教分析這個IGBT有沒有燒壞
簡述IGBT模塊的內部結構與電路圖分析
IGBT在固態電源中是如何保護電路的?且看IGBT損壞機理分析
IGBT模塊瞬態熱特性退化分析
電機驅動器MCU拆解之IGBT分析
IGBT的基礎知識--IGBT的基本結構,參數選擇,使用注意

IGBT的基本結構和工作原理等資料合集說明
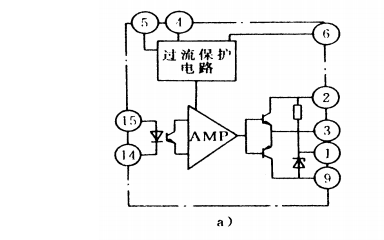




 IGBT中的PIN結構分析(1)
IGBT中的PIN結構分析(1)

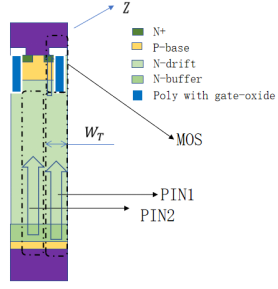
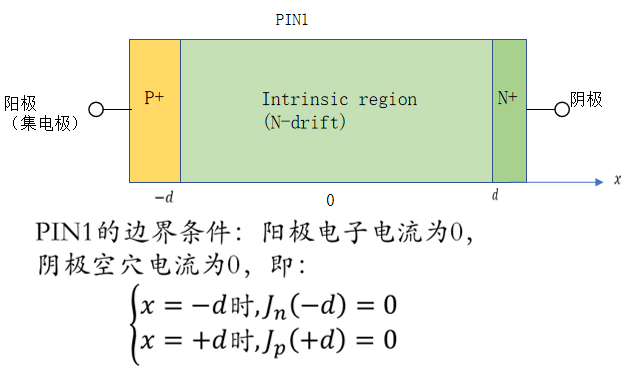











評論