1 引言
無源電位襯度(Passive Voltage Contrast,PVC)定位基于導(dǎo)電結(jié)構(gòu)的FIB或SEM圖像或多或少的亮度差異,可用于半導(dǎo)體電路的失效定位。有源電位襯度(Active Voltage Contrast,AVC)法提供了更多的定位可能性。這種方法是在某些結(jié)構(gòu)上施加外部偏置,使得襯度差異更加明顯。AVC的主要優(yōu)勢(shì)在于不僅可以檢測(cè)開路和短路,還可以檢測(cè)導(dǎo)體或觸點(diǎn)電阻增加導(dǎo)致的失效。
2 FIB中的無源電位襯度
2.1 FIB中PVC定位的基本原理
PVC意味著具有不同電性能的結(jié)構(gòu)在FIB(或SEM)圖像中的亮度差異。芯片未連接任何電源或信號(hào)源(無源),并且在大多數(shù)情況下已經(jīng)進(jìn)行了部分去層。PVC進(jìn)行失效定位的基礎(chǔ)是浮動(dòng)結(jié)構(gòu)在主粒子束影響下荷電。在FIB中,這種荷電總是正的,并在很大程度上取決于主離子束束流。在SEM中,荷電可正可負(fù),其取決于主電子束能量和電子束束流。下文將對(duì)此進(jìn)行詳細(xì)說明。圖1顯示的是較常觀察到的正荷電情況。
絕緣結(jié)構(gòu)飛離二次電子的影響下正荷電。緊接著,產(chǎn)生的大部分二次電子被電場(chǎng)阻止離開樣品。這些結(jié)構(gòu)在圖像中顯示為暗色,因?yàn)殡娮訜o法到達(dá)二次電子探測(cè)器。接地結(jié)構(gòu)不帶電,由于產(chǎn)生的二次電子量大,因此在圖像中顯得明亮。如果通常應(yīng)該是浮起的結(jié)構(gòu)出現(xiàn)亮光,那么就急需懷疑它有問題。另一方面,如果本應(yīng)該接地的結(jié)構(gòu)出現(xiàn)暗色,這也是故障的強(qiáng)烈信號(hào)。第一張情況并不僅限于由于設(shè)計(jì)原因而自然浮起的結(jié)構(gòu)。結(jié)構(gòu)也可以通過去層處理而變成浮起的,如圖2所示的柵極及其觸點(diǎn)。
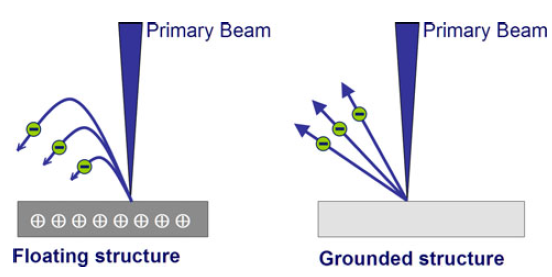
圖1絕緣結(jié)構(gòu)的正荷電

圖2 通過去層使結(jié)構(gòu)浮起
另一種使結(jié)構(gòu)浮動(dòng)的方法是用FIB切割導(dǎo)線。如果這種線是亮的而不是暗的,可以通過如圖3所示的方法將線路切割成若干段找到基底短路。剩下的明亮部分就是故障點(diǎn)。

圖3 通過FIB切割使結(jié)構(gòu)浮起,并找到故障部分
對(duì)于其它失效定位問題,研究接地結(jié)構(gòu)可能會(huì)有所幫助。如圖4所示,由于設(shè)計(jì)原因,結(jié)構(gòu)可以自然接地,例如n阱中的n擴(kuò)散或p阱的p擴(kuò)散。

圖4 經(jīng)過部分去層的樣品,其結(jié)構(gòu)(右)與地面相連
如果要研究一個(gè)未接地的結(jié)構(gòu),可以通過在其上鉆一個(gè)FIB孔,然后進(jìn)行金屬沉積來實(shí)現(xiàn)接地。圖5中左邊的結(jié)構(gòu)應(yīng)該是暗的,因?yàn)樗歉∑鸬摹H绻皇沁@樣,那么相鄰結(jié)構(gòu)之間一定存在短路(氧化物中的細(xì)線),而為了進(jìn)行定位,相鄰結(jié)構(gòu)被特意接地。

圖5 通過FIB將兩個(gè)相鄰的浮起結(jié)構(gòu)中的一個(gè)接地,可以檢測(cè)出它們之間的短路
無源電位襯度產(chǎn)生的基本原理可歸納如下:浮起結(jié)構(gòu)可以通過去層或FIB切割制成。它們呈現(xiàn)暗色。結(jié)構(gòu)可以通過設(shè)計(jì)從一開始就接地,也可以通過FIB連接接地。它們看起來很亮。
2.2 PVC應(yīng)用案例和案例研究
在圖6中,觸點(diǎn)鏈的一部分呈現(xiàn)暗色,因?yàn)橛|點(diǎn)斷開導(dǎo)致其浮動(dòng)。明亮的部分則被設(shè)計(jì)接地。在這種情況下,“接地結(jié)構(gòu)”一詞的意思是,它與任何基底區(qū)域或大的網(wǎng)格有接觸,這與“接地”表示對(duì)質(zhì)量勢(shì)(mass potential)的電阻幾乎為零的常規(guī)含義相矛盾。

圖6 觸點(diǎn)鏈斷開
圖7顯示了在大型梳狀蛇形測(cè)試結(jié)構(gòu)中應(yīng)用二重查找定位線短路的情況。通過在基板上鉆一個(gè)FIB孔,并用氣相輔助沉積法填充鉑,蛇形結(jié)構(gòu)被接地。梳狀結(jié)構(gòu)被隔離開來,本來應(yīng)該是黑的,但由于蛇狀結(jié)構(gòu)被短路,梳狀結(jié)構(gòu)被沒有變黑。梳狀結(jié)構(gòu)被切成兩片,一片變黑,另一片保持明亮。接著,明亮的部分又被切成兩部分,其中一部分仍然明亮(見左上圖)。最后,只有一根橫向的梳狀結(jié)構(gòu)仍然是亮的。現(xiàn)在,這個(gè)梳狀結(jié)構(gòu)又被切成兩等份。亮的部分又被切掉,依次類推。最后分離出一小塊(見右側(cè)顯微照片),它通過一個(gè)導(dǎo)電顆粒與蛇狀結(jié)構(gòu)連接在一起。

圖7 大型梳-蛇形試驗(yàn)結(jié)構(gòu)中定位線短路的二重查找策略
圖8顯示了由幾百個(gè)深溝電容器組成的測(cè)試陣列。電氣測(cè)試顯示存在漏徑,但無法確定是哪個(gè)電容器泄漏。用中等束流進(jìn)行簡(jiǎn)單的FIB掃描后,可以清楚地發(fā)現(xiàn)在陣列的上邊緣有三個(gè)泄漏的電容器。只有這三個(gè)電容器沒有荷電,因此沒有出現(xiàn)黑點(diǎn)。

圖8 深溝電容器測(cè)試陣列俯視圖,有三個(gè)泄漏溝槽
2.3 PVC產(chǎn)生的高級(jí)機(jī)制
如果涉及二極管、電容器和晶體管,PVC的產(chǎn)生和解釋就復(fù)雜得多。在基片接觸的情況下,必須考慮摻雜因素。在研究大型結(jié)構(gòu)時(shí),其電容起著重要作用。甚至晶體管斷裂時(shí)也會(huì)影響PVC的產(chǎn)生。圖9顯示了在源極和漏極觸點(diǎn)(S/D)上產(chǎn)生的PVC。Gemmill等人描述了兩種不同基本類型的基片觸點(diǎn)(p+和n+擴(kuò)散)上的VC。n+在p阱中擴(kuò)散形成的二極管為反向偏置。留下的二次電子產(chǎn)生的電荷無法流向基底。這些觸點(diǎn)看起來是暗的。n阱中的p+擴(kuò)散形成正向偏置二極管。在這里,正電荷很容易流向地面,因此這些觸點(diǎn)是明亮的。

圖9 S/D觸點(diǎn)處產(chǎn)生的PVC
但還必須考慮到連接阱的觸點(diǎn)(p阱中的p擴(kuò)散和n阱中n擴(kuò)散)。由于沒有二極管,這些觸點(diǎn)看起來總是很亮。最暗的觸點(diǎn)是連接?xùn)艠O的觸點(diǎn),因?yàn)闁艠O氧化物將它們與地完全隔離。從圖10中可以看到不同接觸類型的不同襯度。

圖10 不同接觸類型的不同襯度
圖11顯示了結(jié)構(gòu)的電容如何影響PVC的產(chǎn)生。如果結(jié)構(gòu)非常大,例如一條很長(zhǎng)的導(dǎo)線,那么就不會(huì)產(chǎn)生足夠的電荷載流子來顯著提高該結(jié)構(gòu)的電位。它就會(huì)像接地結(jié)構(gòu)一樣保持明亮,或者因?yàn)樵趫D像掃描過程中荷電而緩慢變黑。

圖11 大型結(jié)構(gòu)(右圖)就像一個(gè)大電容器,在離子束掃過它們的短時(shí)間內(nèi)無法充分充電
圖12顯示了具有一定電容C和一定接地電阻R的結(jié)構(gòu)的等效電路圖。電流Is是進(jìn)入結(jié)構(gòu)的正離子和離開結(jié)構(gòu)的二次電子的總和。相應(yīng)微分方程的解給出了在結(jié)構(gòu)中形成的電壓U c 。

圖12 高、中、低結(jié)構(gòu)電容的等效電路圖、相應(yīng)微分方程的解法和圖形表示法
圖中顯示的是不斷荷電情況下的電壓曲線。實(shí)際上,荷電只發(fā)生在離子束掃過結(jié)構(gòu)的時(shí)間內(nèi),標(biāo)記為t scan 。在這段時(shí)間之后,荷電是不完全的,但結(jié)構(gòu)的電容越小,荷電就越大。就VC而言,這意味著電容小的結(jié)構(gòu)往往比電容大的結(jié)構(gòu)更亮。
電壓Uc的計(jì)算公式也非常適合用于研究從結(jié)構(gòu)到地的漏電流的影響。這些漏電流的產(chǎn)生可能是由于去層后的表面導(dǎo)電性,也可能是由于該結(jié)構(gòu)所連接的電路。
在圖13中,我們可以看到Uc(t)在電容C固定但泄漏電阻R值不同的情況下的圖示。對(duì)于低值電阻,電壓Uc無法積累到阻止二次電子離開所需的量。二次電子可以到達(dá)探測(cè)器,從而形成一個(gè)明亮的結(jié)構(gòu)。根據(jù)實(shí)驗(yàn)觀察,Rmedium約為1 GOhm。低于這個(gè)數(shù)量級(jí)就無法觀測(cè)到暗結(jié)構(gòu)。

圖13 在離子束掃描過程中,泄漏電阻對(duì)結(jié)構(gòu)上產(chǎn)生的電壓的影響
在晶體管上還可以看到另外一個(gè)有趣的PVC現(xiàn)象。S/D觸點(diǎn)的襯度隨相應(yīng)柵極是否接地而變化。
圖14中晶體管的左源極觸點(diǎn)通常被認(rèn)為是暗的,因?yàn)樗旅嬗幸粋€(gè)反向偏置的二極管。實(shí)際上,它是明亮的,因?yàn)殡姾煽梢酝ㄟ^打開的晶體管逃逸到接地的漏極。在離子束掃描過程中,柵極通過氧化物帶正電,因此打開。當(dāng)用FIB切割柵極附近的氧化物將柵極導(dǎo)體接地時(shí)(無需填充金屬),源極觸點(diǎn)會(huì)突然變暗。圖15概述了PVC產(chǎn)生的高級(jí)機(jī)制。

圖14 n-MOS晶體管根據(jù)柵極的開啟或關(guān)閉顯示不同的PVC

圖15 產(chǎn)生PVC的高級(jí)機(jī)制
2.4 高級(jí)PVC的應(yīng)用和案例研究
圖16表明,結(jié)構(gòu)容量必須考慮在內(nèi)。這些圓圈標(biāo)記著連接?xùn)艠O導(dǎo)體線的觸點(diǎn),這些觸點(diǎn)通過金屬0的著陸墊和進(jìn)一步的觸點(diǎn)稱為CG。樣品部分去層。從上往下第二個(gè)圓圈中的觸點(diǎn)是看不到的,因?yàn)樗鼛щ姡@示出明顯的電位襯度。另一方面,其他圓圈中的觸點(diǎn)也連接到了浮起結(jié)構(gòu)(柵極線總是浮起的),應(yīng)該是暗的,但事實(shí)并非如此。它們所連接的柵極結(jié)構(gòu)相對(duì)較大,具有相當(dāng)大的電容。觸點(diǎn)暴露在離子束中的時(shí)間太短,無法對(duì)整個(gè)結(jié)構(gòu)充電。在這種幸運(yùn)的情況下,從上往下第二個(gè)圓圈下的開放式觸點(diǎn)得以發(fā)現(xiàn),隨后在FIB中制備的橫截面也證實(shí)了這一點(diǎn),如圖17所示。

圖16 COMS電路柵極觸點(diǎn)開路

圖17 通過電位襯度定位柵極觸點(diǎn)開路
從圖18中還可以研究電容的作用。每四條線中就有一條是浮起線,而且相對(duì)較長(zhǎng),而其他的線則接地。浮起線具有很高的電容,在從上到下的掃描過程中可以看到它們?cè)谥饾u充電。接地線由于電容較小,因此亮度均勻。

圖18 電容較小的位線逐漸充電
下面的失效定位案例研究得益于這樣一個(gè)事實(shí),即npn型晶體管可以通過柵極正向充電來打開,也可以通過柵極接地關(guān)閉。
圖19顯示了深溝道DRAM晶體管的橫截面。離子束掃描部分去層樣品,通過剩余的氧化物對(duì)柵極充電,并打開晶體管。在源極觸點(diǎn)上的感應(yīng)電荷可以通過通道向下流到電容器前面的基底上,如寬箭頭所示。

圖19 深溝道DRAM產(chǎn)品的單元晶體管橫截面
在圖20中,通過柵極切出了一條FIB線,將柵極與基底連接起來,從而使柵極接地。陣列邊緣上標(biāo)記的柵極觸點(diǎn)清楚地表明了這種接地,因?yàn)樗鼈兣c沒有被FIB切斷的柵極線的柵極觸點(diǎn)形成鮮明的對(duì)比。

圖20 在部分去層的DRAM單元陣列表面用FIB切割
電池陣列中的源極觸點(diǎn)變黑了。由于采用了封閉式電池晶體管,它們現(xiàn)在可以充電。不過,其中一些觸點(diǎn)仍然非常明亮。圖21所示的橫截面顯示了其中的原因。右邊的源極觸點(diǎn)因刻蝕殘留物而與兩個(gè)晶體管之間通過柵極線短路。與該區(qū)域的所有柵極線一樣,這條柵極線也被FIB接地,因此柵極觸點(diǎn)也被接地,顯得很亮。

圖21 右側(cè)源極觸點(diǎn)與通過的柵極線因刻蝕殘留物而短路
所有這些應(yīng)用實(shí)例都清楚地表明,要有效地使用VC,就必須詳細(xì)了解CAD。利用CAD數(shù)據(jù)可以預(yù)測(cè)出無失效芯片層的正確VC圖像。如果實(shí)際VC與預(yù)測(cè)值不一致,則該結(jié)構(gòu)一定有問題。
2.5 一些經(jīng)驗(yàn)分享
有時(shí),聚焦離子束很難產(chǎn)生明顯的PVC。了解了產(chǎn)生PVC的機(jī)制,我們就可以得出一些基本規(guī)則,以獲得或提高荷電和浮起結(jié)構(gòu)之間的襯度。所要達(dá)到的目標(biāo)要么是降低漏電流,要么是改善電荷載流子的產(chǎn)生。
- 首先應(yīng)該嘗試增加束流,因?yàn)檫@樣可以提高結(jié)構(gòu)的凈荷電量。但需要注意的是:在通過切削破壞結(jié)構(gòu)與獲得良好PVC效果之間,總是要權(quán)衡利弊。如有疑問,應(yīng)在同類非臨界結(jié)構(gòu)上測(cè)試強(qiáng)離子束的影響。圖22顯示了主離子束束流對(duì)帶有多個(gè)高電阻率觸點(diǎn)的觸點(diǎn)鏈的VC影響。

圖22 FIB離子束束流對(duì)VC的影響
- 下一個(gè)嘗試是改變樣品的方向。如果要對(duì)長(zhǎng)于寬的結(jié)構(gòu)充電,將其長(zhǎng)邊水平對(duì)齊會(huì)更有效果,這樣水平掃描的離子束就會(huì)突然擊中結(jié)構(gòu)中的大部分,從而克服可能出現(xiàn)的漏電流。增加充分充電的機(jī)會(huì)。最簡(jiǎn)單的方法是通過軟件按鈕改變掃描方向,而不是旋轉(zhuǎn)樣品臺(tái)。
- 掃描速度也起著重要作用。較慢的掃描速度可提高充分充電的機(jī)會(huì)。
- 傾斜表面會(huì)比表面發(fā)射出更多的二次電子。這將改善電荷載流子的產(chǎn)生。因此,樣品臺(tái)傾斜可能會(huì)有所幫助,但必須考慮到FIB刻蝕也會(huì)增加。
- 在進(jìn)行FIB切割時(shí),應(yīng)始終使用碘氣噴射,因?yàn)榈鈿鈬娚淇梢苑乐箤?dǎo)電材料在表面上重新沉積,從而降低漏電流(見圖23)。
- 大多數(shù)定位問題的典型束流為10-50pA。對(duì)于低放大倍數(shù),束流可高達(dá)100pA,而對(duì)于高倍數(shù)下的特殊問題,1-10pA可能是最佳選擇。

圖23 未打開碘氣閥(左)和打開碘氣閥(右)
3 SEM與FIB中的PVC
圖24解釋了為什么在FIB中產(chǎn)生的電荷比在SEM中多得多。在掃描電子束顯微鏡中,入射的主電子和離開的二次電子部分相互補(bǔ)充,導(dǎo)致荷電比FIB少。由于這取決于主粒子束束流、樣品材料、樣品位置、放大倍率和其他因素,SEM中的荷電既可以是正的,也可以是負(fù)的,這與FIB相比是一個(gè)優(yōu)勢(shì)。

圖24 FIB和SEM的荷電比較
如圖25所示,電子束的加速電壓對(duì)荷電類型的影響最大。閾值電壓E1可通過實(shí)驗(yàn)確定,約0.5KV,E2約為2KV。但這只是一個(gè)粗略的近似值。這些值在很大程度上取決于表面形貌和樣品材料。圖26中兩種不同束流能量的SEM圖像顯示了不同的PVC。根據(jù)要解決的問題,可以選擇FIB PVC或者SEM PVC方法。表1中列出了兩種方法的優(yōu)缺點(diǎn)。

圖25 掃描電鏡中束流能量對(duì)發(fā)射效率的影響

圖26 SEM中的PVC
表1 FIB和SEM PVC的優(yōu)缺點(diǎn)

4 在線電子束檢測(cè)
無源電位襯度技術(shù)在SEM中的一個(gè)非常重要的應(yīng)用是在線電子束檢測(cè),因?yàn)樗堑谝粋€(gè)也是唯一一個(gè)在晶圓廠中持續(xù)使用的FA技術(shù)。
在在線掃描電子顯微鏡中,卡盤處的減速場(chǎng)可提供較低的電子束著陸能量,這對(duì)于VC的定位非常必要。電子剛離開陰極時(shí)的初級(jí)能量不受減速場(chǎng)影響,其能量與高分辨率掃描電鏡能量一樣高。通過安裝在晶圓上方的電荷控制板,可檢測(cè)到正負(fù)表面電荷(圖27)。

圖27 在線電子束檢測(cè)工具可檢測(cè)正負(fù)電荷
圖28中的示例顯示了由充電板控制的同一樣品的正負(fù)荷電檢測(cè)。只有在正荷電的情況下,才能確定觸點(diǎn)是否斷開。圖29中的示例顯示了相反的情況。其中一個(gè)未填滿的接觸孔不夠深,最終進(jìn)入了氧化層。這恰好可以用負(fù)荷電檢測(cè)到。

圖28 在線電子束檢測(cè)

圖29 在線電子束檢測(cè)
在線電子束檢測(cè)是一項(xiàng)功能強(qiáng)大的技術(shù),可加快晶圓廠的研究周期。在進(jìn)行任何電氣測(cè)試之前,就能及早發(fā)現(xiàn)問題并預(yù)測(cè)產(chǎn)量。然而,這項(xiàng)技術(shù)非常耗時(shí)。雖然該過程已高度自動(dòng)化,但以一個(gè)70nm節(jié)點(diǎn)的300mmDRAM晶圓為例,其中有700個(gè)1 GiBit芯片,繪制接觸測(cè)試鏈需要大約6個(gè)小時(shí)。這意味著生產(chǎn)線上的所有晶圓片不能都被檢查,需要采樣測(cè)試。
5 有源電位襯度
如圖30所示,使用SEM/FIB中的納米探針可以對(duì)確定的結(jié)構(gòu)施加特定電壓。這種方法被稱為“有源電位襯度法”,因?yàn)楫?dāng)外部電壓施加到結(jié)構(gòu)上時(shí),結(jié)構(gòu)就會(huì)被設(shè)置為“有源”。Campbell和Soden早在1999年就描述了這一原理的應(yīng)用。這里需要指出的是,這一原理甚至更早應(yīng)用于高度復(fù)雜的電子束探測(cè)方法中。
電子束探測(cè)曾經(jīng)是一種非常成功的用于集成電路調(diào)試和失效分析的技術(shù),可在工作速度下觀察全功能芯片的AVC像。必須在掃描電子顯微鏡(SEM)中對(duì)已封裝但為去層的集成電路或已完全處理晶片上的單個(gè)芯片進(jìn)行操作。這意味著所有有輸入/輸出和電源都必須與室外的測(cè)試儀連接。電子束會(huì)被引導(dǎo)至感興趣的節(jié)點(diǎn),該節(jié)點(diǎn)不斷變化的表面電位會(huì)調(diào)節(jié)二次電子產(chǎn)量并且探測(cè)器可以記錄波形。通過這種動(dòng)態(tài)有源電位襯度,可以進(jìn)行高水平的失效分析,但始終需要一名經(jīng)驗(yàn)豐富、精通CAD設(shè)計(jì)和集成電路功能的FA工程師。

圖30 安裝在雙束FIB樣品臺(tái)上的4探針納米探針
遺憾的是,現(xiàn)代集成電路的運(yùn)行速度非常高,結(jié)構(gòu)相當(dāng)復(fù)雜,而且由于金屬化層數(shù)較多,無法到達(dá)有趣的節(jié)點(diǎn)。這些都是這種方法在過去十年中失去其重要性的原因。
下文中描述的AVC遠(yuǎn)遠(yuǎn)沒有電子束探測(cè)的潛力大,但儀器要簡(jiǎn)單得多,大多數(shù)SEM操作員都能操作。有時(shí),觸點(diǎn)鏈并非完全斷開,但由于觸點(diǎn)部分?jǐn)嚅_,其電阻很高,遠(yuǎn)遠(yuǎn)超出了規(guī)格要求。通過這種故障觸點(diǎn)泄漏的電流會(huì)阻礙充電和用PVC定位。如圖31所示。
 圖31 故障觸點(diǎn)留下的觸點(diǎn)鏈部分無法帶電
圖31 故障觸點(diǎn)留下的觸點(diǎn)鏈部分無法帶電
在圖32所示的鏈條上施加外部電壓時(shí),鏈條左側(cè)部分會(huì)產(chǎn)生足夠的電荷,根據(jù)歐姆定律,在故障觸點(diǎn)處會(huì)產(chǎn)生電位躍遷。圖33顯示了這種鏈的一個(gè)例子。另一個(gè)有趣的AVC例子如圖34,在儲(chǔ)存器陣列的一條位線上施加正電壓。突然,整條線變黑。只有右端的一小部分保持明亮,因?yàn)樗c偏壓隔離開來。

圖32 有源電位襯度原理
目前有兩種基本的樣品倉(cāng)內(nèi)納米探針系統(tǒng)--樣品安裝式和樣品倉(cāng)安裝式。這兩種系統(tǒng)各有優(yōu)勢(shì),但其缺點(diǎn)取決于使用目的。樣品倉(cāng)安裝系統(tǒng)在探針下降后不允許任何的樣品臺(tái)移動(dòng)。在設(shè)備表征過程中,4個(gè)、6個(gè)甚至8個(gè)探針必須在一個(gè)很小的區(qū)域內(nèi)接觸結(jié)構(gòu)。

圖33 利用AVC檢測(cè)鏈條中的一個(gè)高電阻觸點(diǎn)
對(duì)于AVC,有時(shí)測(cè)試結(jié)構(gòu)會(huì)在其探針墊上接觸,因?yàn)檫@比在極小導(dǎo)線上接觸要容易。探針墊通常距離結(jié)構(gòu)本身數(shù)百微米。在這種情況下,樣品臺(tái)安裝系統(tǒng)就非常有用了,因?yàn)槭紫纫獙⑻结槈|放在電子束下,以便在可視控制下降低探針,然后樣品臺(tái)和探針一起移動(dòng),直到測(cè)試結(jié)構(gòu)位于電子束之下,以便查找AVC。

圖34 通過向內(nèi)存位線施加正電壓來檢測(cè)其是否是開路
樣品臺(tái)安裝系統(tǒng)在樣品臺(tái)移動(dòng)范圍和樣品尺寸方面有一些限制。由于幾何尺寸的限制,某些型號(hào)的探針無法使用鎖定裝置。另一方面,這種探針可以很容易地用于任何其他同類工具,只需要通過法蘭給每個(gè)探針輸入電荷。表2列出了兩種探針的優(yōu)缺點(diǎn)。
表2 兩種基本納米探針的優(yōu)缺點(diǎn)

AVC應(yīng)用的探針數(shù)量并不重要。只需要兩個(gè)探針就足夠了,而設(shè)備表征則需要4、6或8個(gè)探針。
另外一個(gè)有趣的問題是,應(yīng)該使用掃描電鏡還是FIB來解決AVC定位問題。大多數(shù)情況下,可以使用電子束電壓為2KV的掃描電子顯微鏡。但如果需要切割線條,則需要使用FIB。最理想的工具是同時(shí)具有SEM和FIB的雙束設(shè)備。
最后一個(gè)討論的問題是,應(yīng)在結(jié)構(gòu)上施加何種電壓。由于大多數(shù)二次電子的能量在2-4eV及以下,因此應(yīng)在結(jié)構(gòu)中施加一個(gè)+5V電壓。探測(cè)電壓的一般規(guī)則是“越高越好”,但在熱柵極氧化物厚度為2nm的60nm COMS工藝中,當(dāng)電壓超過7V時(shí),就會(huì)出現(xiàn)不可逆的柵極氧化物損壞,從而阻礙進(jìn)一步的定位。對(duì)于新型高K柵極氧化物,如TiN、TiAlN、Al2O3或鉿氧化物,這種效應(yīng)可能完全不同,有待今后研究。
6 總結(jié)
在SEM和FIB中均可以使用電位襯度法進(jìn)行失效定位。這兩種方法各有利弊。了解影響VC產(chǎn)生的所有因素(電容、漏電、摻雜和電路)對(duì)成功定位故障非常有幫助。有源電位襯度實(shí)驗(yàn)比較費(fèi)力,但為失效定位提供了全新的機(jī)會(huì)。
-
電容器
+關(guān)注
關(guān)注
64文章
6254瀏覽量
100234 -
探測(cè)器
+關(guān)注
關(guān)注
14文章
2653瀏覽量
73251 -
PVC
+關(guān)注
關(guān)注
0文章
106瀏覽量
15284 -
DRAM芯片
+關(guān)注
關(guān)注
1文章
84瀏覽量
18060 -
載流子
+關(guān)注
關(guān)注
0文章
134瀏覽量
7693
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
無源晶振失效? 求解!!!
雙束FIB提供TEM制樣、FIB切割、Pt沉積和三維重構(gòu)
雙束FIB提供TEM制樣、FIB切割、Pt沉積和三維重構(gòu)
雙束FIB提供TEM制樣、FIB切割、Pt沉積和三維重構(gòu)
雙束FIB提供TEM制樣、FIB切割、Pt沉積和三維重構(gòu)
TEM制樣、FIB切割、Pt沉積和三維重構(gòu)
TEM制樣、FIB切割、Pt沉積和三維重構(gòu)
聚焦離子束顯微鏡(FIB-SEM)
【經(jīng)典案例】芯片漏電失效分析-LED芯片失效點(diǎn)分析(OBIRCH+FIB+SEM)
什么是有源 什么是無源呢
掃描電鏡電壓襯度技術(shù)在集成電路失效分析中的應(yīng)用
FIB-SEM雙束技術(shù)及應(yīng)用介紹
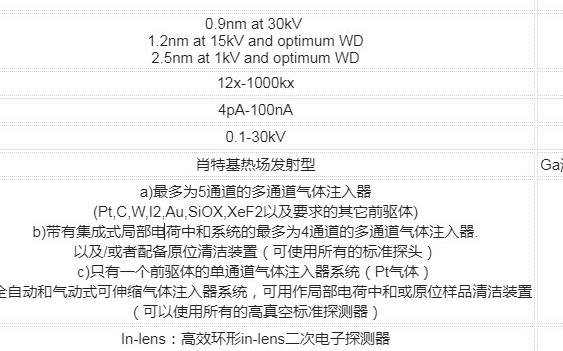
SEM/FIB雙束系統(tǒng)截面加工:實(shí)現(xiàn)離子的成像、注入、刻蝕和沉積

什么是FIB?FIB有哪些應(yīng)用?如何修改線路做FIB?FIB怎么做失效分析?
頂堅(jiān)北斗有源終端的有源定位和無源定位的區(qū)別?





 如何利用FIB和SEM中的有源和無源電位襯度進(jìn)行失效定位呢?
如何利用FIB和SEM中的有源和無源電位襯度進(jìn)行失效定位呢?










評(píng)論