摘要
隨著芯片復雜度的增高和摩爾定律的放緩,半導體行業(yè)正在迅速向先進封裝中的異質芯片組裝轉型。這種轉變實現(xiàn)了通過組件的拆分與新的架構配置下的重新集成來持續(xù)縮小線距和創(chuàng)新。然而也帶來了顯著的設計、驗證、制造和供應鏈等方面的挑戰(zhàn)。本文探討了實現(xiàn)異質芯片組裝主流化所涉及的驅動因素、方法、權衡取舍和未解決問題。
導言
50多年來,摩爾定律推動了半導體行業(yè)的發(fā)展,其核心是每兩年單片硅晶圓上的晶體管數(shù)量就會翻一番。這種堅持不懈的縮小線距使芯片可以更高度地集成,性能更強,成本更低。但是,隨著芯片制造技術進入10納米以下,繼續(xù)縮小線距的成本高得驚人。此外,單片系統(tǒng)級芯片(SoC)也遇到了***曝光范圍限制、良率問題和其他瓶頸。因此,行業(yè)正在大力向2.5D和3D堆棧等先進封裝中更小的異質芯片組裝轉變。這種方法通過組合匹配不同工藝節(jié)點和來源的組件,可以繼續(xù)提升芯片的集成度、帶寬、功耗和性能。然而,異質集成也給設計、驗證、制造和供應鏈帶來了重大的新挑戰(zhàn)。工程師現(xiàn)在必須協(xié)同設計芯片本體、互連和封裝,以實現(xiàn)系統(tǒng)層面的最佳綜合。本文將探討異質芯片組裝主流化的驅動因素、方法、挑戰(zhàn)和展望。
異質集成的驅動力
促使行業(yè)向多芯片架構轉變的幾個關鍵因素:
經(jīng)濟性- 每一代領先工藝節(jié)點的成本呈指數(shù)增長,大多數(shù)芯片市場難以承受。芯片組裝可以混合使用成熟的先進工藝。
良率- 更小的芯片具有更高的良率,可降低成本。但單個故障芯片可能導致整個封裝失效。
帶寬- 在封裝上集成高帶寬內存可獲得巨大的帶寬提升。
定制化- 芯片組裝可以混合不同來源的IP,并在不同產(chǎn)品間重復利用。
尺寸- 新設備需要更小、更定制的封裝,而非單片解決方案。
如圖1所示,在摩爾定律放緩的情況下,芯片組裝可提供更好的技術和經(jīng)濟路徑。
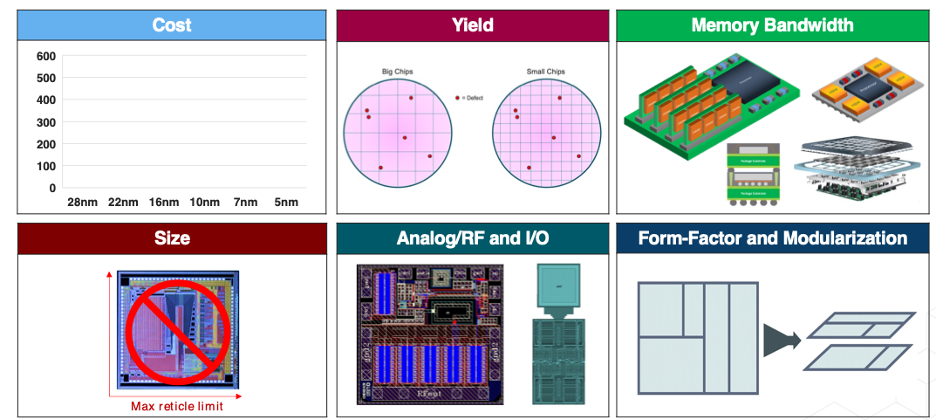
圖1:采用chiplets的理由。僅依賴摩爾定律不再是最佳路徑。來源:Cadence
異質集成方法
連接芯片組裝的兩種主要方法:
2.5D - 芯片并排放置在interposer或載板上。硅中間器可提供高密度互連,有機載板成本更低。
3D - 芯片垂直堆疊。這節(jié)省空間但會帶來熱問題。
芯片可以通過線鍵合、微突塊、硅通孔(TSV)以及UCIe、BoW等新興接口標準進行連接。
協(xié)同設計芯片、封裝和互連,以實現(xiàn)熱性能、功耗、性能和成本的最佳平衡,難度巨大。工程師必須從整體系統(tǒng)視角出發(fā),而不僅僅是設計單獨的ASIC芯片(圖2)。
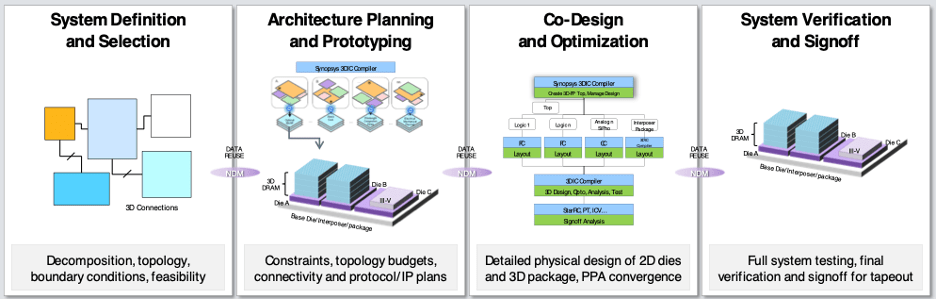
圖2:多芯片系統(tǒng)設計。來源:Synopsys
關鍵挑戰(zhàn)
異質集成前景廣闊但也帶來許多新挑戰(zhàn):
拆分- 如何在芯片間拆分功能以實現(xiàn)最佳重用性、功耗、性能和良率?這需要新的架構和流程。
互連- 芯片間通信標準仍在形成。在帶寬、功耗和延遲方面存在復雜的權衡。
建模- 準確建模完整的多芯片系統(tǒng)非常困難。需要Digital twins作為“黃金”參考。
噪聲- 與單片解決方案相比,芯片間會以新方式相互影響。需要廣泛的聯(lián)合仿真。
熱特性- 更多芯片的高密度集成會帶來必須建模和處理的新熱問題。
應力- 薄芯片會彎曲變形,鍵合/去鍵合也可能損壞脆弱組件。
測試- 測試封裝芯片和裸芯片截然不同。已知良好芯片(KGD)方法很重要。
供應鏈- 芯片組裝允許組件重用,但也增加了對第三方IP/芯片的依賴。
許多標準、工具和方法還在演進,以實現(xiàn)可靠的芯片組裝、驗證和制造。工程師需要廣泛的新知識,涵蓋多芯片設計、系統(tǒng)級驗證、2.5D/3D封裝和測試。
展望
盡管異質芯片集成非常復雜,它在摩爾定律時代結束后也可以持續(xù)縮小線距、創(chuàng)新和降低成本。業(yè)界正在大力開發(fā)圍繞封裝、接口標準、設計工具、建模、自動化和制造的可靠解決方案和生態(tài)系統(tǒng)。
大公司已經(jīng)實現(xiàn)了多芯片設計,但廣泛采用將取決于解決方案的成熟和成本降低。最終,基于芯片組裝的架構將需要從根本上改變系統(tǒng)的構思、設計、集成、驗證、制造和支持,橫跨全球化的供應鏈。這是重大變革,也是半導體行業(yè)一個激動人心的新篇章。
總結
過去無止境的推進摩爾定律縮小線距的結束,推動了向異質芯片先進封裝的重大轉變。這種方法通過組件的混合匹配可以繼續(xù)獲得收益,但也給設計和制造流程帶來了重大新挑戰(zhàn)。各方正在積極開發(fā)標準、工具、方法、測試、供應鏈等,以實現(xiàn)異質集成的大規(guī)模應用,將從根本上改變半導體行業(yè)的經(jīng)濟模式和實踐方式。
來源:逍遙設計自動化
-
芯片
+關注
關注
456文章
51170瀏覽量
427225 -
半導體
+關注
關注
334文章
27703瀏覽量
222618 -
晶圓
+關注
關注
52文章
4973瀏覽量
128313 -
soc
+關注
關注
38文章
4204瀏覽量
219088
原文標題:【光電集成】異質芯片集成的發(fā)展
文章出處:【微信號:今日光電,微信公眾號:今日光電】歡迎添加關注!文章轉載請注明出處。
發(fā)布評論請先 登錄
相關推薦
電腦主板芯片組的介紹
威盛 芯片組HyperionPro驅動5.23
柔性電路板上倒裝芯片組裝技巧
芯片組是什么_芯片組驅動是什么
芯片組驅動不裝有什么影響_如何安裝芯片組驅動程序
芯片組驅動要不要更新_芯片組驅動卸載了會怎么樣
快速成熟的智能照明市場有哪些驅動因素
闡述芯片組與芯片組驅動功能和發(fā)展
芯片組與芯片組驅動功能的介紹和發(fā)展說明
影響可穿戴診斷設備發(fā)展的市場驅動因素
電子燈鎮(zhèn)流器IGBT門驅動因素

剛性電路板的9個成本驅動因素





 異質芯片組裝主流化的驅動因素和方法
異質芯片組裝主流化的驅動因素和方法











評論