來源:半導體芯科技編譯
3D IC(三維集成電路)代表著異質(zhì)先進封裝技術(shù)向三維空間的擴展,在設(shè)計和可制造性方面面臨著與二維先進封裝類似的挑戰(zhàn)以及更多的復雜性。雖然3D IC尚未普及,但芯片組標準化計劃的出現(xiàn)和支持工具的開發(fā)正在使3D IC變得更加可行,并為更廣泛的參與者帶來更多利潤,其中包括生產(chǎn)規(guī)模較小的大型和小型公司。
三維集成電路的實施允許公司將設(shè)計劃分為功能子組件,并在最合適的工藝節(jié)點上集成由此產(chǎn)生的 IP。這有利于低延遲、高帶寬的數(shù)據(jù)傳輸,降低制造成本,提高晶圓產(chǎn)量,降低功耗,并減少總體開支。這些吸引人的優(yōu)勢推動了先進異構(gòu)封裝和 3D IC技術(shù)的顯著增長和進步。
在傳統(tǒng)的集成電路 (IC) 設(shè)計和制造領(lǐng)域,依賴簽核策略是司空見慣的。晶圓代工廠通常在特定于工藝的設(shè)計規(guī)則套件中提供設(shè)計規(guī)則、LVS 和可靠性平臺。然而,這種傳統(tǒng)方法不適用于 3D IC 先進的異構(gòu)封裝。與傳統(tǒng)IC不同,3D IC由多層組成,混合了多種工藝,挑戰(zhàn)了單層上所有內(nèi)容都是共面的假設(shè)。3D IC 中組件的垂直堆疊帶來了復雜性,使半導體和 IC 封裝設(shè)計工程師難以評估具有不同工藝技術(shù)的組件之間的相互作用,并確定哪些相互作用應(yīng)優(yōu)先考慮。
為了確保可制造性和可靠性,我們不能依賴代工廠或外包半導體封裝和測試 (OSAT) 供應(yīng)商提供的通用設(shè)計套件。相反,我們需要從三維集成電路設(shè)計師的頭腦中獲取信息。我們需要規(guī)劃工具來協(xié)助封裝架構(gòu)師做出平面規(guī)劃決策,并將這些信息提供給半導體和集成電路封裝設(shè)計工程師。這些信息應(yīng)包括元件如何垂直堆疊,而不僅僅是元件的一維布局。我們還必須將特定元件的檢查與單個層的定義分開,因為不同的工藝對類似的結(jié)構(gòu)可能會有不同的層號。使用三維集成電路原型設(shè)計和規(guī)劃工具可以盡早提取這些信息。
規(guī)劃和平面布局工具在確保裝配架構(gòu)的正確對齊和可制造性方面發(fā)揮著至關(guān)重要的作用,在片上系統(tǒng)(SoC)領(lǐng)域,這項任務(wù)傳統(tǒng)上由設(shè)計規(guī)則檢查(DRC)來完成。然而,僅僅依靠 DRC 并不能保證預期的功能。幸運的是,布局與原理圖(LVS)分析具有雙重作用,不僅能確認可制造性,還能驗證布局是否準確地表達了預期的電氣結(jié)構(gòu)和行為。與在執(zhí)行前進行網(wǎng)表編制和仿真的傳統(tǒng)方法不同,LVS 對所有芯片、層和器件進行詳細分析,以驗證它們與預期設(shè)計的一致性。這一過程需要一個源網(wǎng)表,通常稱為 "黃金網(wǎng)表",以便進行精確比較。
然而,3D IC給LVS分析帶來了挑戰(zhàn),主要是因為中介層——通常是LVS無法處理的無源元件。與有源元件不同,無源元件缺乏電氣特性,對電路功能沒有貢獻,這使得傳統(tǒng)的 LVS 方法復雜化,該方法依賴于引腳的電氣連接知識。此外,有意將電容器、電阻器和光子元件等無源器件集成到 3D IC 中增加了另一層復雜性,需要了解各種導線位置和材料信息。
引入 3D IC 集成所必需的新組件會給系統(tǒng)帶來額外的寄生效應(yīng)。這些寄生效應(yīng)會影響各種行為方面,例如延遲、噪聲、信號完整性和功耗,從而影響滿足系統(tǒng)設(shè)計要求的能力。為了全面了解其影響,必須對與這些組件相關(guān)的寄生效應(yīng)進行準確有效的建模。此外,垂直堆疊的 3D IC 組件(包括芯片和中介層)的更高密度和更近的距離進一步影響了它們的寄生效應(yīng)。
提取方法和工具的選擇取決于在性能和準確性之間找到適當?shù)钠胶狻R獙崿F(xiàn)更高的精度,需要采用更復雜的模型和先進的工具。基于規(guī)則的工具在提供高性能方面表現(xiàn)出色,而基于字段求解器的工具則優(yōu)先考慮準確性。在處理硅通孔 (TSV) 寄生效應(yīng)時,可以使用代工廠的測量和內(nèi)部全波求解器開發(fā)精確的 TSV 模型。通過基于規(guī)則的工具,可以在互連寄生參數(shù)提取過程中實現(xiàn)這些模型的有效集成。然而,這些工具在TSV耦合方面遇到了挑戰(zhàn)。雖然參數(shù)表可用于耦合電阻和電容,但它們有局限性。全波求解器具有出色的精度,但對于在實際設(shè)計中處理大量 TSV 來說太慢。因此,理想的解決方案是專門的場求解器,它既準確又快速,足以進行整個 TSV 集提取。
三維集成電路的實現(xiàn)有兩種方法:硅連接或有機連接,每種方法都有自己的優(yōu)勢和挑戰(zhàn)。硅三維集成電路結(jié)構(gòu)是通過放置和布線工具創(chuàng)建的,適用于高密度設(shè)計,但僅限于處理正交形狀。相反,有機三維集成電路結(jié)構(gòu)使用的工具類似于傳統(tǒng)的面向印刷電路板的工具。
所選技術(shù)對信號完整性分析所采用的方法和工具有很大影響。在硅設(shè)計中,來自布局布線工具的數(shù)據(jù)流通常采用 GDS 格式,缺乏傳統(tǒng)信號完整性和電磁(EM)工具所需的細節(jié)。這一缺陷導致需要額外的手動提取步驟,從而延長了分析流程并限制了迭代次數(shù)。雖然數(shù)據(jù)表示給硅設(shè)計中的電磁提取帶來了挑戰(zhàn),但用于寄生提取的專用工具可以幫助緩解這些問題。
相反,有機工具更符合面向印刷電路板的方法,在設(shè)計數(shù)據(jù)庫中包含更多智能數(shù)據(jù),包括網(wǎng)絡(luò)名稱和各種結(jié)構(gòu)類型。這一特性縮短了寄生蟲提取的設(shè)置時間,使提取過程不易出錯。它將提取和分析進一步推向設(shè)計流程的上游,便于根據(jù)寄生影響及早識別芯片封裝平面圖中的必要變更。通過在正確的階段利用適當?shù)姆治龉δ埽O(shè)計人員可以在流程的早期階段對精度和性能進行權(quán)衡,從而增強對整個設(shè)計的信心。這種積極主動的方法使設(shè)計人員能夠提前利用三維集成電路設(shè)計的優(yōu)勢。
審核編輯 黃宇
-
集成電路
+關(guān)注
關(guān)注
5392文章
11623瀏覽量
363189 -
半導體
+關(guān)注
關(guān)注
334文章
27712瀏覽量
222660 -
IC
+關(guān)注
關(guān)注
36文章
5982瀏覽量
176222
發(fā)布評論請先 登錄
相關(guān)推薦
半導體封裝的可靠性測試及標準

揭秘3D集成晶圓鍵合:半導體行業(yè)的未來之鑰

第三代功率半導體器件動態(tài)可靠性測試系統(tǒng)
PCB高可靠性化要求與發(fā)展——PCB高可靠性的影響因素(上)
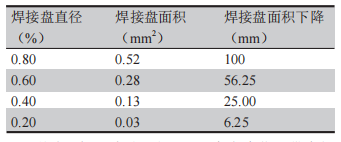
3D封裝熱設(shè)計:挑戰(zhàn)與機遇并存

Samsung 和Cadence在3D-IC熱管理方面展開突破性合作
基于可靠性設(shè)計感知的EDA解決方案

西門子推出Innovator3D IC,用于 3D IC 設(shè)計、驗證和制造的多物理場集成環(huán)境
借助云計算加速3D-IC可靠性的機械應(yīng)力模擬

半導體封裝技術(shù)的可靠性挑戰(zhàn)與解決方案

第三代SiC功率半導體動態(tài)可靠性測試系統(tǒng)介紹
硬件工程師在可靠性設(shè)計中所面臨的挑戰(zhàn)及解決之道

3D-IC 以及傳熱模型的重要性





 3D IC半導體設(shè)計的可靠性挑戰(zhàn)
3D IC半導體設(shè)計的可靠性挑戰(zhàn)










評論