在封裝前,通常要減薄晶圓,減薄晶圓主要有四種主要方法:機械磨削、化學機械研磨、濕法蝕刻和等離子體干法化學蝕刻。
晶圓減薄原因
減薄后的芯片的體積更小,可以適應更薄的封裝設(shè)計。更小的體積在智能手機、平板電腦、智能手表等設(shè)備中可以減少整體厚度和重量。
在3D IC封裝中,可以在有限的空間內(nèi)通過垂直堆疊更多層次的減薄芯片,從而實現(xiàn)更高的功能密度。
減薄后的晶圓具有更短的熱擴散路徑和較高的表面積與體積比,有助于將芯片運行時產(chǎn)生的熱量更快,更有效地傳遞出去。如果芯片太厚,熱量在傳遞過程中會在芯片內(nèi)部積聚,導致局部過熱,影響器件性能。
晶圓能減到多薄?
晶圓減薄的極限厚度與晶圓的材質(zhì)和尺寸有密切關(guān)系。
較大的晶圓在減薄過程中更容易破裂。尺寸越大,減薄越困難。
而晶圓的材質(zhì)多種多樣,一般有Si,GaAs,GaN,InP,LN,LT,玻璃,藍寶石,陶瓷等。LN,LT,GaAs,GaN等相對硅來說更脆,因此減薄的極限厚度更大些。以硅為例,能夠?qū)?2寸硅片減薄到50um左右。
 ? ? ?
? ? ?
四種晶圓減薄方法介紹
機械磨削(Grinding)
Grinding完全通過物理摩擦力去除晶圓表面的材料。磨削通常使用含有金剛石顆粒的砂輪,在高速旋轉(zhuǎn)時接觸晶圓表面,并用純水作為冷卻液和潤滑劑,以達到減薄的目的。
化學機械研磨(cmp)
cmp是一種結(jié)合了化學反應和機械研磨的技術(shù)。在CMP過程中,研磨液與要拋光的材料先發(fā)生輕微化學反應,軟化晶圓表面,再用機械研磨去除軟化的材料,達到全局平坦化的目的。相對于Grinding,cmp的成本更昂貴。
濕法刻蝕
使用液態(tài)化學藥劑來去除晶圓表面的材料。
干法刻蝕
使用等離子體產(chǎn)生的活性基團來去除晶圓表面的材料。
四種晶圓減薄方法的比較
Grinding
優(yōu)點:快速去除大量材料,適合于初步減薄。
缺點:可能導致表面損傷和應力,通常需要后續(xù)工藝來改善表面質(zhì)量。
CMP
優(yōu)點:可實現(xiàn)極高的表面光潔度和平整度,適用于要求高精度的應用。 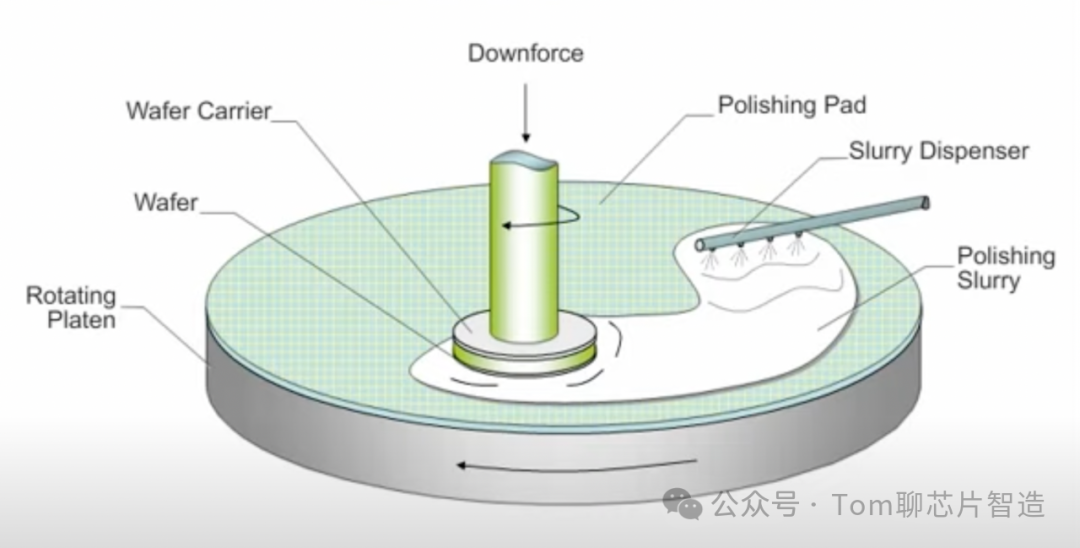 ?
?
缺點:成本較高,過程控制復雜。
濕法蝕刻
優(yōu)點:成本低,設(shè)備簡單,操作容易。
缺點:蝕刻不夠均勻,難以控制蝕刻深度和剖面,減薄后表面粗糙。
干法蝕刻
缺點:成本高,工藝復雜,減薄后表面粗糙。
晶圓減薄工藝難點
精確控制減薄厚度較難:晶圓的均勻厚度對于保證整批晶圓中的器件具有一致性至關(guān)重要。如果采用刻蝕的方法進行減薄,晶圓厚度的均勻性將得不到保障。
控制表面質(zhì)量較難:減薄過程中經(jīng)常會產(chǎn)生表面粗糙度過大、微裂紋,顆粒等其他表面缺陷。
應力控制較難:減薄過程中會引入熱應力和機械應力,這些應力會導致晶圓彎曲、變形或產(chǎn)生內(nèi)部缺陷等。
審核編輯:劉清
-
晶圓
+關(guān)注
關(guān)注
52文章
4973瀏覽量
128312 -
IC封裝
+關(guān)注
關(guān)注
4文章
185瀏覽量
26815 -
CMP
+關(guān)注
關(guān)注
6文章
151瀏覽量
26098
原文標題:晶圓減薄的常見手段
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
宜特晶圓:成功開發(fā)晶圓減薄達1.5mil(38um)技術(shù)
同茂線性馬達談新面世的高精密晶圓減薄機
單面晶圓減薄和處理研究報告
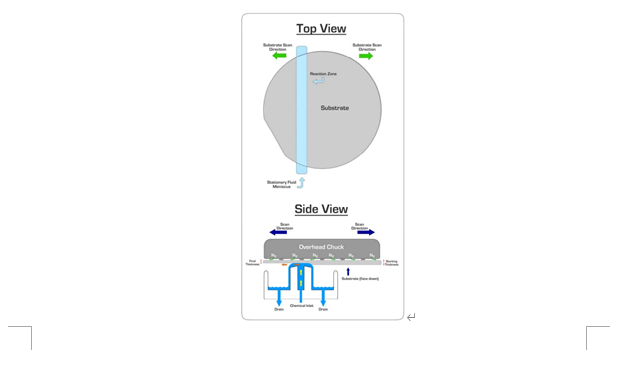
微機械結(jié)構(gòu)硅片的機械減薄研究
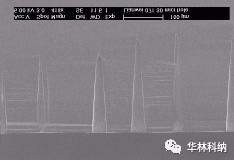
晶圓減薄工藝的主要步驟

GaAs基激光器的減薄和拋光問題
簡述晶圓減薄的幾種方法
晶盛機電減薄機實現(xiàn)12英寸30μm超薄晶圓穩(wěn)定加工
芯豐精密第二臺12寸超精密晶圓減薄機成功交付
晶圓為什么要減薄
減少減薄碳化硅紋路的方法





 介紹晶圓減薄的原因、尺寸以及4種減薄方法
介紹晶圓減薄的原因、尺寸以及4種減薄方法












評論