來源:臺積電
封裝使用硅光子技術來改善互連
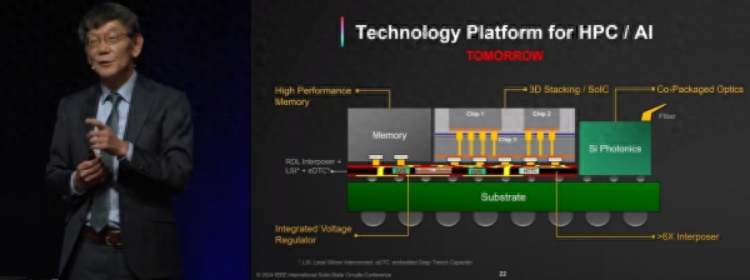
圖片來源: ISSCC
芯片巨頭臺積電(TSMC)近日發布了用于高性能計算和人工智能芯片的新封裝平臺,該平臺利用硅光子技術改善互連。
臺積電業務開發副總裁 Kevin Zhang在 ISSCC 2024 IEEE 國際固態電路大會上表示,開發這項技術是為了提高人工智能加速器的性能,可以通過增加更多高帶寬內存和芯片來實現。
要增加更多的 HBM 和芯片組,還必須增加更多的內插器和片上基板,這可能會導致互連和電源方面的問題。
Zhang解釋說,臺積電的新封裝技術通過硅光子技術,使用光纖代替 I/O 傳輸數據。這位副總經理沒有提及該技術的商業化時間。
該技術的另一個有趣因素是,異質芯片堆疊在基礎芯片上。
封裝技術將在芯片上應用混合鍵合技術,以最大限度地提高 I/O 性能。芯片和 HBM 將安裝在中間件上,很可能是本地硅中間件。
Zhang還表示,封裝將使用集成穩壓器來處理電源問題。
這位副總裁說,目前最先進的芯片可以容納多達 1000 億個晶體管,但對于人工智能來說,3D 封裝技術可以將晶體管數量增加到 1 萬億個。
*此篇編譯文章未經允許,請勿轉載。
審核編輯 黃宇
-
封裝
+關注
關注
127文章
7992瀏覽量
143400 -
AI
+關注
關注
87文章
31513瀏覽量
270323 -
HPC
+關注
關注
0文章
324瀏覽量
23853
發布評論請先 登錄
相關推薦




 臺積電推出面向HPC、AI芯片的全新封裝平臺
臺積電推出面向HPC、AI芯片的全新封裝平臺


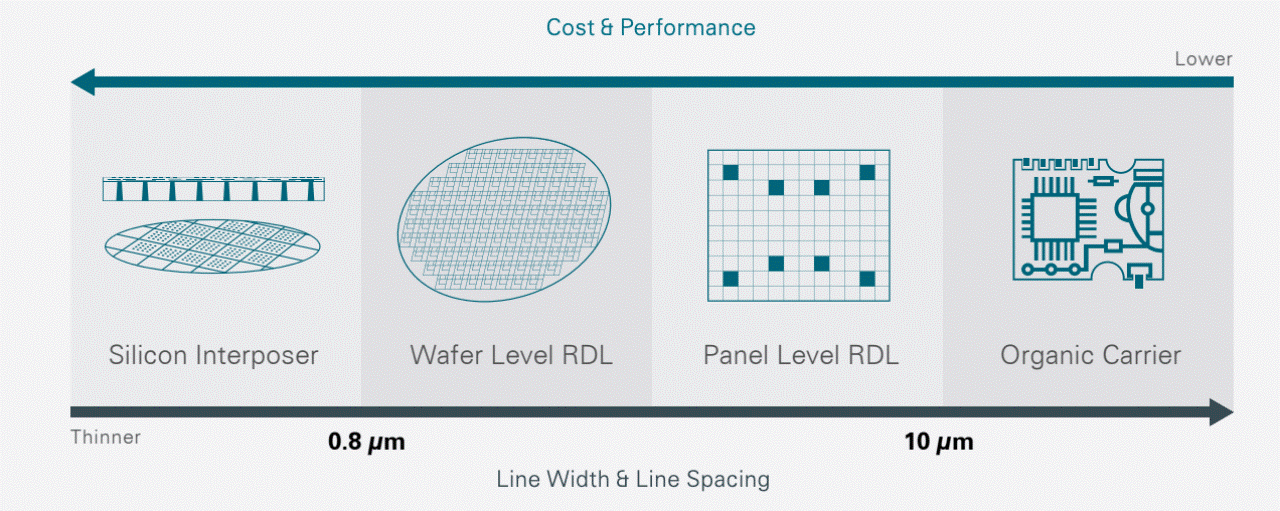










評論