本文介紹了MEMS工藝中快速退火的應用范圍和優勢。
在MEMS工藝中,常用的退火方法,如高溫爐管退火和快速熱退火(RTP)。RTP (Rapid Thermal Processing)是一種在很短的時間內將整個硅片加熱到400~1300°C范圍的方法。與爐管退火相比,它具有熱預算少、硅中雜質運動少、污染少和加工時間短的特點。
RTP工藝是一類單片熱處理工藝,其目的是通過縮短熱處理時間和溫度或只縮短熱處理時間來獲得最小的工藝熱預算(Thermal Budget),RTP工藝的發展,是為了適應等比例縮小器件結構對雜質再分布的嚴格要求。
高溫爐管采用電阻絲,而RTP采用加熱燈管。傳統爐管利用熱對流及熱傳導原理,使硅片與整個爐管周圍環境達到熱平衡,溫度控制精確,而RTP設備通過熱輻射選擇性加熱硅片,較難控制硅片的實際溫度及其均勻性,尤其是對于一個表面帶有圖案的硅片,不均勻性更為明顯。RTP最大的優勢就是快速升降溫,升降溫速率為10~200℃/秒,而傳統爐管的升降溫速率為1-20℃/分鐘。RTP設備為單片工藝,而傳統爐管為批處理工藝。
最早的RTP工藝主要用于注入后的退火,目前,RTP工藝在MEMS中的的應用范圍已擴展到更多的領域。
歐姆接觸
歐姆接觸退火激活工藝是MEMS器件制造中常用的工藝,在這個工藝中,通過在金屬電極和半導體器件之間熱退火,進而改善它們之間的接觸性能,可以有效地降低接觸電阻,并提高器件的性能。目前,在MEMS工藝中的歐姆接觸采用RTP方式,相較于傳統高溫熱退火工藝獲得更加穩定、均勻的歐姆接觸。
離子注入激活
離子注入中,與原子核碰撞后轉移足夠的能量給品格,使基質原子離開品格位置而造成注入損傷(晶格無序)。由于離子注入所造成的損傷區及畸形團,使遷移率和壽命等半導體參數受到影響。此外,大部分的離子在被注入時并不位于置換位置。為激活被注入的離子并恢復遷移率與其它材料參數,必須在適當的時間與溫度下將半導體退火。
傳統爐管使用類似熱氧化的整批式開放爐管系統,需要長時間高溫來消除注入損傷。RTP退火激活時間更短,但需要用更高的溫度,相較于爐管激活溫度高出50~100°C。從測試結果看,RTP退火的激活效率比爐管更低。值得一提的是,RTP退火在淺結摻雜更具有優勢,以最小的雜質再分布情況下完全激活雜質。

圖 離子注入退火激活原理圖(圖片源于網絡)
薄膜淀積
在MEMS工藝中,無論是金屬還是非金屬,采用PVD工藝淀積的薄膜成為淀積態,淀積態薄膜因為受到晶格缺陷、應力和取向等因素影響,通常及其不穩定,需要進行退火處理。在金屬薄膜中,金屬Pt常作為溫度電阻使用,其電學性質穩定性非常關鍵。在實際工藝過程中,退火是必須的步驟,一方面讓Pt的晶粒成核再結晶而穩定電阻,另一方面通過退火釋放應力,而快速降溫能有效的固定晶粒在高溫的微觀結構,類似淬火的作用。
在非金屬薄膜中,例如壓力薄膜PZT,350°C快速退火后傾斜柱狀晶變為垂直柱狀晶且致密化,且晶粒完成擇優取向分布。在多層復合薄膜淀積過程中,薄膜材料會產生一定程度的本征應力,若不及時消除,會影響半導體器件的電學性能。退火可以使應力消除,材料形成平衡態,緩和晶格應變,減少晶格缺陷和雜質的數量和大小,提高MEMS器件的可靠性。
審核編輯:劉清
-
半導體
+關注
關注
334文章
27703瀏覽量
222609 -
熱處理
+關注
關注
0文章
117瀏覽量
18323 -
MEMS工藝
+關注
關注
0文章
8瀏覽量
5888 -
電阻絲
+關注
關注
0文章
29瀏覽量
6421
原文標題:快速退火工藝在MEMS中用在哪里?
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
半導體制造工藝之快速加熱退火(RTA)系統
法國Annealsys快速熱退火爐設備介紹
MEMS傳感器是什么?mems的工藝是什么?
表面硅MEMS加工技術的關鍵工藝
基于模擬退火結合粒子群算法介紹
MEMS傳感器焊接工藝
MEMS與傳統CMOS刻蝕及沉積工藝的關系
MEMS的工藝流程和MEMS加速度計的應用前景詳細說明
退火工藝(Thermal Annealing)介紹
激光退火工藝在IGBT制造中的應用





 MEMS工藝中快速退火的應用范圍和優勢介紹
MEMS工藝中快速退火的應用范圍和優勢介紹



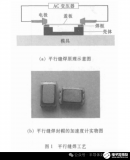










評論