根據湖北九峰山實驗室發(fā)布,光刻膠作為半導體制造的重要材料,其質量與性能直接決定了集成電路的電磁性質、成品率以及可靠性。然而,由于光刻膠技術要求較高,市場上能滿足各種生產條件且性能穩(wěn)定的產品寥寥無幾。
隨著半導體制造工藝節(jié)點不斷發(fā)展至100納米甚至更小的10納米級別,如何制作出尺寸精度高、表面特征優(yōu)秀、線邊緣粗糙度低的光刻圖形已逐漸成為整個行業(yè)面臨的挑戰(zhàn)。
為了解決上述難題,九峰山實驗室與華中科技大學聯(lián)合組建科研團隊,成功攻克了“雙非離子型光酸協(xié)同增強響應的化學放大光刻膠”技術。
這項研究基于獨特的化學結構設計,采用兩種特定的光敏感單元制備出了光刻膠,所得圖像形貌與線邊緣粗糙度優(yōu)秀,space圖案寬度標準差達到最低水平(約為0.05),優(yōu)于多數商用光刻膠,而且在光刻顯影各個環(huán)節(jié)中的操作時間均符合半導體生產對于生產效率的嚴格要求。
此次科研成果有可能為光刻制造領域提供新的思路,同時也為EUV光刻膠的研發(fā)奠定了技術基礎。該研究論文題為“Dual nonionic photoacids synergistically enhanced photosensitivity for chemical amplified resists”,于2024年2月15日在國際頂尖期刊Chemical Engineering Journal(IF=15.1)發(fā)表。
該研究獲得了國家自然科學基金與973計劃的資金支持,來自華中科技大學光電國家研究中心的朱明強教授為第一作者,湖北九峰山實驗室工藝中心的柳俊教授和向詩力博士等參與撰稿。
在此次研究過程中,他們將這項擁有獨立版權的光刻膠系統(tǒng)在生產線進行了全方位的工藝驗證,并且對各項技術指標進行了細致優(yōu)化,實現了從技術創(chuàng)新到實際應用的全過程。
-
半導體制造
+關注
關注
8文章
422瀏覽量
24143 -
EUV
+關注
關注
8文章
608瀏覽量
86150 -
光刻膠
+關注
關注
10文章
322瀏覽量
30346
發(fā)布評論請先 登錄
相關推薦
一文看懂光刻膠的堅膜工藝及物理特性和常見光刻膠
如何成功的烘烤微流控SU-8光刻膠?
如何成功的旋涂微流控SU-8光刻膠?
導致光刻膠變色的原因有哪些?
光刻膠的硬烘烤技術

光刻膠的一般特性介紹
光刻膠后烘技術
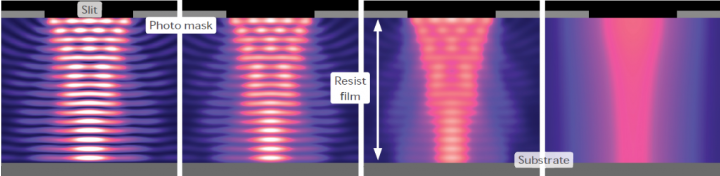




 光刻膠技術創(chuàng)新引領共性難題解決新方向
光刻膠技術創(chuàng)新引領共性難題解決新方向


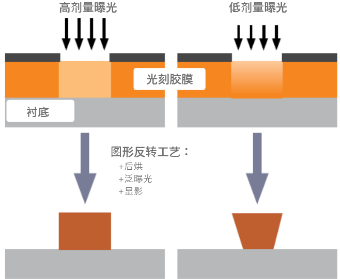

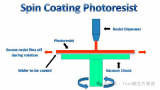










評論