來源:北京大學集成電路學院
隨著GaN為代表的新一代寬禁帶半導體材料的廣泛應用,功率器件的性能大幅度提高。然而受限于器件熱管理性能,目前GaN功率器件僅能發揮其理論性能的20%~30%。嵌入式微流體冷卻技術將微流體集成在器件內部,避免了近乎所有的外部熱阻,利用流體的直接對流換熱完成熱量的高效運輸,因而具有強大的散熱能力,被認為是未來最有可能突破熱管理瓶頸的關鍵技術之一。然而,實際電子器件的器件結構多為兩層以上的復合結構,發熱模式也呈現出多尺寸趨勢,這對于散熱器的設計與制備提出了很大的挑戰,在熱設計時需要系統分析實際器件散熱路徑中的熱阻構成,降低關鍵熱阻。
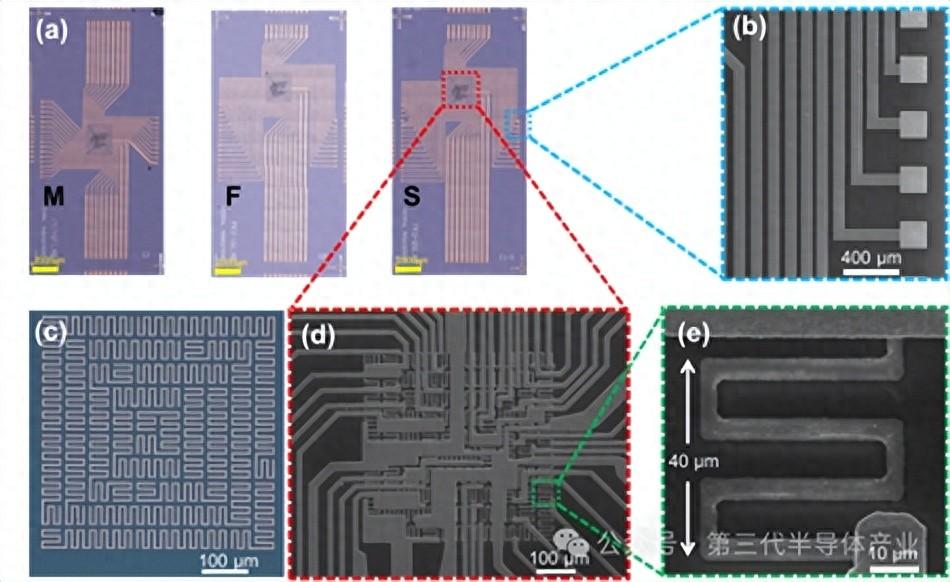
圖1可變尺寸發熱陣列電鏡圖
針對這一關鍵問題,北京大學集成電路學院、微米納米加工技術全國重點實驗室、集成電路高精尖創新中心王瑋教授團隊提出了一種雙“H”歧管型嵌入式微通道散熱方案,同時在該微通道散熱器上集成了尺度可調的發熱陣列,在不同工作模式下測試了微通道散熱器對于不同尺寸熱源的散熱性能。
經過實測,該微通道散熱器針對500 × 500 μm2熱源的散熱熱流密度達到1200 W/cm2以上,平均溫升小于60℃,對流換熱系數達到1.5×105W/(m2?K)。此外,該工作還基于實驗數據構建了熱流耦合仿真與理論模型,系統總結了在多場景下電子器件典型結構中的熱匯熱阻、一維傳導熱阻和擴散熱阻的變化規律。研究發現,在基底尺寸固定的情況下,熱點的尺寸從小到大的變化會導致器件中的主要熱阻從擴散熱阻轉變至熱匯熱阻,因此針對點熱源和面熱源需要根據其主要熱阻的轉變趨勢采用不同的散熱手段。
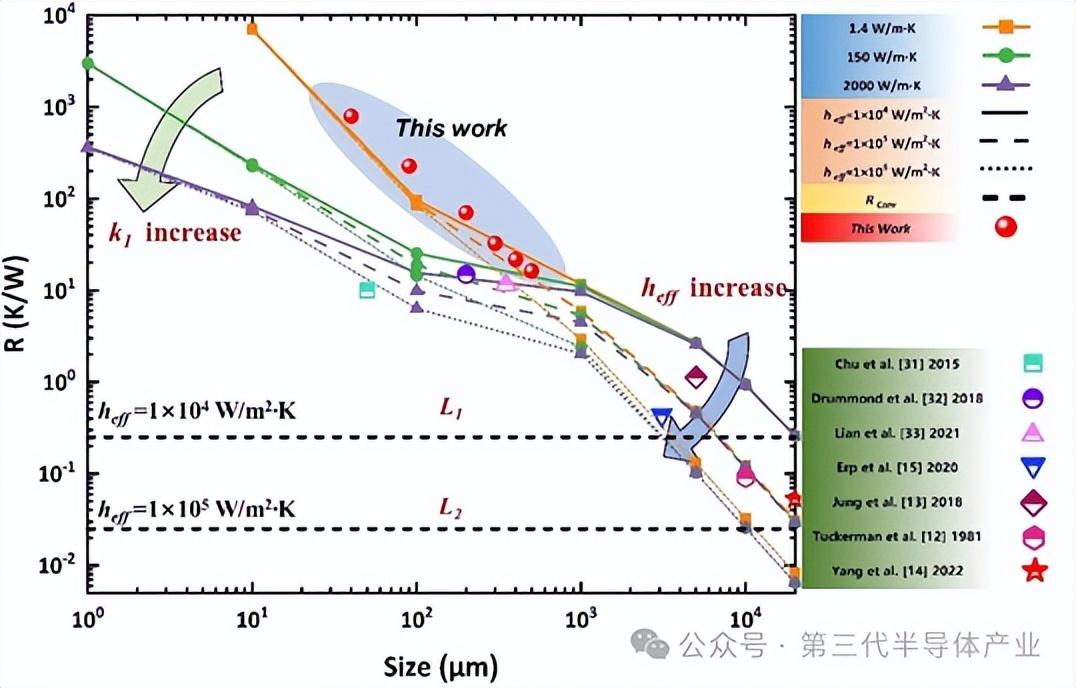
圖2器件熱阻與熱源大小、熱匯對流傳熱系數及介電層熱導率的關系
該研究進一步深入探索了不同尺寸熱源熱管理的關鍵手段,當熱源為點熱源形式時(如高電子遷移率晶體管(HEMT)),主要熱阻為擴散熱阻,此時在熱源近結區集成高導熱材料是降低熱阻的重要方式。在特定熱點尺寸下,近結集成諸如單晶金剛石等高導熱材料,較于氧化硅等低導熱材料,總熱阻可以降低兩個數量級。當熱源為面熱源形式時(如高性能AI計算芯片),主要熱阻為熱匯熱阻,此時增強器件基底的對流換熱能力是提升該類器件散熱性能的重要方式,如通過優化微通道結構,增強熱匯換熱能力可以有效降低此類器件的熱阻。該工作通過實驗和理論計算解析了典型電子器件中的熱阻構成并提出了相應的解決辦法,為下一代具有復雜發熱模式的芯片與集成芯片系統的熱設計帶來新的理解和思路。
相關成果以“Optimization of embedded cooling for hotspots based on compound plate thermal spreading model”發表在傳熱學頂刊《國際傳熱傳質》(International Journal of Heat and Mass Transfer)上。

論文鏈接:
https://doi.org/10.1016/j.ijheatmasstransfer.2024.125866
北京大學集成電路學院2022級博士生杜建宇為文章的第一作者,北京大學集成電路學院張馳助理研究員、中國電科第二十六研究所余懷強研究員為通訊作者,該研究工作得到國家重點研發計劃、重點實驗室基金的支持。這也是王瑋教授團隊圍繞先進封裝領域熱管理方向在《國際傳熱傳質》期刊上連續發表的第5篇文章。王瑋教授團隊長期致力先進封裝中熱管理技術的研究,從仿真、實驗、理論方面進行了一系列卓有成效的探索。團隊在高密度封裝體內的快速熱仿真技術、嵌入式微流體冷卻技術、多孔薄膜兩相冷卻技術上的研究成果連續多年在傳熱學領域頂級期刊《國際傳熱傳質》、電子元器件封裝領域頂級國際會議IEEE Electronic Components and Technology Conference (ECTC)上發表,并取得多項國際先進散熱指標——多芯片散熱模組(散熱功率>3kW,溫升<100℃,IEEEiTherm 2022),單芯片散熱(散熱功率>1kW,溫升<60℃,IEEEECTC 2024)等。
審核編輯 黃宇
-
芯片
+關注
關注
456文章
50950瀏覽量
424722 -
熱阻
+關注
關注
1文章
108瀏覽量
16469 -
熱管理
+關注
關注
11文章
447瀏覽量
21807
發布評論請先 登錄
相關推薦
【dln團隊】DR-熱管理
微型熱管理和電源管理怎么解決散熱設計的難題?
量子通信新進展,郭光燦團隊實現公里級高維量子糾纏分發
清華大學在量子信息領域取得重要進展
GaN和SiC熱管理的進展
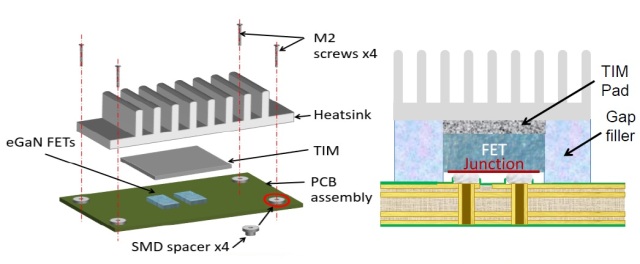
湖南先進傳感與信息技術創新研究院:在微納近紅外探測器領域取得重要研究進展

天府錦城實驗室在生物傳感與蛋白質測序領域取得重要進展





 北大王瑋教授團隊在芯片熱管理領域取得進展
北大王瑋教授團隊在芯片熱管理領域取得進展



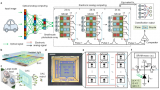












評論