01 正裝LED芯片結構
LED正裝芯片是最早出現的芯片結構,該結果中從上至下依次為:電極、P型半導體層、發光層、N型半導體層和襯底,該結構中PN結處產生的熱量需要經過藍寶石襯底才能傳導到熱沉,藍寶石襯底較差的導熱性能導致該結構導熱性能較差,從而降低了芯片的發光效率和可靠性。
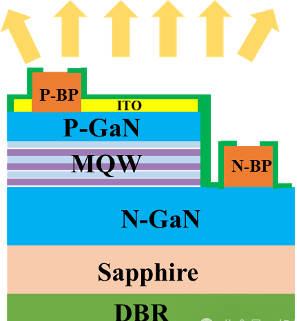
02 正裝LED芯片的優缺點
優點:
該結構簡單、制作工藝相對成熟;
缺點:
(1)正裝結構LED的p、n電極在LED的同一側,電流需橫向流過n-GaN層,導致電流發生擁擠,局部產生大量熱,限制了驅動電流;
(2)藍寶石襯底的導熱性差,嚴重阻礙了熱量的散失;
(3)溫度和濕度等因素可能導致電極金屬遷移,隨著芯片尺寸縮小,正負電極間距減小,可能會有短路的問題出現。
03 正裝LED芯片的分類
正裝芯片有多種分類方式,可以按照發光顏色、芯片功率、應用范圍等進行分類。為更好的闡述正裝LED芯片的結構。本文根據芯片功率將芯片分為小功率芯片、中功率芯片、大功率芯片三類。
04 正裝LED芯片的制備流程
小功率芯片:
小功率芯片的結構相對簡單,制作工藝也相對簡單,通常采用三次光刻制程,分別是MESA光刻、ITO光刻、PAD光刻,詳細流程如下:

中功率芯片:
中功率芯片通常會采用5次光刻制程,在小功率的3次光刻工藝的基礎上增加了電流阻擋層(CBL)光刻、鈍化(PV)光刻,具體工藝流程如下:

也可以采用先ITO后MESA的工藝流程,這有利于芯片良率的提升,詳細流程如下:

中功率芯片在研磨后通常會背鍍上高發射率的DBR。DBR可以顯著提高芯片點測亮度,對封裝后的亮度也有一定的提升。
大功率芯片:
大功率芯片通常也是采用中功率的5次光刻制程,但是背鍍層會由原來的DBR改為ODR(全方位反射層)。
05 正裝LED芯片應用現狀
藍寶石襯底的正裝結構LED以工藝簡單、成本相對較低,一直是GaN基LED的主流結構。目前,多數企業為節約生產與研發成本,仍采用這種結構。
二、LED倒裝芯片
01 倒裝LED芯片結構
倒裝芯片結構從上到下依次為藍寶石襯底、N型半導體發光層、P型半導體層和電極,與正裝芯片結構相比,該結構中PN結處產生的熱量不經過襯底即可直接傳導到熱沉;倒裝結構中,p電極和n電極均處于底面,避免了對出射光的遮擋,提高了出光效率。
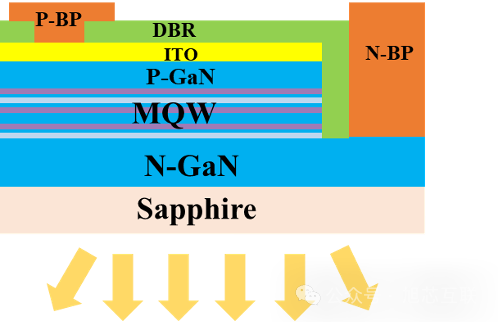
02 倒裝LED芯片的優缺點
優點:
(1)沒有通過藍寶石散熱,從芯片PN極上的熱量通過金絲球焊點傳到Si熱沉,Si是散熱的良導體,其散熱效果遠好于藍寶石的散熱,可以通過大電流使用;
(2)尺寸可以做到更小,密度更高,同時光學更容易匹配;
(3)散熱功能提升,使芯片的壽命得到了提升;
(4)抗靜電能力也會提升;
(5)為后續的封裝工藝打下基礎;
(6)電極之間距離較遠,可以減小電極金屬遷移導致的短路風險。
03 倒裝LED芯片的制備工藝
倒裝LED芯片的制備工藝流程如下圖所示:

04 倒裝LED應用現狀
目前,由于地制造設備和成本要求較高,做此類芯片的廠商還相對較少。因此,在市場應用雖還不是很廣泛,但具有非常廣闊的前景。
三、垂直LED芯片
01 垂直LED芯片結構
采用高熱導率的襯底(Si、Ge、Cu等襯底)取代藍寶石襯底,極大地提高了芯片的散熱。

02 垂直LED芯片優缺點
(1)目前,現有的所有顏色的垂直結構LED:紅光LED、綠光LED、藍光LED及紫外光LED,都可以制成通孔垂直結構;
(2)所有的制造工藝都是在芯片(wafer)水平進行;
(3)由于無需打金線與外界電源相聯結,采用通孔垂直結構的LED芯片的封裝厚度降低;
(4)抗靜電能力強;
(5)可以采用較大直徑的通孔/金屬填充塞和多個的通孔/金屬填充塞進一步提高襯底的散熱效率。
03 結構芯片制備工藝
制備GaN基垂直結構LED的工藝主要分成以下幾個步驟:表面處理、臺面蝕刻、鈍化層沉積等步驟,具體流程如下所示:

04 垂直LED的應用現狀
垂直結構的藍光芯片是正裝的基礎上產生的,這種芯片是將傳統藍寶石襯底的芯片倒過來鍵合在導熱能力較好的硅襯底或金屬等襯底上,在將藍寶石襯底激光剝離。這種結構的芯片解決了散熱的問題,但由于工藝復雜,生產合格率較低,目前發展不溫不火。
-
led
+關注
關注
242文章
23351瀏覽量
663140 -
半導體
+關注
關注
334文章
27697瀏覽量
222578 -
封裝
+關注
關注
127文章
7991瀏覽量
143394 -
LED芯片
+關注
關注
40文章
619瀏覽量
84478
原文標題:技術 | LED芯片的三種封裝結構
文章出處:【微信號:ledxspzj,微信公眾號:LED顯示屏之家】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦

三種類型拓撲結構的LED驅動器方案
教你如何識別和挑選LED三種背光技術
vb程序的三種基本結構2
激光器芯片的三種條形結構

開關電源最常見的三種結構
【干貨】ZigBee的三種組網結構





 LED芯片的三種封裝結構
LED芯片的三種封裝結構
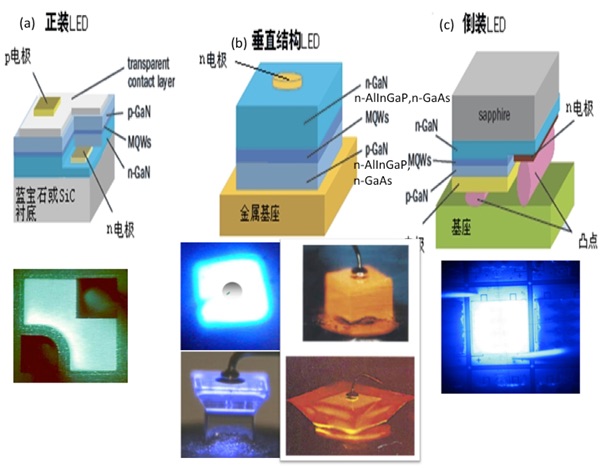
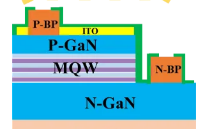











評論