金屬層1工藝是指形成第一層金屬互連線,第一層金屬互連線的目的是實現(xiàn)把不同區(qū)域的接觸孔連起來,以及把不同區(qū)域的通孔1連起來。第一金屬層是大馬士革的銅結(jié)構(gòu),先在介質(zhì)層上挖溝槽,再利用電鍍(Electro Chemical Plating, ECP)在溝槽里填充 Cu。
1) M1 光刻處理。通過微影技術(shù)將 M1掩膜版上的圖形轉(zhuǎn)移到晶圓上,形成 M1光刻膠圖案,M1區(qū)域上保留光刻膠。CT作為 M1光刻曝光對準(zhǔn)。圖4-240所示為電路的版圖,工藝的剖面圖是沿 AA'方向,圖4-241所示為M1光刻的剖面圖。圖4-242所示為M1顯影的剖面圖。
2) 測量 M1 光刻的關(guān)鍵尺寸。
3)測量 M1套刻數(shù)據(jù)。收集曝光之后的 M1 光刻圖形與 CT對準(zhǔn)圖形的套刻數(shù)據(jù)。
4)檢查顯影后曝光的圖形。
5) M1硬掩膜干法刻蝕。利用干法刻蝕去除沒有光刻膠覆蓋的 TiN 區(qū)域。圖4-243所示為M1硬掩膜刻蝕的剖面圖。
6)去除光刻膠。通過干法刻蝕和濕法刻蝕去除光刻膠。圖4-244 所示為去除光刻膠的剖面圖。
7)測量 M1的關(guān)鍵尺寸。收集刻蝕后的 M1的關(guān)鍵尺寸數(shù)據(jù),檢查 M1 的關(guān)鍵尺寸是否符合產(chǎn)品規(guī)格。
8)M1干法刻蝕。干法刻蝕利用CF4,CHF3和 CO 等混合氣體產(chǎn)生等離子電漿刻蝕 Si-COH 層,SiCN 作為停止層。
9)去除ESL SiCN 層。利用濕法刻蝕去除SiCN層。圖4-245所示為去除SiCN 層的剖面圖。
10)淀積 Ta/TaN。利用PVD淀積Ta/TaN。預(yù)淀積一層 Ta/TaN 有助于后續(xù)的Cu 附著在氧化層上,因為Cu與氧化物之間的粘附性很差,如果沒有Ta/TaN的輔助,Cu 層很容易脫落。另外Cu在氧化物中很容易擴(kuò)散,Ta/TaN 層作為阻擋層可以有效地防止Cu擴(kuò)散。
11)淀積Cu 薄籽晶層。利用PVD淀積一層Cu 薄籽晶層。預(yù)淀積一層厚度約500A的Cu 薄籽晶層,Cu薄籽晶層作為電鍍的陰極。圖4-246所示為淀積Cu薄籽晶層的剖面圖。
12)電鍍淀積銅。利用ECP 電鍍淀積一層銅作為金屬連接層,化學(xué)溶液是 H2SO4,CuSO4和H2O。圖4-247所示為電鍍淀積銅的剖面圖。
13)Cu CMP。利用CMP去除表面多余的銅,防止不同區(qū)域的金屬線短路,留下Cu填充金屬互連線區(qū)域。氧化層作為CMP的停止層。CMP 終點偵察器偵查到 IMD1 硅玻璃的信號,但還要考慮工藝的容忍度,防止有銅殘留造成短路,所以偵查到終點時,還要進(jìn)行一定時間的工藝。圖4-248所示 CuCMP 的剖面圖。
14)清洗。首先利用NH4OH和H2O清洗,再使用 HF:H2O(100:1)清洗,最后用超純凈水清洗,得到清潔的表面。
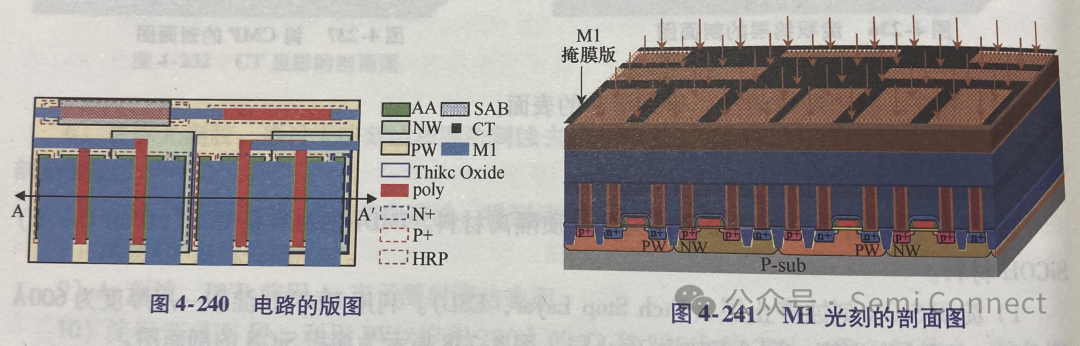
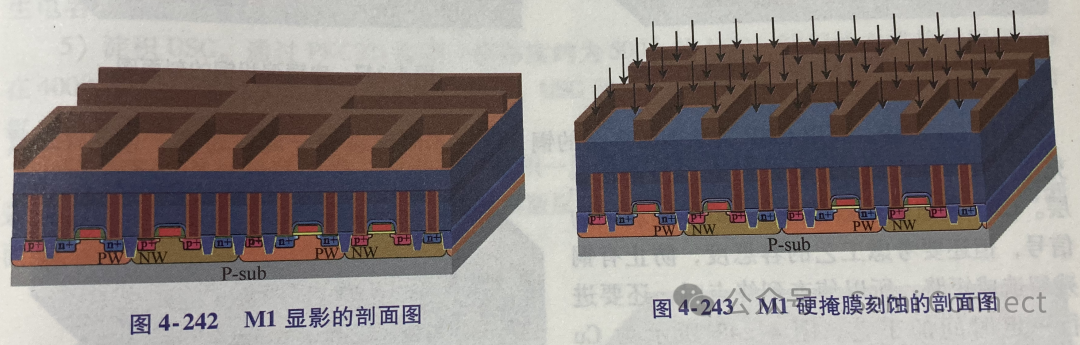
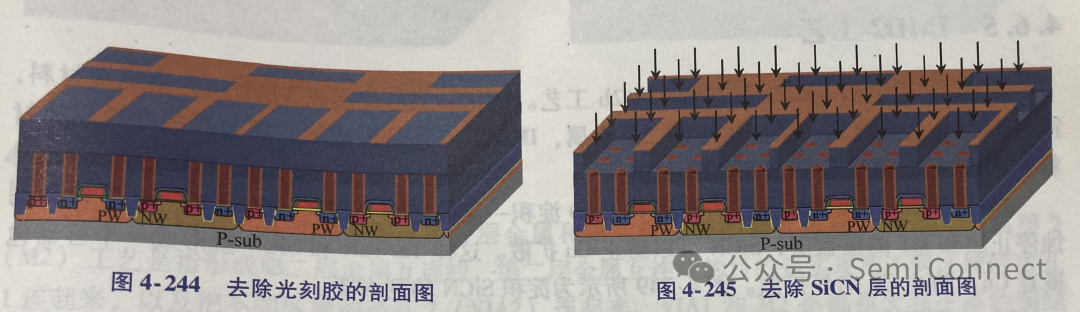
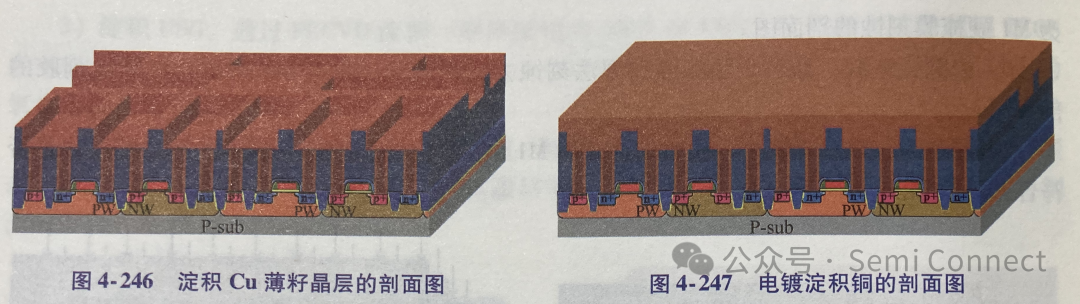
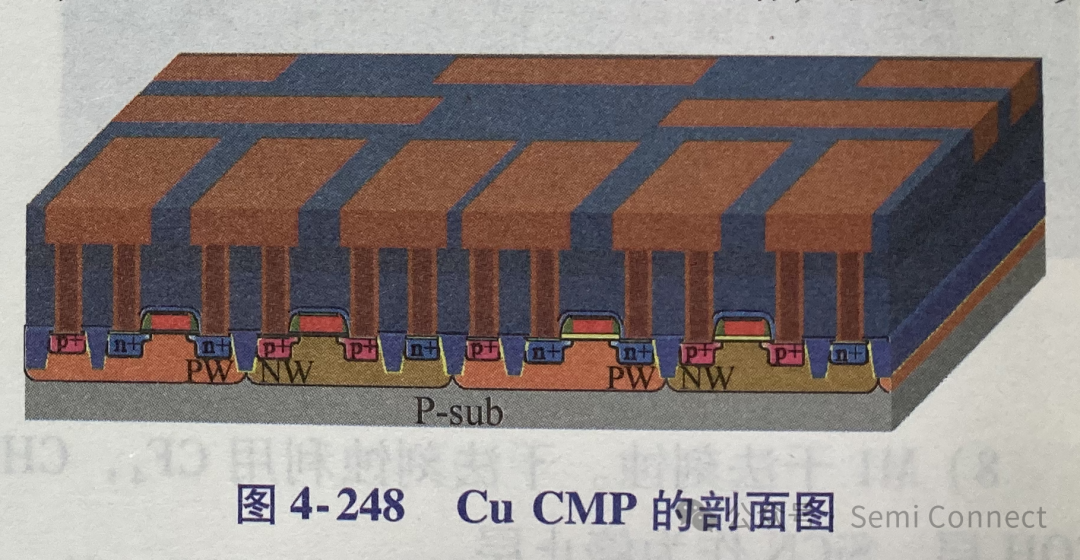
-
集成電路
+關(guān)注
關(guān)注
5392文章
11622瀏覽量
363177 -
晶圓
+關(guān)注
關(guān)注
52文章
4973瀏覽量
128313 -
工藝
+關(guān)注
關(guān)注
4文章
603瀏覽量
28893
原文標(biāo)題:金屬層1工藝-----《集成電路制造工藝與工程應(yīng)用》 溫德通 編著
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
【「大話芯片制造」閱讀體驗】+ 芯片制造過程和生產(chǎn)工藝
圖形反轉(zhuǎn)工藝用于金屬層剝離的研究
雙面柔性PCB板制造工藝及流程
晶圓制造工藝流程完整版
現(xiàn)代集成電路芯片14nm節(jié)點FinFET的制造工藝流程詳細(xì)資料說明

多層PCB的制造工藝流程
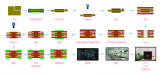
MOSFET晶體管的工藝制造流程





 金屬層1工藝的制造流程
金屬層1工藝的制造流程
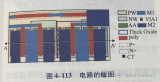
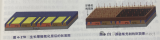

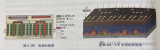
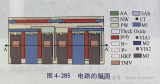










評論