文章來源:半導(dǎo)體與物理
原文作者:jjfly686
本文簡單介紹了兩種新型的選擇性刻蝕技術(shù)——高氧化性氣體的無等離子體刻蝕和原子層刻蝕。
全環(huán)繞柵極晶體管(Gate-All-Around FET, GAAFET)作為一種有望替代FinFET的下一代晶體管架構(gòu),因其能夠在更小尺寸下提供更好的靜電控制和更高的性能而備受關(guān)注。在制造n型GAAFET的過程中,一個關(guān)鍵步驟是在內(nèi)隔層沉積之前對Si-SiGe堆疊納米片進(jìn)行高選擇性的SiGe:Si蝕刻,以產(chǎn)生硅納米片并釋放溝道。
本文將探討這一過程中涉及的選擇性刻蝕技術(shù),并介紹兩種新型的刻蝕方法——高氧化性氣體的無等離子體刻蝕和原子層刻蝕(ALE),它們?yōu)閷崿F(xiàn)高精度、高選擇性的SiGe刻蝕提供了新的解決方案。
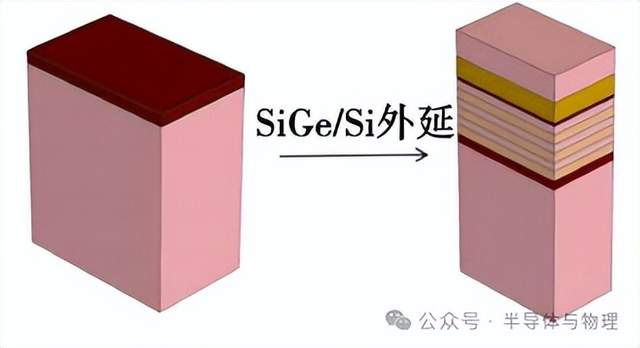
GAA結(jié)構(gòu)中的SiGe超晶格層
在GAAFET的設(shè)計中,為了增強(qiáng)器件性能,通常會在硅襯底上交替生長Si和SiGe層,形成多層結(jié)構(gòu),即所謂的超晶格。這些SiGe層不僅能夠調(diào)整載流子濃度,還能通過引入應(yīng)力來改善電子遷移率。然而,在后續(xù)的工藝步驟中,需要精確地去除這些SiGe層,同時保留硅層,這就要求有高度選擇性的刻蝕技術(shù)。
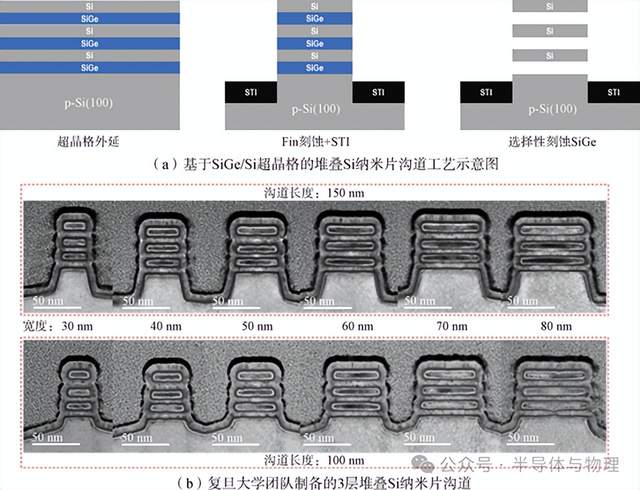
選擇性刻蝕SiGe的方法
1.高氧化性氣體的無等離子體刻蝕
ClF3氣體的選擇:這種刻蝕方法采用具有極高選擇性的高氧化性氣體,如ClF3,SiGe:Si選擇比可達(dá)到1000-5000。并且可以在室溫下完成刻蝕,且不會造成等離子體損傷。
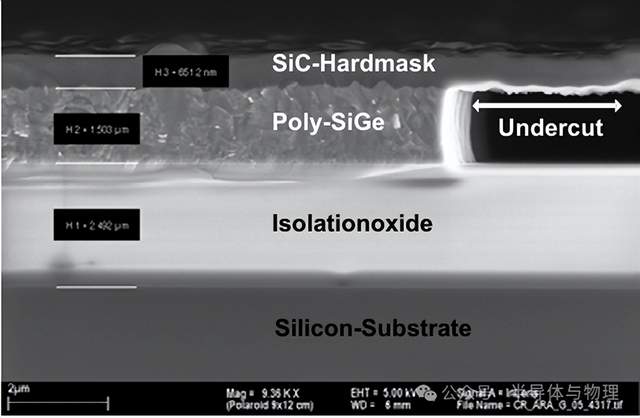
低溫高效:最佳溫度大約在30°C左右,實現(xiàn)了低溫條件下的高選擇性刻蝕,避免了額外熱預(yù)算的增加,這對保持器件性能至關(guān)重要。
干燥環(huán)境:整個刻蝕過程處于完全干燥條件下進(jìn)行,消除了結(jié)構(gòu)粘連的風(fēng)險。

2.原子層刻蝕(ALE)
自限制特性:ALE是一種基于兩步循環(huán)工藝的刻蝕技術(shù),首先對所要刻蝕材料表面的第一層進(jìn)行改性,然后將改性層去除而不影響未改性的部分。每一步都具有自限制性,保證了每次僅去除幾個原子層的精確度。
循環(huán)刻蝕:不斷重復(fù)上述兩步工藝,直到達(dá)到所需的刻蝕深度。這一過程使得ALE能夠?qū)崿F(xiàn)內(nèi)側(cè)墻中小尺寸空腔的原子級別精度刻蝕。
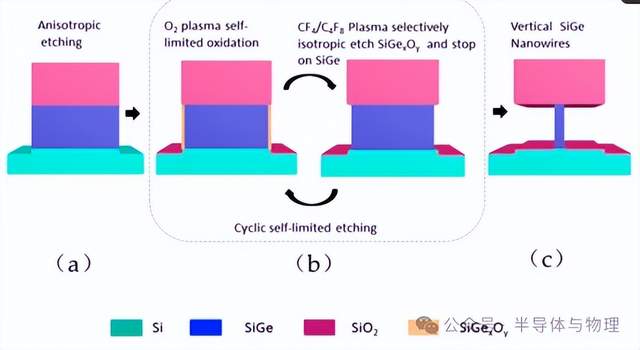
聲明:本網(wǎng)站部分文章轉(zhuǎn)載自網(wǎng)絡(luò),轉(zhuǎn)發(fā)僅為更大范圍傳播。 轉(zhuǎn)載文章版權(quán)歸原作者所有,如有異議,請聯(lián)系我們修改或刪除。聯(lián)系郵箱:viviz@actintl.com.hk, 電話:0755-25988573
審核編輯 黃宇
-
SiGe
+關(guān)注
關(guān)注
0文章
63瀏覽量
23506 -
刻蝕
+關(guān)注
關(guān)注
2文章
192瀏覽量
13178
發(fā)布評論請先 登錄
相關(guān)推薦
如何提高濕法刻蝕的選擇比
晶圓濕法刻蝕原理是什么意思
半導(dǎo)體濕法和干法刻蝕
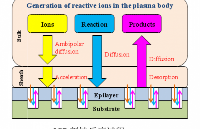
選擇性沉積技術(shù)介紹
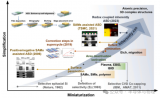
晶圓表面溫度對干法刻蝕的影響

過電流保護(hù)的選擇性是靠什么來實現(xiàn)的
選擇性喚醒如何實現(xiàn)局部聯(lián)網(wǎng)

簡化ECU中具有選擇性喚醒功能的隔離式CAN設(shè)計

交流二元繼電器如何具有相位選擇性和頻率選擇性
在smt貼片加工廠中選擇性波峰焊存在的作用和意義
淺談礦井電網(wǎng)選擇性絕緣在線監(jiān)測技術(shù)研究
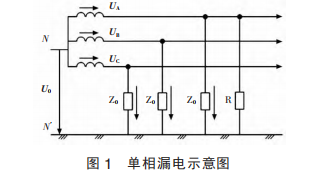
SMT加工廠用選擇性波峰焊有什么優(yōu)點嗎?
鍺化硅(SiGe)和硅(Si)之間的各向同性和選擇性蝕刻機(jī)制
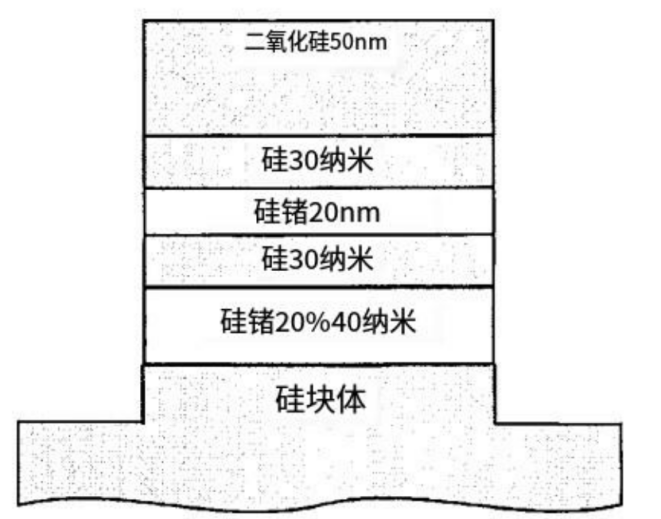




 SiGe與Si選擇性刻蝕技術(shù)
SiGe與Si選擇性刻蝕技術(shù)
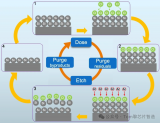











評論