300mm晶圓的厚度為775um,200mm晶圓的度為725um,這個(gè)厚度在實(shí)際封裝時(shí)太厚了。前段制程中晶圓要被處理、要在設(shè)備內(nèi)和設(shè)備間傳送,這時(shí)候上面提到的厚度是合適的,可以滿足機(jī)械強(qiáng)度的要求,滿足晶圓的翹曲度的要求。但封裝的時(shí)候則是薄一點(diǎn)更好,所以要處理到100~200um左右的厚度,就要用到減薄工藝。
滿足封裝要求
降低封裝厚度
在電子設(shè)備不斷向小型化、輕薄化發(fā)展的趨勢下,對集成電路芯片的厚度有嚴(yán)格限制。通過減薄晶圓,可以使芯片在封裝后達(dá)到所需的薄型化要求,從而更好地適應(yīng)各種緊湊型電子設(shè)備的設(shè)計(jì)需求,例如智能手機(jī)、平板電腦等。
更薄的芯片可以在同等空間內(nèi)容納更多的電子元件,提高設(shè)備的集成度和性能。
便于封裝工藝
減薄后的晶圓在封裝過程中更容易進(jìn)行引線鍵合等操作。引線鍵合是將芯片上的電極與封裝引腳連接起來的重要工藝步驟,晶圓減薄后,電極與引腳之間的距離縮短,使得鍵合線可以更短、更穩(wěn)定,降低了信號傳輸?shù)难舆t和損耗,提高了芯片的性能和可靠性。
對于一些先進(jìn)的封裝技術(shù),如晶圓級封裝(WLP)和三維封裝(3D Packaging),晶圓減薄是實(shí)現(xiàn)這些封裝技術(shù)的關(guān)鍵步驟之一。這些封裝技術(shù)可以進(jìn)一步提高芯片的集成度和性能,同時(shí)降低成本。
提高散熱性能
增加熱傳導(dǎo)效率
芯片在工作過程中會(huì)產(chǎn)生大量的熱量,如果不能及時(shí)有效地散熱,會(huì)導(dǎo)致芯片溫度升高,影響芯片的性能和可靠性。減薄后的晶圓可以減少熱阻,提高熱傳導(dǎo)效率,使芯片產(chǎn)生的熱量能夠更快地散發(fā)出去。
例如,在高功率電子設(shè)備中,如服務(wù)器、顯卡等,散熱問題尤為重要。通過減薄晶圓,可以有效地降低芯片的工作溫度,提高設(shè)備的穩(wěn)定性和可靠性。
便于散熱設(shè)計(jì)
減薄后的晶圓可以為散熱設(shè)計(jì)提供更多的空間和可能性。例如,可以在芯片背面直接安裝散熱片或采用其他散熱技術(shù),如熱管、散熱風(fēng)扇等,提高散熱效果。
對于一些對散熱要求極高的應(yīng)用領(lǐng)域,如航空航天、軍事等,晶圓減薄是滿足散熱需求的重要手段之一。
降低成本
減少材料消耗
晶圓減薄可以減少芯片制造過程中的材料消耗。晶圓是由硅等半導(dǎo)體材料制成的,價(jià)格較高。通過減薄晶圓,可以在相同直徑的晶圓上制造更多的芯片,從而降低每個(gè)芯片的材料成本。
此外,減薄后的晶圓在運(yùn)輸和存儲(chǔ)過程中也可以節(jié)省空間和成本。
提高生產(chǎn)效率
晶圓減薄可以提高芯片制造的生產(chǎn)效率。在芯片制造過程中,晶圓的厚度會(huì)影響到一些工藝步驟的時(shí)間和效率。例如,在光刻、刻蝕等工藝中,減薄后的晶圓可以減少光線的散射和反射,提高工藝精度和效率。
同時(shí),減薄后的晶圓在測試和封裝過程中也可以更快地進(jìn)行操作,提高生產(chǎn)效率。
-
晶圓
+關(guān)注
關(guān)注
52文章
4922瀏覽量
128063 -
封裝
+關(guān)注
關(guān)注
126文章
7933瀏覽量
143056
原文標(biāo)題:晶圓為什么要減薄?
文章出處:【微信號:wc_ysj,微信公眾號:旺材芯片】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
改善薄晶圓制造中的檢測挑戰(zhàn)
宜特晶圓:成功開發(fā)晶圓減薄達(dá)1.5mil(38um)技術(shù)
同茂線性馬達(dá)談新面世的高精密晶圓減薄機(jī)
單面晶圓減薄和處理研究報(bào)告
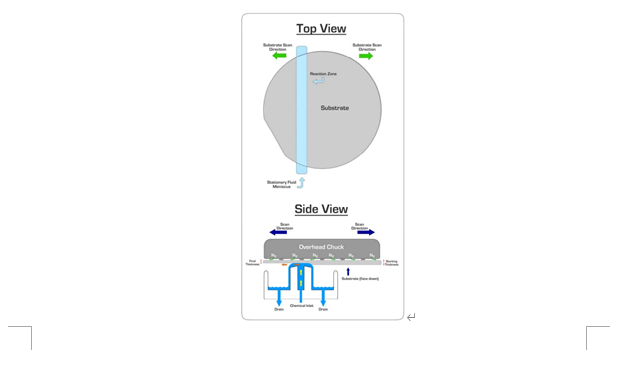
用于高密度晶圓互連的微加工晶圓減薄方法

微機(jī)械結(jié)構(gòu)硅片的機(jī)械減薄研究
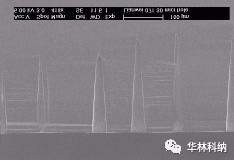
晶圓減薄工藝的主要步驟

簡述晶圓減薄的幾種方法
晶圓鍵合及后續(xù)工藝流程





 晶圓為什么要減薄
晶圓為什么要減薄












評論