HAST測(cè)試的核心宗旨
HAST測(cè)試的核心宗旨
宗旨:HAST測(cè)試的主要宗旨是通過模擬極端環(huán)境條件,加速半導(dǎo)體元器件的失效過程,以此來(lái)驗(yàn)證元器件在高溫、高濕、高壓條件下的可靠性。這種測(cè)試方法能夠有效縮短測(cè)試周期,快速揭示產(chǎn)品潛在的缺陷,例如材料分層、開裂、短路等問題。
失效原因:HAST測(cè)試中的失效原因主要包括濕氣滲透導(dǎo)致的材料分解、結(jié)合力減弱、腐蝕等現(xiàn)象。具體表現(xiàn)在鋁線腐蝕、芯片及PCB的分層、封裝時(shí)銀膏吸水導(dǎo)致的爆米花效應(yīng),以及外引腳錫短路等問題。
PCT測(cè)試的核心宗旨
宗旨:PCT測(cè)試旨在將樣品置于極端的溫度、飽和濕度和壓力條件下,以評(píng)估樣品對(duì)高濕環(huán)境的耐受能力。金鑒實(shí)驗(yàn)室提供專業(yè)的PCT測(cè)試服務(wù),幫助半導(dǎo)體、微電子等行業(yè)的企業(yè)評(píng)估其產(chǎn)品的密封性和老化性能,確保產(chǎn)品在市場(chǎng)中的競(jìng)爭(zhēng)力。
失效原因:PCT測(cè)試中的失效原因與HAST相似,主要是由于大量水氣凝結(jié)滲透導(dǎo)致的分層、氣泡、白點(diǎn)等失效現(xiàn)象。
HAST與PCT的箱體構(gòu)造與特性
HAST與PCT的箱體構(gòu)造與特性
構(gòu)造:HAST試驗(yàn)箱是一個(gè)密封的溫濕度試驗(yàn)箱,其內(nèi)部壓力超過一個(gè)大氣壓,通常設(shè)計(jì)為圓筒形狀。PCT試驗(yàn)箱采用不銹鋼圓形試驗(yàn)內(nèi)箱結(jié)構(gòu),內(nèi)含一個(gè)能夠產(chǎn)生100%飽和環(huán)境的水加熱器。
特性:由于內(nèi)部壓力的特殊性,HAST試驗(yàn)箱需要特殊的連接器設(shè)計(jì),以保證在高壓環(huán)境下的電氣連接。PCT試驗(yàn)箱體積較小,成本較低,操作簡(jiǎn)單,也被廣泛應(yīng)用于消毒工作。

HAST測(cè)試標(biāo)準(zhǔn)
HAST測(cè)試標(biāo)準(zhǔn)
參考標(biāo)準(zhǔn):HAST測(cè)試通常參考JEDEC標(biāo)準(zhǔn),例如130°C、85%相對(duì)濕度、96小時(shí)測(cè)試周期,以及125%的偏壓等。
說(shuō)明:具體的測(cè)試標(biāo)準(zhǔn)可以根據(jù)產(chǎn)品特性和行業(yè)需求進(jìn)行選擇。
PCT測(cè)試標(biāo)準(zhǔn)
參考標(biāo)準(zhǔn):PCT測(cè)試主要參考IEC 60068 - 2 - 66、MIL - STD - 810G Method 514、GB/T 2424.40等標(biāo)準(zhǔn)。
說(shuō)明:美國(guó)軍方標(biāo)準(zhǔn)對(duì)試驗(yàn)的介紹較為詳細(xì),但應(yīng)用于消費(fèi)電子產(chǎn)品可能過于嚴(yán)苛,因此不推薦;GB/T標(biāo)準(zhǔn)主要參考IEC標(biāo)準(zhǔn)編寫,建議以IEC原版標(biāo)準(zhǔn)為準(zhǔn)。
HAST測(cè)試的優(yōu)缺點(diǎn)
優(yōu)點(diǎn):HAST測(cè)試能夠顯著縮短測(cè)試周期,加速產(chǎn)品失效過程,快速暴露產(chǎn)品缺陷;同時(shí),它還能加速腐蝕和離子遷移過程,有助于評(píng)估產(chǎn)品的可靠性;并且,HAST測(cè)試的應(yīng)用范圍廣泛。
缺點(diǎn):HAST測(cè)試的設(shè)備較為復(fù)雜,成本較高,后期升級(jí)困難;可能出現(xiàn)與實(shí)際應(yīng)用環(huán)境不符的失效機(jī)理,結(jié)果判斷需謹(jǐn)慎;對(duì)控制器的要求較高,需要控制多個(gè)參數(shù)。
PCT測(cè)試的優(yōu)缺點(diǎn)
優(yōu)點(diǎn):PCT測(cè)試的設(shè)備簡(jiǎn)單,成本低,操作方便;能夠有效測(cè)試產(chǎn)品的密封性能和老化性能;試驗(yàn)標(biāo)準(zhǔn)明確,便于參考和執(zhí)行。
缺點(diǎn):PCT測(cè)試的濕度控制較為單一,只能設(shè)定飽和濕度(100%);對(duì)于濕度控制要求高的產(chǎn)品,可能無(wú)法滿足精確測(cè)試需求;試驗(yàn)時(shí)間相對(duì)較長(zhǎng),不如HAST測(cè)試快速。
-
PCT
+關(guān)注
關(guān)注
0文章
34瀏覽量
18704 -
可靠性測(cè)試
+關(guān)注
關(guān)注
1文章
90瀏覽量
14198
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
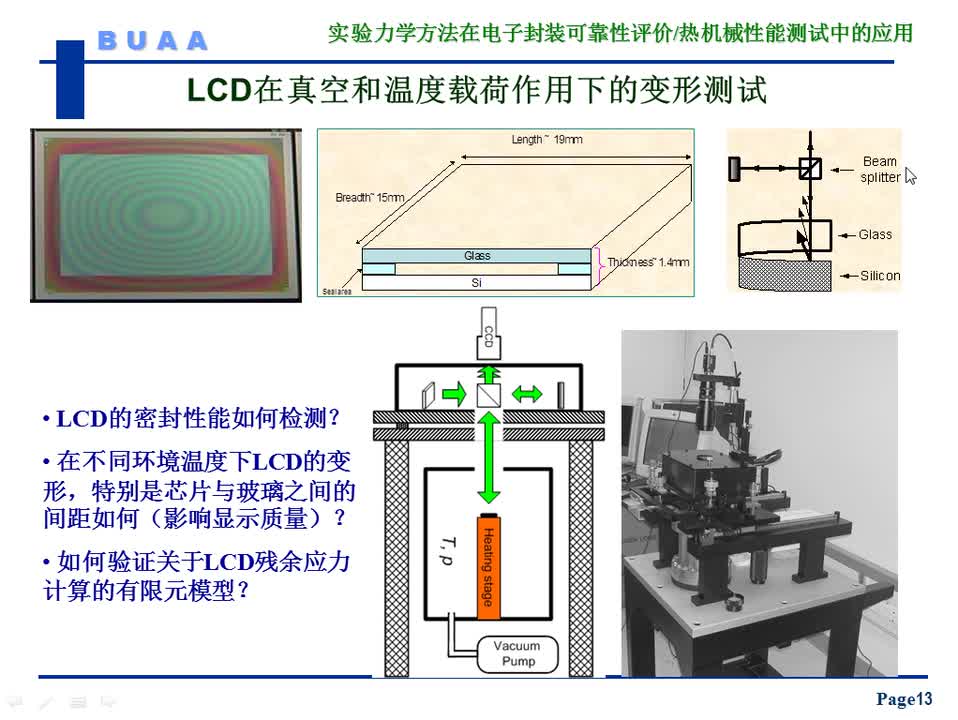
#硬聲創(chuàng)作季 #可靠性 電子封裝可靠性評(píng)價(jià)中的實(shí)驗(yàn)力學(xué)方法-3

#硬聲創(chuàng)作季 #可靠性 電子封裝可靠性評(píng)價(jià)中的實(shí)驗(yàn)力學(xué)方法-5
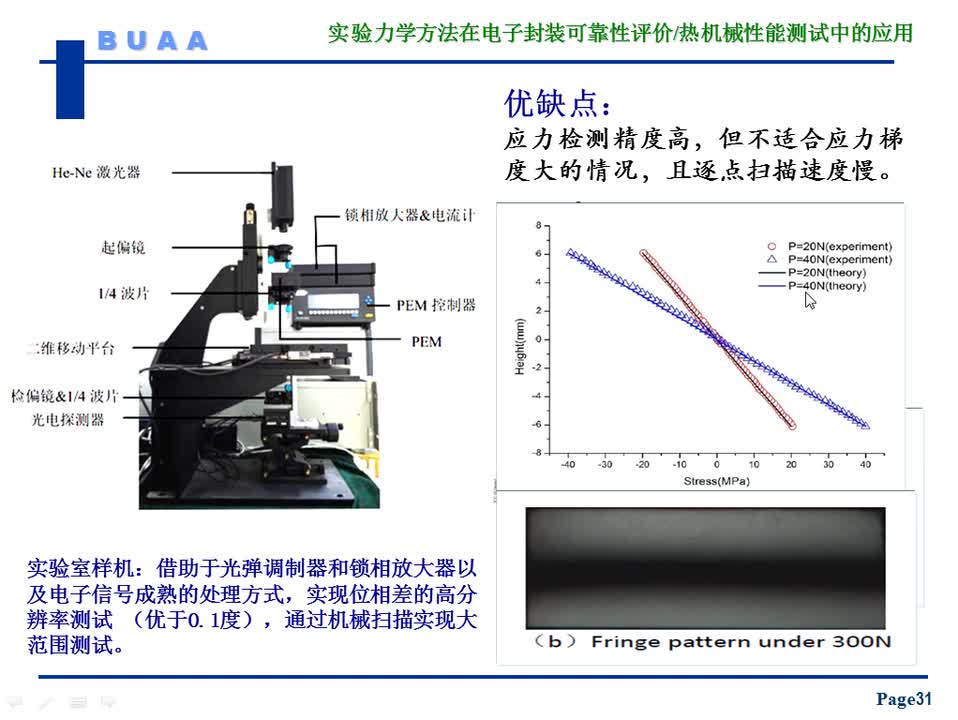
#硬聲創(chuàng)作季 #可靠性 電子封裝可靠性評(píng)價(jià)中的實(shí)驗(yàn)力學(xué)方法-6
GaN可靠性的測(cè)試
芯片IC可靠性測(cè)試、靜電測(cè)試、失效分析
什么是高可靠性?
PCB線路板可靠性分析及失效分析
硅片級(jí)可靠性測(cè)試詳解
高壓加速老化試驗(yàn)箱PCT和HAST的區(qū)別

可靠性測(cè)試中HALT實(shí)驗(yàn)與HASS實(shí)驗(yàn)的區(qū)別





 可靠性測(cè)試:HAST與PCT的區(qū)別
可靠性測(cè)試:HAST與PCT的區(qū)別












評(píng)論