超寬禁帶半導(dǎo)體氧化鎵材料與器件專(zhuān)刊
氧化鎵(Ga2O3)作為繼GaN和SiC之后的下一代超寬禁帶半導(dǎo)體材料,其禁帶寬度約為4.8 eV,理論擊穿場(chǎng)強(qiáng)為8 MV/cm,被廣泛應(yīng)用于高性能電源開(kāi)關(guān)、射頻放大器、日盲探測(cè)器、惡劣環(huán)境信號(hào)處理方面。近年來(lái)隨著氧化鎵晶體生長(zhǎng)技術(shù)的突破性進(jìn)展,氧化鎵材料及器件的研究與應(yīng)用成為國(guó)際上超寬禁帶半導(dǎo)體領(lǐng)域的研究熱點(diǎn)。
針對(duì)該熱點(diǎn)領(lǐng)域,《半導(dǎo)體學(xué)報(bào)》組織了一期“超寬禁帶半導(dǎo)體氧化鎵材料與器件”專(zhuān)刊,并邀請(qǐng)山東大學(xué)陶緒堂教授、南京大學(xué)葉建東教授、中國(guó)科學(xué)技術(shù)大學(xué)龍世兵教授和山東大學(xué)賈志泰副教授共同擔(dān)任特約編輯。
該專(zhuān)刊包括5篇綜述和6篇研究論文,介紹了Ga2O3晶體和外延薄膜生長(zhǎng)、缺陷研究、器件設(shè)計(jì)與加工等方面的最新進(jìn)展。
1. β-Ga2O3單晶生長(zhǎng)及相關(guān)性能研究進(jìn)展
氧化鎵是一種帶隙非常大(~4.8 eV)的半導(dǎo)體材料,在紫外探測(cè)和電力電子器件等領(lǐng)域具有廣闊的應(yīng)用前景。相較于其他寬禁帶半導(dǎo)體材料,氧化鎵最突出的特征是通過(guò)熔體法可以制備低成本、大面積的單晶β-Ga2O3襯底。日本、美國(guó)、歐盟等發(fā)達(dá)國(guó)家正在大力發(fā)展超寬帶Ga2O3半導(dǎo)體材料。國(guó)內(nèi)科學(xué)家也積極開(kāi)展Ga2O3材料及其工業(yè)應(yīng)用的相關(guān)研究。
中國(guó)科學(xué)院上海光學(xué)精密機(jī)械研究所的夏長(zhǎng)泰研究員與埃及蘇哈格大學(xué)的Mohamed博士詳細(xì)總結(jié)并分析了β-Ga2O3單晶的生長(zhǎng)方法、摻雜及應(yīng)用;指出目前研究存在的一些障礙,包括低成本大尺寸單晶的生長(zhǎng)、結(jié)構(gòu)缺陷、p型摻雜、器件熱穩(wěn)定性等問(wèn)題。
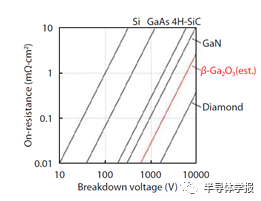
β-Ga2O3功率器件與其他主要半導(dǎo)體功率器件的理論性能極限
Growth and fundamentals of bulkβ-Ga2O3single crystals
H. F. Mohamed,Changtai Xia,Qinglin Sai,Huiyuan Cui,Mingyan Pan,Hongji Qi
J. Semicond.2019, 40(1), 011801
doi: 10.1088/1674-4926/40/1/011801
Full text
http://www.jos.ac.cn/article/doi/10.1088/1674-4926/40/1/011801?pageType=en
2.基于超寬禁帶氧化鎵半導(dǎo)體材料的功率場(chǎng)效應(yīng)晶體管的研究進(jìn)展
氧化鎵(Ga2O3)作為一種新型超寬禁帶半導(dǎo)體材料得到了廣泛關(guān)注,引發(fā)了一場(chǎng)對(duì)氧化鎵功率器件的研究熱潮,并日益成為國(guó)家間的競(jìng)爭(zhēng)熱點(diǎn),美國(guó)和日本已經(jīng)投入了大量的人力、物力和財(cái)力開(kāi)展相關(guān)研究,日本公司Flosfia專(zhuān)門(mén)推行氧化鎵功率器件產(chǎn)品的商業(yè)化,IEDM在2018年開(kāi)始在功率器件板塊收錄Ga2O3文章,由此可見(jiàn)Ga2O3功率器件的巨大應(yīng)用潛力。
中國(guó)科學(xué)技術(shù)大學(xué)龍世兵教授詳細(xì)介紹了氧化鎵的材料優(yōu)勢(shì)和場(chǎng)效應(yīng)晶體管方面的研究進(jìn)展。氧化鎵的性能優(yōu)勢(shì)主要是超寬的禁帶寬度(~4.8 eV)、超高的理論擊穿場(chǎng)強(qiáng)(8 MV/cm)、可調(diào)控的摻雜濃度(1016?1020cm-3),而熔體法制備高質(zhì)量大面積的氧化鎵單晶可以大大降低生產(chǎn)成本。大量研究關(guān)注場(chǎng)效應(yīng)晶體管。器件類(lèi)型包括MESFET、MOSFET、TFT,器件結(jié)構(gòu)包括:場(chǎng)板結(jié)構(gòu)、柵槽結(jié)構(gòu)、鰭型結(jié)構(gòu),常開(kāi)和常關(guān)器件均已實(shí)現(xiàn),平面結(jié)構(gòu)和垂直結(jié)構(gòu)都得到初步探索。盡管氧化鎵基MOSFET研究仍處于早期階段,但實(shí)現(xiàn)了3.8 MV/cm的擊穿場(chǎng)強(qiáng),超過(guò)SiC和GaN的理論值。
總之,本綜述有助于了解氧化鎵從材料到器件的概況,從而把握研究發(fā)展方向、開(kāi)展相關(guān)研究。
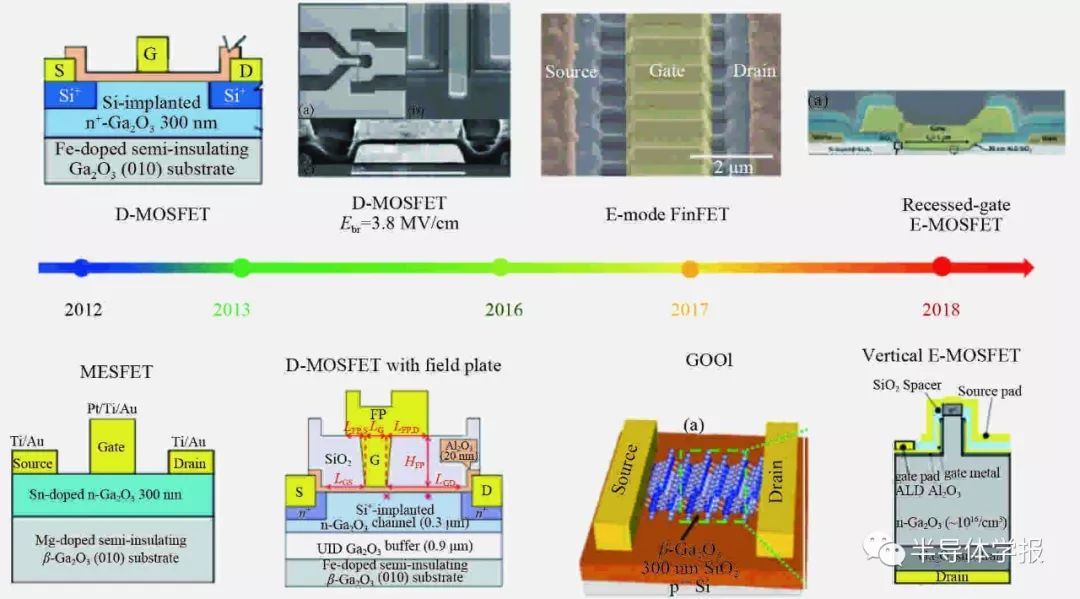
β-Ga2O3晶體管近年來(lái)的發(fā)展
Progress of power field effect transistor based on ultra-wide bandgapGa2O3semiconductor material
Hang Dong,Huiwen Xue,Qiming He,Yuan Qin,Guangzhong Jian,Shibing Long,Ming Liu
J. Semicond.2019, 40(1),011802
doi: 10.1088/1674-4926/40/1/011802
Full text
http://www.jos.ac.cn/article/doi/10.1088/1674-4926/40/1/011802?pageType=en
3.超寬禁帶氧化鎵高效能功率器件的最新進(jìn)展
氧化鎵(β-Ga2O3)作為繼GaN和SiC之后的下一代超寬禁帶半導(dǎo)體材料,其禁帶寬度約為4.8 eV,理論擊穿場(chǎng)強(qiáng)為8 MV/cm,電子遷移率為300cm2/Vs,因此β-Ga2O3具有4倍于GaN,10倍于SiC以及3444倍于Si的Baliga技術(shù)指標(biāo)。同時(shí)通過(guò)熔體法(生長(zhǎng)藍(lán)寶石襯底的方法)可以獲得低缺陷密度(103?104cm-2)的大尺寸β-Ga2O3襯底,使得β-Ga2O3器件的成本相比于GaN以及SiC器件更低。隨著高鐵、電動(dòng)汽車(chē)以及高壓電網(wǎng)輸電系統(tǒng)的快速發(fā)展,全世界急切的需要具有更高轉(zhuǎn)換效率的高壓大功率電子電力器件。β-Ga2O3功率器件在與GaN和SiC相同的耐壓情況下,導(dǎo)通電阻更低、功耗更小、更耐高溫、能夠極大地節(jié)約上述高壓器件工作時(shí)的電能損失,因此Ga2O3提供了一種更高效更節(jié)能的選擇。
氧化鎵器件除日本推出的α-Ga2O3二極管產(chǎn)品以外,其他Ga2O3器件仍然處在實(shí)驗(yàn)室階段。
西安電子科技大學(xué)微電子學(xué)院周弘副教授總結(jié)了目前氧化鎵半導(dǎo)體功率器件的發(fā)展?fàn)顩r。著重介紹了目前大尺寸襯底制備、高質(zhì)量外延層生長(zhǎng)、高性能二極管以及場(chǎng)效應(yīng)晶體管的研制進(jìn)展。同時(shí)對(duì)氧化鎵低熱導(dǎo)率特性的規(guī)避提供了可選擇的方案,對(duì)氧化鎵未來(lái)發(fā)展前景進(jìn)行了展望。
Si襯底上β-Ga2O3on insulator FET的示意圖及解理后β-Ga2O3的AFM圖
Areviewof the most recent progresses of state-of-art galliumoxide power devices
Hong Zhou, Jincheng Zhang, Chunfu Zhang, Qian Feng, Shenglei Zhao, Peijun Ma, Yue Hao
J. Semicond.2019, 40(1), 011803
doi: 10.1088/1674-4926/40/1/011803
Full text
http://www.jos.ac.cn/article/doi/10.1088/1674-4926/40/1/011803?pageType=en
4.β-Ga2O3單晶的缺陷、缺陷形成機(jī)理及其對(duì)器件性能的影響
β-Ga2O3晶體是一種新型的第四代直接帶隙超寬禁帶半導(dǎo)體,相比于第三代半導(dǎo)體,它具有禁帶寬度更大、吸收截止邊更短、生長(zhǎng)成本更低等突出優(yōu)點(diǎn),成為超高壓功率器件和深紫外光電子器件的優(yōu)選材料之一。
山東大學(xué)晶體材料研究所賈志泰副教授總結(jié)了β-Ga2O3單晶中目前已發(fā)現(xiàn)的缺陷類(lèi)型,包括位錯(cuò)、空洞、孿晶和由機(jī)械應(yīng)力引入的小缺陷。然后,詳細(xì)總結(jié)了缺陷對(duì)器件性能的影響,其中位錯(cuò)及其周?chē)鷧^(qū)域會(huì)在單晶襯底中產(chǎn)生漏電通道;并不是所有的空洞缺陷都會(huì)導(dǎo)致漏電;摻雜離子不會(huì)對(duì)漏電產(chǎn)生任何影響;目前還不能明確小缺陷對(duì)器件電學(xué)性能的影響。最后,討論了缺陷形成機(jī)制,發(fā)現(xiàn)大多數(shù)的小缺陷是由機(jī)械應(yīng)力引入的;空洞缺陷可能由過(guò)多氧空位的有序堆疊、微小氣泡的滲入或者局部回熔造成;螺型位錯(cuò)來(lái)源于亞晶界,韌性位錯(cuò)可能來(lái)源于(101)滑移面;孿晶主要在晶體生長(zhǎng)初期“放肩”階段產(chǎn)生。
以上成果有助于晶體缺陷的控制,為器件性能的提高提供了基本參考。
同熔體法生長(zhǎng)獲得的β-Ga2O3體塊單晶:(a)導(dǎo)模法;(b)垂直布里奇曼法;(c)提拉法;(d)光浮區(qū)法
A review of β-Ga2O3single crystal defects, their effects on device performance and their formation mechanism
Bo Fu, Zhitai Jia, Wenxiang Mu, Yanru Yin, Jian Zhang, Xutang Tao
J. Semicond.2019, 40(1), 011804
doi: 10.1088/1674-4926/40/1/011804
Full text
http://www.jos.ac.cn/article/doi/10.1088/1674-4926/40/1/011804?pageType=en
5.鹵化物氣相外延生長(zhǎng)超寬禁帶氧化鎵
氧化鎵是近年來(lái)倍受關(guān)注的新型超寬禁帶半導(dǎo)體材料,相比氮化鎵和碳化硅,超寬帶隙(~4.8 eV)和高達(dá)8 MV/cm的擊穿電場(chǎng)強(qiáng)度,使其在電力電子器件等諸多領(lǐng)域有著重要的應(yīng)用價(jià)值。盡管氧化鎵單晶可以使用熔體法制備,但仍存在成本高、大尺寸易碎裂等缺點(diǎn)。鹵化物氣相外延作為半導(dǎo)體工業(yè)中廣泛應(yīng)用的非有機(jī)氣相外延技術(shù),具有很高的生長(zhǎng)速率,也可以用于大尺寸氧化鎵襯底和器件的制備。
南京大學(xué)電子科學(xué)與工程學(xué)院修向前教授詳細(xì)介紹了鹵化物氣相外延在氧化鎵材料制備及器件應(yīng)用方面取得的最新進(jìn)展,通過(guò)鹵化物氣相外延可以實(shí)現(xiàn)大尺寸氧化鎵襯底材料和同質(zhì)外延,并用于功率電子器件如SBD等的制備。
可以預(yù)期,鹵化物氣相外延將發(fā)展成為通用型生長(zhǎng)技術(shù),用于大尺寸低成本寬禁帶/超寬禁帶半導(dǎo)體如氮化鎵和氧化鎵的外延及相應(yīng)的新型結(jié)構(gòu)器件。
850 ℃ HVPE方法生長(zhǎng)的β-Ga2O3的光學(xué)照片和SEM圖像
Application of halide vapor phase epitaxy for the growth of ultra-wideband gapGa2O3
Xiangqian Xiu, Liying Zhang, Yuewen Li, Zening Xiong, Rong Zhang, Youdou Zheng
J. Semicond.2019, 40(1), 011805
doi: 10.1088/1674-4926/40/1/011805
Full text
http://www.jos.ac.cn/article/doi/10.1088/1674-4926/40/1/011805?pageType=en
6.高摻雜單晶襯底上β-Ga2O3肖特基勢(shì)壘二極管的溫度相關(guān)的電學(xué)性能
β-Ga2O3因帶隙寬,擊穿電場(chǎng)高,可實(shí)現(xiàn)具有成本效益的單晶襯底,在各種光電和電子領(lǐng)域已獲得廣泛關(guān)注。在智能電網(wǎng)、可再生能源、大數(shù)據(jù)中心電源、汽車(chē)電子等領(lǐng)域具有良好的應(yīng)用前景。然而,關(guān)于高摻雜單晶襯底上的β-Ga2O3肖特基勢(shì)壘二極管(SBD)的報(bào)道非常少,這些SBD的溫度相關(guān)性能的機(jī)制尚不清楚。
亞利桑那州立大學(xué)計(jì)算機(jī)與能源工程學(xué)院趙玉吉教授詳細(xì)研究了高摻雜(~3 × 1018cm?3)單晶襯底上的β-Ga2O3SBDs的溫度相關(guān)的電學(xué)性能,介紹了一種修正的具有電壓相關(guān)勢(shì)壘高度的非均勻勢(shì)壘熱離子發(fā)射模型,對(duì)漏電流隨距離的變化進(jìn)行了定量研究。
這些結(jié)果代表了高摻雜襯底上的β-Ga2O3器件的研究進(jìn)展,有利于低損耗β-Ga2O3電子、光電子器件的未來(lái)發(fā)展。
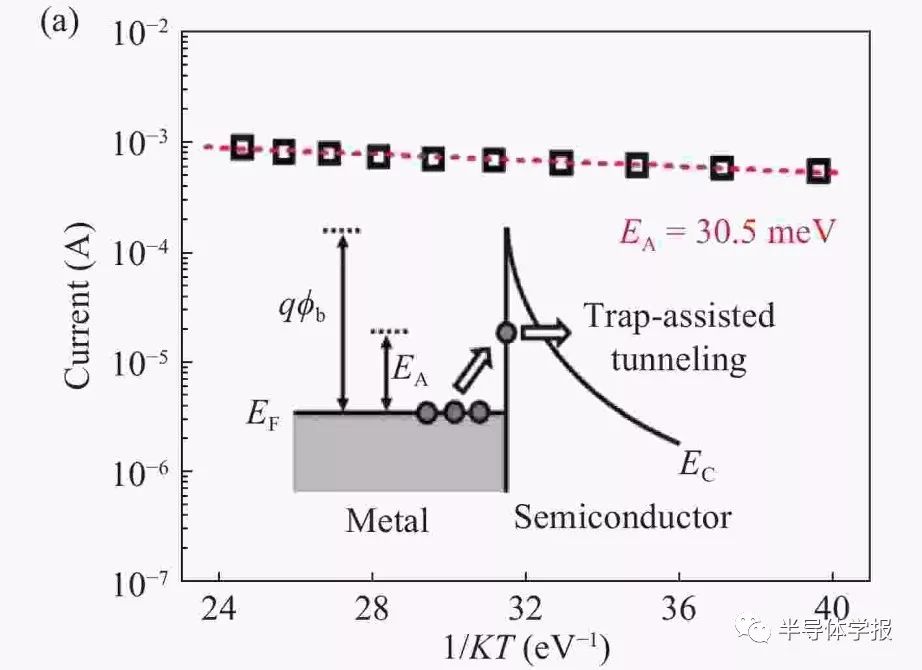
β-Ga2O3SBD的反向漏電流
Temperature-dependent electrical properties of β-Ga2O3Schottky barrier diodes on highly doped single-crystal substrates
Tsung-Han Yang, Houqiang Fu, Hong Chen, Xuanqi Huang, Jossue Montes, Izak Baranowski, Kai Fu, Yuji Zhao
J. Semicond.2019, 40(1), 012801
doi: 10.1088/1674-4926/40/1/012801
Full text
http://www.jos.ac.cn/article/doi/10.1088/1674-4926/40/1/012801?pageType=en
7.藍(lán)寶石襯底上β-Ga2O3薄膜的分子束外延生長(zhǎng)
單斜結(jié)構(gòu)的β-Ga2O3是一種直接帶隙的寬禁帶氧化物半導(dǎo)體材料,其禁帶寬度約為4.8?4.9 eV,擊穿電場(chǎng)約為 8 MV/cm。其巴利加優(yōu)值因子(μEb3)僅次于金剛石,成為功率半導(dǎo)體器件研制的重要候選材料之一,在高頻、高溫、大功率等電子器件方面有廣闊的應(yīng)用前景。同時(shí),Ga2O3本征單晶襯底材料可采用熔體生長(zhǎng)技術(shù)實(shí)現(xiàn),相比于SiC和GaN襯底,更容易實(shí)現(xiàn)大尺寸單晶襯底制備,具有低成本優(yōu)勢(shì)。
北京大學(xué)物理學(xué)院王新強(qiáng)教授主要利用PREVAC-MBE分子束外延系統(tǒng)在藍(lán)寶石襯底上異質(zhì)外延制備Ga2O3薄膜。通過(guò)RHEED和XRD測(cè)量,證實(shí)了外延關(guān)系是[010] (?201) β-Ga2O3|| [01?10] (0001)Al2O3。通過(guò)優(yōu)化生長(zhǎng)條件,提高了β-Ga2O3薄膜的結(jié)晶質(zhì)量,并總結(jié)了簡(jiǎn)單的生長(zhǎng)相圖。與GaN薄膜的富金屬生長(zhǎng)模式不同,β-Ga2O3薄膜的生長(zhǎng)不需要在富金屬條件下生長(zhǎng),在較高的Ga束流下,多余的Ga原子會(huì)和O原子形成氣態(tài)Ga2O,然后從表面解吸,導(dǎo)致生長(zhǎng)速率變小。綜合考慮生長(zhǎng)速率、晶體質(zhì)量和表面平整度幾個(gè)因素,最終得到優(yōu)化后的薄膜(?201)XRD半高寬減小為0.68°,表面粗糙度是2.04 nm(3 μm × 3 μm)。另外CL測(cè)試分析表明,β-Ga2O3薄膜在417 nm附近表現(xiàn)出較強(qiáng)的與缺陷有關(guān)的發(fā)光,推測(cè)可能是來(lái)源于施主-受體對(duì)(DAP)的復(fù)合發(fā)光。
超寬禁帶β-Ga2O3薄膜的MBE外延制備和優(yōu)化,為實(shí)現(xiàn)之后在非故意摻雜的襯底上外延n型載流子濃度大范圍精確可控的Ga2O3薄膜和實(shí)現(xiàn)Ga2O3基電子器件奠定基礎(chǔ)。
藍(lán)寶石襯底上生長(zhǎng)的β-Ga2O3薄膜的XRD 2Θ?w掃描圖。插圖為2英寸背面鍍Ti的藍(lán)寶石襯底上生長(zhǎng)的β-Ga2O3外延薄膜圖片
β-Ga2O3thin film grown on sapphire substrate by plasma-assisted molecular beam epitaxy
Jiaqi Wei, Kumsong Kim, Fang Liu, Ping Wang, Xiantong Zheng, Zhaoying Chen, Ding Wang, Ali Imran, Xin Rong, Xuelin Yang, Fujun Xu, Jing Yang, Bo Shen, Xinqiang Wang
J. Semicond.2019, 40(1), 012802
doi: 10.1088/1674-4926/40/1/012802
Full text
http://www.jos.ac.cn/article/doi/10.1088/1674-4926/40/1/012802?pageType=en
8.擊穿電壓高達(dá)550 V的源場(chǎng)板Ga2O3MOSFET
氧化鎵(Ga2O3)具有超寬的禁帶寬度和超高的臨界擊穿場(chǎng)強(qiáng)的優(yōu)勢(shì),是下一代高能效電力電子器件的理想材料。Ga2O3功率器件與GaN和SiC器件相同耐壓情況下,導(dǎo)通電阻更低,功耗更小,能夠極大地節(jié)省器件工作時(shí)的電能損失。同時(shí)氧化鎵可以熔體生長(zhǎng)技術(shù)實(shí)現(xiàn),具有低成本優(yōu)勢(shì)。氧化鎵功率器件主要分為金屬氧化物半導(dǎo)體場(chǎng)效應(yīng)晶體管(MOSFET)和肖特基二極管(SBD)兩種。國(guó)外從2012年左右就開(kāi)始氧化鎵功率器件的研究,并取得了不錯(cuò)的研究結(jié)果。而國(guó)內(nèi)在氧化鎵功率器件,尤其是MOSFET器件方面的研究還比較薄弱。
中國(guó)電子科技集團(tuán)公司第十三研究所專(zhuān)用集成電路國(guó)家級(jí)重點(diǎn)實(shí)驗(yàn)室呂元杰團(tuán)隊(duì)首次將源場(chǎng)板結(jié)構(gòu)引入Ga2O3MOSFET器件,實(shí)現(xiàn)了擊穿電壓的顯著提升,擊穿電壓最高達(dá)到550 V;同時(shí)采用高介電常數(shù)的HfO2材料作為柵下介質(zhì),有效地降低了器件漏電特性,開(kāi)關(guān)比達(dá)到109。本文填補(bǔ)了國(guó)內(nèi)在Ga2O3MOSFET器件方面的空白,同時(shí)器件特性是國(guó)內(nèi)報(bào)道的最高結(jié)果。
后續(xù)通過(guò)優(yōu)化源場(chǎng)板結(jié)構(gòu)、采用多場(chǎng)板結(jié)構(gòu)有望能繼續(xù)提升Ga2O3MOSFET器件的耐壓特性。
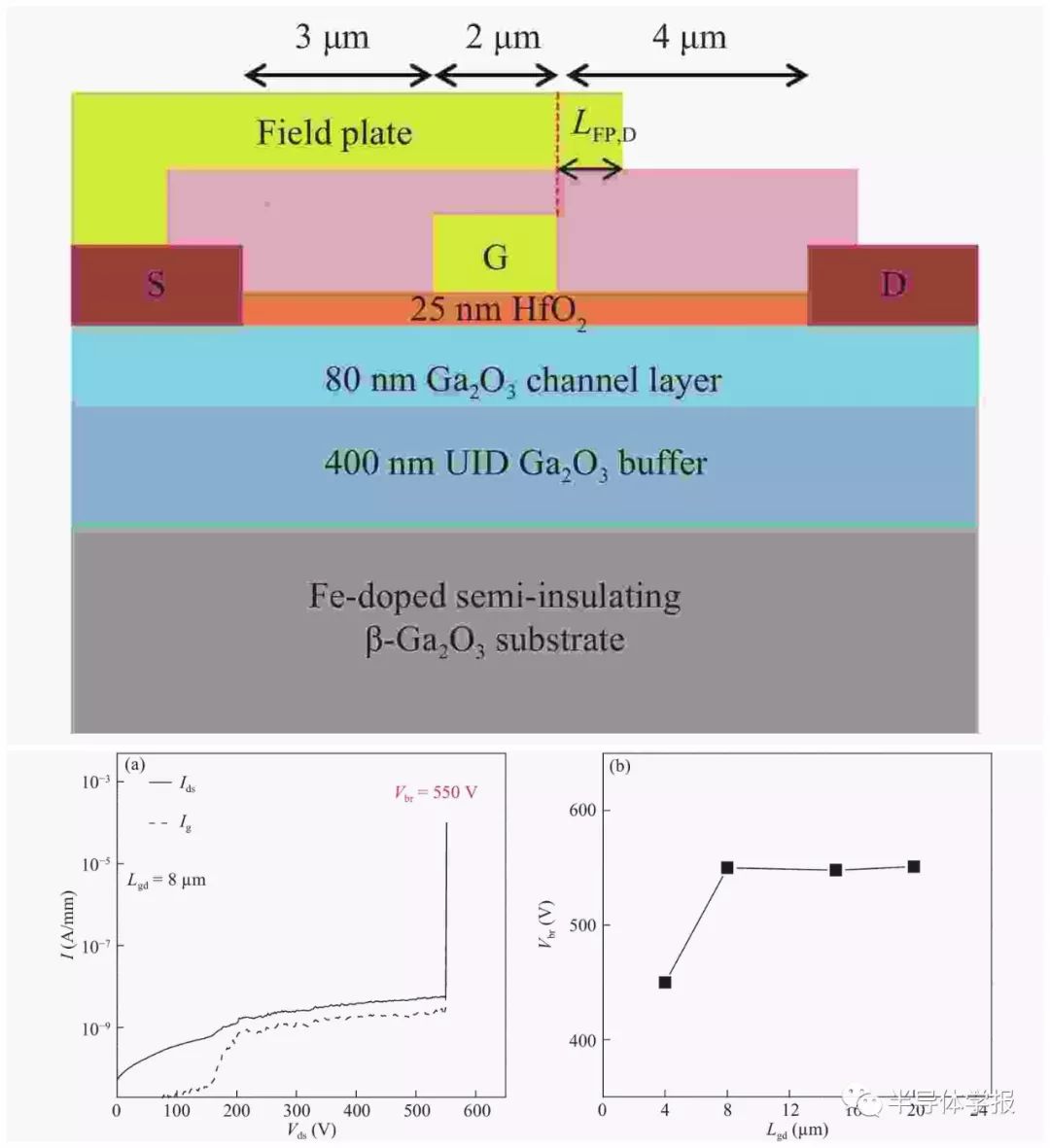
Ga2O3MOSFET的橫截面示意圖及其擊穿特性
Source-field-platedGa2O3MOSFET with a breakdown voltage of 550 V
Yuanjie Lü, Xubo Song, Zezhao He, Yuangang Wang, Xin Tan, Shixiong Liang, Cui Wei, Xingye Zhou, Zhihong Feng
J. Semicond.2019, 40(1), 012803
doi: 10.1088/1674-4926/40/1/012803
Full text
http://www.jos.ac.cn/article/doi/10.1088/1674-4926/40/1/012803?pageType=en
9.藍(lán)寶石(0001)襯底上超聲霧化輸運(yùn)輔助化學(xué)氣相沉積方法同質(zhì)外延厚α-Ga2O3薄膜
作為一種寬禁帶半導(dǎo)體,氧化鎵(Ga2O3)具有比SiC、GaN更為優(yōu)越的物理特性,成為近年來(lái)新型功率半導(dǎo)體材料與器件領(lǐng)域的研究熱點(diǎn)。研究發(fā)現(xiàn),亞穩(wěn)態(tài)α-Ga2O3比β-Ga2O3在禁帶寬度、電子有效質(zhì)量、臨界擊穿場(chǎng)強(qiáng)和Baliga品質(zhì)因子等重要性質(zhì)上更勝一籌,意味著更適合于發(fā)展高性能、低功耗和低成本功率電子器件。更為重要的是,α-Ga2O3和α-Al2O3晶體結(jié)構(gòu)相同,可通過(guò)異質(zhì)外延獲得高質(zhì)量單晶薄膜,并可解決基于β-Ga2O3單晶襯底熱導(dǎo)系數(shù)小導(dǎo)致功率器件散熱性差的嚴(yán)重問(wèn)題。
基于此,南京大學(xué)電子科學(xué)與工程學(xué)院葉建東教授采用低成本的超聲霧化輸運(yùn)輔助化學(xué)氣相沉積(MIST-CVD)方法在藍(lán)寶石(0001)襯底上獲得了8 μm厚的無(wú)龜裂α-Ga2O3單晶薄膜,其螺旋位錯(cuò)和刃位錯(cuò)的位錯(cuò)密度分別為2.24 × 106和1.63 × 109cm-2,表明材料具有很高的單晶晶體質(zhì)量。研究同時(shí)發(fā)現(xiàn),α-Ga2O3具有典型的間接帶隙特征,其光學(xué)禁帶寬度為5.03 eV。
后續(xù)通過(guò)可控?fù)诫s、物相調(diào)控、應(yīng)變工程、能帶剪裁和界面設(shè)計(jì)等關(guān)鍵技術(shù)的實(shí)現(xiàn),可充分挖掘α-Ga2O3材料在功率器件研制方面更為優(yōu)越的物理特性,這為解決耐高壓和低損耗難以兼顧的問(wèn)題提供了新思路和新途徑。

Ga2O3外延薄膜的XRD 2θ/ω掃描圖
Heteroepitaxial growth of thick α-Ga2O3film on sapphire (0001) by MIST-CVD technique
Tongchuan Ma, Xuanhu Chen, Fangfang Ren, Shunming Zhu, Shulin Gu, Rong Zhang, Youdou Zheng, Jiandong Ye
J. Semicond.2019, 40(1), 012804
doi: 10.1088/1674-4926/40/1/012804
Full text
http://www.jos.ac.cn/article/doi/10.1088/1674-4926/40/1/012804?pageType=en
10.輕摻雜的β-Ga2O3的Mg/Au歐姆接觸的電流傳輸機(jī)理
低阻歐姆接觸對(duì)高性能β-Ga2O3基器件是非常重要的,例如β-Ga2O3基功率器件和日盲紫外探測(cè)器。許多研究小組通過(guò)離子注入和半導(dǎo)體插入層的方法獲得了低阻的β-Ga2O3歐姆接觸,但是對(duì)歐姆接觸中電流流動(dòng)機(jī)制的研究幾乎沒(méi)有。了解歐姆接觸中電流流動(dòng)機(jī)制有助于器件性能的提升。
大連理工大學(xué)微電子學(xué)院梁紅偉教授采用Mg/Au在輕摻雜的β-Ga2O3制備了良好的歐姆接觸,根據(jù)比接觸電阻與溫度的關(guān)系和參數(shù)確定電流流動(dòng)機(jī)制為熱電子發(fā)射占主導(dǎo),這不同于傳統(tǒng)的通過(guò)電子遂穿來(lái)獲得歐姆接觸。這有助于我們了解輕摻雜β-Ga2O3歐姆接觸的電流傳輸機(jī)理并提高β-Ga2O3基器件的性能。
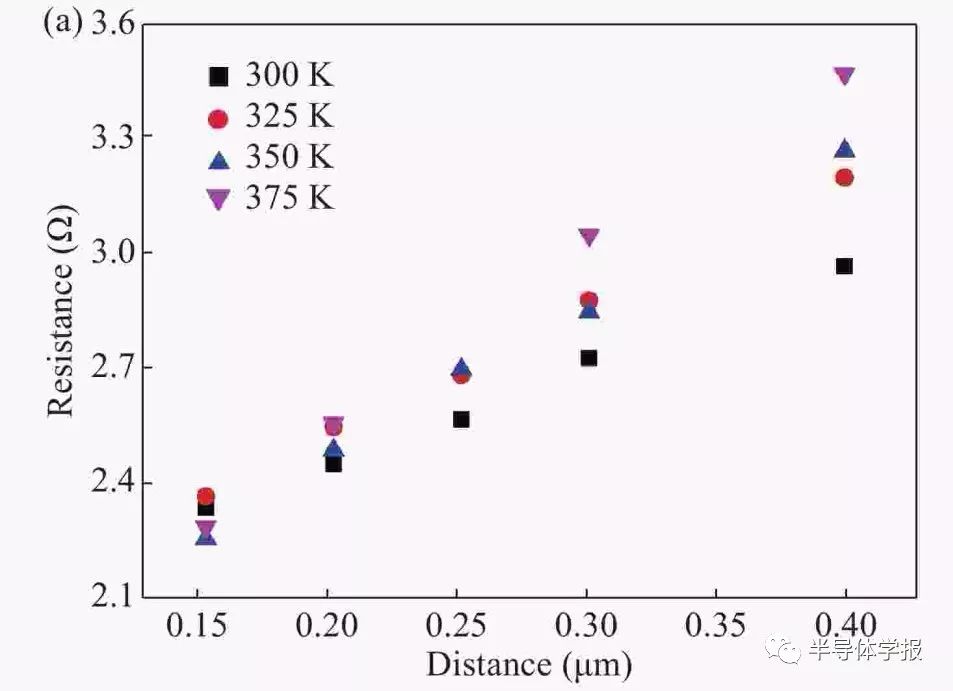
不同溫度下,Mg/Au-β-Ga2O3電阻隨距離的變化
Current transport mechanism of Mg/Au ohmic contacts to lightly doped n-type β-Ga2O3
Jianjun Shi, Xiaochuan Xia, Qasim Abbas, Jun Liu, Heqiu Zhang, Yang Liu, Hongwei Liang
J. Semicond.2019, 40(1), 012805
doi: 10.1088/1674-4926/40/1/012805
Full text
http://www.jos.ac.cn/article/doi/10.1088/1674-4926/40/1/012805?pageType=en
11.具有NH3等離子體原位預(yù)處理的離子體增強(qiáng)原子層沉積法生長(zhǎng)氧化鎵薄膜
在器件工藝過(guò)程中,GaN基外延片不可避免暴露大氣環(huán)境,形成表面氧化層、以及C、H等雜質(zhì)沾污,使得半導(dǎo)體表面本征性質(zhì)發(fā)生明顯改變,且難以得到有效的控制。在GaN基材料與器件方面,缺陷或陷阱俘獲中心一直是研究的難題。通過(guò)界面鈍化來(lái)降低界面態(tài)就成為首選的技術(shù)路線(xiàn)。
Ga2O3是一種具有寬禁帶、高介電常數(shù)、耐高擊穿電壓的氧化物半導(dǎo)體和介質(zhì)材料,在半導(dǎo)體器件的鈍化方面中有廣泛的應(yīng)用。
原子層沉積是一種非常合適于生長(zhǎng)超薄鈍化層材料的技術(shù),其自限制性能夠?qū)Ρ∧さ某煞旨昂穸扔芯_的控制,可得到均勻致密的薄膜。但原子層沉積技術(shù)由于其生長(zhǎng)速率較慢,外延薄膜的結(jié)晶質(zhì)量差問(wèn)題也是科研人員的關(guān)注點(diǎn)。
基于此,中國(guó)科學(xué)院蘇州納米技術(shù)與納米仿生研究所丁孫安研究員提出了一種提高外延Ga2O3薄膜沉積速率的方法,即NH3等離子體原位預(yù)處理GaN,繼而沉積Ga2O3薄膜。研究發(fā)現(xiàn),經(jīng)NH3等離子體處理后,Ga2O3薄膜的表面形貌和化學(xué)計(jì)量比并改變,僅Ga2O3薄膜厚度增加,沉積速率顯著提高。這一現(xiàn)象歸因于NH3等離子體對(duì)GaN表面態(tài)的修飾作用,NH3預(yù)處理增加了GaN表面的羥基活性吸附點(diǎn),導(dǎo)致薄膜沉積速率的增加。但NH3等離子體對(duì)GaN表面的作用可能引入缺陷會(huì)影響Ga2O3薄膜的結(jié)晶質(zhì)量。
在不損傷GaN表面的前提下,外延高質(zhì)量的Ga2O3薄膜,對(duì)實(shí)現(xiàn)Ga2O3/GaN界面的鈍化具有重要意義。
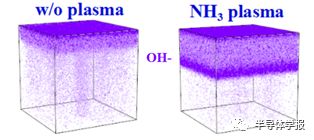
Ga2O3/GaN的3D形貌
GaN上RPEALD沉積的Ga2O3薄膜的HRTEM圖
Remote plasma-enhanced atomic layer deposition of gallium oxide thin films withNH3plasma pretreatment
Hui Hao, Xiao Chen, Zhengcheng Li, Yang Shen, Hu Wang, Yanfei Zhao, Rong Huang, Tong Liu, Jian Liang, Yuxin An, Qing Peng, Sunan Ding
J. Semicond.2019, 40(1), 012806
doi: 10.1088/1674-4926/40/1/012806
Full text
http://www.jos.ac.cn/article/doi/10.1088/1674-4926/40/1/012806?pageType=en
-
半導(dǎo)體
+關(guān)注
關(guān)注
334文章
27703瀏覽量
222630 -
電子器件
+關(guān)注
關(guān)注
2文章
595瀏覽量
32177 -
氧化鎵
+關(guān)注
關(guān)注
5文章
76瀏覽量
10318
原文標(biāo)題:半導(dǎo)體學(xué)報(bào)2019年第1期——超寬禁帶半導(dǎo)體氧化鎵材料與器件專(zhuān)刊
文章出處:【微信號(hào):bdtdsj,微信公眾號(hào):中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
國(guó)內(nèi)氧化鎵半導(dǎo)體又有新進(jìn)展,距離量產(chǎn)還有多遠(yuǎn)?
國(guó)內(nèi)氧化鎵半導(dǎo)體又有新進(jìn)展,距離量產(chǎn)還有多遠(yuǎn)?
報(bào)名 | 寬禁帶半導(dǎo)體(SiC、GaN)電力電子技術(shù)應(yīng)用交流會(huì)
GaN基微波半導(dǎo)體器件材料的特性
吉時(shí)利源表在寬禁帶材料測(cè)試的應(yīng)用方案
8英寸!第四代半導(dǎo)體再突破,我國(guó)氧化鎵研究取得系列進(jìn)展,產(chǎn)業(yè)化再進(jìn)一步
氧化鎵成超寬禁帶功率半導(dǎo)體新寵
金剛石半導(dǎo)體材料距離進(jìn)入半導(dǎo)體產(chǎn)業(yè)鏈還需要多久?
國(guó)內(nèi)氧化鎵半導(dǎo)體又有新進(jìn)展,距離量產(chǎn)還有多遠(yuǎn)?
什么是寬禁帶半導(dǎo)體?

直播回顧 | 寬禁帶半導(dǎo)體材料及功率半導(dǎo)體器件測(cè)試





 超寬禁帶半導(dǎo)體氧化鎵材料與器件專(zhuān)刊
超寬禁帶半導(dǎo)體氧化鎵材料與器件專(zhuān)刊












評(píng)論