英特爾近日在舊金山召開的SemiCon West上公布了他們在半導體領域最新的研究成果,一共公布了三種新的3D封裝工藝,為未來開啟了一個全新的維度。芯片封裝一直是芯片制造中的一個重頭戲,在傳統的2D封裝技術已經發展到瓶頸之后,半導體制造商們把目光轉向了3D堆疊工藝。Foveros是英特爾于2018年提出的3D封裝工藝技術,將在今年晚些時候正式發售的LakeField處理器上率先使用。
3D堆疊工藝
芯片封裝一直是芯片制造中的一個重頭戲,在傳統的2D封裝技術已經發展到瓶頸之后,半導體制造商們把目光轉向了3D堆疊工藝。Foveros是英特爾于2018年提出的3D封裝工藝技術,將在今年晚些時候正式發售的LakeField處理器上率先使用。
Co-EMIB
EMIB和Foveros是英特爾用于3D堆棧式封裝的兩項技術,前者允許芯片模塊間的高速內聯,后者允許堆疊模塊間的垂直通信,這兩項技術可以在低功耗的情況下提供非常高的帶寬和IO密度。新的Co-EMIB技術是將EMIB和Foveros相結合,同樣的,采用Co-EMIB技術的芯片保留了兩項技術原有的優點,可以在低功耗高帶寬的情況下連接模擬電路、內存以及其他的周邊元件。
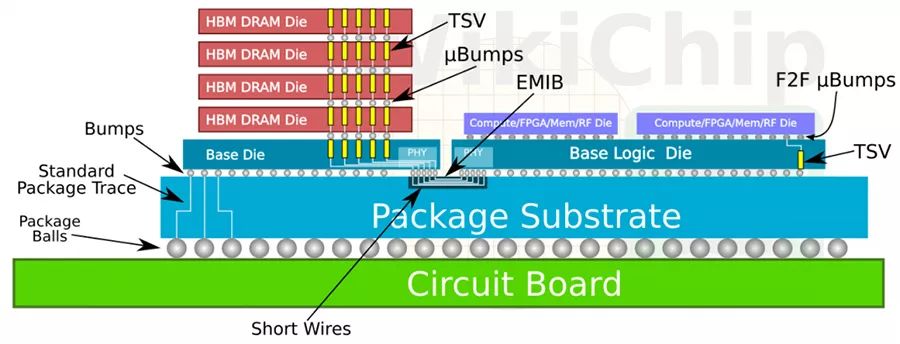
Co-EMIB示意圖,圖源WikiChip
ODI
ODI全稱Omni-Directional Interconnect,在3D封裝中,芯片通信有兩個維度,一是水平方向上的芯片間互相通信,另一個是垂直方向上的,比如一個計算模塊與另一個獨立計算模塊通信就是水平方向上的,而計算模塊與堆疊在其上的高速緩存通信就是垂直方向上的。新的ODI封裝技術減少了與通訊總線接觸的面積,這部分節約出來的面積就可以直接連通底層的供電,減少了中間層可能發生的漏電情況,大幅提升了供電性能。
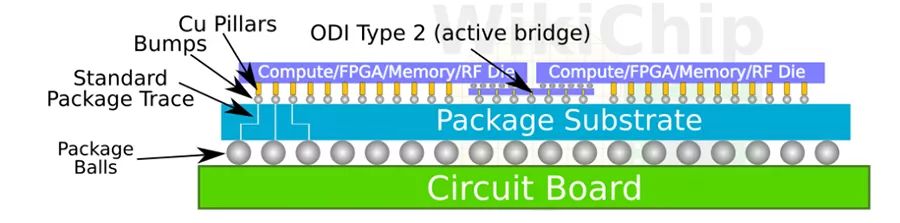
ODI示意圖,圖源WikiChip
MDIO
MDIO是本次公布的最為概念性的技術,它是一種新的片上互聯總線,相比目前使用的AIB(Advanced Interface Bus)物理層,新的總線將提供兩倍的帶寬和更高的電源效率。
總結
這次公布的三種新型技術都是對未來的芯片封裝有著重要作用的技術,它們雖然不會地給我們的PC帶來直觀性的變化,但是他們給英特爾乃至整個半導體業界更高的靈活性去設計一枚處理器或者是SoC,并且采用3D堆疊技術會在性能上有所提升。在后摩爾定律時代,這種新的技術突破是未來半導體發展的堅實基礎。
-
英特爾
+關注
關注
61文章
10008瀏覽量
172337 -
半導體
+關注
關注
334文章
27711瀏覽量
222658 -
3D
+關注
關注
9文章
2911瀏覽量
108008 -
封裝技術
+關注
關注
12文章
553瀏覽量
68039
原文標題:擠牙膏不影響創新,英特爾公布三種3D封裝新技術
文章出處:【微信號:mantianIC,微信公眾號:滿天芯】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
英特爾宣布擴容成都封裝測試基地
英特爾推出全新實感深度相機模組D421
立體視覺新手必看:英特爾? 實感? D421深度相機模組

英特爾IT的發展現狀和創新動向
英特爾是如何實現玻璃基板的?
英特爾計劃最快2026年量產玻璃基板
英特爾CEO:AI時代英特爾動力不減
英特爾推出全新技術Thunderbolt Share
英特爾公布Gaudi 3 AI加速器中國特供版計劃
Ansys和英特爾代工合作開發多物理場簽核解決方案
最新技術!英特爾于IFS Direct Connect會議上公布3D芯片技術、邏輯單元、背面供電等未來代工技術!
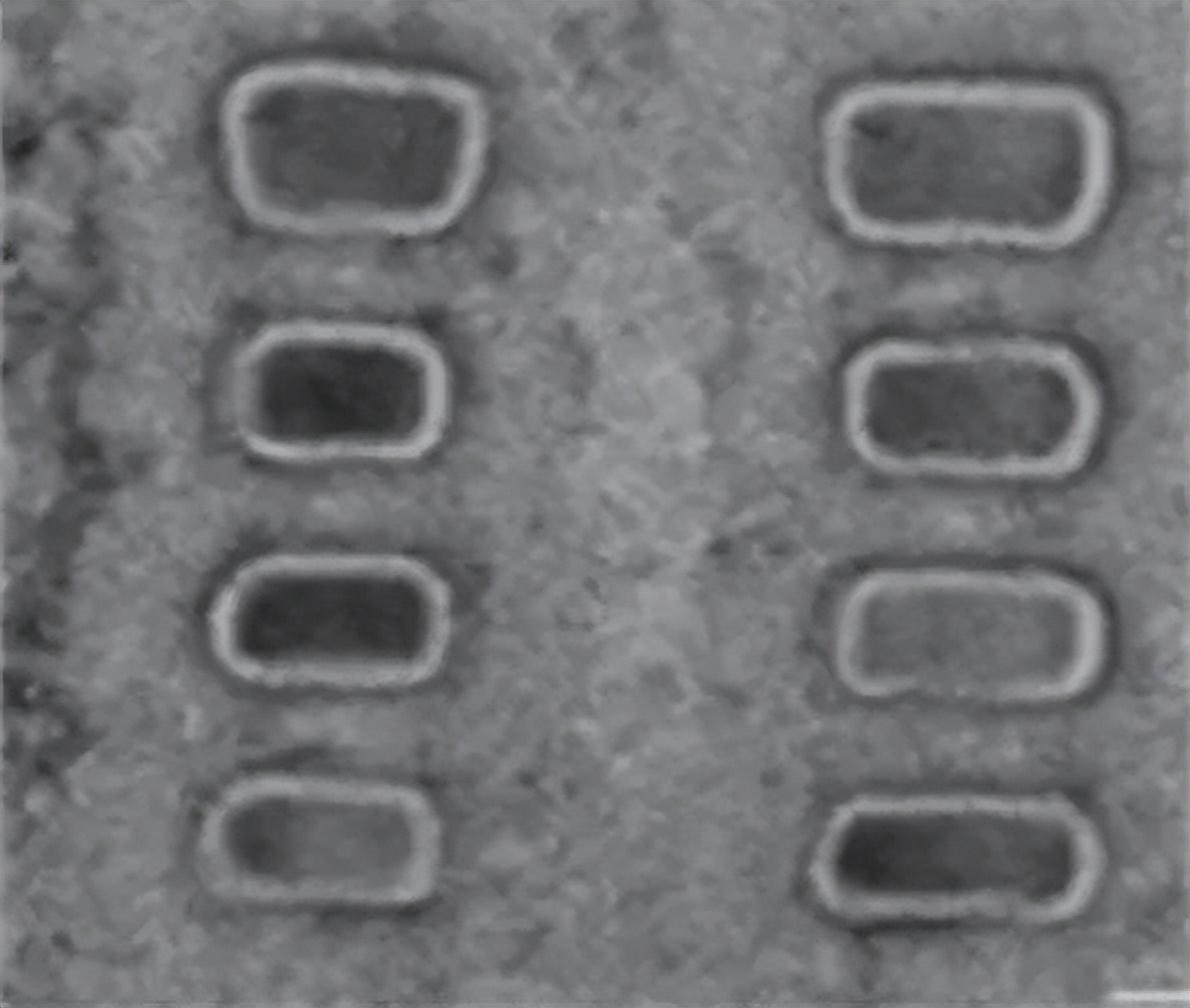




 擠牙膏不影響創新 英特爾公布三種3D封裝新技術
擠牙膏不影響創新 英特爾公布三種3D封裝新技術












評論