本文一般涉及處理光掩模的領域,具體涉及用于從光掩模上剝離光致抗蝕劑和/或清洗集成電路制造中使用的光掩模的設備和方法。
光掩模是涂有金屬層的透明陶瓷襯底,該金屬層形成電子電路的圖案。在集成電路的制造過程中,薄膜通常用于密封光掩模使其免受顆粒污染,從而隔離和保護光掩模表面免受來自光掩模圖案焦平面的灰塵或其他顆粒的影響。為了以高成品率生產功能性集成電路,光掩模和薄膜需要無污染。光掩模的污染可能發生在光掩模本身的制造過程中,也可能發生在光掩模的使用過程中集成電路制造過程中的光掩模,特別是光掩模加工和/或處理過程中的光掩模40。一種類型的污染是光掩模表面的有機/分子污染。光掩模表面上的有機/分子污染物,例如化學污漬或殘留物,降低并降低了透射率特性45和/或光掩模的特性,最終影響被制造的半導體器件的質量。
光刻過程中影響集成電路質量的另一種污染是微粒污染。顆粒污染物可以包括任何小顆粒,例如灰塵顆粒,它們可以在光掩模上或者夾在光掩模和薄膜之間。
光刻過程中投射的是從光掩模表面剝離光刻膠。類似于集成電路器件的制造,在光掩模的制造過程中,光致抗蝕劑被施加到光掩模的表面,并且光和/或紫外線輻射以期望的電路圖案被施加到光掩模表面。
在光掩模制造過程中和作為集成電路維護的一部分,光掩模的制作和清潔10個晶圓廠。常規方法使用硫酸和過氧化氫的高溫混合物(“SPM”)來在第二步中剝離光致抗蝕劑和濃縮的氫氧化銨/過氧化氫(“APM”)的高溫混合物,以進一步清潔光掩模。
目前,光致抗蝕劑清洗過程通常在單個掩模噴霧清潔器工具上完成。目前的清潔技術包括噴涂/刷洗清潔,這種清潔使用混合的SPM,然后是氨清潔。現有技術工藝的問題在于,它們經常遭受不良的化學混合或非常差的沖洗,導致表面上的高硫含量,這由于霧度而對隨后的掩模制造或照相工藝產生負面影響。
因此,本次的目的是提供一種用于光致抗蝕劑剝離和/或光掩模清洗的方法和系統,該系統在集成電路制造過程中增加了器件產量、減少光掩模上的缺陷和/或污染。也增加了光掩模的壽命。
進一步優選的是,當應用于光掩模時,自組裝膜基本上沒有氣泡。無氣泡SOM的使用增強了兆聲聲學傳輸,并導致污染物去除的改善。該系統還可以包括向光掩模提供臭氧化去離子水(DIO)的裝置和在低于30℃的溫度下向光掩模提供氫氧化銨和過氧化氫的稀水溶液的裝置。可配備一個在線冷卻器,以確保dAPM得到充分冷卻。還可以包括向光掩模供應干燥流體的裝置。
圖1是根據本發明實施例的適于剝離和/或清潔光掩模的濕式工作臺系統的示意圖。

圖2是根據本發明實施例的適于剝離和/或清潔光掩模的單晶片系統的示意圖。

圖3是一對照片,比較了根據本發明在清潔之前和清潔之后光掩模上的污染。
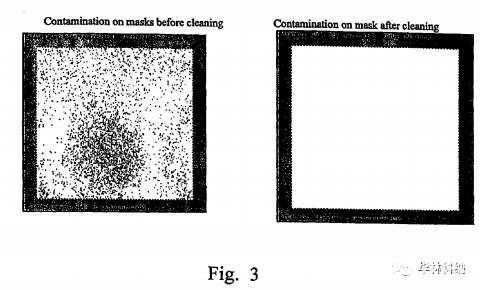
圖4是顯示二元光掩模清潔粒子50的曲線圖,光掩模的暗區域和亮區域的結果。圖5是顯示an的清潔。

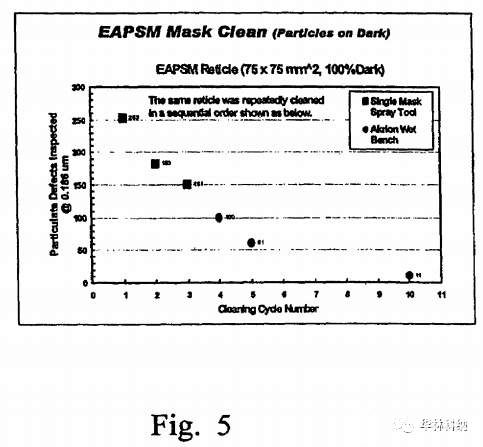
結果的曲線圖
根據本發明實施例的具有100%暗區的EAPSM掩模。
審核編輯:湯梓紅
 電子發燒友App
電子發燒友App









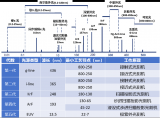


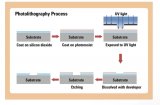
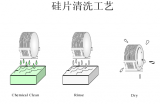

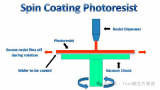
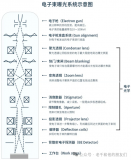







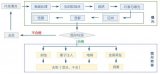



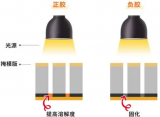




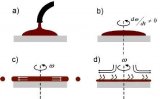




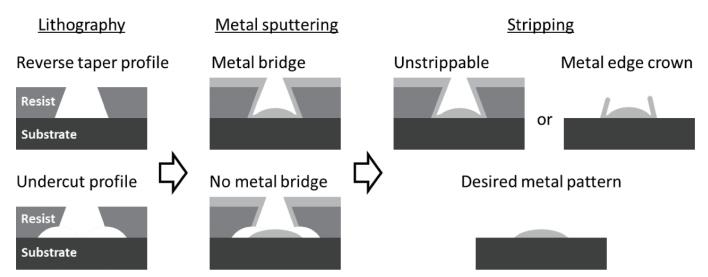

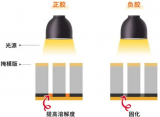
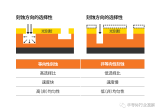
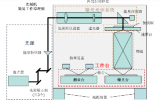

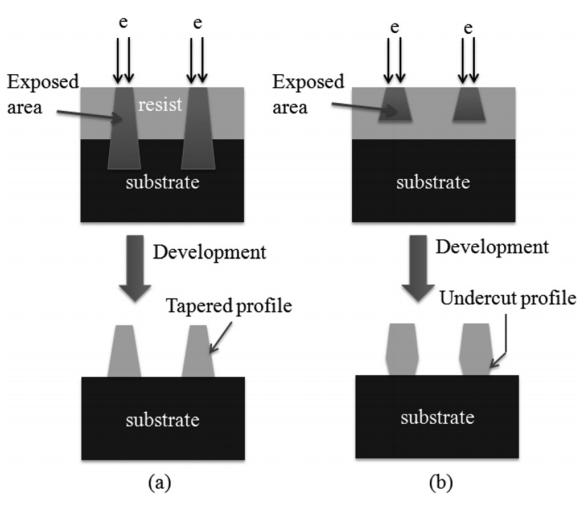
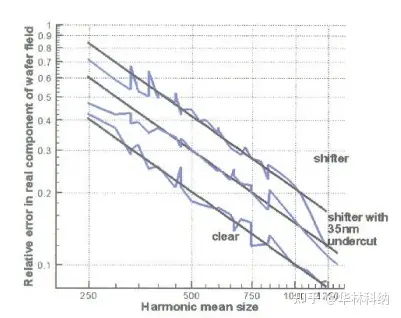










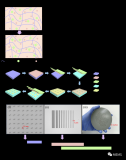

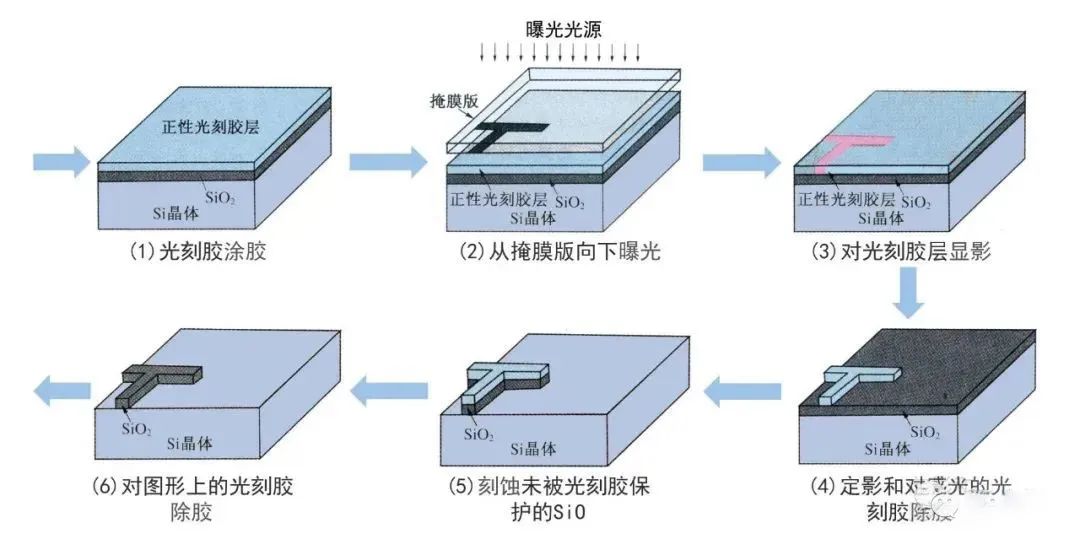
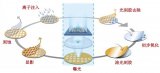
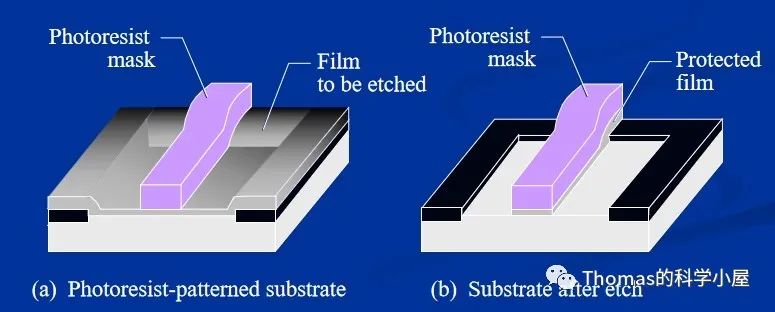





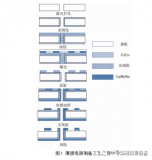


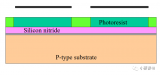


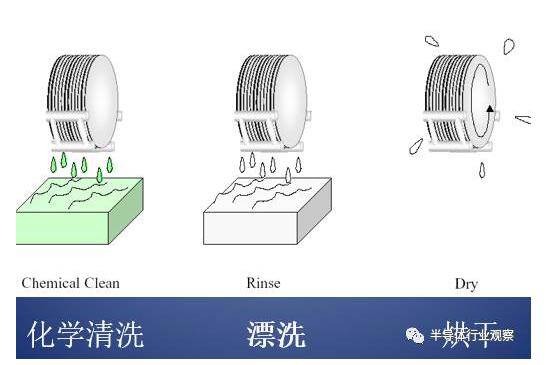
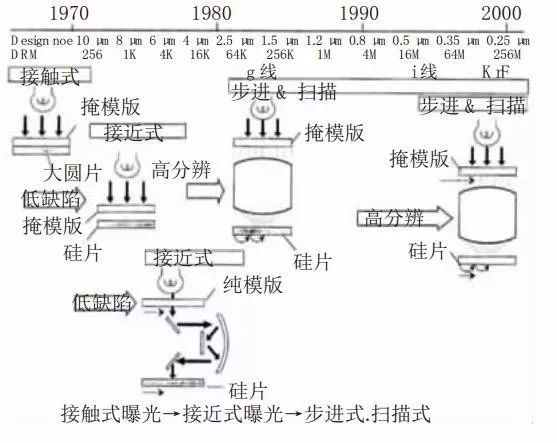
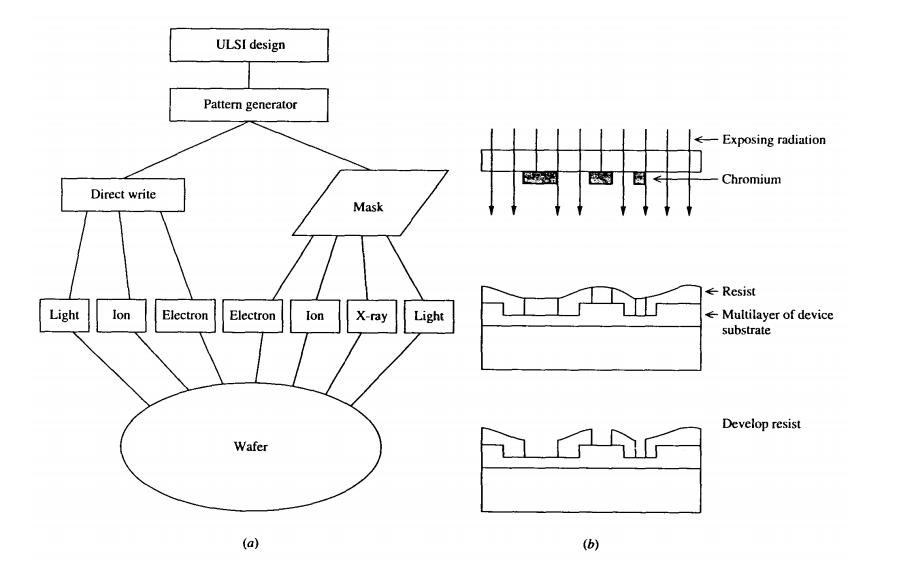











評論